
КАТЕГОРИИ:
Архитектура-(3434)Астрономия-(809)Биология-(7483)Биотехнологии-(1457)Военное дело-(14632)Высокие технологии-(1363)География-(913)Геология-(1438)Государство-(451)Демография-(1065)Дом-(47672)Журналистика и СМИ-(912)Изобретательство-(14524)Иностранные языки-(4268)Информатика-(17799)Искусство-(1338)История-(13644)Компьютеры-(11121)Косметика-(55)Кулинария-(373)Культура-(8427)Лингвистика-(374)Литература-(1642)Маркетинг-(23702)Математика-(16968)Машиностроение-(1700)Медицина-(12668)Менеджмент-(24684)Механика-(15423)Науковедение-(506)Образование-(11852)Охрана труда-(3308)Педагогика-(5571)Полиграфия-(1312)Политика-(7869)Право-(5454)Приборостроение-(1369)Программирование-(2801)Производство-(97182)Промышленность-(8706)Психология-(18388)Религия-(3217)Связь-(10668)Сельское хозяйство-(299)Социология-(6455)Спорт-(42831)Строительство-(4793)Торговля-(5050)Транспорт-(2929)Туризм-(1568)Физика-(3942)Философия-(17015)Финансы-(26596)Химия-(22929)Экология-(12095)Экономика-(9961)Электроника-(8441)Электротехника-(4623)Энергетика-(12629)Юриспруденция-(1492)Ядерная техника-(1748)
Оптическая литография, получение наноструктур
|
|
|
|
Рассматривая возможность применения обычного литографического процесса для получения рисунков с размерами нанометрового масштаба необходимо определить критические ступени, которыми в предлагаемой схеме являются процесс экспонирования и травления.
Минимальный размер рисунка, который может быть разрешен с помощью той или иной оптической системы может быть оценен с использованием известной формулы
 =k1
=k1 /NA (5)
/NA (5)
где  - разрешение, k1 – константа зависящая от типа использованного резиста, типа литографического процесса,
- разрешение, k1 – константа зависящая от типа использованного резиста, типа литографического процесса,  - длина волны света, NA – численная апертура оптической системы.
- длина волны света, NA – численная апертура оптической системы.
Формула показывает, что уменьшение длины волны и (или) увеличение численной апертуры позволяет реализовать более высокое разрешение. Оптическая литография всегда развивалась по этому пути. Для производства микросхем с 350 нм рисунками использовалась 360 нм дуговая ртутная лампа (i линия). Дальнейшее увеличение степени интеграции микросхем привело к переходу литографических систем в область так называемого глубокого ультрафиолета (deep UV). 250 нм транзисторы рисуются с использованием 248 нм KrF эксимерного лазера, 180 нм литография оперирует с излучением 198 нм ArF эксимерного лазера. 118 -120 нм литография ориентирована на использование 157 нм F2 лазера.
Увеличение числовой апертуры имеет определенные ограничения, связанные в первую очередь с уменьшением глубины фокуса (DOF)
В обычной фотографии мы сталкиваемся с проблемой малой глубины фокуса, когда изображения предмета и фона не находятся в фокусе одновременно. С литографической точки зрения необходимо иметь четкое изображение как рисунка на вершине слоя резиста, так и в глубине. Применение систем с высокой апертурой и короткой длиной волны снижает глубину фокуса до недопустимых пределов даже для субмикронного разрешения и становится серьезной проблемой для получения приборов наноэлектроники.
|
|
|
Для толстых резистов (по сравнению с длиной волны используемого света) достижение необходимой глубины фокуса становится существенной проблемой.
Таким образом, существует ряд физических и технических проблем затрудняющих прямое использование существующего литографического процесса для создания структур наноразмерного масштаба. Однако применение более сложных оптических систем и процессов позволяет надеяться на то, что возможности традиционной литографии далеко не исчерпаны. Остановимся на некоторых разрабатываемых в этом направлении процессах подробнее.
Фазосдвигающие маски.
При экспонировании близкорасположенных линий световые лучи имеют приблизительно одинаковые фазы. Это приводит к тому, что в области между линиями наблюдается интерференция хвостов световых потоков экспонирующих различные линии. Это приводит к резкому снижению разрешения при работе в режиме близком к дифракционному пределу. Ситуацию можно исправить, если обеспечить экспонирование соседних линий лучами с противоположными фазами. Сдвиг фаз обеспечивается применением специальных фазосдвигающих покрытий при изготовлении фотошаблонов. Схема соответствующего процесса приведена на рис. 7. В некоторых случаях использование интерференции сдвинутых по фазе лучей используется для экспонирования отдельных линий, размер которых существенно меньше длины волны используемого света.
Более простым способом исключения интерференционных эффектов является экспонирование с применением внеосевого освещения. В этом случае фазовый сдвиг обеспечивается тем, что угол падения света на резист выбирается таким образом, чтобы соседние линии освещались лучами с противоположными фазами.
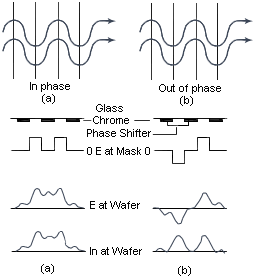
Рис. 7. Схема процесса с использованием фазосдвигающих масок. а) Шаблон без сдвига фазы. б) Шаблон с фазовым сдвигом.
|
|
|
|
Дата добавления: 2014-01-20; Просмотров: 616; Нарушение авторских прав?; Мы поможем в написании вашей работы!