
КАТЕГОРИИ:
Архитектура-(3434)Астрономия-(809)Биология-(7483)Биотехнологии-(1457)Военное дело-(14632)Высокие технологии-(1363)География-(913)Геология-(1438)Государство-(451)Демография-(1065)Дом-(47672)Журналистика и СМИ-(912)Изобретательство-(14524)Иностранные языки-(4268)Информатика-(17799)Искусство-(1338)История-(13644)Компьютеры-(11121)Косметика-(55)Кулинария-(373)Культура-(8427)Лингвистика-(374)Литература-(1642)Маркетинг-(23702)Математика-(16968)Машиностроение-(1700)Медицина-(12668)Менеджмент-(24684)Механика-(15423)Науковедение-(506)Образование-(11852)Охрана труда-(3308)Педагогика-(5571)Полиграфия-(1312)Политика-(7869)Право-(5454)Приборостроение-(1369)Программирование-(2801)Производство-(97182)Промышленность-(8706)Психология-(18388)Религия-(3217)Связь-(10668)Сельское хозяйство-(299)Социология-(6455)Спорт-(42831)Строительство-(4793)Торговля-(5050)Транспорт-(2929)Туризм-(1568)Физика-(3942)Философия-(17015)Финансы-(26596)Химия-(22929)Экология-(12095)Экономика-(9961)Электроника-(8441)Электротехника-(4623)Энергетика-(12629)Юриспруденция-(1492)Ядерная техника-(1748)
Лабораторная работа № 6 Фотолитография
|
|
|
|
Для изготовления тонкопленочных компонентов микросхем (ее пассивных элементов) металлической пленке необходимо придать определенный геометрический рельеф. Его можно получить либо методом маскирования в процессе осаждения, когда пленка наносится только на избранные участки подложки, либо селективным удалением пленки с однородно покрытой подложки, оставляющим необходимый рисунок. Для селективного травления в тонкопленочной технологии широко используется метод фотолитографии. Суть метода основана на использовании защитной пленки заданной конфигурации, нанесенной на поверхность металлических или изолирующих пленок, покрывающих всю поверхность подложки. Защитное (маскирующее) покрытие создается с помощью полимерных фоточувствительных материалов, называемых фоторезистами. Их молекулярная структура и растворимость изменяются при облучении ультрафиолетовым (УФ) светом. Известно большое число органических соединений с такими свойствами, первыми среди этих соединений были природные вещества: желатин, сахар, рыбий клей и т.д. В основном имеются два типа фоторезистов: негативные, они теряют растворимость в ряде веществ после воздействия света, и позитивные, их растворимость под воздействием света в определенной среде возрастает. В позитивном фоторезисте при облучении светом происходит следующее:
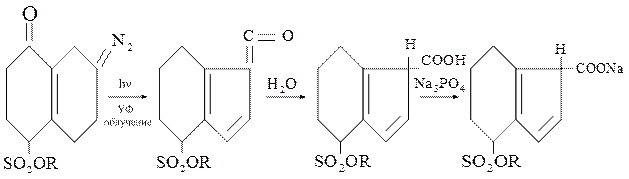
орто-хинон инден инденкарбоновая
диазид кетен кислота
Наличие карбонильной группы предопределяет выбор проявителей для позитивных фоторезистов - это щелочи (NаОН, КОН) или соли щелочных металлов(Na3PO4). Они переводят кислоту в легкорастворимую в воде соль.
При использовании негативного фоторезиста происходит фотополимеризация засвеченных участков, а незасвеченные легко удаляются обработкой в органических растворителях.
|
|
|
Фотолитографический процесс включает следующие основные операции:
1) формирование слоя фоторезиста;
2) формирование защитного слоя;
3) передача изображения на подложку.
Целью данной работы является изучение метода фотолитографии с. проведением всех его основных операций. Формирование рисунка проводится на металлических пленках (Cu или Al), нанесенных на стеклянную или ситаловую подложку методами ионно-плазменного или вакуум-термического испарения.
Нанесение фоторезиста на металлизированную подложку может осуществляться различными методами: полив, окунание, самым распространенным является центрифугирование. Этот метод обеспечивает получение воспроизводимых по толщине пленок. Сама же толщина зависит от вязкости раствора фоторезиста, скорости вращения и ускорения центрифуги. На практике при изготовлении тонкопленочных схем толщина слоев фоторезиста изменяется от 0,3 до 2 мкм. В нашей лаборатории фоторезист наносится методом центрифугирования. Подложка укрепляется на диске центрифуги и накрывается крышкой. После включения двигателя через отверстие в крышке с помощью пипетки на вращающуюся подложку наносятся 1-2 капли фоторезиста. Через 10-15 с центрифуга отключается, и после полной остановки диска подложка снимается. Проверив качество полученной пленки фоторезиста, ее подсушивают в следующем режиме:
выдержка в течение 10-15 мин при комнатной температуре;
сушка в сушильном шкафу при температуре 90°С±10°С в течение 20-30 минут.
Нужно помнить, что в целом режим сушки зависит от типа используемого фоторезиста и от толщины его слоя.
Подложка с нанесенным слоем фоторезиста далее подвергается экспонированию. Оно проводится через фотошаблон или маску. В условиях учебной лаборатории изготовить фотошаблон сложно, поэтому пользуются масками разной конфигурации, изготовленными из алюминиевой или медной фольги. Маска накладывается на подложку на слой фоторезиста, закрепляется в рамке и помещается под УФ осветитель. Время экспозиции подбирается экспериментально и может изменяться от нескольких секунд до нескольких минут. Проэкспонированные образцы подвергаются химической обработке (проявлению), в результате удаляются ненужные участки слоя и на подложке остается защитный рельеф требуемой конфигурации. Для проявления позитивных фоторезистов применяется КОН (1%), для негативных - трихлорэтилен. Процесс ведется при комнатной температуре и контролируется визуально. По окончании проявления подложка промывается в дистиллированной воде и подвергается сушке. При этом одновременно происходит закрепление оставшегося фоторезиста на подложке и придание ему устойчивости к травителям. Процесс этот, называемый задубливанием, ведется при температуре 150-180°С в течение 30-45мин.
|
|
|
Затем проводится заключительная операция фотолитографического процесса - стравливание незащищенных участков металлической пленки в растворе НС1 (для А1) или HNO3 (для Cu). Оставшуюся пленку задубленного фоторезиста удаляют либо обработкой ацетоном, либо плазмохимическим травлением. При выполнении работы по заданию преподавателя могут быть рассмотрены и дополнительные вопросы, например, можно оценить толщину пленки фоторезиста в зависимости:
а) от степени разбавления фоторезиста;
б) от количества капель фоторезиста, наносимого на подложку и т.д.
Определение толщины пленок фоторезиста
Методы измерения толщины пленок резистов разделяются на физические и оптические. Наиболее простым и распространенным физическим методом является профилометрирование. К этой же группе методов относится емкостной, контроль потенциального рельефа. Из оптических методов наибольшей точностью отличаются эллипсометрические измерения. Широкое применение находит метод оптической' интерферометрии на базе микроинтерферометров МИИ-4, МИИ-9. Прозрачность пленок фоторезиста позволяет использовать для контроля их толщины фотометрирование. На рис.22 представлено спектральное распределение коэффициента пропускания и оптической плотности пленки фоторезиста, нанесенной в учебной лаборатории методом центрифугирования на стеклянную подложку.
|
|
|
На этих спектрах хорошо видно, что при длине волны до 440 нм пленки фоторезиста являются поглощающими, а при 450-750нм-прозрачными, и в них наблюдается интерференция. И то, и другое явления могут быть использованы для определения толщины пленки фоторезиста. Расчет толщины по интерференционным экстремумам был рассмотрен выше. Для определения толщины поглощающих слоев может быть использован закон Бугера-Ламберта-Бера:
T(l) = I(l)/I0 = A(l)exp(-α(l)cd),
где I0 - интенсивность света в отсутствие образца;
I(l) - интенсивность света, прошедшего через образец;
с-концентрация исследуемого вещества;
d-толщина слоя образца;
А(l) - множитель, определяющий потери света при его отражении на границе раздела сред;
α(l) - коэффициент экстинкции.
Произведение D(l)=α(l)cd называется оптической плотностью. Из этого выражения видно, что при определенной концентрации вещества оптическая плотность прямо пропорциональна толщине образца.

Рис. 22. Спектральное распределение коэффициента пропускания и оптической плотности пленок фоторезиста
В нашей лаборатории был построен калибровочный график D=f(d), где D-оптическая плотность пленок фоторезиста на длине волны 405нм. Таким образом, измерив оптическую плотность слоя фоторезиста на этой длине волны, по калибровочному графику можно определить его толщину.
Примечание: при регистрации спектрального распределения оптической плотности системы пленка - подложка на приборе "Specord UV - VIS" для исключения влияния подложки на поглощение в канал сравнения необходимо установить аналогичную чистую стеклянную пластину.
|
|
|
|
|
Дата добавления: 2014-12-23; Просмотров: 825; Нарушение авторских прав?; Мы поможем в написании вашей работы!