
КАТЕГОРИИ:
Архитектура-(3434)Астрономия-(809)Биология-(7483)Биотехнологии-(1457)Военное дело-(14632)Высокие технологии-(1363)География-(913)Геология-(1438)Государство-(451)Демография-(1065)Дом-(47672)Журналистика и СМИ-(912)Изобретательство-(14524)Иностранные языки-(4268)Информатика-(17799)Искусство-(1338)История-(13644)Компьютеры-(11121)Косметика-(55)Кулинария-(373)Культура-(8427)Лингвистика-(374)Литература-(1642)Маркетинг-(23702)Математика-(16968)Машиностроение-(1700)Медицина-(12668)Менеджмент-(24684)Механика-(15423)Науковедение-(506)Образование-(11852)Охрана труда-(3308)Педагогика-(5571)Полиграфия-(1312)Политика-(7869)Право-(5454)Приборостроение-(1369)Программирование-(2801)Производство-(97182)Промышленность-(8706)Психология-(18388)Религия-(3217)Связь-(10668)Сельское хозяйство-(299)Социология-(6455)Спорт-(42831)Строительство-(4793)Торговля-(5050)Транспорт-(2929)Туризм-(1568)Физика-(3942)Философия-(17015)Финансы-(26596)Химия-(22929)Экология-(12095)Экономика-(9961)Электроника-(8441)Электротехника-(4623)Энергетика-(12629)Юриспруденция-(1492)Ядерная техника-(1748)
Технология производства биполярных СБИС
|
|
|
|
Обратите внимание, что в любом логическом состоянии один из транзисторов всегда закрыт и ток через инвертор не протекает, а, следовательно, потребляемая им мощность крайне незначительна.
Биполярные интегральные схемы в основном применяются в быстродействующих запоминающих устройствах и логических схемах, используемых в вычислительных системах. В настоящее время биполярные приборы получили свое развитие в интегральной инжекционной логике И2Л, используемой в логических схемах малой мощности и высокой степенью интеграции.
Рассмотрим основные технологические этапы производства биполярных ИС на примере создания n-p-n транзистора.
1 этап. В качестве исходного материала используют слаболегированные подложки p- типа, ориентированные по плоскостям (100) или (111). На подложке формируются скрытый низкоомный слой n+ кремния, предназначенный для уменьшения сопротивления коллектора и, следовательно, уменьшающий рассеиваемую в нем мощность, и низкоомный n- слой эпитаксиального кремния, задающий достаточно высокое напряжение пробоя коллектор - база (см. рис. 1).

Для реализации этого проводят следующие технологические операции:
- окисление кремниевой подложки, используемой в качестве маскирующего слоя для диффузии скрытых слоев,
- вскрытие контактных окон,
- ионная имплантация мышьяка или сурьмы в контактные окна для формирования скрытого n - слоя,
- термический отжиг для разгонки легирующей примеси в глубь кремниевой подложки (отжиг проводят в окисляющей атмосфере). При этом вследствие разницы в скоростях окисления незащищенной поверхности скрытого слоя и окружающей его окисленной поверхности подложки по периметру скрытого слоя образуется ступенька, т. е. этот слой несколько заглублен по отношению к остальной поверхности. Ступенька используется в дальнейших технологических операциях в качестве метки совмещения),
- удаление окисла со всей поверхности подложки,
- нанесение эпитаксиального n- слоя кремния.
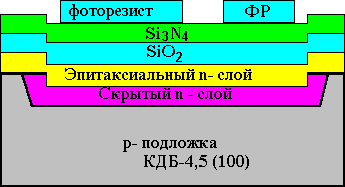
|
|
|
На 2 этапе производства ИС (см. рис. 2) на поверхности кремния формируют двухслойный диэлектрик, состоящий из двуокиси и нитрида кремния. Слой Si3N4 толщиной 100 нм является маской при последующем окислении кремния, а SiO2 толщиной 50 нм служит для минимизации числа дефектов в кремнии (уменьшает величину механических напряжений и защищает поверхность полупроводника).
Затем проводят фотолитографию для определения положения изолирующих областей транзистора.
 На 3 этапе (см. рис. 3) поверхность, не защищенную фоторезистом, подвергают травлению, удаляя при этом двухслойный диэлектрик и частично - эпитаксиальный слой. На этом же этапе проводят ионную имплантацию бора в протравленные участки для формирования областей, ограничивающих распространение канала и по ЛОКОС технологии формируют слои изолирующего окисла. Увеличение уровня легирования p- подложки под изолирующим окислом предотвращает инверсию типа проводимости поверхности полупроводника и, следовательно, возможное установление электрической связи между скрытыми слоями соседних приборов.
На 3 этапе (см. рис. 3) поверхность, не защищенную фоторезистом, подвергают травлению, удаляя при этом двухслойный диэлектрик и частично - эпитаксиальный слой. На этом же этапе проводят ионную имплантацию бора в протравленные участки для формирования областей, ограничивающих распространение канала и по ЛОКОС технологии формируют слои изолирующего окисла. Увеличение уровня легирования p- подложки под изолирующим окислом предотвращает инверсию типа проводимости поверхности полупроводника и, следовательно, возможное установление электрической связи между скрытыми слоями соседних приборов.
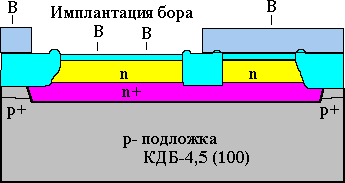
4 этап. После удаления фоторезиста подложки подвергаются термическому окислению до тех пор, пока весь эпитаксиальный слой, не защищенный пленкой Si3N4, не проокислится (см. рис. 4). Затем слой нитрида кремния селективно удаляют с сохранением слоя двуокиси кремния.
Далее на поверхность наносится фоторезист и осуществляется ионная имплантация бора для формирования области базы. Начиная с этого этапа, высокотемпературные или длительные отжиги не производят для избежания разгонки мелких p-n переходов, необходимых при производстве СБИС, на большие глубины. Имплантация проводится через пленку окисла, поэтому процесс каналирования ионов примеси ослабевает и исчезает необходимость в проведении последующего после имплантационного отжига в окисляющей атмосфере.
|
|
|
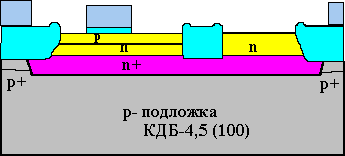 5 этап производства - формирование контактных окон к областям эмиттера, коллектора и базы, которые могут быть вскрыты одновременно с помощью одного шаблона (см. рис. 5). В этом варианте формирования ИС разделение между эмиттерным и базовым контактами определяется заданным минимальным расстоянием между металлическими контактами, а не этапом совмещения, что определяет относительно малую площадь, занимаемую транзистором, и, следовательно, снижает сопротивление базы.
5 этап производства - формирование контактных окон к областям эмиттера, коллектора и базы, которые могут быть вскрыты одновременно с помощью одного шаблона (см. рис. 5). В этом варианте формирования ИС разделение между эмиттерным и базовым контактами определяется заданным минимальным расстоянием между металлическими контактами, а не этапом совмещения, что определяет относительно малую площадь, занимаемую транзистором, и, следовательно, снижает сопротивление базы.
 На 6 этапе (см. рис. 6) формируют эмиттер и высоколегированную область коллектора. Заметим, что подвергаемая ионной имплантации площадь эмиттера определяется размером вскрытого в окисле окна. Легирование осуществляется низкоэнергетичными ионами мышьяка для уменьшения глубины их проникновения в полупроводник.
На 6 этапе (см. рис. 6) формируют эмиттер и высоколегированную область коллектора. Заметим, что подвергаемая ионной имплантации площадь эмиттера определяется размером вскрытого в окисле окна. Легирование осуществляется низкоэнергетичными ионами мышьяка для уменьшения глубины их проникновения в полупроводник.
После ионной имплантации примесь разгоняют на желаемую глубину в почти инертной атмосфере. Образующуюся при этом над контактными областями эмиттера и коллектора окисную пленку удаляют в разбавленном растворе HF.
Далее на поверхность подложки наносят слой Si3N4, защищающий поверхность прибора от попадания подвижных ионов натрия. Для формирования контактов в нитриде кремния впоследствии вскрываются окна. Процесс вскрытия окон осуществляют с использованием еще одного процесса фотолитографии или с применением самосовмещения. В последнем варианте проводят электрохимическое травление нитрида кремния. В местах контакта с кремнием он путем анодирования превращается в двуокись кремния, стравливаемую впоследствии в плавиковой кислоте, а в местах контакта с SiO2 остается неизменным.
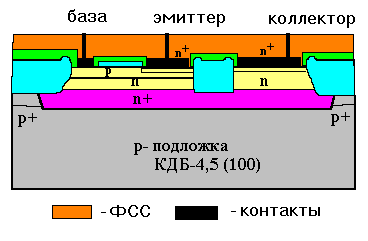 На заключительном этапе (см. рис. 7) проводится металлизация и покрытие прибора слоем фосфорсиликатного стекла. В качестве контактного слоя при металлизации обычно используют PtSi, а верхний слой металлизации формируют из TiPtAu.
На заключительном этапе (см. рис. 7) проводится металлизация и покрытие прибора слоем фосфорсиликатного стекла. В качестве контактного слоя при металлизации обычно используют PtSi, а верхний слой металлизации формируют из TiPtAu.
|
|
|
|
|
Дата добавления: 2014-12-27; Просмотров: 1519; Нарушение авторских прав?; Мы поможем в написании вашей работы!