
КАТЕГОРИИ:
Архитектура-(3434)Астрономия-(809)Биология-(7483)Биотехнологии-(1457)Военное дело-(14632)Высокие технологии-(1363)География-(913)Геология-(1438)Государство-(451)Демография-(1065)Дом-(47672)Журналистика и СМИ-(912)Изобретательство-(14524)Иностранные языки-(4268)Информатика-(17799)Искусство-(1338)История-(13644)Компьютеры-(11121)Косметика-(55)Кулинария-(373)Культура-(8427)Лингвистика-(374)Литература-(1642)Маркетинг-(23702)Математика-(16968)Машиностроение-(1700)Медицина-(12668)Менеджмент-(24684)Механика-(15423)Науковедение-(506)Образование-(11852)Охрана труда-(3308)Педагогика-(5571)Полиграфия-(1312)Политика-(7869)Право-(5454)Приборостроение-(1369)Программирование-(2801)Производство-(97182)Промышленность-(8706)Психология-(18388)Религия-(3217)Связь-(10668)Сельское хозяйство-(299)Социология-(6455)Спорт-(42831)Строительство-(4793)Торговля-(5050)Транспорт-(2929)Туризм-(1568)Физика-(3942)Философия-(17015)Финансы-(26596)Химия-(22929)Экология-(12095)Экономика-(9961)Электроника-(8441)Электротехника-(4623)Энергетика-(12629)Юриспруденция-(1492)Ядерная техника-(1748)
Рентгеновская дифракция
|
|
|
|
Лазерное отражение
Расчет напряжений в пленках: если d = const, то напряжение в пленке на толстой подложке:

E и v - модуль Юнга и коэффициент Пуассона материала подложки.
D и t -толщина подложки и пленки.
R - радиус кривизны структуры.
Для нахождения параметра решетки, наличия аморфных областей, ориентации подложки, а также для исследования поликристаллических свойств кремния и других кристаллов применяют несколько методов, основанных на анализе дифракционной картины отраженных от плоскостей кристаллической решетки исследуемого образца.
Эти методы используют разновидности камер для съемки рентгенограмм: обратная съемка по Лауэ, камеру Рида, камеру Хубера-Зеемана-Болина, а также используют дифрактометры. Во всех методах образец устанавливается так, чтобы одно или несколько семейств кристаллографических плоскостей удовлетворяло условию брэгговского отражения рентгеновских лучей:
nl= 2dsin(q)
где n - порядок отражения,
d- межплоскостное расстояние,
l - длина волны рентгеновского излучения,
q - угол Брэгга.
Обратная съемка рентгенограмм по Лауэ применяется для быстрого определения ориентации подложки. Для данного метода подложку устанавливают параллельно фотопленке с отверстием (см. рис. 1). Через отверстие на подложку направляется коллимированный пучок немонохроматичного рентгеновского излучения, получаемого непосредственно с анода рентгеновской трубки.
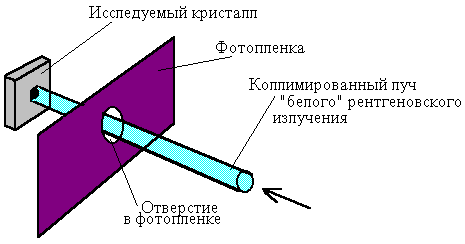
Рис. 1.
В результате дифракции "белого" излучения кристаллической решеткой возникает множество дифрагированных лучей. Дифракция одновременно осуществляется от большого числа плоскостей, поэтому на пленке регистрируется набор точек, каждая из которых соответствует отражению от одной из кристаллографических плоскостей. Эти точки лежат на гиперболах, а характер и симметрия их расположения прямо соотносятся с кристаллографической ориентацией образца.
|
|
|
Рентгенограммы, полученные этим способом, существенно различаются для кремниевых подложек с ориентацией (100), (111) и (110). Для определения ориентации полученную рентгенограмму сравнивают с эталонными рентгенограммами для различных известных ориентаций этого кристалла, что ускоряет проведение анализа.
Применение дифрактометра обеспечивает более точное измерение параметров кристаллической решетки. Принципиальная схема измерений с помощью дифрактометра приведена на рис. 2.

Рис. 2.
Монохроматический рентгеновский пучок падает на поверхность образца под углом Ф. При этом осуществляется одновременное медленное вращение образца и детектора вокруг одной оси. Причем скорость вращения детектора в два раза превышает скорость вращения исследуемого кристалла. При совпадении угла Ф с углом Брэгга детектор регистрирует дифракционный максимум. Затем определяют угловое положение детектора 2Ф, которое соответствует этому максимуму и идентифицируют соответствующее межплоскостное расстояние. Данные обычно регистрируются самописцем или с помощью компьютера, по этим записям легко определить угловые положения, интенсивности и полуширины дифракционных пиков.
Точность измерений в этом методе определяется точностью измерения углов Ф. Максимальная точность достигается при дифрактометрических измерениях в окрестности угла 2Ф= 180°. Точность измерений параметра решетки достигает 0.001 мкм и выше.
|
|
|
|
|
Дата добавления: 2014-12-27; Просмотров: 754; Нарушение авторских прав?; Мы поможем в написании вашей работы!