
КАТЕГОРИИ:
Архитектура-(3434)Астрономия-(809)Биология-(7483)Биотехнологии-(1457)Военное дело-(14632)Высокие технологии-(1363)География-(913)Геология-(1438)Государство-(451)Демография-(1065)Дом-(47672)Журналистика и СМИ-(912)Изобретательство-(14524)Иностранные языки-(4268)Информатика-(17799)Искусство-(1338)История-(13644)Компьютеры-(11121)Косметика-(55)Кулинария-(373)Культура-(8427)Лингвистика-(374)Литература-(1642)Маркетинг-(23702)Математика-(16968)Машиностроение-(1700)Медицина-(12668)Менеджмент-(24684)Механика-(15423)Науковедение-(506)Образование-(11852)Охрана труда-(3308)Педагогика-(5571)Полиграфия-(1312)Политика-(7869)Право-(5454)Приборостроение-(1369)Программирование-(2801)Производство-(97182)Промышленность-(8706)Психология-(18388)Религия-(3217)Связь-(10668)Сельское хозяйство-(299)Социология-(6455)Спорт-(42831)Строительство-(4793)Торговля-(5050)Транспорт-(2929)Туризм-(1568)Физика-(3942)Философия-(17015)Финансы-(26596)Химия-(22929)Экология-(12095)Экономика-(9961)Электроника-(8441)Электротехника-(4623)Энергетика-(12629)Юриспруденция-(1492)Ядерная техника-(1748)
Литография
|
|
|
|
В технологии полупроводниковых приборов важное место занимают маски: они обеспечивают локальный характер напыления, легирования, травления, а в некоторых случаях и эпитаксии. Всякая маска содержит совокупность заранее спроектированных отверстий – окон. Изготовление таких окон есть задача литографии (гравировки). Ведущее место в технологии изготовления масок сохраняют фотолитография и электронолитография.
3.4.1. Фотолитография. В основе фотолитографии лежит исполь- зование материалов, которые называют фоторезистами. Это разновидность фотоэмуль- сий, известных в обычной фотографии. Фоторезисты чувствительны к ультрафиолетовому свету, поэтому их можно обрабатывать в не очень затемненном помещении.
Фоторезисты бывают негативные и позитивные. Негативные фоторе- зисты под действием света полимеризуются и становятся устойчивыми к травителям (кислотным или щелочным). Значит, после локальной засветки будут вытравливаться не засвеченные участки (как в обычном фото- негативе). В позитивных фоторезистах свет, наоборот, разрушает полимерные цепочки и, значит, будут вытравливаться засвеченные участки.
Рисунок будущей маски изготавливается в виде так называемого фо тошаблона. Фотошаблон представляет собой толстую стеклянную пластину, на одной из сторон которой нанесена тонкая непрозрачная пленка с необходимым рисунком в виде прозрачных отверстий. Размеры этих отверстий (элементов рисунка) в масштабе 1: 1 соответствуют размерам будущих элементов ИС, т. е. могут составлять 20—50 мкм и менее (до 2—3 мкм). Поскольку ИС изготавливаются групповым методом, на фотошаблоне по «строкам» и «столбцам» размещается множество однотипных рисунков. Размер каждого рисунка соответствует размеру будущего кристалла ИС.
|
|
|
Процесс фотолитографии для получения окон в окисной маске SiO2, покрывающей поверхность кремниевой пластины, состоит в следующем (рисунок 3.3). На окисленную поверхность пластины наносится, например, негативный фоторезист (ФР). На пластину, покрытую фоторезистом, накладывают фотошаблон ФШ (рисунком к фоторезисту) и экспонируют его в ультрафиолетовых (УФ) лучах кварцевой лампы (рисунок 3.3а). После этого фотошаблон снимают, а фоторезист проявляют и закрепляют.
Если используется позитивный фоторезист, то после проявления и закрепления (которое состоит в задубливании и термообработке фоторезиста) в нем получаются окна на тех местах, которые соответствуют прозрачным участкам на фотошаблоне.
Как говорят, рисунок перенесли с фотошаблона на фоторезист. Теперь слой фоторезиста представляет собой маску, плотно прилегающую к окисному слою (рисунок 3.3б).
Через фоторезистивную маску производится травление окисного слоя вплоть до кремния (на кремний данный травитель не действует). В качестве травителя используется плавиковая кислота и её соли. В результате рисунок с фоторезиста переносится на окисел. После удаления (стравливания) фоторе -зистивной маски конечным итогом фотолитографии оказывается кремниевая пластина покрытая окисной маской с окнами (рисунок 3.3в). Через окна можно осуществлять диффузию, ионную имплантацию, травление и т. п.
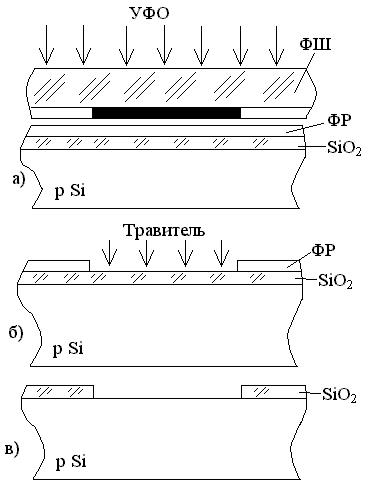
Рисунок 3.3
В технологических циклах изготовления элементов ИМС процесс фотолитографии используется многократно (отдельно для получения базовых слоев, эмиттеров, омических контактов и т. д.). При этом возникает так называемая проблема совмещения фотошаблонов. При многократном использовании фото- литографии (в технологии ППИМС до 5-7 раз) допуск на совмещение доходит до долей микрона. Техника совмещения состоит в том, что на фотошаблонах делают специальные «отметки» (например, крестики или квадраты), которые переходят в рисунок на окисле и просвечивают сквозь тонкую пленку фоторе-зиста. Накладывая очередной фотошаблон, аккуратнейшим образом (под микроскопом) совмещают отметки на окисле с аналогичными отметками на фотошаблоне.
|
|
|
Рассмотренный процесс фотолитографии характерен для получения окисных масок на кремниевых пластинах с целью последующей локальной диффузии. В этом случае фоторезистивная маска является промежуточной, вспомогательной, так как она не выдерживает высокой температуры, при которой проводится диффузия. Однако в некоторых случаях, когда процесс идет при низкой температуре, фоторезистивные маски могут быть основными -рабочими. Примером может служить процесс создания металлической разводки в полупроводниковых ИМС.
При использовании фотошаблона его эмульсионный слой изнашивается (стирается) уже после 15—20 наложений. Срок службы фотошаблонов можно увеличить на два порядка и более путем металлизации: заменяя пленку фотоэмульсии на пленку износостойкого металла, обычно хрома.
Фотошаблоны изготавливаются комплектами по числу операций фотолитографии в технологическом цикле. В пределах комплекта фотошаблоны согласованы, т. е. обеспечивают совмещение рисунков при совмещении соответствующих отметок.
3.4.2 Электронолитография. Описанные методы долгое время составляли одну из основ микроэлектронной технологии. Они и до сих пор не потеряли своего значения. Однако по мере повышения степени интеграции и уменьшения размеров элементов ИС возник ряд проблем, которые частично уже решены, а частично находятся в стадии изучения.
Одно из принципиальных ограничений касается разрешающей способ- ности,т. е. минимальных размеров в создаваемом рисунке маски. Дело в том, что длины волн ультрафиолетового света составляют 0,3-0,4 мкм. Следова- тельно, каким бы малым не было отверстие в рисунке фотошаблона, размеры изображения этого отверстия в фоторезисте не могут достигать указанных значений (из-за дифракции). Поэтому, минимальная ширина элементов составляет около 2 мкм, а при глубоком ультрафиолете (длина волны 0,2-0,3 мкм) – около 1 мкм. Между тем размеры порядка 1—2 мкм уже оказываются недостаточно малыми при создании больших и сверхбольших ИМС.
|
|
|
Наиболее очевидный путь для повышения разрешающей способности лито- графии - использование при экспозиции более коротковолновых излучений.
За последние годы разработаны методы электронной литографии. Их сущность состоит в том, что сфокусированный пучок электронов сканируют (т. е. перемещают «построчно») по поверхности пластины, покрытой электронорезистом, и управляют интенсивностью пучка в соответствии с заданной программой. В тех точках, которые должны быть «засвечены», ток пучка максимален, а в тех, которые должны быть «затемнены», — равен нулю. Диаметр пучка электронов находится в прямой зависимости от тока в пучке: чем меньше диаметр, тем меньше ток. Однако с уменьшением тока растет время экспозиции. Поэтому повышение разрешающей способности (уменьшение диаметра пучка) сопровождается увеличением длительности процесса. Например, при диаметре пучка 0,2—0,5 мкм время сканирования пластины, в зависимости от типа электронорезиста и размеров пластины, может лежать в пределах от десятков минут до нескольких часов.
Одна из разновидностей электронной литографии основана на отказе от электронорезистивных масок и предусматривает воздействие электронного пучка непосредственно на окисный слой SiO2. Оказывается, что в местах «засветки» этот слой в дальнейшем травится в несколько раз быстрее, чем в «затемненных» участках.
Минимальные размеры при электронолитографии составляют 0,2 мкм, хотя предельно достижимы – 0,1 мкм.
В стадии исследования находятся другие методы литографии, например, мягкое рентгеновское излучение (с длинами волн 1—2 нм) позволяет получить минимальные размеры 0,1 мкм, а ионно-лучевая литография 0,03 мкм.
|
|
|
|
|
Дата добавления: 2015-05-06; Просмотров: 536; Нарушение авторских прав?; Мы поможем в написании вашей работы!