
КАТЕГОРИИ:
Архитектура-(3434)Астрономия-(809)Биология-(7483)Биотехнологии-(1457)Военное дело-(14632)Высокие технологии-(1363)География-(913)Геология-(1438)Государство-(451)Демография-(1065)Дом-(47672)Журналистика и СМИ-(912)Изобретательство-(14524)Иностранные языки-(4268)Информатика-(17799)Искусство-(1338)История-(13644)Компьютеры-(11121)Косметика-(55)Кулинария-(373)Культура-(8427)Лингвистика-(374)Литература-(1642)Маркетинг-(23702)Математика-(16968)Машиностроение-(1700)Медицина-(12668)Менеджмент-(24684)Механика-(15423)Науковедение-(506)Образование-(11852)Охрана труда-(3308)Педагогика-(5571)Полиграфия-(1312)Политика-(7869)Право-(5454)Приборостроение-(1369)Программирование-(2801)Производство-(97182)Промышленность-(8706)Психология-(18388)Религия-(3217)Связь-(10668)Сельское хозяйство-(299)Социология-(6455)Спорт-(42831)Строительство-(4793)Торговля-(5050)Транспорт-(2929)Туризм-(1568)Физика-(3942)Философия-(17015)Финансы-(26596)Химия-(22929)Экология-(12095)Экономика-(9961)Электроника-(8441)Электротехника-(4623)Энергетика-(12629)Юриспруденция-(1492)Ядерная техника-(1748)
Этапы изготовления
|
|
|
|
На подложке р-типа формируется эпитаксиальный слой n-типа (рисунок 4.4а). Затем проводится термическое окисление (рисунок 4.4б), и методом фотолитографии формируются окна под разделительную диффузию, т.е. маска из слоя SiO2 остается на тех местах, где будут изготовляться биполярные транзисторы и другие элементы схемы (рисунок 4.4в).
Следующим этапом проводится разделительная диффузия акцепторной примесью (рисунок 4.4в) так, чтобы атомы примеси достигли подложки под эпитаксиальным слоем и в результате получается, что элементы схемы будут отделены друг от друга полупроводником р-типа.
Проводится второе термическое окисление, вторая фотолитография и вторая диффузия акцепторной примесью с тем, чтобы сформировать базовый слой транзистора (рисунок 4.4г). Эта диффузия требует меньшее время, так как глубина базового слоя 2,5-2,7 мкм меньше, чем при разделительной диффузии.
Затем проводятся ещё одно термическое окисление, фотолитография, при которой вскрываются окна под эмиттерную область и вывод коллектора, и проводится последняя диффузия донорной примесью (рисунок 4.4д). В этих областях создается максимальная концентрация примеси. Глубина n+- слоев составляет примерно 2 мкм. Максимальная концентрация примеси в месте вывода коллектора исключает появление выпрямляющего контакта металл-полупроводник (диод Шоттки).
После четвертого заключительного термического окисления и ещё одной фотолитографии вскрываются окна для межэлементных соединений металлической пленкой (рисунок 4.4е).
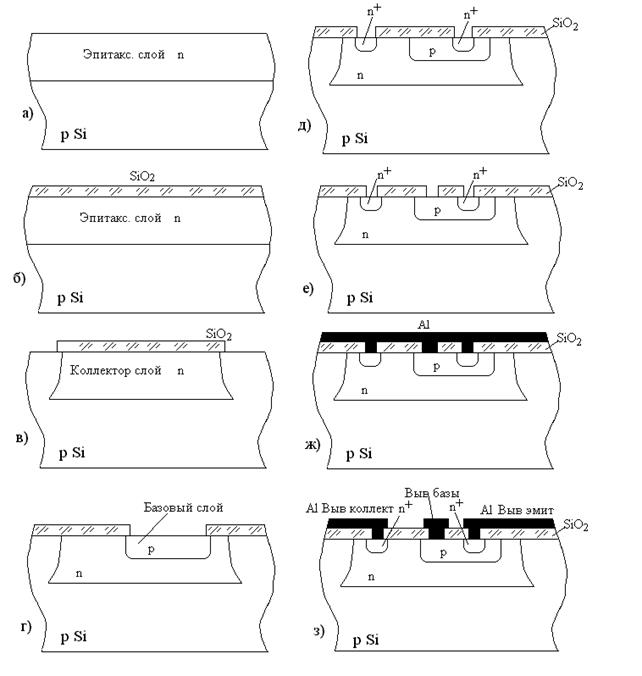
Рисунок 4.4
В результате термического напыления получается сплошная пленка алюминия (рисунок 4.4ж).
На заключительном этапе проводится последняя фотолитография, при которой из пленки Al формируются межэлементные соединения (рисунок 4.4з). Вид на транзистор в плане с размерами показан на рисунке 4.5.
Таким образом, в процессе формирования транзистора использовались: пять фотолитографий, четыре термических окисления, три процесса диффузии, по одному процессу эпитаксии и термическому напылению алюминия не считая ряда вспомогательных операций: очистка, промывка, удаление фоторезиста и т.д.
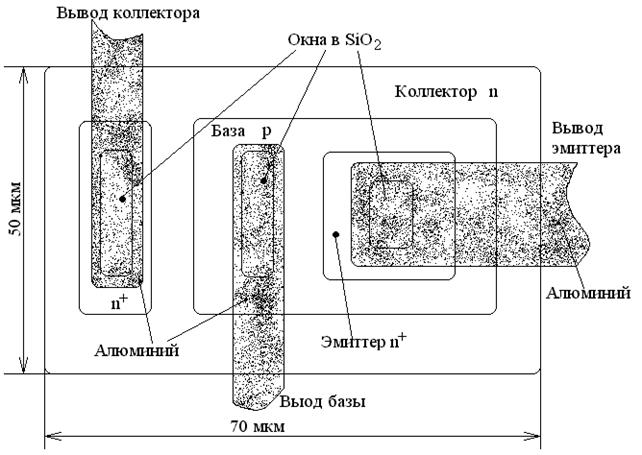 Рисунок 4.5
Рисунок 4.5
|
|
|
|
|
Дата добавления: 2015-05-06; Просмотров: 661; Нарушение авторских прав?; Мы поможем в написании вашей работы!