
КАТЕГОРИИ:
Архитектура-(3434)Астрономия-(809)Биология-(7483)Биотехнологии-(1457)Военное дело-(14632)Высокие технологии-(1363)География-(913)Геология-(1438)Государство-(451)Демография-(1065)Дом-(47672)Журналистика и СМИ-(912)Изобретательство-(14524)Иностранные языки-(4268)Информатика-(17799)Искусство-(1338)История-(13644)Компьютеры-(11121)Косметика-(55)Кулинария-(373)Культура-(8427)Лингвистика-(374)Литература-(1642)Маркетинг-(23702)Математика-(16968)Машиностроение-(1700)Медицина-(12668)Менеджмент-(24684)Механика-(15423)Науковедение-(506)Образование-(11852)Охрана труда-(3308)Педагогика-(5571)Полиграфия-(1312)Политика-(7869)Право-(5454)Приборостроение-(1369)Программирование-(2801)Производство-(97182)Промышленность-(8706)Психология-(18388)Религия-(3217)Связь-(10668)Сельское хозяйство-(299)Социология-(6455)Спорт-(42831)Строительство-(4793)Торговля-(5050)Транспорт-(2929)Туризм-(1568)Физика-(3942)Философия-(17015)Финансы-(26596)Химия-(22929)Экология-(12095)Экономика-(9961)Электроника-(8441)Электротехника-(4623)Энергетика-(12629)Юриспруденция-(1492)Ядерная техника-(1748)
Электронно-дырочный переход
|
|
|
|
Электрические переходы
Электрическим переходом в полупроводнике называется граничный слой между двумя областями, физические характеристики которых имеют существенные физические различия.
Различают следующие виды электрических переходов:
§ электронно-дырочный, или p–n-переход – переход между двумя областями полупроводника, имеющими разный тип электропроводности;
§ переходы между двумя областями, если одна из них является металлом, а другая полупроводником p- или n- типа (переход металл – полупроводник);
§ переходы между двумя областями с одним типом электропроводности, отличающиеся значением концентрации примесей;
§ переходы между двумя полупроводниковыми материалами с различной шириной запрещенной зоны (гетеропереходы).
Работа целого ряда полупроводниковых приборов (диодов, транзисторов, тиристоров и др.) основана на явлениях, возникающих в контакте между полупроводниками с разными типами проводимости.
Граница между двумя областями монокристалла полупроводника, одна из которых имеет электропроводность типа p, а другая – типа n называется электронно-дырочным переходом. Концентрации основных носителей заряда в областях p и n могут быть равными или существенно отличаться. P–n -переход, у которого концентрации дырок и электронов практически равны Np  Nn, называют симметричным. Если концентрации основных носителей заряда различны (Np >> Nn или Np << Nn) и отличаются в 100…1000 раз, то такие переходы называют несимметричными.
Nn, называют симметричным. Если концентрации основных носителей заряда различны (Np >> Nn или Np << Nn) и отличаются в 100…1000 раз, то такие переходы называют несимметричными.
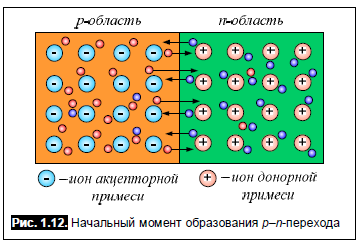 Несимметричные p–n -переходы используются шире, чем симметричные, поэтому в дальнейшем будем рассматривать только их.
Несимметричные p–n -переходы используются шире, чем симметричные, поэтому в дальнейшем будем рассматривать только их.
Рассмотрим монокристалл полупроводника (рис. 1.12), в котором, с одной стороны, введена акцепторная примесь, обусловившая возникновение здесь
электропроводности типа p, а с другой стороны, введена донорная примесь, благодаря которой там возникла электропроводность типа n. Каждому подвижному положительному носителю заряда в области p (дырке) соответствует отрицательно заряженный ион акцепторной примеси, но неподвижный, находящийся в узле кристаллической решетки, а в области n каждому свободному электрону соответствует положительно заряженный ион донорной примеси, в результате чего весь монокристалл остается электрически нейтральным.
Свободные носители электрических зарядов под действием градиента  концентрации начинают перемещаться из мест с большой концентрацией в места с меньшей концентрацией. Так, дырки будут диффундировать из области p в область n, а электроны, наоборот, из области n в область p. Это направленное навстречу друг другу перемещение электрических зарядов образует диффузионный ток p–n -перехода. Но как только дырка из области p перейдет в область n, она оказывается в окружении электронов, являющихся основными носителями электрических зарядов в области n. Поэтому велика вероятность того, что какой-либо электрон заполнит свободный уровень и произойдет явление рекомбинации, в результате которой не будет ни дырки, ни электрона, а останется электрически нейтральный атом полупроводника. Но если раньше положительный электрический заряд каждой дырки компенсировался отрицательным зарядом иона акцепторной примеси в области p, а заряд электрона – положительным зарядом иона донорной примеси в области n, то после рекомбинации дырки и электрона электрические заряды неподвижных ионов примесей, породивших эту дырку и электрон, остались не скомпенсированными. И в первую очередь не скомпенсированные заряды ионов примесей проявляют себя вблизи границы раздела (рис. 1.13), где образуется слой пространственных зарядов, разделенных узким промежутком
концентрации начинают перемещаться из мест с большой концентрацией в места с меньшей концентрацией. Так, дырки будут диффундировать из области p в область n, а электроны, наоборот, из области n в область p. Это направленное навстречу друг другу перемещение электрических зарядов образует диффузионный ток p–n -перехода. Но как только дырка из области p перейдет в область n, она оказывается в окружении электронов, являющихся основными носителями электрических зарядов в области n. Поэтому велика вероятность того, что какой-либо электрон заполнит свободный уровень и произойдет явление рекомбинации, в результате которой не будет ни дырки, ни электрона, а останется электрически нейтральный атом полупроводника. Но если раньше положительный электрический заряд каждой дырки компенсировался отрицательным зарядом иона акцепторной примеси в области p, а заряд электрона – положительным зарядом иона донорной примеси в области n, то после рекомбинации дырки и электрона электрические заряды неподвижных ионов примесей, породивших эту дырку и электрон, остались не скомпенсированными. И в первую очередь не скомпенсированные заряды ионов примесей проявляют себя вблизи границы раздела (рис. 1.13), где образуется слой пространственных зарядов, разделенных узким промежутком  . Между этими зарядами возникает электрическое поле с напряжённостью E, которое называют полем потенциального барьера, а разность потенциалов на границе раздела двух зон, обуславливающих это поле, называют контактной разностью потенциалов
. Между этими зарядами возникает электрическое поле с напряжённостью E, которое называют полем потенциального барьера, а разность потенциалов на границе раздела двух зон, обуславливающих это поле, называют контактной разностью потенциалов 
Это электрическое поле начинает действовать на подвижные носители электрических зарядов. Так, дырки в области p – основные носители, попадая в зону действия этого поля, испытывают со стороны него тормозящее, отталкивающее действие и, перемещаясь вдоль силовых линий этого поля, будут вытолкнуты вглубь области p. Аналогично, электроны из области n, попадая в зону действия поля потенциального барьера, будут вытолкнуты им вглубь области n. Таким образом, в узкой области  , где действует поле потенциального барьера, образуется слой, где практически отсутствуют свободные носители электрических зарядов и вследствие этого обладающий высоким сопротивлением. Это так называемый запирающий слой.
, где действует поле потенциального барьера, образуется слой, где практически отсутствуют свободные носители электрических зарядов и вследствие этого обладающий высоким сопротивлением. Это так называемый запирающий слой.
Если же в области p вблизи границы раздела каким-либо образом окажется свободный электрон, являющийся неосновным носителем для этой области, то он со стороны электрического поля потенциального барьера будет испытывать ускоряющее воздействие, вследствие чего этот электрон будет переброшен через границу раздела в область n, где он будет являться основным носителем. Аналогично, если в области n появится неосновной носитель – дырка, то под действием поля потенциального барьера она будет переброшена в область p, где она будет уже основным носителем. Движение неосновных носителей через p–n -переход под действием электрического поля потенциального барьера обусловливает составляющую дрейфового тока.
При отсутствии внешнего электрического поля устанавливается динамическое равновесие между потоками основных и неосновных носителей электрических зарядов. То есть между диффузионной и дрейфовой составляющими тока p–n -перехода, потому что эти составляющие направлены навстречу друг другу.
Потенциальная диаграмма p–n -перехода изображена на рис. 1.13, причем за нулевой потенциал принят потенциал на границе раздела областей. Контактная разность потенциалов образует на границе раздела потенциальный барьер с высотой  . На диаграмме изображен потенциальный барьер для электронов, стремящихся за счет диффузии перемещаться справа налево (из области n в область p). Если отложить вверх положительный потенциал, то можно получить изображение потенциального барьера для дырок, диффундирующих слева направо (из области p в область n).
. На диаграмме изображен потенциальный барьер для электронов, стремящихся за счет диффузии перемещаться справа налево (из области n в область p). Если отложить вверх положительный потенциал, то можно получить изображение потенциального барьера для дырок, диффундирующих слева направо (из области p в область n).
При отсутствии внешнего электрического поля и при условии динамического равновесия в кристалле полупроводника устанавливается единый уровень Ферми для обеих областей проводимости.
Однако поскольку в полупроводниках p -типа уровень Ферми
смещается к потолку валентной зоны  , а в полупроводниках n -типа –
, а в полупроводниках n -типа –
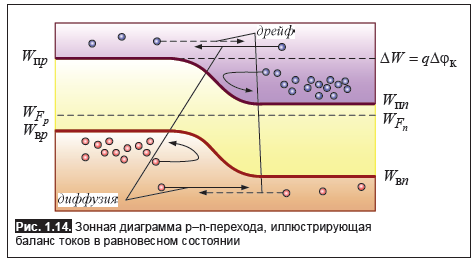 ко дну зоны проводимости
ко дну зоны проводимости  , то на ширине p–n -перехода
, то на ширине p–n -перехода  диаграмма энергетических зон (рис. 1.14) искривляется и образуется потенциальный барьер:
диаграмма энергетических зон (рис. 1.14) искривляется и образуется потенциальный барьер:
 , (1.13),
, (1.13),
где  –энергетический барьер, который необходимо преодолеть электрону в области n, чтобы он мог перейти в область p, или аналогично для дырки в области p, чтобы она могла перейти в область n.
–энергетический барьер, который необходимо преодолеть электрону в области n, чтобы он мог перейти в область p, или аналогично для дырки в области p, чтобы она могла перейти в область n.
Высота потенциального барьера зависит от концентрации примесей, так как при ее изменении изменяется уровень Ферми, смещаясь от середины запрещенной зоны к верхней или нижней ее границе.
1.7.2. Вентильное свойство p–n-перехода
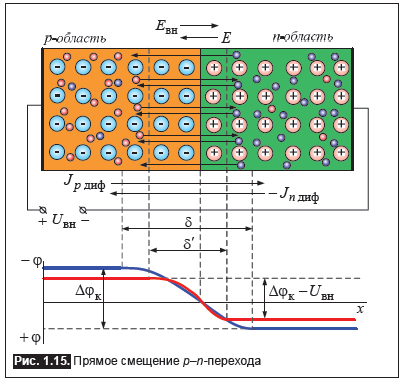 P–n -переход, обладает свойством изменять свое электрическое сопротивление в зависимости от направления, протекающего через него тока. Это свойство называется вентильным, а прибор, обладающий таким свойством, называется электрическим вентилем.
P–n -переход, обладает свойством изменять свое электрическое сопротивление в зависимости от направления, протекающего через него тока. Это свойство называется вентильным, а прибор, обладающий таким свойством, называется электрическим вентилем.
Рассмотрим p–n -переход, к которому подключен внешний источник напряжения Uвн с полярностью, указанной на рис. 1.15, «+» к области p -типа, «–» к области n -типа. Такое подключение называют прямым включением p–n -перехода (или прямым смещением p–n-перехода). Тогда напряженность электрического поля внешнего источника E вн будет направлена навстречу напряженности поля потенциального барьера E и, следовательно, приведет к снижению результирующей напряженности E рез:
Eрез = E - Eвн, (1.14).
Это приведет, в свою очередь, к снижению высоты потенциального барьера и увеличению количества основных носителей, диффундирующих через границу раздела в соседнюю область, которые образуют так называемый прямой ток p–n -перехода. При этом вследствие уменьшения тормозящего, отталкивающего действия поля потенциального барьера на основные носители, ширина запирающего слоя  уменьшается (
уменьшается ( ’<
’<  ) и, соответственно, уменьшается его сопротивление.
) и, соответственно, уменьшается его сопротивление.
По мере увеличения внешнего напряжения прямой ток p–n -перехода возрастает. Основные носители после перехода границы раздела становятся неосновными в противоположной области полупроводника и, углубившись в нее, рекомбинируют с основными носителями этой области. Но, пока подключен внешний источник, ток через переход поддерживается непрерывным поступлением электронов из внешней цепи в n -область и уходом их из p -области во внешнюю цепь, благодаря чему восстанавливается концентрация дырок в p -области.
Введение носителей заряда через p–n -переход при понижении высоты потенциального барьера в область полупроводника, где эти носители являются неосновными, называют инжекцией носителей заряда.
При протекании прямого тока из дырочной области р в электронную область n инжектируются дырки, а из электронной области в дырочную – электроны.
 Инжектирующий слой с относительно малым удельным сопротивлением называют эмиттером; слой, в который происходит инжекция неосновных для него носителей заряда, - базой.
Инжектирующий слой с относительно малым удельным сопротивлением называют эмиттером; слой, в который происходит инжекция неосновных для него носителей заряда, - базой.
На рис. 1.16 изображена зонная энергетическая диаграмма, соответствующая прямому смещению p–n -перехода.
Если к р-n -переходу подключить внешний источник с противоположной полярностью «–» к области p -типа, «+» к области n -типа (рис. 1.17), то такое подключение называют обратным включением p–n-перехода (или обратным смещением p–n-перехода).
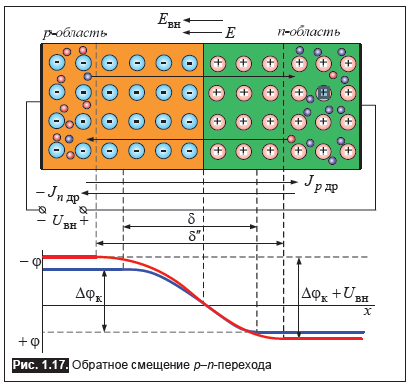 В данном случае напряженность электрического поля этого источника E вн будет направлена в ту же сторону, что и напряженность электрического поля E потенциального барьера; высота потенциального барьера возрастает, а ток диффузии основных носителей практически становится равным нулю. Из-за усиления тормозящего, отталкивающего действия суммарного электрического поля на основные носители заряда ширина запирающего слоя
В данном случае напряженность электрического поля этого источника E вн будет направлена в ту же сторону, что и напряженность электрического поля E потенциального барьера; высота потенциального барьера возрастает, а ток диффузии основных носителей практически становится равным нулю. Из-за усиления тормозящего, отталкивающего действия суммарного электрического поля на основные носители заряда ширина запирающего слоя  увеличивается (
увеличивается ( >
>  ), а его сопротивление резко возрастает.
), а его сопротивление резко возрастает.
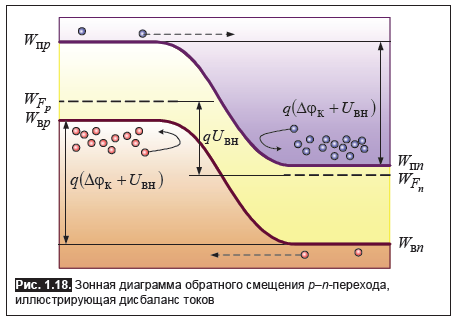 Теперь через р–n -переход будет протекать очень маленький ток, обусловленный перебросом суммарным электрическим полем на границе раздела, основных носителей, возникающих под действием различных ионизирующих факторов, в основном теплового характера. Процесс переброса неосновных носителей заряда называется экстракцией. Этот ток имеет дрейфовую природу и называется обратным током р–n-перехода.
Теперь через р–n -переход будет протекать очень маленький ток, обусловленный перебросом суммарным электрическим полем на границе раздела, основных носителей, возникающих под действием различных ионизирующих факторов, в основном теплового характера. Процесс переброса неосновных носителей заряда называется экстракцией. Этот ток имеет дрейфовую природу и называется обратным током р–n-перехода.
На рис. 1.18 изображена зонная энергетическая диаграмма, соответствующая обратному смещению p–n - перехода.
Выводы:
1. P–n -переход образуется на границе p - и n -областей, созданных в монокристалле полупроводника.
2. В результате диффузии в p–n -переходе возникает электрическое поле - потенциальный барьер, препятствующий выравниванию концентраций основных носителей заряда в соседних областях.
3. При отсутствии внешнего напряжения U вн в p–n -переходе устанавливается динамическое равновесие: диффузионный ток становится равным по величине дрейфовому току, образованному неосновными носителями заряда, в результате чего ток через p–n -переход становится равным нулю.
4. При прямом смещении p–n -перехода потенциальный барьер понижается и через переход протекает относительно большой диффузионный ток.
5. При обратном смещении p–n -перехода потенциальный барьер повышается, диффузионный ток уменьшается до нуля и через переход протекает малый по величине дрейфовый ток. Это говорит о том, что p–n -переход обладает односторонней проводимостью. Данное свойство широко используется для выпрямления переменных токов.
6. Ширина p–n -перехода зависит: от концентраций примеси в p - и n -областях, от знака и величины приложенного внешнего напряжения U вн. При увеличении концентрации примесей ширина p–n -перехода уменьшается и наоборот. С увеличением прямого напряжения ширина p–n -перехода уменьшается. При увеличении обратного напряжения ширина p–n -перехода увеличивается.
1.7.3. Вольт-амперная характеристика р–n-перехода
Вольт-амперная характеристика p–n -перехода – это зависимость тока через p–n -переход от величины приложенного к нему напряжения. Ее рассчитывают исходя из предположения, что электрическое поле вне обедненного слоя отсутствует, т.е. все напряжение приложено к p–n -переходу. Общий ток через p–n -переход определяется суммой четырех слагаемых:
 , (1.15),
, (1.15),
где  электронный ток дрейфа;
электронный ток дрейфа;
 дырочный ток дрейфа;
дырочный ток дрейфа;
 - электронный ток диффузии;
- электронный ток диффузии;
 дырочный ток диффузии;
дырочный ток диффузии;  концентрация электронов, инжектированных в р - область;
концентрация электронов, инжектированных в р - область;
 концентрация дырок, инжектированных в n - область.
концентрация дырок, инжектированных в n - область.
При этом концентрации неосновных носителей np0 и pn0 зависят от концентрации примесей Np и Nn следующим образом:
 ,
,  ,
,
где ni, pi – собственные концентрации носителей зарядов (без примеси) электронов и дырок соответственно.
Скорость диффузии носителей заряда υ n, p диф можно допустить близкой к их скорости дрейфа υ n, p др в слабом электрическом поле при небольших отклонениях от условий равновесия. В этом случае для условий равновесия выполняются следующие равенства:
υ p диф = υ p др = υ p, υ nдиф = υ n др = υ n.
Тогда выражение (1.15) можно записать в виде:


 , (1.16).
, (1.16).
Обратный ток  можно выразить следующим образом:
можно выразить следующим образом:
 ,
,
где Dn, p – коэффициент диффузии дырок или электронов;
Ln, p – диффузионная длина дырок или электронов. Так как параметры D n, p, pn0, np0, Ln , p =  зависят от температуры, то обратный ток
зависят от температуры, то обратный ток  чаще называют тепловым током.
чаще называют тепловым током.
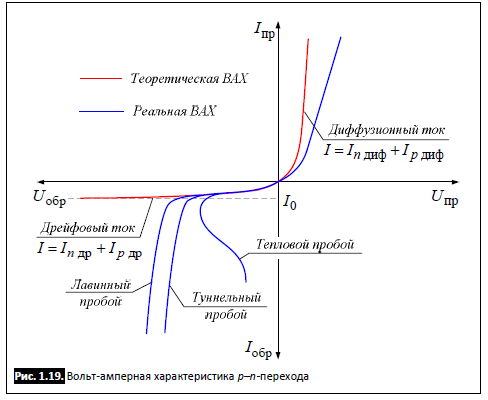 При прямом напряжении внешнего источника (U вн > 0) экспоненциальный член
При прямом напряжении внешнего источника (U вн > 0) экспоненциальный член  в выражении (1.16) быстро возрастает, что приводит к быстрому росту прямого тока, который, как уже было отмечено, в основном определяется диффузионной составляющей.
в выражении (1.16) быстро возрастает, что приводит к быстрому росту прямого тока, который, как уже было отмечено, в основном определяется диффузионной составляющей.
При обратном напряжении внешнего источника
( ) экспоненциальный член много меньше единицы и ток р–n -перехода практически равен обратному току
) экспоненциальный член много меньше единицы и ток р–n -перехода практически равен обратному току  , определяемому, в основном, дрейфовой составляющей. Вид этой зависимости представлен на рис. 1.19. Первый квадрант соответствует участку прямой ветви вольт-амперной характеристики, а третий квадрант – обратной ветви. При увеличении прямого напряжения ток р–n -перехода в прямом направлении вначале возрастает относительно медленно, а затем начинается участок быстрого нарастания прямого тока, что приводит к дополнительному нагреванию полупроводниковой структуры. Если количество выделяемого при этом тепла будет превышать количество тепла, отводимого от полупроводникового кристалла либо естественным путем, либо с помощью
, определяемому, в основном, дрейфовой составляющей. Вид этой зависимости представлен на рис. 1.19. Первый квадрант соответствует участку прямой ветви вольт-амперной характеристики, а третий квадрант – обратной ветви. При увеличении прямого напряжения ток р–n -перехода в прямом направлении вначале возрастает относительно медленно, а затем начинается участок быстрого нарастания прямого тока, что приводит к дополнительному нагреванию полупроводниковой структуры. Если количество выделяемого при этом тепла будет превышать количество тепла, отводимого от полупроводникового кристалла либо естественным путем, либо с помощью
специальных устройств охлаждения, то могут произойти в полупроводниковой структуре необратимые изменения вплоть до разрушения кристаллической решетки. Поэтому прямой ток р–n -перехода необходимо ограничивать на безопасном уровне, исключающем перегрев полупроводниковой структуры. Для этого необходимо использовать ограничительное сопротивление последовательно подключенное с p–n -переходом.
При увеличении обратного напряжения, приложенного к р–n -переходу, обратный ток изменяется незначительно, так как дрейфовая составляющая тока, являющаяся превалирующей при обратном включении, зависит в основном от температуры кристалла, а увеличение обратного напряжения приводит лишь к увеличению скорости дрейфа неосновных носителей без изменения их количества. Такое положение будет сохраняться до величины обратного напряжения, при котором начинается интенсивный рост обратного тока – так называемый пробой р–n-перехода.
1.7.4. Виды пробоев p–n-перехода
Возможны обратимые и необратимые пробои. Обратимый пробой – это пробой, после которого p–n -переход сохраняет работоспособность. Необратимый пробой ведет к разрушению структуры полупроводника.
Существуют четыре типа пробоя: лавинный, туннельный, тепловой и поверхностный. Лавинный и туннельный пробои объединятся под названием – электрический пробой, который является обратимым. К необратимым относят тепловой и поверхностный.
Лавинный пробой свойственен полупроводникам, со значительной толщиной р–n -перехода, образованных слаболегированными полупроводниками. При этом ширина обедненного слоя гораздо больше диффузионной длины носителей. Пробой происходит под действием сильного электрического поля с напряженностью Е  (8…12)
(8…12)  ,
,  .В лавинном пробое основная роль принадлежит неосновным носителям, образующимся под действием тепла в р–n -переходе.
.В лавинном пробое основная роль принадлежит неосновным носителям, образующимся под действием тепла в р–n -переходе.
Эти носители испытывают со стороны электрического поля р–n -перехода ускоряющее действие и начинают ускоренно двигаться вдоль силовых линий этого поля. При определенной величине напряженности неосновные носители заряда на длине свободного пробега l (рис. 1.20) могут разогнаться до такой скорости, что их кинетической энергии может оказаться достаточно, чтобы при очередном соударении с атомом полупроводника ионизировать его, т.е. «выбить» один из его валентных электронов и перебросить его в зону 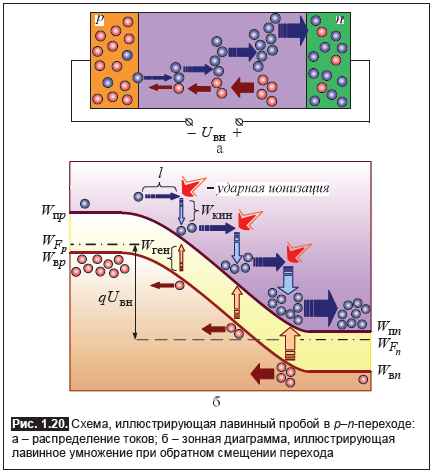 проводимости, образовав при этом пару «электрон – дырка». Образовавшиеся носители тоже начнут разгоняться в электрическом поле, сталкиваться с другими нейтральными атомами, и процесс, таким образом, будет лавинообразно нарастать. При этом происходит резкий рост обратного тока при практически неизменном обратном напряжении.
проводимости, образовав при этом пару «электрон – дырка». Образовавшиеся носители тоже начнут разгоняться в электрическом поле, сталкиваться с другими нейтральными атомами, и процесс, таким образом, будет лавинообразно нарастать. При этом происходит резкий рост обратного тока при практически неизменном обратном напряжении.
Параметром, характеризующим лавинный пробой, является коэффициент лавинного умножения M, определяемый как количество актов лавинного умножения в области сильного электрического поля. Величина обратного тока после лавинного умножения будет равна:
 ,
,
 , (1.17)
, (1.17)
где  – начальный ток; U – приложенное напряжение; U п – напряжение лавинного пробоя; n – коэффициент, равный 3 для Ge, 5 для Si.
– начальный ток; U – приложенное напряжение; U п – напряжение лавинного пробоя; n – коэффициент, равный 3 для Ge, 5 для Si.
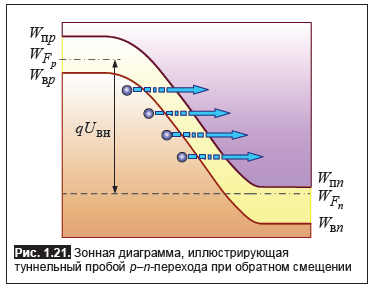 Туннельный пробой происходит в очень тонких р–n -переходах, что возможно при очень высокой концентрации примесей N
Туннельный пробой происходит в очень тонких р–n -переходах, что возможно при очень высокой концентрации примесей N  1019 см-3, когда ширина перехода становится малой (порядка 0,01 мкм) и при небольших значениях обратного напряжения (несколько вольт), когда возникает большой градиент электрического поля. Высокое значение напряженности электрического поля, воздействуя на атомы кристаллической решетки, повышает энергию валентных электронов и приводит к их туннельному «просачиванию» сквозь «тонкий» энергетический барьер (рис. 1.21) из валентной зоны p -области в зону проводимости n -области. Причем «просачивание» происходит без изменения энергии носителей заряда. Для туннельного пробоя также характерен резкий рост обратного тока при практически неизменном обратном напряжении.
1019 см-3, когда ширина перехода становится малой (порядка 0,01 мкм) и при небольших значениях обратного напряжения (несколько вольт), когда возникает большой градиент электрического поля. Высокое значение напряженности электрического поля, воздействуя на атомы кристаллической решетки, повышает энергию валентных электронов и приводит к их туннельному «просачиванию» сквозь «тонкий» энергетический барьер (рис. 1.21) из валентной зоны p -области в зону проводимости n -области. Причем «просачивание» происходит без изменения энергии носителей заряда. Для туннельного пробоя также характерен резкий рост обратного тока при практически неизменном обратном напряжении.
Если обратный ток при обоих видах электрического пробоя не превысит максимально допустимого значения, при котором произойдет пере-
грев и разрушение кристаллической структуры полупроводника, то они являются обратимыми и могут быть воспроизведены многократно.
Тепловым называется пробой р–n- перехода, обусловленный ростом количества носителей заряда при повышении температуры кристалла. С увеличением обратного напряжения и тока возрастает тепловая мощность, выделяющаяся в р–n -переходе, и, соответственно, температура кристаллической структуры. Под действием тепла усиливаются колебания атомов кристалла и ослабевает связь валентных электронов с ними, возрастает вероятность перехода их в зону проводимости и образования дополнительных пар носителей «электрон – дырка». Если электрическая мощность в р–n -переходе превысит максимально допустимое значение, то процесс термогенерации лавинообразно нарастает, в кристалле происходит необратимая перестройка структуры и р-n -переход разрушается.
Для предотвращения теплового пробоя необходимо выполнение условия
 , (1.18)
, (1.18)
где  - максимально допустимая мощность рассеяния р-n -перехода.
- максимально допустимая мощность рассеяния р-n -перехода.
Поверхностный пробой. Распределение напряженности электрического поля в р–n -переходе может существенно изменить заряды, имеющиеся на поверхности полупроводника. Поверхностный заряд может привести к увеличению или уменьшению толщины перехода, в результате чего на поверхности перехода может наступить пробой при напряженности поля, меньшей той, которая необходима для возникновения пробоя в толще полупроводника. Это явление называют поверхностным пробоем. Большую роль при возникновении поверхностного пробоя играют диэлектрические свойства среды, граничащей с поверхностью полупроводника. Для снижения вероятности поверхностного пробоя применяют специальные защитные покрытия с высокой диэлектрической постоянной.
1.7.5. Ёмкость р–n -перехода
Изменение внешнего напряжения на p–n -переходе приводит к изменению ширины обедненного слоя и, соответственно, накопленного в нем электрического заряда (это также обусловлено изменением концентрации инжектированных носителей заряда вблизи перехода). Исходя их этого p–n -переход ведет себя подобно конденсатору, ёмкость которого определяется как отношение изменения накопленного в p–n -переходе заряда к обусловившему это изменение приложенному внешнему напряжению.
Различают барьерную (или зарядную) и диффузионную ёмкость р-n -перехода.
Барьерная ёмкость соответствует обратновключенному p–n -переходу, который рассматривается как обычный конденсатор, где пластинами являются границы обедненного слоя, а сам обедненный слой служит несовершенным диэлектриком с увеличенными диэлектрическими потерями:
 , (1.19)
, (1.19)
где  относительная диэлектрическая проницаемость полупроводникового материала;
относительная диэлектрическая проницаемость полупроводникового материала;  – электрическая постоянная (
– электрическая постоянная ( ); S – площадь p–n -перехода;
); S – площадь p–n -перехода;  – ширина обеднённого слоя.
– ширина обеднённого слоя.
 Барьерная ёмкость возрастает при увеличении площади p–n -перехода и диэлектрической проницаемости полупроводника и уменьшении ширины обедённого слоя. В зависимости от площади перехода Сбар может быть от единиц до сотен пикофарад.
Барьерная ёмкость возрастает при увеличении площади p–n -перехода и диэлектрической проницаемости полупроводника и уменьшении ширины обедённого слоя. В зависимости от площади перехода Сбар может быть от единиц до сотен пикофарад.
Особенностью барьерной ёмкости является то, что она является нелинейной ёмкостью. При возрастании обратного напряжения ширина перехода увеличивается и ёмкость Сбар уменьшается. Характер зависимости Сбар = f (Uобр) показывает график на рис. 1.22. Как видно, под влиянием Uпроб ёмкость Сбар изменяется в несколько раз.
Диффузионная ёмкость характеризует накопление подвижных носителей заряда в n - и p -областях при прямом напряжении на переходе. Она практически существует только при прямом напряжении, когда носители заряда диффундируют (инжектируют) в большом количестве через пониженный потенциальный барьер и, не успев рекомбинировать, накапливаются в n - и p -областях. Каждому значению прямого напряжения соответствуют определенные значения двух разноименных зарядов + Qдиф и -Qдиф, накопленных в n - и p -областях за счет диффузии носителей через переход. Ёмкость Сдиф представляет собой отношение зарядов к разности потенциалов:
 , (1.20)
, (1.20)
С увеличением Uпр прямой ток растет быстрее, чем напряжение, т.к. вольт-амперная характеристика для прямого тока имеет нелинейный вид, поэтому Qдиф растет быстрее, чем Uпр и Сдиф увеличивается.
Диффузионная ёмкость значительно больше барьерной, но использовать ее не удается, т.к. она оказывается шунтированной малым прямым сопротивлением p–n -перехода. Численные оценки величины диффузионной ёмкости показывают, что ее значение доходит до нескольких единиц микрофарад.
Таким образом, р–n -переход можно использовать в качестве конденсатора переменной ёмкости,
управляемого величиной и знаком приложенного напряжения.
1.7.6. Контакт «металл – полупроводник»
В современных полупроводниковых приборах помимо контактов с p–n -переходом применяются контакты «металл – полупроводник».
Контакт «металл – полупроводник» возникает в месте соприкосновения полупроводникового кристалла n - или р -типа проводимости с металлами. Происходящие при этом процессы определяются соотношением работ выхода электрона из металла  и из полупроводника
и из полупроводника  . Под работой выхода электрона понимают энергию, необходимую для переноса электрона с уровня Ферми на энергетический уровень свободного электрона. Чем меньше работа выхода, тем больше электронов может выйти из данного тела.
. Под работой выхода электрона понимают энергию, необходимую для переноса электрона с уровня Ферми на энергетический уровень свободного электрона. Чем меньше работа выхода, тем больше электронов может выйти из данного тела.
В результате диффузии электронов и перераспределения зарядов нарушается электрическая нейтральность прилегающих к границе раздела областей, возникает контактное электрическое поле и контактная разность потенциалов:
 . (1.21)
. (1.21)
Переходный слой, в котором существует контактное электрическое поле при контакте «металл –полупроводник», называется переходом Шоттки, по имени немецкого ученого В. Шоттки, который первый получил основные математические соотношения для электрических характеристик таких переходов.
Контактное электрическое поле на переходе Шоттки сосредоточено практически в полупроводнике, так как концентрация носителей заряда в металле значительно больше концентрации носителей заряда в полупроводнике. Перераспределение электронов в металле происходит в очень тонком слое, сравнимом с межатомным расстоянием.
В зависимости от типа электропроводности полупроводника и соотношения работ выхода в кристалле может возникать обеднённый, инверсный или обогащённый слой носителями электрических
зарядов.
1. 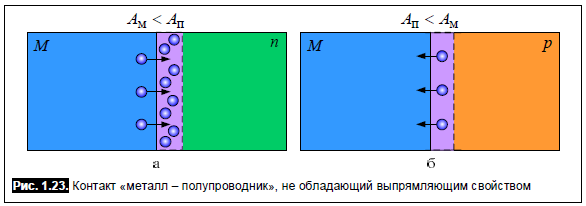
 <
<  , полупроводник n -типа (рис. 1.23, а). В данном случае будет преобладать выход электронов из металла (M) в полупроводник, поэтому в слое полупроводника около границы раздела накапливаются основные носители (электроны), и этот слой становится обогащенным, т.е. имеющим повышенную концентрацию электронов. Сопротивление этого слоя будет малым при любой полярности приложенного напряжения, и, следовательно, такой переход не обладает выпрямляющим свойством. Его иначе называют невыпрямляющим переходом.
, полупроводник n -типа (рис. 1.23, а). В данном случае будет преобладать выход электронов из металла (M) в полупроводник, поэтому в слое полупроводника около границы раздела накапливаются основные носители (электроны), и этот слой становится обогащенным, т.е. имеющим повышенную концентрацию электронов. Сопротивление этого слоя будет малым при любой полярности приложенного напряжения, и, следовательно, такой переход не обладает выпрямляющим свойством. Его иначе называют невыпрямляющим переходом.
2.  <
<  , полупроводник p -типа (рис. 1.23, б). В этом случае будет преобладать выход электронов из полупроводника в металл, при этом в приграничном слое также образуется область, обогащенная основными носителями заряда (дырками), имеющая малое сопротивление. Такой переход также не обладает выпрямляющим свойством.
, полупроводник p -типа (рис. 1.23, б). В этом случае будет преобладать выход электронов из полупроводника в металл, при этом в приграничном слое также образуется область, обогащенная основными носителями заряда (дырками), имеющая малое сопротивление. Такой переход также не обладает выпрямляющим свойством.
3. 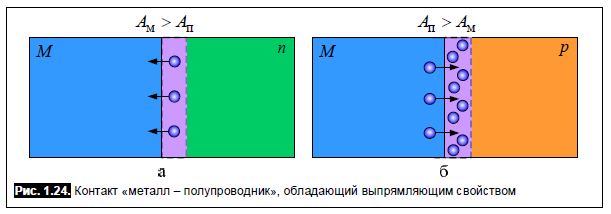


 , полупроводник n-типа (рис. 1.24, а). При таких условиях электроны будут переходить главным образом из полупроводника в металл и в приграничном слое полупроводника образуется область, обедненная основными носителями заряда и имеющая большое сопротивление. Здесь создается сравнительно высокий потенциальный барьер, высота которого будет существенно зависеть от полярности приложенного напряжения. Если
, полупроводник n-типа (рис. 1.24, а). При таких условиях электроны будут переходить главным образом из полупроводника в металл и в приграничном слое полупроводника образуется область, обедненная основными носителями заряда и имеющая большое сопротивление. Здесь создается сравнительно высокий потенциальный барьер, высота которого будет существенно зависеть от полярности приложенного напряжения. Если 

 , то возможно образование инверсного слоя (p -типа). Такой контакт обладает выпрямляющим свойством.
, то возможно образование инверсного слоя (p -типа). Такой контакт обладает выпрямляющим свойством.
4. 

 , полупроводник p -типа (рис. 1.24, б). Контакт, образованный при таких условиях обладает выпрямляющим свойством, как и предыдущий.
, полупроводник p -типа (рис. 1.24, б). Контакт, образованный при таких условиях обладает выпрямляющим свойством, как и предыдущий.
Отличительной особенностью контакта «металл – полупроводник» является то, что в отличие от обычного p–n -перехода здесь высота потенциального барьера для электронов и дырок разная. В результате такие контакты могут быть при определенных условиях неинжектирующими, т.е. при протекании прямого тока через контакт в полупроводниковую область не будут инжектироваться неосновные носители, что очень важно для высокочастотных и импульсных полупроводниковых приборов.
|
|
|
|
|
Дата добавления: 2015-06-04; Просмотров: 8934; Нарушение авторских прав?; Мы поможем в написании вашей работы!