
КАТЕГОРИИ:
Архитектура-(3434)Астрономия-(809)Биология-(7483)Биотехнологии-(1457)Военное дело-(14632)Высокие технологии-(1363)География-(913)Геология-(1438)Государство-(451)Демография-(1065)Дом-(47672)Журналистика и СМИ-(912)Изобретательство-(14524)Иностранные языки-(4268)Информатика-(17799)Искусство-(1338)История-(13644)Компьютеры-(11121)Косметика-(55)Кулинария-(373)Культура-(8427)Лингвистика-(374)Литература-(1642)Маркетинг-(23702)Математика-(16968)Машиностроение-(1700)Медицина-(12668)Менеджмент-(24684)Механика-(15423)Науковедение-(506)Образование-(11852)Охрана труда-(3308)Педагогика-(5571)Полиграфия-(1312)Политика-(7869)Право-(5454)Приборостроение-(1369)Программирование-(2801)Производство-(97182)Промышленность-(8706)Психология-(18388)Религия-(3217)Связь-(10668)Сельское хозяйство-(299)Социология-(6455)Спорт-(42831)Строительство-(4793)Торговля-(5050)Транспорт-(2929)Туризм-(1568)Физика-(3942)Философия-(17015)Финансы-(26596)Химия-(22929)Экология-(12095)Экономика-(9961)Электроника-(8441)Электротехника-(4623)Энергетика-(12629)Юриспруденция-(1492)Ядерная техника-(1748)
Современные технологии в исследовании материалов
|
|
|
|
(Рассчитана на 2 академических часа)
Исследование остаточных напряжений
В настоящее время в эксплуатации находится большое количество различных стальных строительных конструкций, значительная часть которых претерпела определенный износ. Помимо этого возникает потребность в усилении элементов при реконструкции, в связи с изменением технологических процессов и нагрузок на конструкции. Наиболее распространенным приемом в практике усиления металлоконструкций является увеличение сечения расчетных элементов, усиление узлов, сопряжений элементов, стыков. Дополнительные элементы крепят к основным посредством сварки. Сварка существенно влияет на работу стержней, как в процессе усиления, так и после усиления. Имеют место тепловые ослабления, временные и остаточные напряжения и деформации. Взаимодействие сварочных напряжений и деформаций с внешней силовой или температурной нагрузкой может способствовать уменьшению несущей способности, коррозионной стойкости и жесткости сварных конструкций. Таким образом, задача определения величины и характера распределения сварочных напряжений и деформаций представляется актуальной на сегодняшний день.
Расчетный путь определения остаточных напряжений является довольно сложным и громоздким. Это объясняет причины измерения остаточных напряжений экспериментальными методами. Существующие экспериментальные методы определения остаточных напряжений обычно разделяют на механические и физические. Механические методы основаны на принципе упругой разгрузки объема металла путем его разрезания. Физические методы определения остаточных напряжений не связаны с обязательным разрушением металла, в отличие от механических. Они основаны на изменении свойств металла, происходящего под влиянием остаточных напряжений. Рассмотрим наиболее разработанные физические методы, которые в отдельных случаях могут быть применены при измерении остаточных напряжений.
|
|
|
Одним из наиболее распространенных физических методов, является рентгенографический. Применение рентгеновских лучей для исследования напряженного состояния в металлах и сплавах основано на явлении дифракции рентгеновских лучей при прохождении их через кристаллическую решетку исследуемого материала. Преимуществом рентгенографического метода является возможность его применения при исследовании напряжений в малых зонах деталей сложной конфигурации без их разрушения. Недостатками метода являются использование сложной аппаратуры и относительная длительность обработки полученных данных [1].
Магнитоупругий метод базируется на магнитоупругом эффекте – свойстве изменения намагниченности ферромагнитного тела, в данном случае стального. Однако ввиду недостаточной изученности различных факторов, оказывающих влияние на изменение магнитоупругого эффекта, измерения полученные данным методом характеризуются разбросом и относительной степенью достоверности. Относительно новым является метод магнитной памяти металла, который основан на использовании магнитоупругого и магнитомеханического эффектов. Основные преимущества нового магнитного способа – исключение подготовки контролируемой поверхности и применение малогабаритных приборов [2].
Ультразвуковой метод также представляет определенный интерес в исследовании остаточных напряжений и основан на зависимости между напряжениями в твердых телах и скоростями распространения продольных и сдвиговых ультразвуковых колебаний. Преимуществами метода являются относительно невысокая погрешность, высокая чувствительность, возможность исследования на значительных глубинах. Но использование дорогостоящего комплекса аппаратуры и трудности ввода колебаний в исследуемый материал усложняют проведение эксперимента [3].
|
|
|
Бесконтактный электростатический метод оценки напряженно-деформированного состояния твердых тел основан на экспериментально установленной зависимости между данным состоянием твердого тела и величиной электрического поля исследуемого объекта [4]. Данный способ позволяет проводить неразрушающий контроль напряжений и деформаций в твердых
телах, определять пространственные координаты участков локальных концентраций напряжений и определять его величину. Голографический метод определения остаточных напряжений является бесконтактным методом [5]. Но широкое применение методов голографической интерферометрии для исследования остаточных напряжений натурных конструкций ограничивается в связи с требованиями виброизоляции как исследуемых объектов, так и применяемой голографической установки.
Резистивный электроконтактный метод – это метод, основанный на измерении электрического сопротивления на участке поверхностного слоя металла при подачи к нему переменного тока. Метод был разработан С.Ю.Ивановым, Д.В.Васильковым и В.Э.Хитриком для оценки остаточных механических напряжений, сохраняющихся в металлических изделиях после их изготовлении. В работе [6] предложено использовать резистивный электроконтактный метод для оценки напряженно-деформированного состояния стальных конструкций, обусловленного воздействием эксплуатационных нагрузок.

Рис.1 Распределение электрического сопротивления в активной зоне сварного соединения
Исследование проводится на модели – пластине, отобранной из стенки стального прокатного профиля двутаврового сечения 36М по ГОСТ 19425-74. Сварной шов выполнен ручной электродуговой сваркой. Проведена зачистка сварного шва и прилегающих к нему участков основного металла в каждую сторону от шва с двух сторон. Датчик прибора был установлен непосредственно на сварном шве и на нескольких участках зоны шва в обоих направлениях вдоль пластины. На рис.1 представлены результаты измерения электрического сопротивления в активной зоне сварного соединения, на основе которых можно сделать следующие выводы: − величина электрического сопротивления уменьшается по мере приближения к сварному шву; − зона влияния сварного шва составляет около пяти значений его ширины. Таким образом, резистивный электроконтактный метод представляет определенный интерес в вопросе определения влияния сварочных напряжений и деформаций на элементы конструкций и требует дальнейшего изучения.
|
|
|
СПИСОК ЛИТЕРАТУРЫ
1. Корякина В.Е., Новоселова Т.М., Соломатин В.Е. Возможности рентгеновского измерения остаточных напряжений в наплавленном валике и основном металле крупнозернистой аустенистой стали 15х23Н18Л. Сварочное производство № 9, с 37-38, 62; 2000.
2. А.В. Башкатов, А.В. Бондарь, А.Б. Булков. Напряжения и деформации при сварке. Учебное пособие, Воронеж, Изд-во ВГТУ, 1999.
3. Ботаки А.А., Ульянов В.А.. Шарко В.А. Ультразвуковой контроль прочностных свойств конструкционных материалов. – М.: Машиностроение. 1983.
4. Антонов А.А., Ифимовская А.А., Чернышев Г.Н. Бесконтактный электростатический метод оценки НДС твердых тел. Сб. Остаточные технологические напряжения». – М.: с.32-38. 1988.
5. Антонов А.А., Бобрик А.И., Морозов В.К., Чернышев Г.Н. Определение остаточных напряжений при помощи создания отверстий и голографической интерферометрии. Механика твердого тела № 2. 1980.
6. Улыбин А.В. Метод измерения электрического сопротивления для контроля механических напряжений в стальных конструкциях [Текст]: автореф. диссерт. на ст. к.т.н. 05.11.01. СПбГПУ, 2010.
Исследование энергии активации (склерометрия)
Анализ результатов многочисленных исследований отечественных и зарубежных ученых показывает, что в основе любых моделей изнашивания лежит соотношение между параметрами внешнего воздействия и критическими свойствами материалов, характеризующими их реакцию на это воздействие. Чаще всего рассматривают отношение энергии внешнего воздействия к удельной энергоемкости деформируемых объектов, накопленной к моменту образования продуктов изнашивания. Несмотря на кажущуюся обоснованность такого подхода, во многих случаях точность прогнозирования износостойкости материалов по указанному энергетическому соотношению оказывается невысокой. Это имеет место: при фазовых превращениях и рекристаллизации в процессе изнашивания; фазовых превращениях и рекристаллизации в процессе изнашивания; при неучете структурной неоднородности, хрупкости и неоднородности насыщения изнашиваемых объемов внутренней энергией, существенно неодинаковых на различных масштабных уровнях нагружения при соответствующих различных жесткостях напряженного состояния поверхности материалов и в ряде других случаев.
|
|
|
В настоящее время преобладает мнение о том, что локальные периодически повторяющиеся импульсы внешнего воздействия (энергии, давления, скорости и т.п.) в большинстве случаев фрикционного взаимодействия пар трения, а также при контакте твердых поверхностей с жидкими средами и прочими субстанциями имеют динамический характер. При этом изнашивание материалов происходит в результате суммирования повреждений под воздействием спектра импульсов различной интенсивности. Очевидно, что интенсивность внешнего воздействия будет определяться средним значением энергии импульсов, их частотой и продолжительностью, а также масштабным фактором. Анализ показывает, что по мере увеличения объемов, где происходят необратимые структурные изменения, и глубины слоя, испытывающего упругопластические деформации, происходит: увеличение жесткости их напряженного состояния и склонности к охрупчиванию, изменение энергии активации элементарных актов атомно-молекулярных перегруппировок, морфологии диссипативных структур, фрактальной размерности эрозионного рельефа и крупности продуктов изнашивания с неодинаковой плотностью насыщения внутренней энергией. [2]
Если по мере возрастания геометрического масштаба изнашивания выделить пять уровней структурных изменений (атомно-молекулярный, микро-, мезо- и суперструктурный и макроскопический), то разумно предположить, что модель процесса изнашивания материалов на каждом масштабном (структурном) уровне должна учитывать комплекс физико-механических свойств, наилучшим образом отражающих сопротивление активируемых объемов внешнему разрушающему воздействию. Справедливость такого предположения подтверждается многочисленными экспериментальными данными, где износостойкость широкого круга материалов с различной степенью корреляции сопоставлялась с энергией активации химических реакций, интенсивностью экзоэмиссии, поверхностной энергией, работой деформации, плотностью дислокаций, степенью деформационного упрочнения, периодом повреждаемости, плотностью скрытой энергии, твердостью, критическим раскрытием трещин, сопротивлением царапанию и срезу и т.п.
Если весьма широкий диапазон переменных условий повреждаемости материалов, от малоинтенсивного окислительного изнашивания до образования продуктов изнашивания вследствие резания, совместить с перечисленными критериями, то для первой половины указанного диапазона наиболее подходящими окажутся химико-физические характеристики, а для второй – физико-механические свойства изнашиваемых материалов. В настоящее время сложилось единое мнение о том, что изнашивание материалов в большинстве случаев представляет собой результат суперпозиции одновременно протекающих разномасштабных процессов повреждаемости, приводящих в итоге к образованию продуктов изнашивания.
В качестве критериев износостойкости должны фигурировать критические потоковые характеристики материалов, раскрытие которых возможно на основе: анализа особенностей распространения в материалах поверхностей разрыва; решения уравнений механики однородных и гетерогенных сплошных сред, пригодных для описания поведения материалов на мезо-, суперструктурном и макроуровнях, и сращивания полученных решений с известными термокинетическими закономерностями повреждаемости материалов при оценке их долговечности. Иными словами хочется сказать о том, что энергия активации есть энергия связи между атомами в кристаллической решетке, на которую в свою очередь влияет и термическая обработка. Минимальная энергия активации наблюдается при отжиге – то есть в равновесном, упорядоченном состоянии, а максимальная – при закалке – наиболее неупорядоченном состоянии. То есть по значениям энергии активации можно судить о твердости поверхности а затем в свою очередь и о износостойкости.
Склерометрический программно-аппаратурный комплекс «Склерометр «Ресурс-3Л»
Исследования энергии активации проводились на склерометрическом программно-аппаратурном комплексе « СКЛЕРОМЕТР «РЕСУРС-3Л», предназначенного для оценки накопленной повреждаемости и прогнозирования остаточного ресурса на образцах и деталях из конструкционных металлов и сплавов в лабораторных условиях.
Общий вид склерометров для работы в автономном и стационарном режимах показан на рисунке 2. Более подробно конструкция механической части прибора представлена на рисунке 3.
|












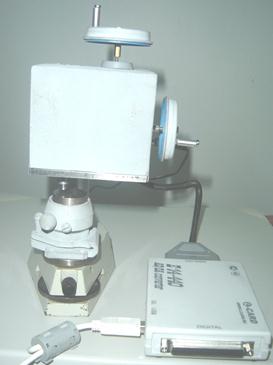
А) Б)
Рисунок 2 - Общий вид склерометров в переносном (автономном) (А)
и стационарном (Б) исполнениях.
Измерительная часть склерометрического комплекса, схема электрическая принципиальная и структурные элементы которой приведены на рисунке 4, предназначена для оценки касательной и нормальной нагрузок, действующих на индентор при пропахивании борозды, определения момента касания и глубины заглубления индентора в исследуемый материал.
При контроле серийных изделий из каждой партии отбираются 3…5% деталей (но не менее трех). При единичном производстве контроль проводится на пяти различных участках одной детали. [2]
Обязательному контролю подвергаются участки концентрации напряжений (деформаций), выявляемые расчетными (например, методом конечных элементов) и (или) экспериментальными методами, включая участки с неоднородными свойствами (прижоги, сегрегации, вмятины, риски, поверхности трения, микротрещины, сварные швы и т.д.).

Рисунок 3 - Конструкция механической части склерометра - вид сбоку (а) и сверху (б), с установкой на стойке (в): 1 – стойка; 2 – индентор; 3 – датчик акустической эмиссии (АЭ); 4 – плоскопараллельные пружины для касательных перемещений индентора «вперед-назад»; 5 – плоскопараллельные пружины для нормальных перемещений индентора «вверх-вниз»; 6 – датчик глубины внедрения индентора; 7 – датчик касательной силы при царапании; 8 - платформа.
Испытанию могут подвергаться отдельные детали или специально подготовленные шлифы. Образцы перед испытаниями рекомендуется заделать в оправку диаметром не более 30 мм и высотой не более 15мм с помощью эпоксидного клея или другого быстротвердеющего состава.
При испытаниях борозды на поверхности образцов формируются в направлении действия главных напряжений при эксплуатации изделий.
После транспортировки образцов перед испытаниями их выдерживают при комнатной температуре не менее 30 мин.
Для испытываемых материалов необходимо: на основе известного химического состава рассчитать молярный объем Vм (мм3/моль); оценить энергию активации пластической деформации материала в отожженном (начальном) uн, а также в критическом u* состояниях (кДж/моль). Погрешность оценки указанных величин не более ±5%. Оценку критического значения энергии активации пластической деформации u* производят возле краев усталостной трещины, образовавшейся при эксплуатации или выращенной искусственно при усталостных испытаниях.
В завершении анализа проблем, возникающих при прогнозировании износостойкости и долговечности материалов на основе нового структурно-энергетического подхода, следует особо подчеркнуть необходимость учета многомасштабности разрушения материалов при различных видах изнашивания, подчиняющихся синергетическим особенностям возникающих диссипативных структур и закономерностям фрактальной механики разрушения. Все это позволяет не только обобщить и упорядочить накопленный банк данных, но и создать основу для разработки расчетных методов прогнозирования надежности технических средств, используемых в различных отраслях промышленности.
Методы структурных исследований
Рентгеноструктурный анализ
В данном разделе рассмотрен метод рентгеноструктурного анализа, применяемого для полной аттестации кристаллической структуры, ана-лиза дефектов и фазового состава материалов. Рассмотрены основные экспериментальные методы и особенности применения для исследова-ния материалов. Рентгеноструктурный анализ (РСА) основан на явлении дифракции рентгеновских лучей, открытом Максом фон Лауэ в 1912 г. Методами РСА по дифракционным картинам, возникающим при рассеянии рент-геновских лучей кристаллическими веществами, можно изучать распо-ложение атомов в этих веществах, процессы, связанные с перестройкой атомов в кристаллах. Можно исследовать диаграммы состояний систем, определять внутренние напряжения, размеры кристаллитов, виды и ко-личество дефектов структуры. Задачи, решаемые методом:
1. Определение периода идентичности при вращении монокристал-ла.
2. Определение числа атомов в элементарной ячейке.
3. Определение типа твердого раствора
4. Определение коэффициента термического расширения
и в разных фазах композиционного материала.
5. Фазовый анализ и изучение диаграмм состояний При сплавлении различных компонентов возможно формирование различных фаз, наличие которых легко определить с помощью рентге-ноструктурного анализа. Если при получении рентгенограммы на ней присутствует только одна система линий, то мы имеем твердый раствор с неограниченной растворимостью. В случае эвтектического типа на рентгенограмме появляются две системы линий в двухфазной области и изменение интенсивности, а в однофазной области имеем только изменение параметров. В случае диаграммы с промежуточной фазой на рентгенограмме она имеет свою собственную систему линий.
6. Исследование границ растворимости Существует два метода: 1. Метод исчезающей фазы. В этом методе измеряют интенсив-ность рентгеновских линий при различных концентрациях в сплаве для разных температур; далее проводят экстраполяцию на нулевое значение интенсивности. 2. Метод определения изменения периодов решетки. Это метод бо-лее точный. В данном случае измеряют параметр решетки (межплоско-стное расстояние), который меняется при легировании. Далее проводят интерполяцию, а точка пересечения линий определяет границу раство-римости.
7. Методы исследования границ растворимости и установление наличия фаз в исследуемом образ-це, их идентификация (качественный анализ) и определение относи-тельного содержания (количественный анализ). Качественно фазовый анализ основан на том, что от каждого хими-ческого соединения (сплава) на рентгенограмме возникает своя система линий. Набор измеренных относительных интенсивностей линий и межплоскостных расстояний {Ihkl, dhkl} называют «рентгеновской харак-теристикой вещества». Три самые сильные линии – «реперные». Методы количественного фазового анализа основаны на том, что соотношение интенсивностей линий каждой фазы не зависит от других веществ, присутствующих в образце, но пропорциональна содержанию этой фазы.
Все разработанные до настоящего времени методы основаны либо на устранении, либо на учете причин, вызывающих отклонение от пря-мой пропорциональности между интенсивностью и объемной долей фа-зы в смеси.
Методы количественного анализа Метод гомологических пар Используется для двухфазных систем, в которых коэффициенты поглошения фазы и смеси примерно одинаковы (также для трехфазной смеси, если количество третьей фазы менее 5 %). Этот случай реализу-ется, например, в аустенитно-мартенситных сталях.
Рентгенографическое определение внутренних напряжений в материалах
Металлический образец, если к нему приложить напряжение, пре-восходящее предел упругости, пластически деформируется. При этом изменяются и другие физические и физико-химические свойства метал-ла. С увеличением степени пластической деформации повышается внутренняя энергия металла, искажается его кристаллическая структу-ра, меняются свойства: металл упрочняется, понижается сопротивление коррозии, увеличивается скорость диффузии и фазовых превращений, понижается плотность, появляется анизотропия свойств, связанная с предпочтительной ориентацией кристаллитов (текстурой). Различают следующие типы внутренних напряжений, отличающих-ся объемами, в которых они уравновешиваются.
1. Макронапряжения (зональные напряжения, напряжения I рода). Эти напряжения уравновешиваются в объеме всего образца или изде-лия. Они имеют ориентацию, связанную с формой изделия. При нали-чии макронапряжений удаление какой-либо части детали пpиводит к нарушению равновесия между остальными ее частями, что вызывает деформирование (коробление и растрескивание) изделия. Разрушение пpоисходит большей частью под действием растягивающих напряже-ний. Сжимающие напряжения (их можно создавать специальными тех-нологическими процессами) снижают чувствительность материала к концентраторам напряжений и повышают усталостную прочность мате-риала.
2. Микронапряжения (микроискажения, напряжения II рода). Эти напряжения уравновешиваются в пределах отдельных кристаллов или блоков и могут быть как неориентированными, так и ориентированны-ми (в направлении усилия, произведшего пластическую деформацию).
3. Статические искажения решетки. Уравновешиваются в пределах небольших групп атомов. В деформированных металлах статические искажения уравновешиваются в группах атомов, лежащих у границ зе-рен, плоскостей скольжения и т. д. Такие искажения могут быть связаны с дислокациями. Смещения атомов из идеальных положений (узлов ре-шетки) могут также возникать в кристаллах твердого раствора из-за различия размеров атомов и химического взаимодействия между одно-именными и разноименными атомами, образующими твердый раствор. При наличии микронапряжений и статических искажений удаление час-ти тела не приводит к их перераспределению. Напряжения разных типов приводят к различным изменениям рент-генограмм и дифрактограмм, чтo позволяет изучать внутренние напря-жения рентгенографическими методами.
Макронапряжения вызывают сдвиг интерференционных линий, особенно заметный под большими брэгговскими углами. Микронапряжения приводят к уширению линий. Наибольшее изменение ширины интерференционных линий наблюдают при больших брэгговских углах. Ориентированные микронапряжения могут также вызывать смещение линий. При наличии статических ис-кажений, связанных со смещениями атомов из идеальных положений, уменьшается интенсивность интерференционных линий и возрастает диффузный фон. Эффект уменьшения интенсивности особенно заметен для линий с большими индексами. Дефекты в кристаллах, связанные с микронапряжениями и статиче-скими искажениями, делятся на два класса: ограниченные и бесконечно большие в одном или в двух направлениях. Дефекты относятся к перво-му классу, если создаваемые ими смещения убывают с расстоянием, как 1/r2 (или быстрее), и ко второму классу, если смещения убывают, как 1/r2/З (или медленнее). Прямолинейные дислокации, проходящие через весь кристалл, яв-ляются бесконечно протяженными дефектами и вызывают уширение линий. К этому эффекту приводят также хаотически распределенные по кристаллу дефекты упаковки или системы дислокаций, образующие границы блоков в бесконечном кристалле. При рассеянии рентгеновских лучей поликристаллическими образ-цами может также наблюдаться эффект уширения линий, связанный с флуктуациями числа дефектов в различных кристаллитах. Определение макронапряжений Макронапряжения возникают при неоднородном нагреве или охла-ждении (например, при сварке, огневой резке), в процессе холодной прокатки или правки готовых изделий, в результате структурных пре-вращений, при химической и механической обработке поверхности (то-чении, шлифовке, полировке), а также при нанесении электролитиче-ских покрытий. Контроль макронапряжений имеет важное значение в практике, так как позволяет значительно повышать надежность изделий в эксплуатации. Рентгенографический метод определения макронапряжений осно-ван на точном измерении периодов решетки. Исследование проводится без разрушения изделий, напряжения определяются в очень тонком по-верхностном слое металла. Однако рентгенографический метод иссле-дования позволяет получить сведения о напряженном состоянии только определенным образом ориентированных кристаллитов, в то время как механические методы дают средние величины деформации для всех зе-рен металла. По этой причине результаты, полученные механическими и рентгенографическими методами, не всегда совпадают. Рентгеногра-фические методы позволяют изучать напряжения на очень небольшой площади и, следовательно, устанавливать распределение напряжений по образцу. С помощью этих методов можно исследовать металлы как в линей-но-напряженном, так и в плосконапряженном состоянии. Линейно-напряженное состояние. При теоретическом рассмотре-нии условий отражения монохроматических рентгеновских лучей от уз-ловых плоскостей в линейно-напряженном поликристаллическом агре-гате показано, что его упругая деформация должна приводить к смеще-нию линий на рентгенограммах, полученных методом порошков. Определение напряжений в рассматриваемом случае произво-дится с помощью двух рентгенограмм с напряженного и ненапряжен-ного образцов.
Как указано выше, микронапряжения возникают вследствие: 1) пластической деформации поликристаллов; 2) неоднородности поля температур (разные КТР у разных фаз); 3) распада твердых растворов (некогерентность решеток); 4) локальных структурных превращений (например, цементация). Микроискажения приводят к уширению рентгеновских линий, ко-торое может быть охарактеризовано величиной Δd/d, где Δd – макси-мальное отклонение межплоскостного расстояния от среднего значения. Ранее было показано, что Δd/d = – ctgθΔθ, т. е. эффект уширения линий растет с увеличением брэгговского угла.
Статические искажения Статические искажения кристаллической решетки, возникающие вокруг дислокаций, вокруг внедренных атомов и вокруг вакансий также приводят к уширению рентгеновских линий. Рентгенографическое определение величины кристаллитов Некоторые кристаллиты в поликристалле оказываются ориентиро-ванными под брэгговскими углами. Каждый из таких кристаллитов дает на дебаеграмме отражение в виде точки или двух точек, отвечающих дублету Kα12 под большими брэгговскими углами. При размерах кри-сталлитов L < 10–3 см эти точки сливаются в сплошные интерференци-онные линии. В случае же крупнокристаллического образца с размера-ми зерен L > 10–3 см интерференционные линии имеют точечную струк-туру. Число точек на этих линиях пропорционально вероятности нахо-ждения кристаллита в отражающем положении и числу кристаллитов в освещенном объеме, которое зависит от их размеров. Для исследования тонких образцов можно использовать метод съем-ки на просвет (образец не должен иметь текстуры). Пучок рентгеновских лучей должен иметь известное сечение S, чтобы можно было определить облучаемый объем V, который равен Sd, где d – толщина образца.
Для исследования массивных образцов применяют метод съемки на отражение (обратной съемки). Облучаемый объем образца V не может быть определен непосредст-венно, так как он зависит от максимальной глубины d, на которую про-никает излучение, способное выйти из образца после отражения от кри-сталлографических плоскостей (hkl) кристаллитов. Для преодоления этой трудности предложен метод двойных экспозиций. От образца получают две рентгенограммы с экспозициями t0 и t1. Экспозиция t1 мала, и поэтому в отражении принимают участие лишь кристаллиты, расположенные на поверхности образца и близко к ней. Экспозиция t0 более длительная, вследствие чего на рентгенограмме регистрируются отражения от кри-сталлитов, находящихся на большей глубине. Затем производят сравне-ние полученных рентгенограмм и подсчитывают разность Δn числа пятен на обеих рентгенограммах с почернением, превышающим определенную величину D0 (для одной и той же линии с индексами hkl). Вероятность отражения кристаллов равна Whkl = [р(γ+Δϕ)cosΘ]/2, (67) где Δϕ — дополнительная угловая ширина отраженного пучка, связан-ная с мозаичнностью зерен, дифракционным уширением, естественной шириной спектральной линии и другими факторами. Для определения величины кристаллов малых размеров часто исполь-зуют уширение дифракционных линий. Однако надо помнить, что най-денная таким образом величина – это размер кристалла, а не размер час-тицы, так как частица может состоять из нескольких микрокристаллов.
Электронная микроскопия
Чтобы понять поведение материалов и об-легчить задачу создания новых материалов или материалов с улучшен-ными свойствами, их состав и микроструктура должны быть изучены при возможно более высоком разрешении. Такое исследование мате-риалов требует сложных и совершенных методик анализа, включая микроскопические, дифракционные и спектрографические исследова-ния. Это делает электронную микроскопию незаменимым методом, обеспечивающим все потребности физического и химического анализа. Используется два основных вида рассеяния: а) упругое – взаимодействие электронов с полем эффективного по-тенциала ядер, при котором не происходит энергетических потерь и ко-торое может быть когерентным или некогерентным; б) неупругое – взаимодействие электронов пучка с электронами об-разца, при котором происходят энергетические потери, и имеет место поглощение. Дифракция электронов была открыта в 1927 г. К. Девиссоном и Л. Джермером. Если рентгеновские лучи рассеиваются электронами ато-мов, т. е. они чувствительны к распределению электронной плотности в веществе, то электроны рассеиваются под действием электрического по-ля электронов и атомных ядер. При этом интенсивность рассеяния почти в 106 раз выше, чем у рентгеновского излучения. Поэтому для получения дифракционной картины равной интенсивности следует брать образцы намного более тонкие – 10–7…10–5 см при работе на просвет, а при работе на отражение изучаемая глубина составляет 3…20 нм.

Рис.4. Пределы пространственного разрешения при исследовании материалов

Рис.5 – Глубина поля и глубина резкости электронных линз

Рис.6. Схемы получения реплик с поверхности образцов

Рис.7 Реплики с экстракцией частиц
Приготовление образцов для электронной микроскопии
Образец обычно представляет собой диск диаметром 3 мм. Участок для исследования должен иметь толщину 10…100 нм и площадь, не превышающую несколько десятков квадратных микрон, поскольку уве-личение достигает 20000х. Получение столь тонких образцов представ-ляет существенные технические трудности.
Методы, используемые для получения образцов для электронной микроскопии.
1. Реплики с поверхностей объемных образцов.
2. Скалывание тонких слоев.
3. Микротомия (сверхтонкие срезы).
4. «Отбор» малых частиц.
5. Испарение материалов с осаждением на подложку.
6. Осаждение с помощью химической реакции из жидкой или газо-вой фазы.
7. Утонение (химическое, электрохимическое, ионное).
Реплики – это слепок с поверхности образца, полученный с помо-щью углеродной пленки. Реплик бывают одноступенчатые, двухступенчатые, оттененные; реплики с экстракцией рис. 6 и 7.
Электролитическая полировка. Она применяется для электропро-водных образцов. Для получения качественного образца первоначально необходимо построить вольт-амперную диаграмму процесса и полиров-ку проводить в режиме «плато» (участок А–Б). Рекомендуется охлаж-дать раствор для лучшего контроля процесса.
Ионное утонение (распыление) Ионы, летящие с энергией 3…6 кэВ, проникают вглубь на несколь-ко нанометров, выбивая один или несколько атомов. Коэффициент рас-пыления зависит от соотношения масс иона и атомов мишени, энергии иона, типа структуры мишени, угла. Коэффициент распыления растет с энергией, но растет и повреждаемость образца.
Для применения всех этих методов необходимо механически под-готовить фольгу толщиной 50…100 мкм. Для этого используют: про-катку (с последующим отжигом), резку алмазным инструментом, шли-фовку и полировку. К сожалению, все механические методы вносят де-фекты, поэтому образец тоньше 50 мкм приготовить нельзя.
В зависимости от состояния образца электронограммы могут быть либо кольцевыми, либо точечными, рис. 48. В соответствии с этим про-водят индицирование полученных электронограмм. Прежде всего, про-меряют радиус (диаметр) получившегося кольца или расстояние от цен-тра электронограммы до какого-либо пятна. Зная постоянную прибора, легко рассчитать межплоскостное расстояние, соответствующее данно-му кольцу или пятну. Как и в случае с индицированием рентгенограмм, его начинают с самой симметричной структуры – кубической. Используют метод от-ношений для определения индексов Миллера.
Растровая электронная микроскопия
Раздел посвящен изучению растровой электронной микроскопии. Здесь даны принцип работы, области применения метода при исследо-вании материалов. Рассмотрен микрорентгеноспектральный анализ ма-териалов. Получение информации об исследуемых объектах с помощью элек-тронного зонда возможно на основе физических явлений, возникающих при взаимодействии электронов с веществом объекта. При взаимодействии электронов с веществом, как показано на рисунке, по-является много вторичных излучений. Падающий электронный пучок может быть поглощен, упруго рассеян, может пройти через вещество, испытав при этом дифракцию, возбудить рентгеновское излучение, вы-звать появление низкоэнергетичных вторичных и Оже-электронов.
Принцип работы РЭМ основан на движении тонкого электронного луча (зонда) вдоль поверхности образца вдоль близко расположенных друг к другу линий, образующих растр. Способ получение изображения во вторичных электронах в РЭМ является наиболее распространенным. Сам процесс формирования изо-бражения в растровом микроскопе подобен процессу формирования оп-тического изображения, видимого в оптическом микроскопе. Это обу-словливает сходство по внешнему виду изображений, полученных в РЭМе, и в оптическом микроскопе. Следует отметить, что световые лу-чи, формирующие изображение, распространяются по прямым линиям, в то время как вторичные электроны могут достигать детектора по искривленным траекториям. Таким образом, для формирования изображе-ния в РЭМе важны не пути электронов к детектору, а только количество электронов, попадающих на детектор от данной точки объекта.
Наряду с прикладным значением Э. м. является самостоятельным научным направлением, предмет и цели которого включают: усовершенствование и разработку новых МЭ и других корпускулярных микроскопов (например, протонного микроскопа) и приставок к ним; разработку методик препарирования образцов, исследуемых в МЭ; изучение механизмов формирования электроннооптических изображений; разработку способов анализа разнообразной информации (не только изображений), получаемой с помощью МЭ.
Объекты исследований в Э. м. — большей частью твёрдые тела. В просвечивающих МЭ (ПЭМ), в которых электроны с энергиями от 1 кэв до 5 Мэв проходят сквозь объект, изучаются образцы в виде тонких плёнок, фольги (рис. 8), срезов и т. п. толщиной от 1 нм до 10 мкм. Поверхностную и приповерхностную структуру массивных тел с толщиной существенно больше 1 мкм исследуют с помощью непросвечивающих МЭ: растровых (РЭМ) (рис. 9), зеркальных, ионных проекторов и электронных проекторов.
Можно изучать порошки, микрокристаллы, частицы аэрозолей и т. д., нанесённые на подложку: тонкую плёнку для исследования в ПЭМ или массивную подложку для исследования в РЭМ. Поверхностная геометрическая структура массивных тел изучается и методом реплик: с поверхности такого тела снимается отпечаток в виде тонкой плёнки углерода, коллодия, формвара и др., повторяющий рельеф поверхности и рассматриваемый в ПЭМ. Обычно предварительно на реплику в вакууме напыляется под скользящим (малым к поверхности) углом слой сильно рассеивающего электроны тяжёлого металла (например, Pt), оттеняющего выступы и впадины геометрического рельефа. При исследовании методом так называемого декорирования не только геометрической структуры поверхностей, но и микрополей, обусловленных наличием дислокаций (рис. 10), скоплений точечных дефектов, ступеней роста кристаллических граней, доменной структуры и т. д., на поверхность образца вначале напыляется очень тонкий слой декорирующих частиц (атомы Au, Pt и др., молекулы полупроводников или диэлектриков), осаждающихся преимущественно на участках сосредоточения микрополей, а затем снимается реплика с включениями декорирующих частиц.
Специальные газовые микрокамеры — приставки к ПЭМ или РЭМ — позволяют изучать жидкие и газообразные объекты, неустойчивые к воздействию высокого вакуума, в том числе влажные биологические препараты. Радиационное воздействие облучающего электронного пучка довольно велико, поэтому при исследовании биологических, полупроводниковых, полимерных и т. п. объектов необходимо тщательно выбирать режим работы МЭ, обеспечивающий минимальную дозу облучения.
Наряду с исследованием статическим, не меняющихся во времени объектов Э. м. даёт возможность изучать различные процессы в динамике их развития: рост плёнок, деформацию кристаллов под действием переменной нагрузки, изменение структуры под влиянием электронного или ионного облучения и т. д. (исследования «in situ»). Вследствие малой инерционности электрона можно исследовать периодические во времени процессы, например перемагничивание тонких магнитных плёнок, переполяризацию сегнетоэлектриков, распространение ультразвуковых волн и т. д., методами стробоскопической Э. м.: электронный пучок «освещает» образец импульсами, синхронными с подачей импульсного напряжения на образец, что обеспечивает фиксацию на экране прибора определенной фазы процесса точно так же, как это происходит в светооптических стробоскопических приборах (рис. 11). Предельное временное разрешение при этом может, в принципе, составлять около 10-15 сек для ПЭМ (практически реализовано разрешение Электронная микроскопия 10-10 сек для ПЭМ и РЭМ).
Для интерпретации изображений аморфных и других тел (размеры частиц которых меньше разрешаемого в МЭ расстояния), рассеивающих электроны диффузно, используются простейшие методы амплитудной Э. м. Например, в ПЭМ контраст изображения, т. е. перепад яркостей изображения соседних участков объекта, в первом приближении пропорционален перепаду толщин этих участков. Для расчёта контраста изображений кристаллических тел (рис. 12), имеющих регулярные структуры (при рассеянии частиц на таких телах происходит дифракция частиц, и решения обратной задачи — расчёта структуры объекта по наблюдаемому изображению — привлекаются методы фазовой Э. м.: решается задача о дифракции электронной волны на кристаллической решетке. При этом дополнительно учитываются неупругие взаимодействия электронов с объектом: рассеяние на плазмах, фононах и т. п. В ПЭМ и растровых ПЭМ (ПРЭМ) высокого разрешения получают изображения отдельных молекул или атомов тяжелых элементов; пользуясь методами фазовой Э. м., восстанавливают по изображениям трехмерную структуру кристаллов и биологических макромолекул. Для решения подобных задач применяют, в частности, методы голографии, а расчеты производят на ЭВМ.
Разновидность фазовой Э. м. — интерференционная Э. м., аналогичная оптической интерферометрии: электронный пучок расщепляется с помощью электронных призм, и в одном из плеч интерферометра устанавливается образец, изменяющий фазу проходящей сквозь него электронной волн. Этим методом можно измерить, например, внутренний электрический потенциал образца.
С помощью лоренцовой Э. м., в которой изучают явления, обусловленные силой Лоренца, исследуют внутренние магнитные и электрические поля или внешние поля рассеяния, например поля магнитных доменов в тонких пленках (рис. 13), сегнетоэлектрических доменов, поля головок для магнитной записи информации и т. п.
Состав объектов исследуется методами микродифракции, т. е. электронографии локальных участков объекта, рентгеновского и катодолюминисцентного спектрального микроанализа: регистрируются характеристические рентгеновские спектры или катодолюминисцентное излучение, возникающее при бомбардировке образца сфокусированным пучком электронов (диаметр электронного «зонда» менее 1 мкм). Кроме того, изучаются энергетические спектры вторичных электронов, выбитых первичным электронным пучком с поверхности или из объема образца.
Интенсивно разрабатываются методы количественной Э. м. — точное измерение различных параметров образца или исследуемого процесса, например измерение локальных электрических потенциалов (рис. 14), магнитных полей (рис. 15), микрогеометрии поверхностного рельефа и т. д. МЭ используются и в технологических целях (например, для изготовления микросхем методом фотолитографии.
Литература.
1. Хокс П., Электронная оптика и электронная микроскопия, пер. с англ., М., 1974;
2. Стоянова И. Г., Анаскин И. Ф., Физические основы методов просвечивающей электронной микроскопии, М., 1972;
3. Утевский Л. М., Дифракционная электронная микроскопия в металловедении, М., 1973; 4. Электронная микроскопия тонких кристаллов, пер. с англ., М., 1968;
5. Спивак Г. В., Сапарин Г. В., Быков М. В., Растровая электронная микроскопия, «Успехи физических наук», 1969, т. 99, в. 4;
6. Вайнштейн Б. К., Восстановление пространственной структуры биологических объектов по электронным микрофотографиям, «Изв. АН СССР. Сер. физическая», 1972, т. 36, № 9;
7. Quantitftive scanning electron microscopy, L. — N. Y. — S. F., 1974.
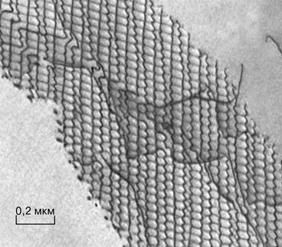
Рис. 8. Полученное в просвечивающем электронном микроскопе изображение сетки дислокаций на границах зёрен в тонкой молибденовой фольге, деформированной при высокотемпературном нагреве.

Рис. 9. Изображение предварительно отполированной, а затем подвергнутой ионной бомбардировке поверхности монокристалла меди. Снято в растровом электронном микроскопе. Увеличение 3000.

Рис. 10. Винтовые дислокации на поверхности кристалла NaCl, подвергнутого термическому травлению при температуре 500 °С. Изображение получено методом декорирования.

Рис. 11. Изображения поверхности кремниевого полупроводникового диода, полученные в стробоскопическом эмиссионном электронном микроскопе: а — напряжение на диоде отсутствует; б — на диод подано запирающее напряжение 40 в, появившаяся тёмная область — падение напряжения на р — n-переходе; в — кратковременное (менее 40 нсек) прямое падение напряжения (широкая тёмная область) на базе диода при переключении его в состояние, при котором он «отперт».

Рис. 12. Изображение атомной решётки плёнки золота. Расстояние между кристаллографическими плоскостями 2,04 Å. Снято в просвечивающем электронном микроскопе ЭМВ-100Л при электроннооптическом увеличении 350000 с последующим оптическим увеличением снимка.

Рис. 13. Изображение доменной структуры тонкой однородной по толщине пермаллоевой плёнки. Снято в просвечивающем электронном микроскопе при дефокусировке изображения (метод лоренцевой электронной микроскопии). Светлые и тёмные узкие полосы — границы доменов. Видна «рябь» намагниченности, возникающая вследствие малых изменений направлений векторов намагниченности (отмечены стрелками) внутри доменов.

Рис. 14. Полученное с помощью растрового электронного микроскопа изображение участка интегральной микросхемы.

Рис. 15. Изображение линий равной напряженности поля (от 25 до 150 гс через 25 гс) над зазором магнитной головки (ширина зазора 2δ = 2 мкм) для магнитной записи информации. Получено в растровом электронном микроскопе со специальной приставкой.
Нейтронография
В этом разделе изучается нейтронография. Приведена сравнитель-ная характеристика метода по отношению к рентгенографии, рассмот-рены различные области применения метода. В настоящее время в связи с развитием реакторостроения начала успешно развиваться новая область науки — нейтронография, исполь-зующая явление дифракции нейтронов на кристаллических веществах. Нейтронография не может полностью заменить рентгеноструктурный анализ, так как уступает последнему по разрешающей способности, но в некоторых случаях позволяет получить данные, которые не могут быть получены с помощью рентгеноструктурного анализа. Взаимодействие нейтронов с веществом имеет следующие особенности: • для движущегося со скоростью V нейтрона его длина волны может быть выражена как: λ = h/mV = h/p = h/ 2mV – длина волны части-цы де Бройля, где V – скорость, p – импульс, E – кинетическая энергия частицы; • λ = 0,287/Е (где Е измерено в электронвольтах, длина волны в ангс-тремах). При взаимодействии потока нейтронов с веществом существует два вида рассеяния: а) Ядерное рассеяние в поле ядерных сил. Оно определяется ампли-тудой рассеяния для ядра с нулевым спином и двумя независимыми ам-плитудами для ядер, обладающих спином (вверх и вниз). б) Магнитное рассеяние. Нейтрон взаимодействует с магнитным моментом атома. Сечение взаимодействия, кроме того, зависит от изотопа.
Взаимодействие нейтронов с веществом имеет следующие особен-ности:
1. Нейтроны мало поглощаются веществами: в тяжелых веществах по-глощение нейтронов в 104 раз меньше, чем рентгеновских лучей. Однако поглощение нейтронов в некоторых веществах, например в В и Cd велико.
2. Рассеяние рентгеновских лучей растет с увеличением атомного номера вещества, интенсивность рассеянных лучей зависит от брэггов-ского угла. Нейтроны практически одинаково рассеиваются под всеми углами Θ, и строгая зависимость рассеяния от атомного номера (фактор Лоренца) отсутствует. Интегральное сечение рассеяния σs свя-зано с амплитудой рассеяния f соотношением: σs = 4πf2. Некоторые легкие вещества рассеивают нейтроны так же эффективно, как и тяже-лые, а иногда обнаруживаются значительные различия в рассеянии со-седними элементами. Часто значительно различается рассеивающая способность изотопов одного и того же элемента. Водород и углерод рассеивают нейтроны почти так же, как и тяжелые элементы.
3. Рассеяние нейтронов вызываются их взаимодействием с ядрами рассеивающего вещества (а не с электронами, как у рентгеновских лу-чей). Однако, если строение электронной оболочки таково, что атом обладает постоянным магнитным моментом (у элементов с недостроенной электронной оболочкой), то вследствие наличия у нейтрона собственно-го магнитного момента будет наблюдаться диполь-дипольное взаимо-действие, которое сравнимо и во многих случаях может даже превосхо-дить взаимодействие нейтрона с ядром. Таким образом, нейтронное рассеяние дает возможность получить сведения о расположении маг-нитных моментов атомов в кристаллах. Эти данные нельзя получить с помощью рентгеноструктурного анализа.
Области применения нейтронографии
С помощью нейтронографии успешно проводят следующие иссле-дования:
1. Изучение кристаллической структуры веществ, содержащих ато-мы легких элементов, наряду с тяжелыми атомами (водорода в гидриде циркония, углерода в аустените и др.), а также структур из легких эле-ментов (льда, гидрида натрия, дейтерида натрия, графита). Такие струк-туры нельзя исследовать с помощью рентгеновских лучей из-за незна-чительного рассеяния их легкими элементами. Нa рентгенограммах ди-фракционные максимумы почти полностью обусловлены рассеянием на тяжелых атомах, тогда как на нейтронограмме они возникают и за счет рассеяния легкими атомами.
2. Исследование упорядочения в системах с близкими атомными номерами. С помощью рентгеновских лучей невозможно изучить, на-пример, систему Fe-Co, так как интенсивность основных (структурных) отражений пропорциональна структурному множителю: Fc2 = 16[fFe + fCо]2 ~ 45000, а интенсивность сверхструктурных линий:
Fcс2 = 16[fFe – fCо]2 ~ 16, т. е. Fc2/ Fcс2 ≈ 2800.
Естественно, что такие слабые сверхструктурные отражения на рентгенограмме зарегистрировать не удается. Так как амплитуды ней-тронного рассеяния для Fe и Со резко различаются: fFe =0,96·1012 см, fСо=0,28·1012 см, отношение Fc2/ Fcс2 ≈ 3,3 небольшое. Следовательно, на нейтронограмме структурные максимумы будут только примерно в три раза интенсивнее сверхструктурных.
3. Определение магнитных структур кристаллических веществ. Это уникальное использование дифракции нейтронов в настоящее время развилось в область науки, называемую магнитной нейтронографией. Нейтроны, благодаря собственному магнитному моменту, могут взаимодействовать с любыми магнитными моментами, локализованны-ми в веществе, и это взаимодействие проявляется на нейтронограммах. Для парамагнитных веществ, в которых атомные магнитные моменты распределены хаотически, рассеяние нейтронов некогерентное (диф-фузное) и зависит от угла рассеяния (интенсивность рассеяния убывает с увеличением угла). Из интенсивности парамагнитного рассеяния ней-тронов можно определить атомный магнитный момент и радиальное распределение электронов в оболочке атома.
Нейтронографическими исследованиями установлены новые типы магнитных структур веществ – антиферромагнетики и ферримагнетики. В антиферромагнетиках магнитные моменты расположены антипарал-лельно, поэтому результирующий магнитный момент такого вещества равен нулю. В другом типе веществ (ферримагнетиках) намагничен-ность первой подрешетки превышает намагниченность второй подре-шетки (нескомпенсированный антиферромагнетизм). Такие вещества называются ферритами. Они обладают большой самопроизвольной на-магниченностью и широко используются в радиотехнике для изготов-ления сердечников катушек индуктивностей.
4. Изучение глубинных слоев материалов. Нейтроны проникают очень глубоко и удается определить предпочтительные ориентации в крупных образцах. С помощью рассеяния нейтронов удается исследо-вать текстуры в крупных образцах. Например, проведен анализ текстур в образце железа толщиной 2,5 см, достаточно прозрачном для нейтро-нов. В отличие от рентгенографического исследования анализ ориента-ции оказался справедливым не только для поверхностного слоя, но и для всего объема образца. Нейтронография успешно используется для различных исследова-ний, и области ее применения постоянно расширяются. В частности, представляет интерес исследование неупругого рассеяния нейтронов. Некоторые работы показывают, что этот эффект позволяет изучить си-ловое взаимодействие между атомами металла и получить численные значения силовых констант.
|
|
|
|
Дата добавления: 2014-01-06; Просмотров: 593; Нарушение авторских прав?; Мы поможем в написании вашей работы!