
КАТЕГОРИИ:
Архитектура-(3434)Астрономия-(809)Биология-(7483)Биотехнологии-(1457)Военное дело-(14632)Высокие технологии-(1363)География-(913)Геология-(1438)Государство-(451)Демография-(1065)Дом-(47672)Журналистика и СМИ-(912)Изобретательство-(14524)Иностранные языки-(4268)Информатика-(17799)Искусство-(1338)История-(13644)Компьютеры-(11121)Косметика-(55)Кулинария-(373)Культура-(8427)Лингвистика-(374)Литература-(1642)Маркетинг-(23702)Математика-(16968)Машиностроение-(1700)Медицина-(12668)Менеджмент-(24684)Механика-(15423)Науковедение-(506)Образование-(11852)Охрана труда-(3308)Педагогика-(5571)Полиграфия-(1312)Политика-(7869)Право-(5454)Приборостроение-(1369)Программирование-(2801)Производство-(97182)Промышленность-(8706)Психология-(18388)Религия-(3217)Связь-(10668)Сельское хозяйство-(299)Социология-(6455)Спорт-(42831)Строительство-(4793)Торговля-(5050)Транспорт-(2929)Туризм-(1568)Физика-(3942)Философия-(17015)Финансы-(26596)Химия-(22929)Экология-(12095)Экономика-(9961)Электроника-(8441)Электротехника-(4623)Энергетика-(12629)Юриспруденция-(1492)Ядерная техника-(1748)
Оптическая литография
|
|
|
|
Оптическая литография получила наиболее широкое распространение ввиду ее широкого использования для изготовления полупроводниковой вычислительной техники. Этот метод основывается на облучении резиста квантами света с длиной волны от 1 до -1000 нм. По энергетическому диапазону используемого излучения оптическая литография условно делится на следующие области:
• литография оптического диапазона (> 400 нм),
• литография УФ-области (UV: 395-436 нм),
• литография глубокого УФ-излучения (Deep UV - DUV: 190-250 нм),
• литография вакуумного УФ-излучения (Vacuum UV - VUV: 150-190 нм),
• литография жесткого ультрафиолета (Extreme UV - EUV: 10-15 нм),
• рентгеновская литография (<10 нм).
Необходимость уменьшения размеров элементов микроэлектроники накладывает ограничение на длину волны используемого излучения. Так, еще недавно широко используемые в производстве микросхем источники на основе ртутных ламп (длина волны 436 нм) сегодня заменены ArF-лазерами (X = 193 нм). Рассматривается возможность промышленного применения синхротронного излучения и снижения длины волны вплоть до нескольких нанометров, что соответствует литографии жесткого ультрафиолета и рентгеновской литографии.
Схема контроля освещенности, проекционная литография
Методы оптической литографии также классифицируют по применяемой схеме контроля освещенности: различают схемы с различным взаимным расположением маски и резиста, а также схемы проецирования с использованием дополнительных оптических систем. Таким образом, выделяют схемы контактной (рис. 2,а), бесконтактной (рис. 2,б) и проекционной (рис. 2,в) литографии.

Рис. 2.
Контактная литография: маска непосредственно контактирует с резистом. Разрешающая способность велика (R=600 нм при λ=400 нм и толщине резиста d=1 мкм).
|
|
|
Бесконтактная литография: между маской и резистом есть зазор h. Разрешающая способность ниже (R=2 мкм при λ=400 нм и толщине резиста d=1 мкм, h=10 мкм).
Проекционная литография: рисунок проектируется на резист с помощью фокусирующей оптической схемы. Достоинства метода – увеличивается срок службы маски в сравнении с контактной схемой и разрешающая способность выше бесконтактной схемы.
Маски микро- и нанолитографии
Простейшие маски, используемые в оптической литографии, представляют собой пластину из непрозрачного для используемого диапазона длин волн материала, в которой «прорезан» прообраз наносимого рисунка, определяющий области подложки, подвергаемые экспонированию. Однако при уменьшении линейных размеров рисунка большую роль начинают играть эффекты рассеяния излучения на границах раздела фаз, что приводит к необходимости учета этих явлений на стадии создания шаблона. Например, для нанесения отображения на резисте в форме квадрата (рис. 3,а), на маске необходимо сформировать дополнительные прорези в его вершинах (рис. 3,б). Однако и в этом случае отображение оказывается несколько "размытым" (рис.3,в). На рис. 3,г и 3,д показано соответствие формы прорезей в маске и отображения на резисте. Видно, что даже применение масок со специальной формой прорези не позволяет достигнуть полного соответствия нанесенного и требуемого рисунков.

Рис. 3.
Фазосдвигающие маски
| LcrJ |
| <г регулятор фазы |
Одним из возможных методов увеличения разрешающей способности оптической литографии является использование фазосдвигающих масок. На рис. 4 показано распределение интенсивности освещения и амплитуды фронта световой волны для масок без фазового сдвига и фазосдвигающей маски. Для обычных масок фронт волны после прохождения двух соседних отверстий маски может быть представлен условным набором амплитуд +1, 0, +1 (рис. 4). Однако ввиду дифракционных эффектов наблюдается рассеяние излучения и "размытие" максимумов. В результате интенсивность светового потока в каждой точке подложки определяется как сумма световых потоков, прошедших через каждую из щелей, и представляет собой систему частично перекрывающихся максимумов. Освещенность точки между соседними щелями зависит от расстояния между ними, толщины маски, расстояния между маской и подложкой, когерентности излучения и т.д. Эти параметры и определяют разрешающую способность системы в целом (т.е. минимальное расстояние между соседними наносимыми элементами).
|
|
|

Рис. 4.
Увеличения разрешающей способности можно добиться с использованием фазосдвигающих масок (рис. 4). Часть щелей таких масок покрывают веществом, сдвигающим фазу волны пропущенного излучения на л. Благодаря этому два потока квантов, прошедшие через соседние щели, находятся в противофазе, а фронт волны выражается условным набором амплитуд+ 1,0,-1. При этом, несмотря на рассеяние излучения, суммарная амплитуда волн, прошедших через соседние отверстия, и, соответственно, интенсивность облучения подложки между соседними максимумами проходит через ноль. Таким образом, использование фазосдвигающих масок позволяет более четко разделить элементы микросхемы, что, в конечном счете, сказывается на разрешающей способности метода и, как следствие, минимальных размерах элементов.
Внеосевая литография
Помимо использования фазосдвигающих масок и уменьшения длины волны излучения разрешающую способность литографических процессов можно увеличить с помощью внеосевого освещения. Этот метод широко известен как способ увеличения контраста в оптических микроскопах. В обычных схемах вследствие дифракции при прохождении щели маски формируется расходящийся пучок, причем только не изменившие направления кванты несут информацию о ее реальной структуре (рис. 5, а). При внеосевом освещении луч проходит не через центр линзы, а под некоторым углом, в результате чего на фокусирующую линзу, расположенную за маской, попадает не весь пучок, а только его часть (рис. 5, 6). Таким образом, «вырезая» часть расходящегося пучка, метод внеосевой литографии позволяет снизить интенсивность рассеяния и «увидеть» более мелкие элементы.
|
|
|
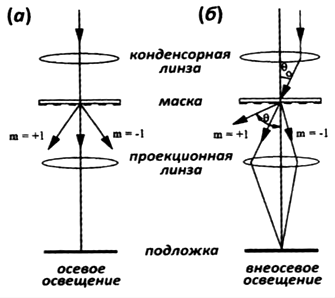
Рис. 5.
Материалы резистов
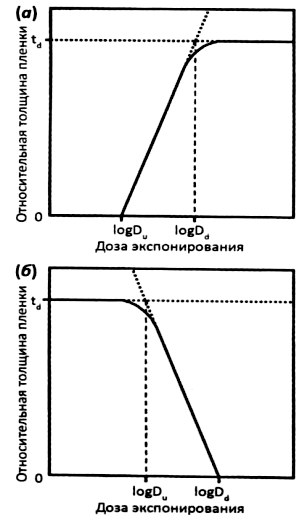 Непременным атрибутом оптической литографии является наличие резиста. В большинстве случаев в качестве резиста выступают полимеры, претерпевающие изменения под действием света. Как упоминалось ранее, в зависимости от реакции на излучение резисты делятся на «позитивные» и «негативные». Любые резисты состоят из трех частей: смолы, которая выступает в качестве связующей компоненты и определяет механические свойства резиста, фотоактивной компоненты и растворителя.
Непременным атрибутом оптической литографии является наличие резиста. В большинстве случаев в качестве резиста выступают полимеры, претерпевающие изменения под действием света. Как упоминалось ранее, в зависимости от реакции на излучение резисты делятся на «позитивные» и «негативные». Любые резисты состоят из трех частей: смолы, которая выступает в качестве связующей компоненты и определяет механические свойства резиста, фотоактивной компоненты и растворителя.
Необходимым условием получения высокого контраста с помощью подбора резиста является резкий скачок растворимости в зависимости от времени/ интенсивности освещения участка. Для «негативного» резиста толщина пленки резиста, оставшейся после ее растворения, зависит от дозы облучения таким образом, что резист полностьюрастворяется при облучении дозой меньшей, чем Du, и остается практически неизменной относительно исходной толщины пленки td при облучении дозой, большей Dd (рис. 6). Для позитивного резиста наблюдается обратная ситуация. Наличие такого скачка растворимости облученного резиста позволяет получать достаточно четкий рельеф поверхности, тогда как в случае линейной зависимости растворимости от дозы облучения наблюдается размытие рельефа поверхности, что сильно понижает разрешающую способность.
Рис. 6.
Для литографии на G- и I-линиях ртути в качестве «позитивного» резиста используется система новолак/диазонафтокинон (novolac/diazonaphthoquinones(DNQ)). Новолак выступает в качестве «смолы», взаимодействующей с водными растворами оснований. DNQ является фотоактивной компонентой и ингибитором растворения. В процессе взаимодействия с квантами света происходит реакция, приводящая к разрушению DNQ и образованию продукта, который растворяется в щелочах более чем в 100 раз быстрее, чем исходная смесь. Это позволяет быстро растворить освещенные части резиста, таким образом формируя рисунок на поверхности подложки. «Негативный» фоторезист обычно содержит бис-арилазид (bys-arylazide) в качестве фотоактивного компонента и полимер, который не подвержен действию света и хорошо растворяется в неполярных растворителях.
|
|
|
При облучении фотоактивный компонент образует радикал, способный вступать в реакцию с полимером и образующий мостики между полимерными цепями, что значительно уменьшает их растворимость. Таким образом, растворяются в первую очередь неосвещенные участки резиста, содержащие неразветвленные и несшитые молекулы.
2. Электронно-лучевая литография (ЭЛЛ)
В качестве фактора, модифицирующего поверхность подложки или резиста, может быть использован поток заряженных частиц - электронов или ионов. Общая схема установок проекционной электронно-лучевой литографии включает источник электронов, электростатические линзы, формирующие нерасходящийся пучок, маску и подложку, свободно перемещаемую в плоскости, перпендикулярной направлению пучка.
Основными преимуществами метода электронно-лучевой литографии является высокая разрешающая способность (-1 нм) и возможность варьировать энергию элементарных частиц в широких пределах. Так, поток электронов может быть легко сфокусирован в пучок с размером "пятна" менее нанометра, а ускоряющее напряжение может достигать сотен кВ. В отличие от оптических методов, использование электронно-лучевой литографии позволяет применять как классическую литографическую схему с использованием масок (проекционная литография), так и непосредственно формировать рисунок направленным электронным пучком (безмасочная литография). Кроме того, ввиду схожести механизмов химической модификации резиста под действием жесткого УФ-излучения и пучка электронов, материалы для оптической литографии могут использоваться в методе ЭЛЛ.
Недостатки метода ЭЛЛ:
• высокая глубина проникновения электронов в облучаемый материал,
• процессы генерации вторичных электронов в объеме резиста, что приводит к размытию экспонированных областей (рис. 7).
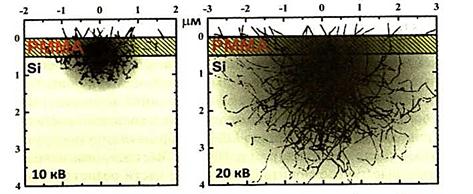
Рис. 7.
3. SCALPEL
Указанные недостатки можно устранить путем применения специальных рассеивающих масок. В этом случае области маски с высокой рассеивающей способностью соответствуют затемненным участкам поверхности, а области, не рассеивающие электронный пучок, - освещенным участкам. Избыточный фон, образованный рассеянными электронами, можно исключить, расположив диафрагму в фокальной плоскости собирающей линзы (рис. 8, а).
Электронная литография с ограничением угла проекции (SCALPEL) – метод применения рассеивающих масок: области маски с высокой R cоответствуют затемненным участкам поверхности, области, не рассеивающие электронный пучок-освещенным участкам. Для исключения избыточного фона, образованного рассеянными электронами, диафрагму располагают в фокальной плоскости собирающей линзы. Принципиальная структура масок для технологии SCALPEL представлена на рис. 8, б.
4. Ионно-лучевая литография (ИЛЛ)
Альтернативой методу ЭЛЛ является ионно-лучевая литография. Несмотря на более сложную схему генерации и фокусировки ионного пучка, а также его меньшую интенсивность, этот метод обладает несомненным преимуществом по сравнению с электронно-лучевой литографией ввиду малой глубины проникновения ионов в резист и практически полного отсутствия генерации вторичных ионов. Поскольку ионный пучок фактически является потоком вещества, то изменяя энергию ионов, можно добиться не только направленной модификации резиста, но и внедрения ионов в приповерхностный слой подложки или создания планарных структур на ее поверхности.
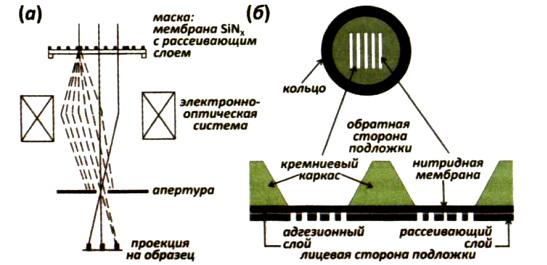
Рис. 8.
Схема проекционной ионно-лучевой литографии полностью аналогична установкам ЭЛЛ. Поскольку глубина проникновения ионов в материал относительно невелика и даже тонкая мембрана способна значительно снизить интенсивность проходящего пучка, необходимым требованием к маскам ИЛЛ является отсутствие вещества в прорезях. Такая структура маски не позволяет получать циклические структуры на поверхности подложки (например, кольцо). Поэтому в большинстве случаев проекционная ионно-лучевая литография требует применения системы масок для каждого фрагмента рисунка.
В настоящее время проекционная ионно-лучевая литография позволяет достигать разрешения до 50 нм. Поскольку такое разрешение не является теоретическим пределом метода, а дальнейшее его увеличение связано в основном со сложностью технической реализации, предполагается, что в ближайшем будущем минимальные размеры получаемых структур будут планомерно уменьшаться. Помимо применения в микроэлектронике (микросхемы, процессоры, модули оперативной памяти) ионно-лучевая литография является перспективным методом для производства устройств хранения информации со сверхвысокой плотностью записи. Уже создан прообраз такого устройства - для получения поверхности с упорядоченным расположением магнитных доменов заданного размера была использована многослойная структура, содержащая кобальт и платину, бомбардировка которой тяжелыми ионами приводила к смешению слоев в экспонированных областях и образованию магнитного сплава CoPt, что позволило контролируемо изменять магнитные свойства подложки.
Другим подходом к формированию заданной структуры на поверхности подложки является непосредственное облучение выбранных областей с использованием сфокусированного пучка ионов.
5. Безмасочная литография (direct writing)
Методы безмасочной литографии представляют особый интерес для создания прототипов микро- и наноустройств и, главное, масок для классической литографии. Эти методы не требуют заранее подготовленного «шаблона», а структура поверхности подложки полностью определяется программой, управляющей процессом модификации поверхности. Специфика метода состоит в последовательном «прорисовывании» каждого элемента, аналогично письму пером по бумаге (отсюда и англ. название метода - «direct writing»). В качестве подобного нанометрового «пера» могут выступать направленные пучки заряженных частиц (электроны или ионы) или зонды атомно-силового микроскопа. Заряженный пучок или зонд АСМ скользит по поверхности образца, оставляя след на резисте, после чего материал подвергается обработке, позволяющей растворить модифицированный резист и получить заданный рельеф поверхности. Использование метода безмасочной литографии предполагает большие затраты времени и наличие сложных установок как для нанесения рисунка на поверхность, так и для управления «пером». Поэтому данная методика не получает широкого распространения для изготовления планарных схем в промышленных масштабах. Тем не менее, она находит широкое применение для решения научно-исследовательских задач.
Методы безмасочной литографии можно условно разделить по типу воздействия на резист:
• воздействие потоком заряженных частиц (электронов или ионов),
• механическое воздействие (зонд атомно-силового микроскопа),
• пространственно ограниченное химическое воздействие (локальное окисление подложек с помощью зонда сканирующей туннельной микроскопии).
6. Воздействие сфокусированным пучком заряженных частиц, FIB-литография
В целом схема литографической установки с применением фокусированных потоков ионов схожа с устройством просвечивающего электронного микроскопа. Заряженные частицы проходят систему фокусирующих линз и попадают на образец. В целях упрощения установки обычно перемещается не пучок, а подложка под ним. Положение образца и его перемещения задаются с предельно возможной точностью (часто с помощью пьезодвигателей). Во избежание влияния внешнего воздействия систему оснащают защитой от вибраций. Для независимого контроля поверхности систему часто оснащают сканирующим микроскопом.
На рис. 9 показаны структуры, полученные литографией с применением сфокусированного электронного (разложение пленки A1F3) и ионного (травление кремния ионами Ga+) пучка.

Рис. 9.
Ионно-лучевая литография оказывается более предпочтительным методом по сравнению с ЭЛЛ из-за меньшего размытия границ освещенной области ивозможности непосредственного использования ионного пучка для направленного переноса вещества от источника к подложке. Литографические установки с использованием сфокусированного ионного пучка позволяют работать в нескольких режимах (нанесение вещества, "допирование" подложки, воздействие на резист, вытравливание подложки быстрыми ионами), которые переключаются путем изменения ускоряющего напряжения.
Одной из сфер применения литографии с использованием направленного ионного пучка является изготовление и исправление дефектов масок для классических литографических процессов. Так как производство масок сопряжено с технологическими трудностями, а также большими временными и финансовыми затратами, незначительные дефекты маски, полученные в ходе ее использования, выгодно исправлять с помощью FIB-литографии (Focused Ion Beam), нежели менять маску полностью. В отличие от других типов воздействия на наноуровне, литография с применением сфокусированного ионного пучка позволяет использовать несколько модифицирующих поверхность методов. Кроме того, установка подобного рода обычно оснащается уникальной системой контроля поверхности, что дает возможность направленно и локально изменять свойства образца. Литография фокусированным ионным пучком часто применяется для создания прототипов наноустройств, наноактюаторов, подвода контактов к единичным углеродным нанотрубкам и т.д. На сегодняшний день максимальная разрешающая способность метода составляет около 8 нм.
7. Механическое воздействие зондом СЗМ
Локальное воздействие на поверхность подложки зондом сканирующего зондового микроскопа можно производить в нескольких режимах: механическая модификация поверхности, перенос материала зонда на образец и перенос материала образца на зонд. Механическое воздействие в свою очередь также подразделяется на 2 группы: статическое (наногравировка) и динамическое (наночеканка). При осуществлении наногравировки с использованием методики обычной контактной силовой микроскопии зонд микроскопа перемещается по поверхности подложки с достаточно большой силой прижима, так что на подложке (резисте) формируется рисунок в виде царапин. Преимуществом метода наногравировки по сравнению с электронно- и ионно-лучевой литографией является простота реализации, а также отсутствие глубокого воздействия на подложку. К недостаткам метода следует отнести возможность случайных торсионных изгибов кантилевера, приводящих к краевым неоднородностям рисунка.
В случае динамической нанолитографии (наночеканки) модификация поверхности происходит за счет формирования углублений на поверхности колеблющимся зондом (полуконтактный метод сканирования). Такой метод нанолитографии свободен от сдвиговых и торсионных искажений и позволяет производить визуализацию сформированного рисунка без серьезного воздействия на поверхность подложки или резиста.
8. Нанооксидирование
Альтернативой непосредственному механическому воздействию зондом СЗМ на подложку или нанесенный резист является модификация поверхности с помощью электрических импульсов. Это становится возможным благодаря приложению разности потенциалов между зондом и проводящей подложкой. В результате такого воздействия, изменяя потенциал, можно направленно менять структуру и химический состав поверхности. Примером подобного воздействия на подложку может служить «рисунок», полученный анодным окислением пленки аморфного титана с помощью СЗМ (рис. 10). На подложке были сформированы полосы диоксида титана шириной -8 нм.

Рис. 10.
Помимо непосредственного изменения химического состава проводящей подложки возможно электрохимическое воздействие кантилевером на материал резиста. Как и в классической литографии, после модификации резист может бытьудален дополнительной химической обработкой (вытравливанием).
| кремний |
Возможность контролируемой химической модификации поверхностных адсорбционных слоев позволяет несколько модифицировать методику эксперимента и получать более сложные и разнообразные наноструктуры Так, если молекулярную пленку углеводорода, химически связанного с поверхностью кремниевой подложки, окислить до образования (СООН)-групп, заменить ионы водорода на катионы металла и провести восстановление, то образующийся металлический слой будет в точности повторять траекторию движения кантилевера (рис. 11).
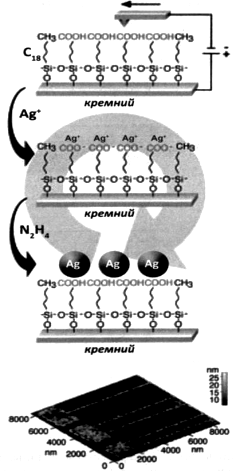
Рис. 11.
|
|
|
|
Дата добавления: 2014-01-07; Просмотров: 3910; Нарушение авторских прав?; Мы поможем в написании вашей работы!