
КАТЕГОРИИ:
Архитектура-(3434)Астрономия-(809)Биология-(7483)Биотехнологии-(1457)Военное дело-(14632)Высокие технологии-(1363)География-(913)Геология-(1438)Государство-(451)Демография-(1065)Дом-(47672)Журналистика и СМИ-(912)Изобретательство-(14524)Иностранные языки-(4268)Информатика-(17799)Искусство-(1338)История-(13644)Компьютеры-(11121)Косметика-(55)Кулинария-(373)Культура-(8427)Лингвистика-(374)Литература-(1642)Маркетинг-(23702)Математика-(16968)Машиностроение-(1700)Медицина-(12668)Менеджмент-(24684)Механика-(15423)Науковедение-(506)Образование-(11852)Охрана труда-(3308)Педагогика-(5571)Полиграфия-(1312)Политика-(7869)Право-(5454)Приборостроение-(1369)Программирование-(2801)Производство-(97182)Промышленность-(8706)Психология-(18388)Религия-(3217)Связь-(10668)Сельское хозяйство-(299)Социология-(6455)Спорт-(42831)Строительство-(4793)Торговля-(5050)Транспорт-(2929)Туризм-(1568)Физика-(3942)Философия-(17015)Финансы-(26596)Химия-(22929)Экология-(12095)Экономика-(9961)Электроника-(8441)Электротехника-(4623)Энергетика-(12629)Юриспруденция-(1492)Ядерная техника-(1748)
Эллипсометрия и ее применение для контроля толщины слоев диэлектрика и полупроводника
|
|
|
|
Метод эллипсометрии предназначен для исследования поверхности и тонких слоев, определения оптических постоянных и толщин поверхностных пленок с резкой границей раздела между пленкой и подложкой.
Развитие эллипсометрии долгое время сдерживалось из-за сложной функциональной связи между измеряемыми величинами и параметрами, которые следовало определить. Современные устройства вычислительной техники сделали эллипсометрию удобным методом исследования поверхности и многослойных структур.
 Метод эллипсометрии основан на анализе состояния поляризации света, отраженного от исследуемого образца.
Метод эллипсометрии основан на анализе состояния поляризации света, отраженного от исследуемого образца.
Пусть падающий свет является линейно-поляризованным с вектором поляризации  (рис.2) и частотой w.
(рис.2) и частотой w.
Представим вектор  в виде векторной суммы двух векторов
в виде векторной суммы двух векторов  и
и  . Вектор
. Вектор  принадлежит плоскости падения луча, вектор
принадлежит плоскости падения луча, вектор  пер-пендикулярен этой плоскости. При линейной поляризации разность фаз между
пер-пендикулярен этой плоскости. При линейной поляризации разность фаз между  и
и  равна нулю. После отражения от образца меняются как фазы, так и амплитуды этих компонент. Сложение двух взаимно перпендикулярных колебаний с разными амплитудами и разностью фаз приводит к образованию эллиптического колебания, при котором конец результирующего вектора
равна нулю. После отражения от образца меняются как фазы, так и амплитуды этих компонент. Сложение двух взаимно перпендикулярных колебаний с разными амплитудами и разностью фаз приводит к образованию эллиптического колебания, при котором конец результирующего вектора  описывает эллипс с круговой частотой w.
описывает эллипс с круговой частотой w.
В самом деле, представим компоненты  и
и  и после отражения в виде
и после отражения в виде
 , (1)
, (1)
 . (2)
. (2)
Исключив временную зависимость в (1) и (2), получим
 , (3)
, (3)
то есть уравнение эллипса, ориентация которого в координатах р и s зависит от сдвига фаз j компонент и
и  . Если
. Если  , соотношение (3) приобретает вид канонического уравнения эллипса
, соотношение (3) приобретает вид канонического уравнения эллипса
 ,
,
а при равенстве амплитуд  =
= соответствует круговой поляризации волны. При
соответствует круговой поляризации волны. При  или
или  (3) описывает колебание с линейной поляризацией.
(3) описывает колебание с линейной поляризацией.
Состояние поляризации полностью определяется двумя параметрами - отношением амплитуд  и
и  , которое обозначают
, которое обозначают  , и разностью фаз
, и разностью фаз  компонент
компонент  и
и  .
.
|
|
|
Запишем выражения для компонент  и
и  . отраженного луча в комплексном виде
. отраженного луча в комплексном виде
 ,
,
 .
.
Тогда
 .
.
Воспользуемся выражениями для коэффициентов отражения Rp и Rs:

 ,
,
 ,
,
где индексы r и i относятся к отраженной и падающей волнам соответственно.
Тогда, обозначив через D разность фаз в падающей i и отраженной r волнах для р и s компонент

и через tg y - отношение их амплитуд

получим:
 (4)
(4)
Уравнение (4) есть основное уравнение эллипсометрии.
Величины y и D зависят от характеристик отражающей поверхности (природы, структуры, качества окружающей среды, наличия поверхностных пленок) и измеряются с помощью эллипсометров.
Если на поверхности образца имеется пленка, то его эллипсометрические параметры изменяются, что связано с многократным отражением света на границах разделов пленка - внешняя среда и пленка - подложка и последующей интерференцией отраженных лучей.
Для структуры, изображенной на рис.2, формула (4) приобретет вид:
 (5)
(5)
где индексы 0, 1, 2 относятся к подложке, пленке и среде соответственно; δ - оптическая разность хода между отраженными лучами.
Уравнение (5) - это уравнение Друде в однослойной модели.
Для оптической разности хода между отраженными лучами δ легко получить выражение
 (6)
(6)
Коэффициенты отражения R в (6) определяются формулами Френеля и являются функциями угла падения луча Q i и коэффициентов преломления N 0, N 1, n 2.
Таким образом, формулу (5) можно представить в виде
 (7)
(7)
Это соотношение устанавливает связь между измеряемыми эллипсометрическими углами y и D и характеристиками исследуемой системы, подлежащими определению. Величины y и D являются периодическими функциями толщины и повторяются через так называемый эллипсометрический период, равный (250 - 300) нм, поэтому порядок величины d должен быть известен.
|
|
|
Поскольку состояние поляризации света характеризуется только параметрами y и D, из измерений можно определить при одном угле падения также два параметра, задав остальные.
Уравнение (7) наиболее часто используется для определения толщины и показателя преломления прозрачной пленки на подложке с известным показателем преломления (классическая задача эллипсометрии). Решение уравнения Друде можно представить в виде номограмм.
Например, на границе двух непоглощающих сред




где индексы i и t относятся к падающему и преломленному лучам соответственно. При преобразовании этих формул использовалось соотношение n 1sinθ i = n 0sinθ t.
Для определения характеристик поверхности материала на границе со средой с показателем преломления n 1 (не поглощающая среда) уравнение (7) приводится к виду
 (8)
(8)
Если известны эллипсометрические параметры поверхности y и D, измеренные при угле падения  , то из (9) можно определить показатель преломления
, то из (9) можно определить показатель преломления
 (9)
(9)
Это единственный случай, когда решение получают в аналитическом виде.
Если измерения проводят на воздухе (n 1=1) и поглощение в образце отсутствует (K 0=0), то  и (9) преобразуется к виду
и (9) преобразуется к виду
 (10)
(10)
Верхние знаки берутся, если Θ i< Θ β, нижние - если Θ i> Θ β, где Θ β - угол Брюстера. При Θ i= Θ β в отраженном свете компонента Ep 0=0, поэтому y =0 и tg y =0. Отсюда n 0=tg Θ β.
Угол Брюстера Θ β – угол полной поляризации естественного света при отражении от поверхности диэлектрика.
Для структур прозрачная пленка-подложка при известных параметрах подложки и среды находят показатель преломления n 1 и толщину пленки d. На рис.4а и 4б представлены номограммы Арчера для структур Si - пленка диэлектрика в диапазоне толщин (0 − 100) нм с шагом в 10 нм, а на рис.4 - в диапазоне толщин (0 ÷ 10) нм с шагом в 2 нм. Угол падения луча, длина волны и показатели преломления подложки и среды фиксированы.
 Рис.4а. Номограммы Арчера (Y - Δ-номограммы) для структур диэлектрическая пленка - кремний в диапазоне толщин пленки (0 ÷ 100) нм
Рис.4а. Номограммы Арчера (Y - Δ-номограммы) для структур диэлектрическая пленка - кремний в диапазоне толщин пленки (0 ÷ 100) нм
|  Рис.4б. Номограммы Арчера (Y - Δ-номограммы) для структур диэлектрическая пленка - кремний в диапазоне толщин пленки (0 ÷ 100) нм
Рис.4б. Номограммы Арчера (Y - Δ-номограммы) для структур диэлектрическая пленка - кремний в диапазоне толщин пленки (0 ÷ 100) нм
|
Точность определения величин d и n 1 во многом зависит от выбора угла падения луча света на образец. На рис.6 представлены зависимости y и D от угла падения для чистого кремния и кремния с пленкой окисла толщиной в 30 нм. Существенное изменение y и D наблюдается для углов θi ~(60 − 70)°.
|
|
|
Если слой является поглощающим, число неизвестных (n 1, k 1, d) превышает число величин y и D, получаемых при одном измерении. Тогда необходимо провести измерения при двух значениях угла падения либо в двух различных средах.
 Для полупроводниковых n-n+-структур в области прозрачности эпитаксиального слоя можно определить толщину эпитаксиального слоя и один из параметров подложки, например, концентрацию носителей заряда, связанную с оптическими константами подложки n 0 и k 0. Расчеты искомых характеристик проводятся с привлечением численных методов на компьютере.
Для полупроводниковых n-n+-структур в области прозрачности эпитаксиального слоя можно определить толщину эпитаксиального слоя и один из параметров подложки, например, концентрацию носителей заряда, связанную с оптическими константами подложки n 0 и k 0. Расчеты искомых характеристик проводятся с привлечением численных методов на компьютере.
При выводе формулы (5) предполагалось, что система состоит из однородных слоев с резкой границей между ними. Экспериментальные исследования подтвердили наличие резкой границы в структуре Si-SiO2, в других же структурах (Ge-GeO2, Ge-SiO2, Ge-GeS) существует переходной слой, в котором показатель преломления является переменной величиной. Аналитическое решение таких задач удается получить только для простейших случаев (например, при линейном изменении n).
Величины tg y и D определяют с помощью эллипсометров. Принципиальная схема метода эллипсометрии представлена на рис.7.
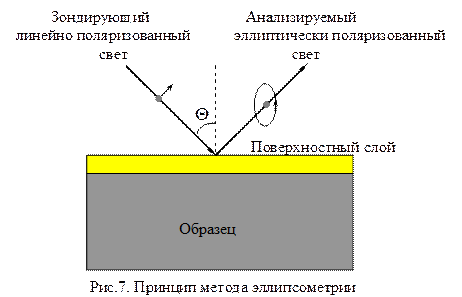
|
|
|
|
Дата добавления: 2014-01-07; Просмотров: 993; Нарушение авторских прав?; Мы поможем в написании вашей работы!