
КАТЕГОРИИ:
Архитектура-(3434)Астрономия-(809)Биология-(7483)Биотехнологии-(1457)Военное дело-(14632)Высокие технологии-(1363)География-(913)Геология-(1438)Государство-(451)Демография-(1065)Дом-(47672)Журналистика и СМИ-(912)Изобретательство-(14524)Иностранные языки-(4268)Информатика-(17799)Искусство-(1338)История-(13644)Компьютеры-(11121)Косметика-(55)Кулинария-(373)Культура-(8427)Лингвистика-(374)Литература-(1642)Маркетинг-(23702)Математика-(16968)Машиностроение-(1700)Медицина-(12668)Менеджмент-(24684)Механика-(15423)Науковедение-(506)Образование-(11852)Охрана труда-(3308)Педагогика-(5571)Полиграфия-(1312)Политика-(7869)Право-(5454)Приборостроение-(1369)Программирование-(2801)Производство-(97182)Промышленность-(8706)Психология-(18388)Религия-(3217)Связь-(10668)Сельское хозяйство-(299)Социология-(6455)Спорт-(42831)Строительство-(4793)Торговля-(5050)Транспорт-(2929)Туризм-(1568)Физика-(3942)Философия-(17015)Финансы-(26596)Химия-(22929)Экология-(12095)Экономика-(9961)Электроника-(8441)Электротехника-(4623)Энергетика-(12629)Юриспруденция-(1492)Ядерная техника-(1748)
Химическое травление потоком нейтральных частиц
|
|
|
|
Резист.
Материалы.
Для реализации реактивного травления необходимо обеспечить появление в ходе плазмохимических реакций на поверхности образование легколетучих компонентов, т.е. веществ с низкой температурой плавления и испарения. Такими свойствами обладают фториды, хлориды и некоторые гидратные формы полупроводниковых соединений. Именно поэтому для реактивного травления используются газообразные соединения F, Cl, Br, иногда I.
Важной материаловедческой проблемой остается сильная химическая активность реактивной плазмы и химических продуктов процесса травления. Особенно это относится к Cl содержащим газам. Их применение предъявляет высокие требования к коррозионной стойкости конструкционных материалов реактора, нанесение различных пассивирующих покрытий и тщательной процедуры очистки реактора и обрабатываемых изделий от остатков процесса травления.
Одной из ключевых проблем субмикронной литографии является низкая стойкость к плазменным процессам существующих резистов. Представляя собой органические полимерные композиции они легко разрушаются в ходе плазменного травления. Кроме того, плазменная обработка сопровождается определенным нагревом обрабатываемой поверхности, что приводит к дополнительной деградации резистивного слоя. При создании структур с высоким отношением высоты линии к ширине толщина резиста не может превышать ширину линии. Это приводит к необходимости использования сложных многослойных резистов, в которых обычные полимерные композиции обеспечивают высокую экспозиционную чувствительность, тогда как другие добавляют необходимую плазмо- и термостойкость. Альтернативный подход заключается в разработке принципиально новых резистов на основе неорганических материалов, которые по своей природе имеют высокую стойкость к плазменным и термическим обработкам.
|
|
|
Одним из наиболее процессов травления является травление потоком химически активных но нейтральных частиц. К таким частицам относятся свободные радикалы и некоторые короткоживущие молекулярные комплексы, которые возникаю в плазме соответствующих газов. СВЧ разряд в реактивном газе возбуждается в кварцевой трубе, помещенной в волновод. За счет разницы давлений в разрядной камере и реакторе плазма распространяется по транспортной трубе в разрядную камеру. Заряженные частицы быстро рекомбинируют, тогда как радикалы достигают обрабатываемой пластины.
Основное применение такого процесса находится в технологических операциях связанных с изотропным но высоко селективным травлением. Например, при удалении резистов, при травлении маски из нитрида кремния на оксиде или поликремнии в LOCOS процессах. При применении этих процессов в комбинации с пассивирующими слоями на боковых стенках линий было достигнуто травление с высокой анизотропией, достаточной для травления структур с высоким отношением высоты к ширине линий.
Двойной «Дамасцен» Процесс
На пластину осаждается изолирующий оксид, в котором вытравливается структура под алюминиевую разводку методами реактивного ионного травления с использованием фоторезистной маски. После травления оксида и снятия резиста, структура заполняется алюминием. Оставшийся алюминий на областях, где структуры не должны оставаться, удаляется методом химико-динамической полировки, и осаждается второй изоляционный слой. С использованием Damascene-процесса, типичные для реактивного ионного травления проблемы, например недостаточная селективность фоторезиста, недостаточный контроль профиля и коррозии, можно избежать. С другой стороны, появляются проблемы с травлением оксида, заполнением узких структур алюминием и полировкой 'мягкого' алюминия.
|
|
|
В методике химико-динамической полировки пластина устанавливается на вращающемся подложкодержателе (рис. 6), который прижимается к вращающемуся столу с полировальником. Благодаря этим двум вращениям, поверхность пластины заземлена. Технология шлифовки химически усиливается суспензией, которая вводится на полировальник. Суспензия состоит из маленьких частиц для улучшения процесса шлифовки и травителя, реагирующего с материалом, который требуется удалить, и не реагирует с нижележащим материалом. Таким образом, возможно избирательное удаление пленок.

Рис. 6. Схема методики CMP.
Типичная последовательность технологических операций - "Двойной Дамасцен Процесс", показана на рис. 7. В первом шаге осаждается ILD оксид (рис. 7a). После литографии контактного окна (рис. 7b), оно травится реактивным ионным травлением оксида (рис. 7с). Удаляется фоторезист (рис. 7d), и проводится вторая литография для формирования рисунка металлических структур (рис. 7e). Металлические структуры вытравливаются в оксиде в фиксированном по времени RIE процессе (рис. 7f). Время травления в комбинации со скоростью травления определяют глубину структур. После удаления фоторезиста (рис. 7g), осаждается алюминий (рис. 7h). В завершении металлические структуры формируются за счет процесса CMP (рис. 7i). Последовательность заканчивается плоской поверхностью после второго осаждения оксида (рис. 7j).
В таблице 1 сравниваются технологические операции для Двойного Дамасцен процесса и последовательности RIE. Двойной Дамасцен процесс имеет на 6 технологических операций меньше чем последовательность RIE. Это приводит к уменьшению стоимости модуля на 13% и уменьшению времени процесса на 18% для 256 М DRAM [13].
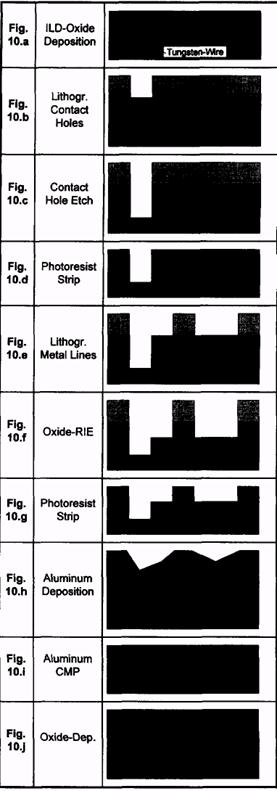
Рис. 7. Последовательность Двойного Дамасцен Процесса.
Таблица 1. Сравнение последовательности RIE и «Dual Damascene».
| RIE процесс | Двойной Damascene процесс | |
| Осаждение оксида (USG) | Осаждение оксида (USG) | |
| Литография контактных окон | Литография контактных окон | |
| Травление контактных окон | Травление контактных окон | |
| Удаление фоторезиста | Удаление фоторезиста | |
| Осаждение Ti/TiN | Литография первого металлического слоя | |
| Осаждение W | Травление оксида для первого металлического слоя | |
| CMP W | Удаление фоторезиста | |
| Осаждение первого металлического слоя | Осаждение алюминия (первый металлический слой) | |
| Литография первого металлического слоя | CMP первого металлического слоя | |
| RIE первого металлического слоя | Осаждение оксида (USG) | |
| Удаление фоторезиста | ||
| Отжиг | ||
| Осаждение оксида (DFSG) | ||
| CMP оксида | ||
| Отжиг | ||
| Осаждение оксида (USG) |
|
|
|
|
|
|
|
Дата добавления: 2014-01-07; Просмотров: 663; Нарушение авторских прав?; Мы поможем в написании вашей работы!