
КАТЕГОРИИ:
Архитектура-(3434)Астрономия-(809)Биология-(7483)Биотехнологии-(1457)Военное дело-(14632)Высокие технологии-(1363)География-(913)Геология-(1438)Государство-(451)Демография-(1065)Дом-(47672)Журналистика и СМИ-(912)Изобретательство-(14524)Иностранные языки-(4268)Информатика-(17799)Искусство-(1338)История-(13644)Компьютеры-(11121)Косметика-(55)Кулинария-(373)Культура-(8427)Лингвистика-(374)Литература-(1642)Маркетинг-(23702)Математика-(16968)Машиностроение-(1700)Медицина-(12668)Менеджмент-(24684)Механика-(15423)Науковедение-(506)Образование-(11852)Охрана труда-(3308)Педагогика-(5571)Полиграфия-(1312)Политика-(7869)Право-(5454)Приборостроение-(1369)Программирование-(2801)Производство-(97182)Промышленность-(8706)Психология-(18388)Религия-(3217)Связь-(10668)Сельское хозяйство-(299)Социология-(6455)Спорт-(42831)Строительство-(4793)Торговля-(5050)Транспорт-(2929)Туризм-(1568)Физика-(3942)Философия-(17015)Финансы-(26596)Химия-(22929)Экология-(12095)Экономика-(9961)Электроника-(8441)Электротехника-(4623)Энергетика-(12629)Юриспруденция-(1492)Ядерная техника-(1748)
Многослойные резисты
Существует различные причины применения сложных многослойных композиций в литографическом процессе. В большинстве случаев эти приложения помогают увеличить разрешение процесса. Часто перед нанесением фоточувствительного резистивного слоя на подложку наносится тем или иным способом специальное антиотражающее покрытие (рис. 8). Этот дополнительный слой выполняет различные функции. В первую очередь его можно рассматривать как дополнительный планаризирующий слой, который сглаживает сложную топологию уже организованного на поверхности пластины рельефа. Кроме того, он поглощает отраженные от поверхности подложки обратно рассеянные лучи, которые могут существенно исказить получаемую картину. Высокочувствительный слой верхнего резиста может иметь малую толщину, что положительно влияет на допустимую глубину фокуса процесса. Обычно в качестве АОП используются различные низкочувствительные органические композиции. Они должны пропускать свет в том же спектральном диапазоне, что и резист, обладать хорошей адгезией к подложке и резисту и проявляться и удаляться тем же процессом, что и резист.

Рис. 8. Применение двухслойного резиста с антиотражающим покрытием (АОП).
Схемы применения многослойных резистов могут быть сложными и дорогостоящими. В качестве примера рассмотрим процесс, который может быть назван литографией с двухслойным резистом различной полярности. Он приведен на рис. 9. На первом этапе на подложку с ранее организованным сложным рельефом наносится толстый слой положительного резита. Его толщина выбирается из условия достижения максимальной планаризации поверхности пластины. Затем наносится тонкий слой резиста другой полярности. Его толщина выбирается из условия получения оптимальной глубины фокуса и достижения наивысшего разрешения для данной оптической системы. После экспонирования и проявления тонкого верхнего резистивного слоя он играет роль маски при глубоком экспонировании толстого нижележащего резиста.

Рис. 9. Схемы литографического процесса с двойным резистом разной полярности.

Рис. 10. «Lift –off» процесс, основанный на применении двухслойного резиста.
Существует много вариантов использования двухслойного резиста. Один из них получил название «lift-off» процесс и часто используется для получения металлических линий нанометрового масштаба. Он приведен на рис. 10.
Применение сложных оптических систем, новых источников экспонирования (F2), многослойных резистов позволяет рассчитывать, что существующие литографические процессы, основанные на применении глубокого ультрафиолета, позволят перешагнуть 100 нм рубеж. Существующее состояние может быть продемонстрировано рис. 11.
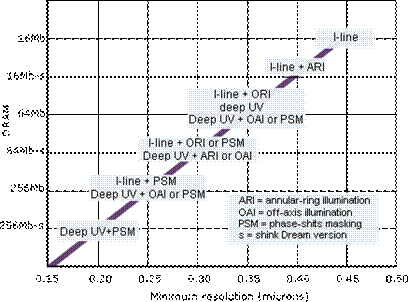
Рис. 11. Тенденции в развитии литографического процесса с субмикронным разрешением.
Для получения структур с разрешением ниже 100 нм становится обоснованным использование принципильно новых способов экспонирования. Принимая во внимание необходимость разработки высокопроизводительных литографических систем можно выделить следующие 4 основные направления: предельный или экстремальный ультрафиолет, электронная проекционная литография (SCALPEL), рентгеновская литография, ионная литография.
|
Дата добавления: 2014-01-20; Просмотров: 1232; Нарушение авторских прав?; Мы поможем в написании вашей работы!