
КАТЕГОРИИ:
Архитектура-(3434)Астрономия-(809)Биология-(7483)Биотехнологии-(1457)Военное дело-(14632)Высокие технологии-(1363)География-(913)Геология-(1438)Государство-(451)Демография-(1065)Дом-(47672)Журналистика и СМИ-(912)Изобретательство-(14524)Иностранные языки-(4268)Информатика-(17799)Искусство-(1338)История-(13644)Компьютеры-(11121)Косметика-(55)Кулинария-(373)Культура-(8427)Лингвистика-(374)Литература-(1642)Маркетинг-(23702)Математика-(16968)Машиностроение-(1700)Медицина-(12668)Менеджмент-(24684)Механика-(15423)Науковедение-(506)Образование-(11852)Охрана труда-(3308)Педагогика-(5571)Полиграфия-(1312)Политика-(7869)Право-(5454)Приборостроение-(1369)Программирование-(2801)Производство-(97182)Промышленность-(8706)Психология-(18388)Религия-(3217)Связь-(10668)Сельское хозяйство-(299)Социология-(6455)Спорт-(42831)Строительство-(4793)Торговля-(5050)Транспорт-(2929)Туризм-(1568)Физика-(3942)Философия-(17015)Финансы-(26596)Химия-(22929)Экология-(12095)Экономика-(9961)Электроника-(8441)Электротехника-(4623)Энергетика-(12629)Юриспруденция-(1492)Ядерная техника-(1748)
Нанолитография
|
|
|
|
Литографией в микроэлектронике называют различные методы микрогравировки диэлектрических, металлических и полупроводниковых слоев, используемых при изготовлении интегральных микросхем (ИМС).основным методом в технологии ИМС в настоящее время является фотолитография - фотохимический метод микрогравировки. Кроме оптической литографии используются рентгенолитография, электронолитография и ионолитография. Это лучевые и пучковые методы литографии.
Оптическая проекционная литография: изображение фотошаблона (маски) проектируются на поверхность фоторезиста с помощью специальной оптической системы.см рис218 с+
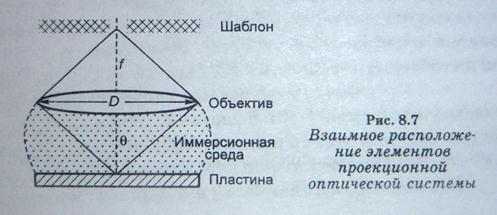
Рис Взаимное расположение элементов проекционной системы.
Разрешающая способность. Разрешающая способность метода фотолитографии называется число линий одинаковой ширины
одинаковой ширины  разделенных промежутками той же ширины, которое можно получить на 1 мм поверхности резиста
разделенных промежутками той же ширины, которое можно получить на 1 мм поверхности резиста

На практике под разрешающей способность подразумевается характеристика  .
.
Фотолитография имеет физический предел разрешающей способности. Определяемый для проекционной системы дифракционным критерием Рэлея (изображение двух близко расположенных точек видны раздельно)

Где  для УФ –излучения,
для УФ –излучения,  -длина волны излучения
-длина волны излучения  -показатель преломления,
-показатель преломления, -половина апертурного угла выхода,
-половина апертурного угла выхода, - числовая апертура.
- числовая апертура.
Проекционная система работает с уменьшением рисунка шаблона (обычно4:1).см рис218+
При данной длине волны можно отобразить детали на поверхности фоторезиста размером до половины длины волны. До 2003 гв фотолитографии применялась длина волны  излучения фторкриптоного
излучения фторкриптоного  -эксимерного (активная среда –молекулы галогены инертных газов) лазера, чему соответствует
-эксимерного (активная среда –молекулы галогены инертных газов) лазера, чему соответствует  .
.
Нанолитография в дальнем экстремальном вакуумном ультрафиолете(ЭУФ). Излучение (ЭУФ)лежит в диапазоне 10-50 нм, и граничит с мягким рентгеном 0,5-10 нм.
Эта нанолитография предназначена для изготовления микропроцессорных интегральных микросхем сверхвысокого уровня интеграции до 108-1010 элементов на кристалле.
Принцип действия ЭУФ –нанолитографа. Пошаговое экспонирование чипов при помощи проекционной отражательной оптической системы с последующим сканированием. схема на рис223с+.

Рис Принципиальная схема ЭУФ-нанолитографа
Устройство состоит из четырех главных блоков.
1.Источник УФ излучения -50-100 микронное облачко вещества мишени (источник6).в плазменном состоянии при температуре 106К ионизированное до 10-20 крат. Плазма создается импульсным лазерным излучением 1 при его взаимодействии с мишенью. используют излучение ксенона  .
.
2.Узел маски.3.Поверхность шаблона - плоское зеркало с бреговским покрытием. На его поверхности наносится поглощающий слой вольфрама, таллия, хрома  , в котором гравируется увеличенный рисунок ИМС.
, в котором гравируется увеличенный рисунок ИМС.
3.оптическая система состоит из конденсора2, объектива4, Конденсор направляет излучение на шаблон3.Объектив переносит уменьшенное изображение рисунка маски шаблона на поверхность пластины5, покрытой резистом. Зеркала конденсора и объектива имеют расчетную кривизну и бреговские покрытия, состоящие из нескольких десятков чередующихся слоев молибдена и кремния толщиной  .покрытия обеспечивают высокий коэффициент отражения, максимум которого достигается при длине волны 13.4 нм.
.покрытия обеспечивают высокий коэффициент отражения, максимум которого достигается при длине волны 13.4 нм.
8-зеркальный промышленный ЭУФ-литограф сможет обеспечить апертуру  и разрешение
и разрешение  .
.
4.образец с нанесенным резистом 5 на рис223. Здесь необходимы специальные резисты с высоким контрастом и чувствительностью. Например, кремний - водородные (силановые) полимеры, неорганические резист селенид мышьяка. .
.
|
|
|
|
Дата добавления: 2013-12-12; Просмотров: 876; Нарушение авторских прав?; Мы поможем в написании вашей работы!