
КАТЕГОРИИ:
Архитектура-(3434)Астрономия-(809)Биология-(7483)Биотехнологии-(1457)Военное дело-(14632)Высокие технологии-(1363)География-(913)Геология-(1438)Государство-(451)Демография-(1065)Дом-(47672)Журналистика и СМИ-(912)Изобретательство-(14524)Иностранные языки-(4268)Информатика-(17799)Искусство-(1338)История-(13644)Компьютеры-(11121)Косметика-(55)Кулинария-(373)Культура-(8427)Лингвистика-(374)Литература-(1642)Маркетинг-(23702)Математика-(16968)Машиностроение-(1700)Медицина-(12668)Менеджмент-(24684)Механика-(15423)Науковедение-(506)Образование-(11852)Охрана труда-(3308)Педагогика-(5571)Полиграфия-(1312)Политика-(7869)Право-(5454)Приборостроение-(1369)Программирование-(2801)Производство-(97182)Промышленность-(8706)Психология-(18388)Религия-(3217)Связь-(10668)Сельское хозяйство-(299)Социология-(6455)Спорт-(42831)Строительство-(4793)Торговля-(5050)Транспорт-(2929)Туризм-(1568)Физика-(3942)Философия-(17015)Финансы-(26596)Химия-(22929)Экология-(12095)Экономика-(9961)Электроника-(8441)Электротехника-(4623)Энергетика-(12629)Юриспруденция-(1492)Ядерная техника-(1748)
Современная теория зародышеобразования в адсорбированной фазе при физическом осаждении паров. 1 страница
|
|
|
|
Критическое разделение фаз (фазовые переходы 2-го рода).
Статистическая теория зарождения новой фазы.
Теоретические оценки зародышеобразования новой фазы показывают, что при низкой температуре конденсации (сильном переохлаждении) критический размер зародыша может составлять величину rк =(5…10).10-10 м, т.е. иметь размеры нескольких атомов. При этом присоединение следующего атома должно сопровождаться дискретным изменением ΔG(r), тогда как термодинамическая теория предполагает непрерывное изменение как поверхностной, так и объемной свободной энергии зародышей. Следовательно, для описания частиц малого размера это условие не выполняется. По этой причине более строгой и универсальной является статистическая теория зародыше- или кластерообразования. В этой теории, исходя из параметров межатомного взаимодействия отдельных атомов, особенностей их поведения определяются вероятности роста и распада кластеров. Однако статистическая теория очень сложна и позволяет сравнительно просто рассчитывать кластеры, состоящие только из 6 атомов.
При большом углублении в метастабильную область и невозможности фазового разделения по нуклеационному механизму (фазового перехода 1-го рода) вследствие кинетических или стерических (геометрических пространственных) ограничений система может потерять устойчивость к флуктуациям плотности любых размеров и претерпевать критический распад. Такой распад обусловлен термодинамической выгодностью роста флуктуаций любых размеров и характерен как для конденсации переохлажденного пара в критической точке, так и фазового распада переохлажденных жидкостей – их стеклования, обусловленного критическим ростом твердоподобных флуктуаций, и спинодального распада бинарных растворов.
|
|
|
На Рис. 2.10 схематически показаны изотермы реального газа в координатах p-V, рассчитанные по уравнению Ван-дер-Ваальса, с критической температурой Тс, выше которой пар невозможно перевести в жидкость, т.е. сконденсировать. При Т < Тс кривая, образуемая точками

Рис. 2.10. Схематическое изображение изотерм реального газа в координатах p-V, рассчитанных по уравнению Ван-дер-Ваальса.
сосуществования фаз жидкости и пара, называется кривой сосуществования, или бинодалью, а кривая, которая образуется точками, соответствующими потере устойчивости сосуществующих фаз и ограничивает внутри себя нестабильную область, называется спинодалью. Пунктирные линии, соединяющие точки сосуществования фаз на одной и той же изотерме, называются коннодами. Область между бинодалью и спинодалью соответствует метастабильным состояниям перегретой жидкости или пересыщенного пара. Критическая точка Тс расположена на границе между стабильной и нестабильной области, т.е. в ней касаются бинодаль и спинодаль. Так как критическая точка определяется по совпадению параметров сосуществующих фаз, то она является точкой перегиба изотермы с горизонтальной касательной и в координатах p-V описывается двумя дифференциальными уравнениями:  и
и  (2.86).
(2.86).
В соответствие с этой теорией при осаждении пара на твердой поверхности зародышеобразование адсорбированной фазы, т.е. формирование устойчиво растущих ее частиц происходит при некоторых относительно высоких значениях плотности адсорбционного слоя. В общем случае возможны два основных механизма образования таких частиц (зародышей):
Первый классический механизм гомогенного зародышеобразования заключается в образовании зародышей вследствие флуктуаций плотности адсорбированных атомов. При этом образование устойчивых частиц (островков новой фазы) на поверхности, как и в объемной теории, происходит в результате случайного взаимодействия атомов между собой, приводящего к возникновению достаточно больших по размеру и устойчивых при данных условиях ассоциатов.
|
|
|
Второй основной механизм заключается в зародышеобразовании на дефектах - участках поверхности с более высоким потенциалом взаимодействия. Закрепленные на поверхностном дефекте атомы последовательно присоединяют к себе диффундирующие частицы, и в результате формируется система стабильных ассоциатов, плотность которых и их поверхностное распределение коррелирует с параметрами поверхностной дефектности.
Считается, что зародышеобразование вследствие флуктуации плотности адсорбированных атомов наиболее вероятно при осаждении на поверхность, имеющую низкую температуру. При высокой температуре поверхности и относительно низкой плотности потока поступающих на поверхность атомов зародышеобразование проявляется преимущественно на дефектах. При определенных условиях и режимах процесса осаждения первый и второй механизмы могут протекать одновременно.
Зародышеобразование по флуктуационному механизму происходит тогда, когда на поверхности подложки образуется адсорбционная фаза с плотностью, превышающей критическую:  . При этом флуктуация плотности:
. При этом флуктуация плотности:  а ~
а ~  а, а критическая плотность адсорбированных атомов зависит от природы материала подложки и ее температуры и связана с кинетикой адсорбции потока пара, падающего на подложку. При больших временах осаждения, когда на поверхности образуется равновесная плотность адсорбированных атомов, условие зародышеобразования имеет вид:
а, а критическая плотность адсорбированных атомов зависит от природы материала подложки и ее температуры и связана с кинетикой адсорбции потока пара, падающего на подложку. При больших временах осаждения, когда на поверхности образуется равновесная плотность адсорбированных атомов, условие зародышеобразования имеет вид:  , где j - плотность потока атомов, ат./(м2с), tа=tоexp(Eа/kT) – время жизни в адсорбированном состоянии, tо =10-13…10-12с; Eа – энергия связи с поверхностью; k – постоянная Больцмана (см. выше раздел 2.1.2. Адсорбция). Тогда плотность потока, при которой протекает процесс зародышеобразования, может быть получена из условия:
, где j - плотность потока атомов, ат./(м2с), tа=tоexp(Eа/kT) – время жизни в адсорбированном состоянии, tо =10-13…10-12с; Eа – энергия связи с поверхностью; k – постоянная Больцмана (см. выше раздел 2.1.2. Адсорбция). Тогда плотность потока, при которой протекает процесс зародышеобразования, может быть получена из условия:  Данное условие графически представлено на рисунке 2.11а как область выше кривой в координатах режима осаждения плотность потока – температура.
Данное условие графически представлено на рисунке 2.11а как область выше кривой в координатах режима осаждения плотность потока – температура.

Рисунок 2.11а. Область режимов осаждения, при которых возможно зародышеобразование и, соответственно, конденсация пара.
|
|
|
Анализ этих соотношений по отношению к плотности потока падающих частиц при заданной температуре показывает, что:
 1) существуют некоторые пороговые значения плотности потока падающих частиц jк, ниже которых зарождение конденсированной фазы не происходит;
1) существуют некоторые пороговые значения плотности потока падающих частиц jк, ниже которых зарождение конденсированной фазы не происходит;
2) пороговое значение jк зависит от температуры: при понижении температуры поверхности подложки пороговое значение jк уменьшается.
Аналогичные выводы можно сделать по отношению к температуре при заданной плотности потока. Максимальное значение температуры Tк, при которой происходит конденсация, получило название критической температуры или температуры Кнудсена. Значение Tк зависит, в основном, от природы и плотности падающих частиц, а также от состояния поверхности подложки. Наличие в падающем на поверхность потоке или в адсорбированном слое атомных ассоциатов (кластеров из нескольких атомов) способствует процессам зародышеобразования, т. к. при этом увеличивается время жизни в адсорбированном состоянии τа и снижается вероятность перехода частиц в газовую фазу.
В процессе дальнейшего осаждения атомов происходит рост  образовавшихся зародышей. Присоединение атомов к зародышам осуществляется двумя способами:
образовавшихся зародышей. Присоединение атомов к зародышам осуществляется двумя способами:
1) Непосредственный захват атомов из газовой фазы. Данный перенос не является определяющим на начальных стадиях осаждения, когда размер зародыша мал. Он доминирует на поздних стадиях роста островковой пленки. Доля атомов, присоединяемых к зародышу таким путем равна: α =(NзSr)-1,где Sr~πR23 –средняя площадь отдельного зародыша; R3 – радиус зародыша; N-плотность зародышей. Осажденные на поверхности атомы в условиях проявления сильной связи их с поверхностью формируют купол частицы, определяют ее внешнюю форму (сферическую, эллипсовидную, пирамидальную или какую-то другую).
2) Захват зародышем диффундирующих по поверхности подложки адсорбированных атомов. Зародыши являются стоком диффундирующих атомов. Вокруг зародыша образуется зона с градиентом плотности адсорбированных атомов (Рис. 2.11б), который и определяет направление и плотность потока диффузии. Ширина градиентной зоны соизмерима с длиной диффузионного пробега адатомов.
|
|
|

Рисунок 2.11б. Зависимость плотности атомов от расстояния до центра зародыша
Для характеристики процесса осаждения используется зона захвата зародыша А(t,Rз) – эффективный участок площади поверхности, при попадании на который атом неизбежно конденсируется, т.е. захватывается зародышем. С учетом возможности одновременного роста зародышей по двум рассмотренным выше механизмам эффективная площадь зоны захвата приближенно может быть оценена с помощью выражения: 
 .
.
Для характеристики кинетики процесса осаждения атомов вводится коэффициент конденсации. Различают:
· мгновенный коэффициент конденсации:  ;
;  ;
; 
где  - плотность потока атомов, присоединенных к растущим зародышам в данный момент времени за дифференциально малый его промежуток;
- плотность потока атомов, присоединенных к растущим зародышам в данный момент времени за дифференциально малый его промежуток;  - плотность потока атомов, реиспаренных в газовую фазу с поверхности;
- плотность потока атомов, реиспаренных в газовую фазу с поверхности;
· интегральный коэффициент конденсации:  ,
,
где N, Nк – число атомов, поступивших на поверхность и претерпевших конденсацию на поверхности в течение времени t соответственно.
В общем случае значение  зависит от плотности зародышей и средней площади их зоны захвата:
зависит от плотности зародышей и средней площади их зоны захвата:  , где
, где  – коэффициент, который учитывает перекрытие зон захвата.
– коэффициент, который учитывает перекрытие зон захвата.
Как правило, на поверхности неорганических материалов зародыши образуются мгновенно, и их плотность в процессе роста меняется незначительно. При осаждении же на поверхность полимерных материалов вследствие подвижности адсорбционно-активных групп в поверхностном слое полимера плотность зародышей, как правило, возрастает в процессе осаждения. Характер изменения плотности зародышей в процессе вакуумной металлизации полимеров сказывается на зависимости коэффициента конденсации от температуры поверхности подложки. Отметим, что для неорганических материалов коэффициент конденсации при нагревании подложки монотонно уменьшается вследствие возрастания вероятности реиспарения адатомов.
При осаждении атомов металла на поверхности неполярных полимеров при T>Tс (Tс –температура стеклования полимера) вследствие сегментальной подвижности макромолекул на поверхности возрастает плотность активных центров, имеющих высокий потенциал взаимодействия и способных выполнять роль стоков адсорбированных атомов. Как следствие этого, при нагревании полимера имеет место возрастание коэффициента конденсации. При Т>Тmax преобладающим становится процесс термической активации процесса реиспарения, и в результате наблюдается снижение К. При достаточно высокой температуре полимера, когда происходит его плавление (Т >Тпл), резко возрастает адсорбционная активность поверхности, имеет место диффузия адатомов в объем подложки и наблюдается повышение коэффициента конденсации.
Кинетика конденсации атомов металла в условиях непрерывной генерации зародышей на поверхности полимеров, может быть описана в рамках релаксационно-диффузионной теории конденсации. В соответствии с представлениями данной теории полимер рассматривается как система связанных между собой макромолекул, движение кинетических элементов и сложный химический состав которых порождают неоднородность адсорбционных свойств поверхности, их изменение во времени. Особый интерес представляет выход на поверхность участков макромолекул, которые обладают высокой активностью и способны при взаимодействии с адатомами металла образовывать достаточно стабильные комплексы. Эти комплексы можно рассматривать как потенциальные центры зародышеобразования конденсированной фазы. Основное уравнение релаксационно-диффузионной теории конденсации:  где
где  – плотность зародышей в начальный момент времени (
– плотность зародышей в начальный момент времени ( );
);  – площадь средней зоны захвата зародыша в момент времени t;
– площадь средней зоны захвата зародыша в момент времени t;  –площадь зоны захвата зародыша, образовавшегося через время
–площадь зоны захвата зародыша, образовавшегося через время  , отсчитанное от начала процесса осаждения и находящегося на поверхности время
, отсчитанное от начала процесса осаждения и находящегося на поверхности время  .
.
Таким образом, первое слагаемое релаксационного уравнения определяет эффективную (суммарную) зону захвата зародышей, образовавшихся в начальный момент времени, второе слагаемое описывает вклад в коэффициент конденсации процессов присоединения атомов к зародышам, которые образовались в процессе осаждения.
Приведенное выше релаксационное уравнение описывает изменение коэффициента конденсации в процессе осаждения и его зависимость от температуры поверхности подложки, плотности потока падающих на нее атомов.
В рамках релаксационно-диффузионной теории конденсации дано объяснение наблюдаемых при металлизации полимеров эффектов: селективное осаждение металлического покрытия на аморфных участках поверхности; влияние механических напряжений в поверхностных слоях на коэффициент конденсации; явление передачи через тонкие полимерные слои адсорбционной активности подложки и др.
2.3. Формирование сплошного слоя или покрытия в результате взаимодействия зародышей между собой, их срастание (коалесценция, созревание Освальда)и дальнейший рост слоя или покрытия.
Коалесценция является одной из основных стадий роста пленки. Она протекает после того, как на поверхности образуются частицы конденсированной фазы, плотность и степень заполнения поверхности которых достигают критических значений. Островки конденсата по мере их роста вступают в контакт друг с другом и, в итоге, образуют непрерывную пространственную сетку, закономерности формирования которой описывается теорией перколяции и геометрии фракталов. На более глубоких стадиях слияние островков приводит к формированию сплошного (монолитного) слоя или покрытия.
Процесс слияния островковых структур вначале протекает очень быстро, а затем после возникновения непрерывной пространственной сетки существенно замедляется. В процессе взаимодействия таких структур при достаточно высоких температурах возможно их перемещение по поверхности. В этом случае на поверхности образуются участки, свободные от конденсированной фазы и на которых возможно протекание процессов вторичного зародышеобразования. На стадии коалесценции, в зависимости от условий осаждения и природы материалов покрытия и подложки, размер частиц составляет 50…500 Å.
Предполагается, что процесс коалесценции при достаточно высокой температуре подложки подобен процессу слияния двух капель жидкости. Слияние жидкоподобных островков происходит быстро, и уже за время t=0,1 с образуется большая частица. В этом случае процесс коалесценции происходит, в основном, в результате протекания процессов объемной диффузии. Данный процесс является энергетически выгодными, т.к.  , где
, где  и
и  –свободная энергия Гиббса первого и второго островков; ∆G∑– свободная энергия Гиббса образовавшейся крупной частицы.
–свободная энергия Гиббса первого и второго островков; ∆G∑– свободная энергия Гиббса образовавшейся крупной частицы.
Стадия коалесценции может наблюдаться и при взаимодействии кристаллических микрочастиц. В этом случае основным механизмом массопереноса является поверхностная диффузия. Для кристаллических пленок стадия коалесценции является очень важной, т.к. она определяет дисперсность покрытия, характер распределения и плотность дефектов, структуру межкристаллитных зон.
В общем случае кинетика слияния островков может быть описана эмпирическим уравнением  где x – радиус зоны контакта (Рис. 2.12), n, m – характеристики коалесценции, зависящие от механизма слияния (если основной механизм слияния – объемная диффузия, то n=5; m=2, если же основной механизм переноса массы – поверхностная диффузия, то n=7; m=3); A(t) – кинетическая функция, зависящая от температуры поверхности и физических констант материалов покрытия и подложки.
где x – радиус зоны контакта (Рис. 2.12), n, m – характеристики коалесценции, зависящие от механизма слияния (если основной механизм слияния – объемная диффузия, то n=5; m=2, если же основной механизм переноса массы – поверхностная диффузия, то n=7; m=3); A(t) – кинетическая функция, зависящая от температуры поверхности и физических констант материалов покрытия и подложки.

Рисунок 1.12 – Схема контакта двух частиц при коалесценции
Cчитается, что на начальной стадии рост шейки происходят, в основном, в результате переноса уже осажденного материала, а на поздних стадиях слияние обусловлено преимущественным осаждением вновь поступающих атомов на участки с повышенной кривизной.
В ряде случаев, например, при осаждении покрытия из ионизированных потоков на диэлектрические подложки существенное влияние на коалесценцию оказывают электростатические взаимодействия, и эффективным технологическим приемом ее регулирования является создание внешнего электрического поля.
После формирования монолитного слоя или покрытия дальнейший его рост происходит за счет адсорбции и конденсации пара.
2. Процессы химического осаждения из газовой фазы (СVD).
Химическое газофазное нанесение покрытий или осаждения слоев осуществляется путем адсорбции одного или нескольких летучих реакционноспосбных соединений (прекурсоров) на нагретой поверхности подложки, где они вступают в реакции между собой или разлагаются, образуя твердые высокочистые пленки с заданными свойствами. При этом часто образуются побочные летучие продукты, которые удаляются потоком газа, выходящим из реакционной камеры (Рис.2.13). Основой метода химического осаждения служат гетерогенные химические реакции в парогазовой среде вблизи поверхности подложки, в результате которых образуются требуемые материалы. Исходные соединения находятся в газообразном состоянии и смешаны с инертным газом-носителем.
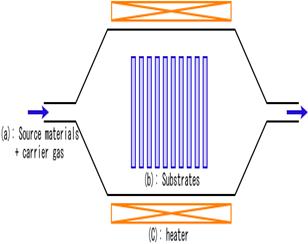

Рис.2.13. Схемы реакционных камердля химического осаждения из газовой фазы с горячими стенками и массовой загрузкой подложек (а) (Souce materials +carrier gas –прекурсор +газ-носитель; Substrates - подложки; Heater - нагреватель) и стимулированного плазмой химического осаждения (б) (electrodes - электроды; substrate – подложка; to pump - к насосу; source gas +carrier gas – газ-прекурсор +газ-носитель).
Благодаря высокой интенсивности процессов массопереноса, присущих газообразным средам, метод химического осаждения обладает исключительной "кроющей" способностью. Возможность обеспечивать высокие массовые потоки исходных соединений в газообразном состоянии к покрываемой поверхности позволяет реализовать высокую производительность процессов нанесения покрытия, в которых скорость роста может достигать от нескольких сотен микрон в час до нескольких миллиметров в час. Высокая поверхностная подвижность адсорбированных соединений позволяет в этих процессах получать покрытия с плотностью, близкой к теоретической, при температурах ~ 0,15-0,3 от температуры плавления материала, что недоступно для других методов нанесения покрытий, а также формировать совершенные эпитаксиальные покрытия. Особенно эффективными являются методы плазмохимического газофазного осаждения (ПХГФО)или стимулированного плазмой химического осаждения (ПХО) - Plasma Enhanced or Assisted (РЕ or PA) CVD (см. Рис.2.6б). В технологии плазмохимического осаждения используют высокочастотную газоразрядную плазму для разложения реакционного газа на активные радикалы или ионы. Применение различных приемов возбуждения плазмы в реакционном объёме и управление её параметрами позволяет интенсифицировать процессы роста покрытий, проводить осаждение аморфных и поликристаллических пленок при значительно более низких температурах подложки, делает более управляемыми процессы формирования заданного микрорельефа, структуры, примесного состава и других характеристик покрытия по сравнению с аналогичными процессами при использовании методов химического осаждения из газовой фазы, основанных на термическом разложении реакционного газа.
Таким образом, среди известных методов нанесения покрытий высокого качества плазмо-химические методы осаждения находятся вне конкуренции в большинстве случаев, когда необходимо:
· наносить равномерные по толщине, высокоплотные покрытия на изделия сложной формы с развитой поверхностью, в том числе, на внутренние поверхности, протяженные и глухие полости, отверстия;
- получать покрытия из тугоплавких, труднообрабатываемых металлов, сплавов и соединений с плотностью близкой к теоретической и высокой чистоты, формировать из них самонесущие изделия различной геометрии.
- наносить покрытия на порошки и другие сыпучие материалы, пропитывать (уплотнять) пористые структуры.
Химические и плазмо-химические методы осаждения могут осуществляться при атмосферном давлении - Atmospheric рressure (AP) CVD), при пониженном давлении - Low pressure (LP) CVD, либо при сверхвысоком вакууме (ниже 10−6 Па или примерно 10−8 мм рт. ст.) - Ultra high vacuum (UHV) CVD. Понижение давления во всех случаях снижает вероятность нежелательных реакций в газовой фазе и ведёт к более равномерному осаждению плёнки на подложку. Поэтому большинство современных CVD-установок — либо LPCVD, либо UHVCVD.
На рис. 2.14 приведена принципиальная схема установки плазмохимического осаждения тонких неорганических слоев или покрытий, в частности нитрида кремния (НК). Установка состоит из откачиваемого до остаточного давления ~ 10-6 Торр (мм рт. ст.) реактора, объединенного с электронным циклотронным резонансным (ЭЦР) плазменным источником и газовой системой для подачи реакционных газов. ЭЦР-плазменный источник представляет собой охлаждаемую резонансную камеру, снабженную магнитной системой на основе сдвоенных катушек Гельмгольца и объединенную при помощи волноводного тракта с магнетронным блоком, генерирующим СВЧ излучение частотой 2,45 ГГц (не путать с магнетронным распылителем).
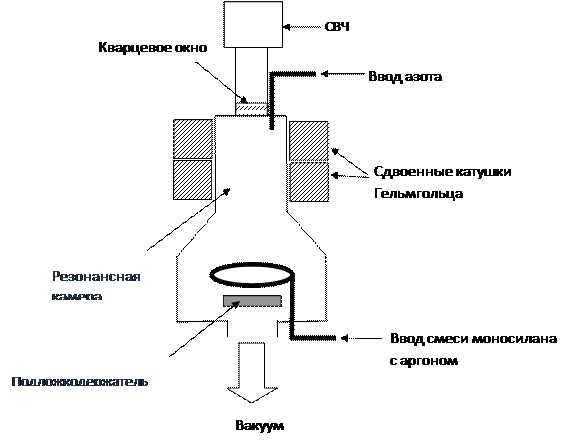
Рис. 2.14. Принципиальная схема установки плазмохимического осаждения тонких неорганических слоев или покрытий.
Плазма возбуждается СВЧ излучением, вводимым по волноводному тракту через кварцевое окно в резонансную камеру, при условии совпадения его частоты с частотой вращения электронов в магнитном поле, создаваемом магнитной системой, т.е. при проявлении эффекта ЭЦР. Эта частота определяется по уравнению ω=eH/mec, где H – интенсивность магнитного поля, e – заряд электрона, me – масса электрона, c – скорость света в вакууме.
Для синтеза НК применяют газовую смесь моносилана SiH4 с газом-носителем аргоном Ar (25 об. % моносилана и 75 об. % аргона) и азотом N2 или аммиаком NH3. Обобщенные схемы реакций синтеза
НК выглядят следующим образом: х SiH4 + у/2 N2 →SixNyHz + (4х-z)/2 H2 и х SiH4 + у NH3 →SixNyHz + (4х+3у- z)/2 H2. При этом азот или аммиак вводится в резонансную камеру, а смесь моносилана с аргоном - в область подложки через газовое кольцо, локализуя таким образом синтез НК у подложки. В зависимости от величины магнитной индукции возле кварцевого окна возможны различные формы потока (режимы) плазмы: узкий, круговой, однородный. Они характеризуются различным распределением плотности плазмы по радиальному профилю резонансной камеры. Так, узкий и круговой режимы характеризуется повышенной плотностью плазмы в середине и на краях резонансной камеры соответственно. Однородный режим характеризуется приблизительно одинаковой плотностью плазмы по всему радиальному профилю резонансной камеры.
Основное соединение кремния с азотом Si3N4 (43 ат. % кремния и 57 ат. % азота), соответствующее стехиометрическому соотношению компонентов, образует тригональную (α) и гексагональную (β) кристаллические сингонии. В блоке Si3N4 обычно образует поликристаллическую структуру, обладающую высокими физико-механическими и электрофизическими характеристиками. Так, модуль упругости поликристаллического Si3N4 составляет величину порядка 304 ГПа. При синтезе НК осаждением из газовой фазы получают, в основном, аморфные слои, в химический состав которых, помимо кремния и азота, и, соответственно, ковалентных связей Si – N и Si – Si, входят также побочные атомы водорода и кислорода, образующие ковалентные связи с кремнием и азотом (Si – H, Si – O, N – H, N - O). Количество побочных атомов и связей определяется как условиями осаждения (технологическими режимами), так и общей технологической культурой.
Кроме трудной воспроизводимости состава структуры осажденного слоя НК большую проблему при этом составляют возникающие остаточные (внутренние) напряжения. Общепринята модель, в рамках которой остаточные напряжения в тонких пленках представляются как сумма термической и структурной составляющей. Термические напряжения однородны по толщине и возникают из-за разности КТЛР пленки и подложки. Они определяются по соотношению:  , где a1 и a2 – коэффициенты термического линейного расширения (КТЛР) материалов подложки и пленки, Е - модуль Юнга подложки, ν – коэффициент Пуассона, ΔT– разность между температурой процесса осаждения и комнатной температурой. Структурные напряжения неоднородны по толщине и возникают в результате изменения плотности или размеров зерен по толщине пленки, из-за неоднородного распределения дефектов и др. Общая величина остаточных напряжений в тонких пленках при этом представляется в виде полиномиальной функции:
, где a1 и a2 – коэффициенты термического линейного расширения (КТЛР) материалов подложки и пленки, Е - модуль Юнга подложки, ν – коэффициент Пуассона, ΔT– разность между температурой процесса осаждения и комнатной температурой. Структурные напряжения неоднородны по толщине и возникают в результате изменения плотности или размеров зерен по толщине пленки, из-за неоднородного распределения дефектов и др. Общая величина остаточных напряжений в тонких пленках при этом представляется в виде полиномиальной функции:  , где z – расстояние от нижнего края пленки, hf – суммарная толщина пленки [106]. При этом, k = 0 соответствует однородным термическим напряжениям в пленке, а k = 1 - линейному распределению структурной составляющей остаточных напряжений по толщине слоя.
, где z – расстояние от нижнего края пленки, hf – суммарная толщина пленки [106]. При этом, k = 0 соответствует однородным термическим напряжениям в пленке, а k = 1 - линейному распределению структурной составляющей остаточных напряжений по толщине слоя.
Разновидностью метода химического осаждения является метод металлоорганического химического газофазного осаждения - Metalorganic CVD, называемый часто металлорганической эпитаксией из газовой фазы - Metalorganic vapour phase epitaxy (MOVPE), в котором используются металлоорганические летучие прекурсоры и который позволяет получать моно- или поликристаллические эпитаксиальные тонкие сдли, в первую очередь из термодинамичеки метастабильных сплавов. Этот метод близок к молекулярно-лучевой эпитаксии, однако в нем рост кристаллических слоев при получении многослойных структур осуществляются не в результате физической адсорбции, а в результате очень сложных химических и адсорбционных процессов. Кроме того, этот процесс проводится не при глубоком вакууме, а в газовой фазе при сравнительно высоеом давлен (от10 до 760 торр).
|
|
|
|
|
Дата добавления: 2014-12-25; Просмотров: 1149; Нарушение авторских прав?; Мы поможем в написании вашей работы!