
КАТЕГОРИИ:
Архитектура-(3434)Астрономия-(809)Биология-(7483)Биотехнологии-(1457)Военное дело-(14632)Высокие технологии-(1363)География-(913)Геология-(1438)Государство-(451)Демография-(1065)Дом-(47672)Журналистика и СМИ-(912)Изобретательство-(14524)Иностранные языки-(4268)Информатика-(17799)Искусство-(1338)История-(13644)Компьютеры-(11121)Косметика-(55)Кулинария-(373)Культура-(8427)Лингвистика-(374)Литература-(1642)Маркетинг-(23702)Математика-(16968)Машиностроение-(1700)Медицина-(12668)Менеджмент-(24684)Механика-(15423)Науковедение-(506)Образование-(11852)Охрана труда-(3308)Педагогика-(5571)Полиграфия-(1312)Политика-(7869)Право-(5454)Приборостроение-(1369)Программирование-(2801)Производство-(97182)Промышленность-(8706)Психология-(18388)Религия-(3217)Связь-(10668)Сельское хозяйство-(299)Социология-(6455)Спорт-(42831)Строительство-(4793)Торговля-(5050)Транспорт-(2929)Туризм-(1568)Физика-(3942)Философия-(17015)Финансы-(26596)Химия-(22929)Экология-(12095)Экономика-(9961)Электроника-(8441)Электротехника-(4623)Энергетика-(12629)Юриспруденция-(1492)Ядерная техника-(1748)
Сенсор на польовому транзисторі із використанням пористого кремнію. Поясніть принцип дії. Який принцип дії газового сенсора з пористим кремнієм на основі КМОН процесу?
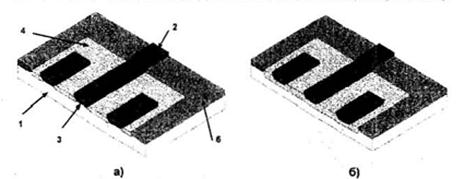
| Рис. 5.10. Схема APSFET-структури з несуцільною (а) і суцільною поруватою плівкою (б). Позначенння: 1 – p-Si (1015 см–3); 2 – n+ полі-Si; 3 – імплантований n-Si (4х1020 см–3); 4 – поруватий Si; 5 – Si3N4 |
Польовий транзистор. GasFET-структура чи газовий польовий транзистор на основі поруватого Si представлено на рис. 5.10. Він отримав назву APSFET (adsorption porous silicon-based FET) або адсорбціонний польовий транзистор на основі поруватого кремнію. Технологія його формування базується на використанні стандартної біполярної та КМОН кремнієвої технології. Чутливість таких приладів до газів виникає за рахунок утворення індукованого (під дією адсорбції молекул) провідного каналу в кристалічному кремнії, який знаходиться під сенсорним елементом – поруватою плівкою. Тобто принцип його роботи повністю аналогічний описаному звичайному сенсору на КМОН транзисторі, тільки в поруватому Si зміна заряду відбувається за іншим механізмами. Залежно від параметрів процесу анодизації можна створити два типи структури – з неперервною та "розірваною", несуцільною поруватою плівкою на поверхні (рис. 5.10).
Адсорбовані в поруватому шарі молекули за рахунок інжекції чи екстракції електронів з об'єму або наведеної поляризації змінюють ширину області збіднення в підзатворній області монокремнію. Легко показати, що для виникнення індукованого каналу в МОН - структурі, утвореній на підкладці р-типу кремнію з концентрацією вільних носіїв 1015 см–3, треба ввести в підзатворний оксид або поверхневі дефектні стани 1011 заряджених дефектів/см2. Така велика кількість адсорбційних вузлів легко досягається саме при формуванні поруватого кремнію. Причому, залежно від знака заряду, що інжектується в поруватий шар, можна спостерігати як зростання струму "витік – стік" у польовому транзисторі, так і зменшення струму зі зростанням концентрації адсорбованих молекул. Так, адсорбція ізопропанолу веде до зростання струму "витік – стік", а оцтової кислоти – навпаки, до його зменшення (рис. 5.11).
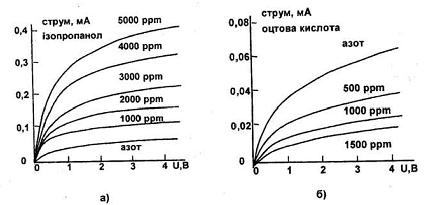
|
| Рис. 5.11. ВАХ APSFET структури для випадку адсорбції у атмосфері ізопропанолу (а) та оцтової кислоти (б) різної концентрації. За відлік взято характеристику в атмосфері азоту |
МДН-структура на основі контакту метал – поруватий кремній – кремній. Структури типу метал – поруватий кремній – кремній (чи МДН-структура з тонким поруватим шаром) можуть бути створені за технологією сенсорів вертикального типу, проте товщина поруватого шару при цьому значно менша – 10–1000 нм. Для цих сенсорів вимірюються частотні ВФХ або ВАХ. Чутливість сенсорів визначається за відносною зміною струму, ємності чи опору структури під час адсорбції. Оскільки найпростіша еквівалентна схема такої структури складається з паралельно з'єднаних резистора, ємності потенціального бар'єра та послідовного опору, то в загальному випадку вимірювані струм та напруга є комплексними:  (5.14) Закон Ома для комплексних значень струму та напруги:
(5.14) Закон Ома для комплексних значень струму та напруги:  (5.15).
(5.15).
Якщо знехтувати послідовним опором, то для кожної частоти й потенціалу величина активного та реактивного опорів визначається як:
 (5.16) Опір та ємність для кожної частоти можна визначити з експериментальних величин Zp та Zq:
(5.16) Опір та ємність для кожної частоти можна визначити з експериментальних величин Zp та Zq:  (5.17)
(5.17)
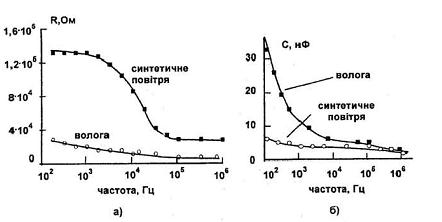
|
| Рис. 5.12. Залежність опору (а) та ємності (б) сенсора Ti – поруватий кремній (300 нм) – p-Si від частоти в атмосфері синтетичного повітря з відносною вологістю 0 % та 50 %, V = 0,1 В |
Рис. 5.12 показує частотні залежності опору та ємності R, C, які розраховувалися з еквівалентної схеми вертикальних структур Ті – поруватий кремній (100 нм) – p-Si при вимірюванні, відповідно, у сухому та вологому повітрі. Імпеданс розраховувався при вимірюванні ВАХ у діапазоні частот від 170 Гц до 800 КГц. При малих (ω < 2х103 Гц) і великих
(ω > 105 Гц) частотах спостерігається насичення залежності опору від частоти; ємність також насичується при високих частотах. Адсорбція вологи суттєво збільшує C і провідність тільки в області малих ω. Ефект пояснюється впливом ПЕС на адсорбційну чутливість сенсора: при частотах більших 104 Гц, спостерігається кореляція між різким зменшенням впливу адсорбції на ємність структури та зникненням внеску ПЕС у зворотні ВФХ.
Інтегрована структура до КМОН процесу. Інтегрована структура поєднує в собі хімічний сенсор та електронний підсилювач. Вона створюється на одному кристалі (чипі) і сумісна з КМОН технологічним процесом (рис. 5.13). Сенсор складається з р-типу кремнієвого резистора на підкладці n-Si. На лицевій частині р-області формується шар поруватого кремнію, який відіграє роль адсорбенту й дозволяє модулювати величину опору р-шару при експозиції в парах органічних сполук.
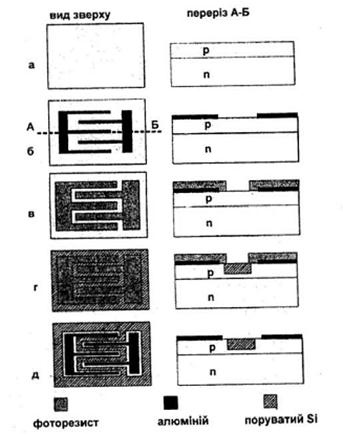
|
| Рис. 5.13. Процес формування інтегрального сенсора, сумісного з КМОН процесом |
Етапи формування інтегрованої сенсорної структури з КМОН процесом та чутливим поруватим шаром представлено на рис. 5.13. Базові етапи виготовлення такої структури такі: 1) оксидація поверхні n-Si; 2) імплантація бору крізь оксид і дифузія для формування глибокого (2,3 мкм) р-шару (рис. 5.13, а); 3) травлення SiO2 у HF; 4) напилення плівки Al та відпал;
5) формування двох алюмінієвих електричних контактів гребінчастого типу (рис. 5.13, б);
6) нанесення плівки фоторезистора на алюміній; 7) фотолітографічне утворення вікна у фоторезисті (рис. 5.13, в); 8) напилення Al на тильний бік кремнієвої пластини;
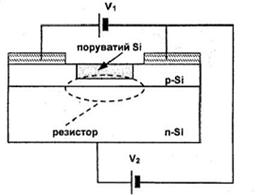
|
| Рис. 5.14. Схема електричного ввімкнення інтегрованої структури |
9) електрохімічне травлення р-Si у вікні до створення поруватого шару товщиною до 2 мкм (рис. 5.13, г); 10) промивання в ацетоні, етанолі та сушіння в азоті (рис. 5.13, д).
У структурі вимірюється струм між двома алюмінієвими омічними контактами залежно від прикладеної напруги V1. Для зменшення струмів витоку в об'єм n-Si і для забезпечення умов протікання струмів тільки через
р-область кристалічного резистора (вважається, що область поруватого кремнію має значно більший електричний опір) до тильного омічного контакту прикладається позитивний потенціал V2 > V1. При невеликих потенціалах –1,0 B < V1 < 1,0 B струм між алюмінієвими електродами майже лінійний. Величина опору резистора змінюється від 150 кОм при експозиції в парах азоту до 50 кОм при експозиції в парах 15000 ppm ізопропонолу.
29. Основні властивості полімерів. π-спряжені зв’язки. Використання полімерів для сенсорів провідності.

|
| Рис. 6.1: а) розподіл електронної густини p-орбіталей у гіпотетичному одномірному ланцюгу, σ -зв'язки – заштриховані (вигляд збоку); б) молекула поліацетилену: зліва – розподіл електронної густини, σ -зв'язки – заштриховані, справа – структурна формула. Кожний атом вуглецю має три σ-зв'язки з атомом Н та двома атомами С і делокалізований π -зв'язок |
Полімери (від грец. polymers – складений з багатьох частин) – це речовини, які складаються з макромолекул, молекулярних полімерних ланцюгів. Тому їх називають ще високомолекулярними сполуками. Існують як природні (біологічні полімери), так і синтетичні. Основна характеристика полімерного ланцюга – кількість мономерних ланок N – називається ступенем полімеризації; молекулярна маса та контурна довжина ланцюга прямо пропорційна N. Для типових синтетичних полімерів N ~ 102–104, для біополімерів
ДНК N ~ 109. Завдяки ланцюговій будові молекул та їх великій довжині полімери набувають специфічних фізичних властивостей: 1) об'єднання мономерних ланок у полімерні ланцюги лишає їх вільного незалежного трансляційного руху. Завдяки цьому для полімерів характерні аномально високі сприйнятливості до багатьох зовнішніх дій (механічних, електромагнітних тощо); 2) послідовність ланок у кожному полімерному ланцюгу фіксується при синтезі полімеру, взаємний перетин ланцюгів під час руху макромолекул неможливий (топологічна заборона). Тому для полімерів характерні довготривала топологічна пам'ять про умови синтезу та передісторії відносного руху ланок;
3) макромолекулярні ланцюги створюють далекодіючі кореляції, завдяки чому специфічні для полімерів фізичні властивості формуються достатньо великими (порівнюючи з атомними) просторово-часовими масштабами, вони слабо залежать від мікроскопічних деталей хімічної будови мономерних ланок і якісно універсальні для полімерів різного типу;
4) макромолекулярні ланцюги формують анізотропні електронні спектри, завдяки чому поряд зі звичайними діелектричними полімерами існують також полімерні органічні напівпровідники, провідники, надпровідники та феромагнетики. Газові сенсори можна побудувати з використанням ефекту зміни опору полімерної плівки при експозиції в газовому середовищі. Цей ефект спостерігається в органічних полімерних напівпровідниках на основі
вуглеводнів (поліацетилен, поліпірол, поліпарафеніл, поліанілін). Це електропровідні полімери, оскільки вони мають спряжені зв'язки вздовж всієї своєї довжини, які забезпечують делокалізацію π-електронів уздовж полімерної молекули. Орбіталі π -електронів спряжених зв'язків плоских молекул витягнуті у вигляді вісімки перпендикулярно площині молекули (рис. 6.1,а). Вони забезпечують достатньо добре перекривання електронних хвильових функцій сусідніх молекул. Тому π -електрони плоских молекул делокалізовані не тільки всередині молекули, але й вздовж ланцюга. У найпростішій молекулі цього типу – поліацетилені (СН)х (рис. 6.1, б) довжина ланцюга спряження х досягає кількох тисяч  . Полімерні молекули зібрані у волокна з діаметром 200
. Полімерні молекули зібрані у волокна з діаметром 200  . Взаємодія ниток у волокні слабка, і рух електронів має одномірний характер. У результаті димеризації, а також кулонівського відштовхування в енергетичному спектрі π -електронів з'являється щілина шириною 1,8 еВ. Тому чистий поліацетилен – діелектрик. Легування поліацетилену атомами К, Nа, Вr, І, органічними донорами чи акцепторами призводить до суттєвого зростання про-відності поліацетилену до значень s ~10–4–10–3 Ом–1см–1.
. Взаємодія ниток у волокні слабка, і рух електронів має одномірний характер. У результаті димеризації, а також кулонівського відштовхування в енергетичному спектрі π -електронів з'являється щілина шириною 1,8 еВ. Тому чистий поліацетилен – діелектрик. Легування поліацетилену атомами К, Nа, Вr, І, органічними донорами чи акцепторами призводить до суттєвого зростання про-відності поліацетилену до значень s ~10–4–10–3 Ом–1см–1.
Технологія виготовлення полімерних газових сенсорів заснована на синтезі тонких полімерних плівок на сенсорній структурі, яку в найпростішому випадку роблять за двоелектродною схемою (дві близько розташовані металеві смужки на ізолюючій підкладці) для вимірювання зміни опору в газовій атмосфері. Дизайн промислових сенсорів дуже схожий на сенсор вологості на основі металоксидів, оскільки металеві електроди роблять гребінчастого типу (дві металі гребінки, які входять одна в одну) для зменшення опору структури, тобто це трансдьюсер гребінчастого типу IDT. На зворотному боці підкладки розташовано нагрівач для підтримки сенсора при заданій оптимальній температурі та терморезистор, який використовується у схемі контролю температури сенсора (рис. 6.2). Зазвичай сенсор мінімізується за розміром і монтується в стандартних корпусах.
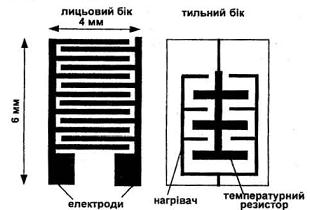
|
| Рис. 6.2. Схематичний вигляд сенсорної структури |
Лінійні ланцюгові молекули полімерної плівки на діелектричній підкладці можна утворювати внаслідок процесів полімеризації послідовного приєднання мономерів до полімерного ланцюга, що росте за схемою:
 (6.1) або поліконденсації, тобто послідовного об'єднання ділянок ланцюга з вільними валентностями на кінцях за схемою:
(6.1) або поліконденсації, тобто послідовного об'єднання ділянок ланцюга з вільними валентностями на кінцях за схемою:  (6.2) Ріст ланцюга закінчується при приєднанні до кінця макромолекули одновалентної сполуки або (для полімеризації) при вичерпанні мономера. Використовують також методи трафаретного друку, термічного розпилення та золь-гель технології формування полімерної плівки. Молекули газу адсорбуються на полімерну плівку і, залежно від природи взаємодії адсорбат–адсорбент, електрони інжектуються або захоплюються з об'єму плівки. Зміни у складі газової атмосфери ведуть до зміни опору сенсора. Вимірюване значення провідності є комбінацією провідності приповерхневої (σs), яка залежить від адсорбції газу, і провідності об'єму плівки (σb), яка не залежить від адсорбції молекул. Тоді з еквівалентної схеми двох паралельних провідностей σs та σb і закону Ома можна записати, що зміна шарової провідності σ: U= RI,
(6.2) Ріст ланцюга закінчується при приєднанні до кінця макромолекули одновалентної сполуки або (для полімеризації) при вичерпанні мономера. Використовують також методи трафаретного друку, термічного розпилення та золь-гель технології формування полімерної плівки. Молекули газу адсорбуються на полімерну плівку і, залежно від природи взаємодії адсорбат–адсорбент, електрони інжектуються або захоплюються з об'єму плівки. Зміни у складі газової атмосфери ведуть до зміни опору сенсора. Вимірюване значення провідності є комбінацією провідності приповерхневої (σs), яка залежить від адсорбції газу, і провідності об'єму плівки (σb), яка не залежить від адсорбції молекул. Тоді з еквівалентної схеми двох паралельних провідностей σs та σb і закону Ома можна записати, що зміна шарової провідності σ: U= RI, 
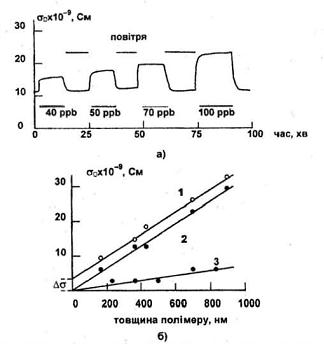
|
| Рис. 6.3: а) залежність шарової провідності полімерного сенсора (полімер фталоцианін свинцю PbPc, d = 350 нм на підкладці Al2O3) від часу при послідовній подачі NO2 різних концентрацій (40, 50, 70, 100 ppb) у камеру з атмосферним повітрям, Т = 443 К; б) залежність шарової провідності від товщини полімерного шару при вимірюванні в різних атмосферах: 50 ppb NO2 у повітрі (1), повітрі (2), надвисокому вакуумі (3) |
На рис. 6.3 представлено типовий результат для хімічного полімерного сенсора на газ акцепторного типу NO2. Добре видно, що висока чутливість таких сенсорів дозволяє фіксувати дуже малі концентрації токсичних молекул NO2 у звичайній атмосфері (у 100 разів менше, ніж за вимогами ГДК). Хоча провідність плівки практично лінійно залежить від товщини, чутливість приладу Δσ до NO2 не залежить від товщини плівки при вимірюванні на атмосферному повітрі  . Водночас, якщо порівнювати провідність плівки у звичайній атмосфері та надвисокому вакуумі, то видно, що криві мають різний нахил у координатах від товщини полімерної плівки. Це свідчить насамперед про те, що сенсор неселективний. Окрім невеликого сигналу від дуже малої концентрації NO2 провідність сенсора залежить і від адсорбції інших газів, які присутні в атмосфері. Чутливість і селективність полімерних сенсорів може змінюватись у широких межах за рахунок легування полімерних ланцюгів, вибору легуючих домішок, варіації довжини полімерних ланцюгів та умов полімеризації. На відміну від сенсорів типу метал-оксид полімерні сенсори ефективні при кімнатних температурах і чутливі до температурних змін. Вони також чутливі до полярних молекул і зазвичай мають добру відновлюваність параметрів після закінчення дії газів.
. Водночас, якщо порівнювати провідність плівки у звичайній атмосфері та надвисокому вакуумі, то видно, що криві мають різний нахил у координатах від товщини полімерної плівки. Це свідчить насамперед про те, що сенсор неселективний. Окрім невеликого сигналу від дуже малої концентрації NO2 провідність сенсора залежить і від адсорбції інших газів, які присутні в атмосфері. Чутливість і селективність полімерних сенсорів може змінюватись у широких межах за рахунок легування полімерних ланцюгів, вибору легуючих домішок, варіації довжини полімерних ланцюгів та умов полімеризації. На відміну від сенсорів типу метал-оксид полімерні сенсори ефективні при кімнатних температурах і чутливі до температурних змін. Вони також чутливі до полярних молекул і зазвичай мають добру відновлюваність параметрів після закінчення дії газів.
30. Об’ємні на поверхневі акустичні хвилі. Рівняння Соурбрея. Гравіметричній коефіцієнт чутливості. Сенсори на кварцовому мікро- балансі та поверхневих акустичних хвилях. Еквівалентна електрична схема. Приклади сенсорів. Гібридні мембранні структури на кремнії.
ОБ'ЄМНІ АКУСТИЧНІ ХВИЛІ
Сенсори на об'ємних акустичних хвилях в англомовній літературі – bulk acoustic wave sensor (BAW) називають ще по-іншому – thickness shear mode resonator (TSMR) – модовим резонатором зміни товщини або quartz micro balance (QMB) – кварцовим мікробалансом завдяки їх чутливості до зміни маси. Акустичні сенсори базуються на використанні пружних хвиль у п'єзоелектричних кристалах, які виникають при прикладеній змінній напрузі. Робоча частота лежить у межах від мегагерців до часток гігагерців. У багатьох випадках вихідним сигналом сенсора є частота, яка може дуже просто визначатися з високою точністю завдяки сучасним вимірювальним приладам електроніки. Найпростіші ультразвукові сенсори використовують пластинку кварцу, до якої прикладено змінну напругу (рис. 6.4). Зростання маси сенсора при адсорбції молекул перетворюється на зменшення частоти згідно з рівнянням Соурбрея (Sauerbrey):  (6.3) де Δf – зсув частоти, Δm – зміна маси, A – ефективна площа сенсора, f0 – робоча частота, Cf – постійна, яка залежить від конструкції, матеріалу та робочої частоти сенсора, її називають гравіметричним коефіцієн-том чутливості. Для прикладу, частота 6 МГц кристалічного кварцового резонатора зменшується на 1 Гц при осадженні всього 12 нг (12 10–9 г) речовини на площі 1 см2 на одному боці резонатора, оскільки гравіметричний коефіцієнт чутливості для кварцу на цій частоті дорівнює 14 см2/г.
(6.3) де Δf – зсув частоти, Δm – зміна маси, A – ефективна площа сенсора, f0 – робоча частота, Cf – постійна, яка залежить від конструкції, матеріалу та робочої частоти сенсора, її називають гравіметричним коефіцієн-том чутливості. Для прикладу, частота 6 МГц кристалічного кварцового резонатора зменшується на 1 Гц при осадженні всього 12 нг (12 10–9 г) речовини на площі 1 см2 на одному боці резонатора, оскільки гравіметричний коефіцієнт чутливості для кварцу на цій частоті дорівнює 14 см2/г.
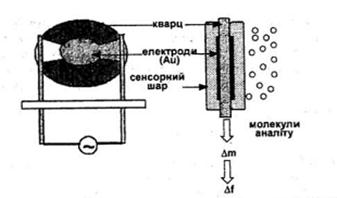
|
| Рис. 6.4. Схематичне зображення сенсора на об'ємних акустичних хвилях |
Селективність і чутливість таких сенсорів досягається за рахунок використання різних покриттів (рис. 6.4), насамперед полімерів. Оскільки для цього підходить значна кількість матеріалів покриття, то розроблено BAW сенсори для різноманітних речовин. Наприклад, якщо пластину кварцу покрити дуже тонким шаром золота, яке легко утворює амальгаму під дією парів ртуті, то за вимірами резонансної частоти такого сенсора можна визначити масу ртуті на пластині, а, відповідно, і концентрацію її пари.
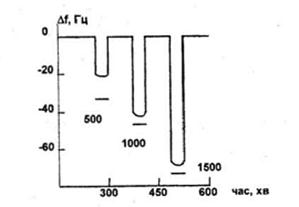
|
| Рис. 6.5. Кінетика відповіді QMB сенсора при послідовній подачі 500, 1000 та 1500 ppm тетрахлоретану |
На рис. 6.5. представлено приклад залежності зміни частоти QMB при послідовній інжекції малих доз тетрахлоретану в експериментальну камеру із сенсором. Зміна частоти сягає ~ 22 Гц при подачі 500 ppm цього газу. Відзначимо, що сенсори QMB-типу лінійні в широкому діапазоні зміни концентрацій. У той самий час, сигнал залежить від температури вимірювань, оскільки чим нижча температура, тим повільніше кінетика адсорбції-десорбції. Проте при високих температурах зменшується кількість адсорбованих молекул. Перевагами таких сенсорів є висока стабільність сигналу, можливість роботи при кімнатних температурах та їх висока відтворюваність при виробництві. Недоліком є великий розмір і висока ціна сенсора. QMB дуже стійкі до вологості, проте малоефективні для малих концентрацій газів (менших 10 ppm), якщо порівняти їх з MOSFET чи метал-оксидними сенсорами.
ПОВЕРХНЕВІ АКУСТИЧНІ ХВИЛІ
Cенсори на поверхневих акустичних хвилях, в англомовній літерату-рі – surface acoustic wave sensors (SAW) також використовують п'єзоелектричний ефект. Тут зміна маси реєструється як зміна частоти поверхневих акустичних хвиль (на частотах вищих, ніж 400–600 МГц). Сенсори типу SAW належать до так званих мікросенсорів, тобто займають об'єм лише кілька нанолітрів.
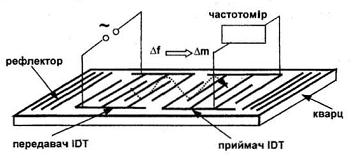
|
| Рис. 6.6. Схематичне зображення SAW |
SAW сенсор складається з двох гребінчастих трансдьюсерів IDT – тонких металевих електродів "пальчикового" типу на полірованій п'єзоелектричній підкладці (рис. 6.6). Перший IDT електрод – це передавач поверхневої акустичної хвилі, другий електрод – приймач. Вони розділені так званою лінією затримки та розташовані в центрі рефлектора (резонатора). Змінний струм, який прикладено до IDT передавача, викликає ефекти розширення та стискання приповерхневих атомів п'єзокристала. Цей рух збуджує поверхневі релеївські хвилі, які поширюються вздовж підкладки. IDT електрод-приймач приєднано до вимірювача частоти. Частота та інші параметри поверхневої хвилі визначаються геометрією IDT металевих електродів, характеристиками п'єзоелектричного кристала та фізичними властивостями поверхні. Параметри поверхневої хвилі можуть бути визначені з еквівалентної схеми сенсора, яка складається з еласто-електричного конвертора та паразитних елементів – послідовних індуктивності та опору, які шунтуються паралельними ємністю й опором. Наприклад, паралельний опір обчислюється як:  (6.4) де N – кількість "пальців" у кожній парі електродів, Cs – ємність на одну пару "пальців", k – коефіцієнт електромеханічного зв'язку, f0 – резонансна частота. Як чутливий шар можна використовувати або чисту поверхню п'єзокристала, або полімерне покриття в області лінії затримки чи області IDT електродів. Адсорбція газів змінює масу або інші фізичні властивості чутливого шару, що веде до змін характеристик поверхневих хвиль. На приклад, для тонкоплівкового п'єзоелектричного сенсора (він формується на не п'єзоелектричній мембрані) фазова швидкість поверхневої акустичної хвилі записується як:
(6.4) де N – кількість "пальців" у кожній парі електродів, Cs – ємність на одну пару "пальців", k – коефіцієнт електромеханічного зв'язку, f0 – резонансна частота. Як чутливий шар можна використовувати або чисту поверхню п'єзокристала, або полімерне покриття в області лінії затримки чи області IDT електродів. Адсорбція газів змінює масу або інші фізичні властивості чутливого шару, що веде до змін характеристик поверхневих хвиль. На приклад, для тонкоплівкового п'єзоелектричного сенсора (він формується на не п'єзоелектричній мембрані) фазова швидкість поверхневої акустичної хвилі записується як:  (6.5) де Т – компонента пружності в напрямку поширення на одиницю довжини
(6.5) де Т – компонента пружності в напрямку поширення на одиницю довжини  – коефіцієнт жорсткості, Е – модуль Юнга, d – товщина,
– коефіцієнт жорсткості, Е – модуль Юнга, d – товщина,
σ - співвідношення Пуассона, M – маса на одиницю площі. Якщо маса на одиницю площі мембрани підвищується на величину Δm при адсорбції, то фазова швидкість зменшується:

|
| Рис. 6.7. Кінетика відповіді SAW сенсора при послідовній подачі 45, 60, 75, 100, 150 ppm тетрахлоретану, f0 = 433 МГц |
 (6.6). Тут vp0 – фазова швидкість до адсорбції. Тоді гравіметричний коефіцієнт чутливості збільшується для менших значень M:
(6.6). Тут vp0 – фазова швидкість до адсорбції. Тоді гравіметричний коефіцієнт чутливості збільшується для менших значень M:  (6.7) Теоретично SAW сенсори мають кращу чутливість, ніж QMB прилади. Так, гравіметричний коефіцієнт чутливості для ZnO на Si дорівнює 440 (4,7 МГц) та 990 см2/г (2,6 МГц). Для близьких концентрацій одного й того самого газу тетрахлоретану чутливість SAW сенсора більше на 2-3 порядки, ніж QMB сенсора (порівняйте рис. 6.5 та 6.7). Зміна частоти досягає ~ 1400 Гц для SAW при подачі всього 45 ppm цього газу (проте рівень шуму також зростає для SAW сенсорів). Для сенсора на толуол (покриття з етилцелюлози) спостерігається лінійна залежність зміни частоти від концентрації толуолу з нахилом кривої 1,1 Гц/ppm, рівень шуму – 0,4 Гц. Якщо чутливість сенсора визначити з умови, що співвідношення сигнал/шум дорівнює 1, то такий сенсор спроможний вимірювати концентрацію парів толуолу менше, ніж 0,4 ppm. Для мінімізації шумів і температурних ефектів використовують додатково такий самий SAW сенсор, але без полімерного покриття, обидва вони розташовані на одному кристалі.
(6.7) Теоретично SAW сенсори мають кращу чутливість, ніж QMB прилади. Так, гравіметричний коефіцієнт чутливості для ZnO на Si дорівнює 440 (4,7 МГц) та 990 см2/г (2,6 МГц). Для близьких концентрацій одного й того самого газу тетрахлоретану чутливість SAW сенсора більше на 2-3 порядки, ніж QMB сенсора (порівняйте рис. 6.5 та 6.7). Зміна частоти досягає ~ 1400 Гц для SAW при подачі всього 45 ppm цього газу (проте рівень шуму також зростає для SAW сенсорів). Для сенсора на толуол (покриття з етилцелюлози) спостерігається лінійна залежність зміни частоти від концентрації толуолу з нахилом кривої 1,1 Гц/ppm, рівень шуму – 0,4 Гц. Якщо чутливість сенсора визначити з умови, що співвідношення сигнал/шум дорівнює 1, то такий сенсор спроможний вимірювати концентрацію парів толуолу менше, ніж 0,4 ppm. Для мінімізації шумів і температурних ефектів використовують додатково такий самий SAW сенсор, але без полімерного покриття, обидва вони розташовані на одному кристалі.
Оскільки параметри поверхневих хвиль залежать від маси, діелектричної сталої, в'язкості полімерної фази, температури, тиску, то SAW
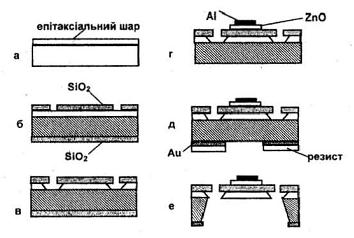
|
| Рис. 6.8. Спрощений процес формування кремнієвої мембрани для SAW сенсора |
сенсор може бути приладом не тільки зміни маси, а й інших параметрів. Як полімерні покриття використовують плівки непровідних полімерів модифікованих полісилоксанів, фталоцианінів тощо. Наприклад, для детекції СО2 і метану полімерне покриття не використовують, оскільки чутливість базується на зміні термічної провідності під час адсорбції газу. Для детекції водню та аміаку як чутливий шар використовують, відповідно, плівки паладію та платини. Серед п'єзоелектричних матеріалів, які використовуються для акустичних сенсорів можна відзначити кварц, ніобат літію LiNbO3, LiTaO3, LiB4O7, ZnO, AlN, Pb(Zr,Ti)O3 (PZT, тобто свинець – цирконат – титанат). На сьогодні найбільш використовуваними є гібридні мембранні структури, виробництво яких сумісно з кремнієвим інтегральним виробництвом (КМОН-технологія). Це дозволяє створювати інтегральні сенсори, коли на одному кристалі розташовано сенсорну структуру, інтегральну кремнієву схему (підсилювач і перетворювач) і додатково сенсор без полімерного покриття для температурної компенсації.
На рис. 6.8 показано процес виготовлення сенсора. На стандартній кремнієвій підкладці р-типу (товщина 300 мкм, орієнтація (100), опір 0,01 Ом* см) формуються два епітаксіальних шари кремнію n-типу (процес а). Ближчий до підкладки шар має товщину 20 мкм та опір 30 Ом* см, шар на поверхні має товщину 10 мкм та опір 10 Ом* см. Поверхня кремнію термічно окислюється й на фронтальному боці в оксиді протравлюються вікна за допомогою фотолітографічного процесу. У цих вікнах потім формують балки для консолі (процес б). Наступний етап – травлення епітаксіального шару кремнію у відкритих вікнах оксиду за допомогою EDP розчину (процес в). Оскільки сильно легований р+-кремній не травиться в EDP розчині, то процес травлення закінчується, коли розчин доходить до межі епітаксіального шару з р+-підкладкою. Цей процес називається back-side etch-stop using p+ doping – закінчення травлення тильного боку при використанні р+-шару. Після цього на фронтальному боці структури методом магнетронного розпилення формується тонкий шар п'єзоелектричної плівки ZnO і фронтальна плівка алюмінію для електричного контакту (процес г). Потім на тильний бік напиляють плівку золота товщиною 300 нм і покривають тильний бік товстою плівкою полімерного фоторезисту. Наступний крок – автосуміщення фотошаблонів тильного боку з фронтальною структурою. Після експонування фоторезисту з тильного боку та його травлення проводять травлення вікна у плівці золота (процес д). Потім проводять процес електрохімічного травлення кремнієвої підкладки у розчині H2SO4:HF:H2O, який відбувається лише до шару епітаксійної плівки, після цього процес травлення зупиняється, оскільки кремній n-типу в цьому розчині не травиться (цей процес називається electrochemical control etch-stop, тобто електрохімічний контроль зупинки травлення). У результаті формується мембранна структура (процес е), яку можна використовувати для SAW сенсора.
|
|
Дата добавления: 2015-01-03; Просмотров: 1325; Нарушение авторских прав?; Мы поможем в написании вашей работы!