
КАТЕГОРИИ:
Архитектура-(3434)Астрономия-(809)Биология-(7483)Биотехнологии-(1457)Военное дело-(14632)Высокие технологии-(1363)География-(913)Геология-(1438)Государство-(451)Демография-(1065)Дом-(47672)Журналистика и СМИ-(912)Изобретательство-(14524)Иностранные языки-(4268)Информатика-(17799)Искусство-(1338)История-(13644)Компьютеры-(11121)Косметика-(55)Кулинария-(373)Культура-(8427)Лингвистика-(374)Литература-(1642)Маркетинг-(23702)Математика-(16968)Машиностроение-(1700)Медицина-(12668)Менеджмент-(24684)Механика-(15423)Науковедение-(506)Образование-(11852)Охрана труда-(3308)Педагогика-(5571)Полиграфия-(1312)Политика-(7869)Право-(5454)Приборостроение-(1369)Программирование-(2801)Производство-(97182)Промышленность-(8706)Психология-(18388)Религия-(3217)Связь-(10668)Сельское хозяйство-(299)Социология-(6455)Спорт-(42831)Строительство-(4793)Торговля-(5050)Транспорт-(2929)Туризм-(1568)Физика-(3942)Философия-(17015)Финансы-(26596)Химия-(22929)Экология-(12095)Экономика-(9961)Электроника-(8441)Электротехника-(4623)Энергетика-(12629)Юриспруденция-(1492)Ядерная техника-(1748)
Особенности легирования при МЛЭ
|
|
|
|
Предэпитаксиальная обработка подложки
Предэпитаксиальная обработка подложки при использовании метода МЛЭ осуществляется двумя способами.
- Высокотемпературный отжиг при температуре 1000 - 1250 °С длительностью до 10 минут. При этом за счет испарения или диффузии внутрь подложки удаляется естественный окисел и адсорбированные примеси.
- Очистка поверхности с помощью пучка низкоэнергетичных ионов инертного газа. Этот способ дает лучшие результаты. Для устранения радиационных дефектов проводится кратковременный отжиг при температуре 800 - 900 °С.
Одной из отличительных особенностей МЛЭ является низкая скорость роста пленки: приблизительно 1 монослой/с или 1 мкм/час, что позволяет легко модулировать молекулярные пучки, попадающие на подложку, если время управления движением заслонки менее 1 секунды.
Легирование при МЛЭ имеет несколько особенностей. По сравнению с эпитаксией из газовой фазы расширен выбор легирующих соединений, возможно управление профилем легирования. Легирующая примесь может быть как p-, так и n-типа.
Возможны два способа легирования:
- После испарения примесные атомы достигают поверхности и встраиваются в кристаллическую решетку. Наиболее часто применяемые примеси (As, H, B) испаряются или слишком быстро или слишком медленно для эффективного управления. В результате чаще прибегают к употреблению Sb, Ga или Al.
- В другом способе легирования используется ионная имплантация. В этом случае применяются слаботочные (1 мкА) ионные пучки с малой энергией. Низкая энергия этого процесса позволяет внедрять примесь на небольшую глубину под поверхность растущего слоя, где она встраивается в кристаллическую решетку. Этот способ позволяет использовать такие примеси как B, P и As.
|
|
|
Перспективы развития.
Приборы, получаемые с использованием МЛЭ
МЛЭ используется для изготовления пленок и слоистых структур при создании приборов на (GaAs) и (AlxGa1-xAs). К таким приборам относятся лавиннопролетные диоды, переключающие СВЧ-диоды, полевые транзисторы с барьером Шоттки, интегральные оптические структуры.
Метод молекулярно-лучевой эпитаксии перспективен для твердотельной электроники создания СВЧ-приборов и оптических твердотельных приборов и схем, в которых существенную роль играют слоистые структуры субмикронных размеров. При этом особое значение придается возможности выращивания слоев с различным химическим составом.
Дополнительные вопросы
Технология "Кремний на изоляторе"
Монолитные кремниевые слои имеют такие недостатки, как паразитные электрические цепи, возникающие вследствие большой емкости изолирующего перехода. Причем с уменьшением размеров приборов трудности, возникающие при решении этой проблемы возрастают.
Один из способов решения - формирование отдельных приборов на небольших островках кремния на изолирующей подложке. С целью дальнейшего совершенствования методов производства СБИС для получения быстродействующих приборов была предложена новая технология - кремний на изоляторе (КНИ). Ее идея состояла в том, что в случае синтезирования монокристаллического кремния на диэлектрической подложке исчезает необходимость в создании изолирующих p-n переходов между элементами ИС, замедляющих работу приборов.
Как разновидность метода КНИ используется технология кремний на сапфире (КНС). В КНС технологии в качестве подложки используется сапфир - Al2O3. На него эпитаксиальным способом наносят слои полупроводников, например, кремния или арсенида галлия. Процесс является гетероэпитаксиальным, так как материал слоя и подложки отличаются (например, AlxGa1-x выращивается на GaAs). В качестве кремнийсодержащего соединения наиболее часто выбирают силан, газом-носителем служит водород. При нагревании происходит пиролиз силана:
|
|
|
SiH4  Si+2H2 .
Si+2H2 .
Основные параметры КНС следующие:
- температура роста от 1000 до 1050 °С,
- скорость роста до 0.5 мкм/мин,
- толщина слоя не превышает 1 мкм,
- уровень легирования находится в диапазоне 1014-1016 см-3.
Поскольку материалы подложки и полупроводника не являются "родственными" и имеет место автолегирование Al из подложки, то полупроводник обладает высокой плотностью дефектов. Эти дефекты обуславливают значительные токи утечки p-n переходов, малое время жизни и низкую подвижность носителей. Поэтому КНС технологии можно использовать только при производстве приборов, работающих на основных носителях, например, КМОП схем.
Для уменьшения автолегирования Al из подложки полупроводники наносят молекулярно-лучевым способом, имеющим низкие температуры процесса.
В КНИ технологии в качестве диэлектрической подложки используется слой SiO2. Он может быть сформирован во внутренних частях монокристалла кремния путем его ионного легирования кислородом на определенную глубину с последующим отжигом в инертной атмосфере.
 Возможен другой вариант. В технологическом цикле осуществляют процесс рекристаллизации аморфного кремния, осажденного на двуокись кремния (см. рис. 1). Рекристаллизация производится за счет локального нагрева участка поверхности лазером или электронным лучом. Слой монокристаллического кремния, граничащий поликристаллом или аморфным слоем Si, играет роль затравки, а SiO2 используется для уменьшения загрязнений в кремнии.
Возможен другой вариант. В технологическом цикле осуществляют процесс рекристаллизации аморфного кремния, осажденного на двуокись кремния (см. рис. 1). Рекристаллизация производится за счет локального нагрева участка поверхности лазером или электронным лучом. Слой монокристаллического кремния, граничащий поликристаллом или аморфным слоем Si, играет роль затравки, а SiO2 используется для уменьшения загрязнений в кремнии.
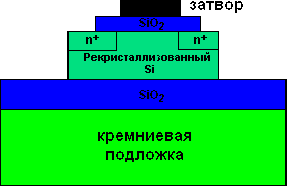 Существует и третий способ, который можно использовать для изготовления МОП транзистора (см. рис. 2). На окисленную подложку монокремния наносят островки поликремния, которые впоследствии рекристаллизуют.
Существует и третий способ, который можно использовать для изготовления МОП транзистора (см. рис. 2). На окисленную подложку монокремния наносят островки поликремния, которые впоследствии рекристаллизуют.
Отметим, что кремний, полученный по КНИ технологии, имеет меньшую плотность дефектов, чем КНС кремний. Развитие КНИ технологии может послужить толчком в создании ИС нового поколения- трехмерных интегральных схем.
|
|
|
|
|
Дата добавления: 2014-12-27; Просмотров: 602; Нарушение авторских прав?; Мы поможем в написании вашей работы!