
КАТЕГОРИИ:
Архитектура-(3434)Астрономия-(809)Биология-(7483)Биотехнологии-(1457)Военное дело-(14632)Высокие технологии-(1363)География-(913)Геология-(1438)Государство-(451)Демография-(1065)Дом-(47672)Журналистика и СМИ-(912)Изобретательство-(14524)Иностранные языки-(4268)Информатика-(17799)Искусство-(1338)История-(13644)Компьютеры-(11121)Косметика-(55)Кулинария-(373)Культура-(8427)Лингвистика-(374)Литература-(1642)Маркетинг-(23702)Математика-(16968)Машиностроение-(1700)Медицина-(12668)Менеджмент-(24684)Механика-(15423)Науковедение-(506)Образование-(11852)Охрана труда-(3308)Педагогика-(5571)Полиграфия-(1312)Политика-(7869)Право-(5454)Приборостроение-(1369)Программирование-(2801)Производство-(97182)Промышленность-(8706)Психология-(18388)Религия-(3217)Связь-(10668)Сельское хозяйство-(299)Социология-(6455)Спорт-(42831)Строительство-(4793)Торговля-(5050)Транспорт-(2929)Туризм-(1568)Физика-(3942)Философия-(17015)Финансы-(26596)Химия-(22929)Экология-(12095)Экономика-(9961)Электроника-(8441)Электротехника-(4623)Энергетика-(12629)Юриспруденция-(1492)Ядерная техника-(1748)
Основные понятия и тенденции
|
|
|
|
Вплоть до начала 2000х годов прогресс в микроэлектронной промышленности практически полностью определялся темпами развития литографии. В настоящее время при переходе от одной топологической нормы к другой её роль хоть и слегка уменьшилась, но, тем не менее, по-прежнему остаётся определяющей. Согласно прогнозам специалистов ведущих фирм-производителей литографического оборудования, вплоть до достижения топологической нормы 45 нм, основным процессом формирования резистивных масок останется проекционная фотолитография.
Основной параметр, характеризующий совершенство и качество фотолитографии, – это воспроизводимое и стабильно получаемое разрешение, или минимальный размер элемента, Δ. При этом топологическая норма определяется как полуширина линии и пространства между линиями в регулярных плотно упакованных полосчатых структурах. Естественно, что разрешение для изолированных элементов (элементы топологического рисунка, расстояние между которыми в несколько раз превышает их характерный размер, например затворы транзисторов) может быть в 1,4–1,8 раз меньше топологической нормы.
В первом приближении предельное разрешение оптической литографии описывается выражением:
Δ= k 1λ / NA, (5.1)
где λ – длина волны экспонирующего излучения, NA – числовая апертура проекционных линз, характеризующая способность линз собирать преломлённые лучи света, и определяемая как
NA = n· sin θ, (5.2)
где n – это показатель преломления среды над фоторезистивной маской, а θ – это наибольший угол сбора лучей с поверхности фоторезистивной маски. Если среда это воздух, то n = 1 и, следовательно, максимальное значение NA не может превысить 1. Величина параметра k 1 отражает кумулятивный эффект влияния таких факторов как способ и характеристики освещения, плотность и тип рисунка на фотошаблоне, толщина, состав и свойства фоторезистивного слоя, наличия антиотражающих покрытий и контрастоусиливающих материалов на поверхности Si пластины. Теория дифракции даёт минимальное значение для k 1 = 0,25. Для простых рисунков фотошаблона при низкой плотности линий k 1 может уменьшаться до 0,05 и менее.
Для получения максимальной разрешающей способности Δнеобходимо
уменьшать длину волны экспонирующего излучения λ,
уменьшать параметр k 1,
а также увеличивать числовую апертуру NA.
Все эти три возможности активно используются для развития метода проекционной литографии.
Уменьшение величины λ является одним из основных направлений увеличения разрешающей способности. Использование в литографических установках излучения со всё более короткой длиной волны определяется скоростью разработки и внедрения новых источников электромагнитного излучения, а также созданием оптических систем из новых прозрачных для короткого ультрафиолетового (КУФ) излучения материалов.
В первых установках оптической литографии использовались источники немонохроматического излучения на основе ртутных дуговых ламп
λ = 436 (g -линия),
405 нм (h -линия),
365 нм (i -линия),.
250 нм (глубокий УФ).
Затем были разработаны источники когерентного монохроматического излучения:
KrF лазер (λ = 248 нм, КУФ, Δ= 350–130 нм),
ArF лазер (λ = 193 нм, КУФ, Δ= 90–45 нм (возможно вплоть до 32 нм)),
F2 лазер (λ = 157 нм, вакуумный УФ).
В настоящее время заканчивается разработка и внедрение импульсных источников лазерной плазмы с длиной волны λ ≈ 13 нм (экстремальный УФ (ЭУФ)). Дальнейшая эволюция источников электромагнитного излучения для оптической литографии может пойти по пути использования рентгеновского синхротронного излучения с λ≈1 нм и менее.
Эволюция длины волны экспонирующего излучения, поставленная в соответствие с реализуемой топологической нормой, представлена на рис.5.1. Видно, что до середины 90х годов прошлого столетия λ была меньше топологической нормы. Однако, затем ситуация изменилась, и λ стала существенно превышать минимальный размер элемента. В настоящее время топологическая норма в три раза меньше длины волны излучения, и в ближайшее время эта разница возрастёт вплоть до четырёх раз.

Рис.5.1 - Эволюция длины волны экспонирующего излучения в сравнении с эволюцией топологической нормы: 1 – длина волны; 2 – топологическая норма
Другой способ улучшения разрешающей способности фотолитографии, согласно выражению 5.1, связан с уменьшением параметра k 1. Величина k 1 изменилась с 0,8 в 1980 году до 0,4–0,35 в настоящее время. В ближайшие годы ожидается дальнейшее уменьшение k 1 вплоть до 0,3–0,25.
Этот прогресс связан с внедрением:
внеосевого освещения, когда распределения интенсивности света по сечению пучка неоднородно и имеет специальную форму, получаемую с помощью диафрагм, вырезающих из осевого цилиндрического пучка излучение внеосевых трубчатых (кольцевых в сечении) или квадрупольных (четыре полюса в сечении) пучков;
фазосдвигающих фотошаблонов, когда осуществляется управление не только амплитудой проходящего через шаблон излучения, но и его фазой, что позволят за счёт интерференции получать лучшее разрешение в резисте (рис.5.2 и 5.3);
коррекции эффекта близости элементов топологического рисунка на фотошаблоне с помощью дополнительных служебных элементов, повышающих точность передачи рисунка в фоторезистивную маску, нарушенную вследствие влияния дифракции (рис.5.4);
пленок контрастоусиливающего материалов, наносимых поверх слоя фоторезиста;
пленок антиотражающих покрытий, формируемых под слоем фоторезиста, что позволяет уменьшить влияние отраженного от подложки излучения на точность передачи топологического рисунка.
Схема, поясняющая принцип работы фазосдвигающих шаблонов, а так же две возможные конструкция шаблонов представлены на рис.5.2 и 5.3. В том случае, когда используется обычный фотошаблон, изображение в резисте от одного окна в фотошаблоне будет несколько размытым за счёт дифракции света (рис.5.2, а).

Рис. 5.2 - Схема, поясняющая принцип работы фазосдвигающего шаблона: а – амплитуда и интенсивность излучения; б – рисунок в резисте
В случае двух близкорасположенных окон, ситуация усугубляется за счёт сложения амплитуд дифрагированных волн в области между окнами. Интенсивность света на поверхности резиста между двумя окнами становится отличной от нуля, что приводит к засветке резиста в этом месте. В результате в резисте вместо двух линий получится одна более широкая линия (рис.5.2, б). В случае фазосдвигающего шаблона, световые волны, проходящие сквозь рядом лежащие окна, за счёт нанесения специального покрытия на область одного из окон, имеют противоположные фазы. В результате в пространстве между окнами происходит не сложение, а вычитание амплитуд волн, что и приводит к росту разрешающей способности и прорисовке в резисте обеих линий (рис.5.2, а, б).
Сдвиг фазы световой волны на 180 градусов реализуется за счёт изменения длины её оптического пути. Это может быть осуществлено за счёт осаждения прозрачной плёнки на поверхность одного из двух рядом лежащих окон (рис.5.3, а). При этом толщина плёнки выбирается, исходя из выражения
d 1 = λ / 2 (n f - 1), (5.3)
где d 1 – толщина плёнки, n f – показатель преломления материала плёнки.

Рис. 5.3 - Фазосдвигающие шаблоны, в которых сдвиг фазы световой волны на 180 градусов: а - реализуется за счёт осаждения прозрачной плёнки; б – за счёт травления материала фотошаблона
Второй способ создания сдвига фазы это травление материала фотошаблона (обычно кварца) внутри одного из двух рядом лежащих окон на глубину задаваемую следующим выражением
d 2 = λ / 2 (n g - 1), (5.4)
где d 2 – глубина травления материала шаблона, n g – показатель преломления материала шаблона (рис.5.3, б).
Как уже упоминалось выше, для коррекции эффекта близости в рисунок фотошаблона приходится вводить дополнительные служебные элементы, которые частично компенсируют влияние дифракции. На рис.5.4, а приведено изображение элемента, которое необходимо получить в слое резиста, а также его изображение в фотошаблоне с корректирующими элементами (рис.5.4, б). Видно, что только для коррекции эффекта близости уже приходится существенным образом усложнять рисунок фотошаблона. Дальнейшее усложнение происходит при добавлении фазосдвигающих элементов.

Рис.5.4 - Изображения элементов в фотошаблоне (а, б) и в слое резисте (в, г) без применения элементов коррекции (в) и с их использованием (г)
На рис.5.5 представлена зависимость роста числа элементов на фотошаблоне от топологической нормы. Данная зависимость имеет ярко выраженный экспоненциальный характер и обусловлена введением дополнительных элементов для коррекции эффекта близости, а также фазосдвигающих элементов.

Рис.5.5 - Рост числа элементов на фотошаблоне и на полупроводниковой пластине в зависимости от топологической нормы
Ещё одна возможность уменьшения минимального размера элемента, согласно выражению 5.1, может быть связана с ростом величины NA. Из того, что числовая апертура определяется как
NA = 2 r 0 / D, (5.5)
где r 0 – радиус линз, D – расстояние от пластины до линзы, следует, что рост NA может быть обеспечен увеличением диаметра линз проекционной системы.
Развитие техники в этом направлении привело к тому, что величина NA выросла от 0,5 в 1990 г. до 0,8 в 2004 г. и до. 0,93 сегодня. Предполагается дальнейший рост NA вплоть до величины близкой к единице. Однако на пути совершенствования линз встречаются большие трудности. Так, например, длина, диаметр и вес системы проекционных линз, уменьшающих рисунок шаблона, сегодня составляют около 1 м, 0,5 м и 1000 кг, соответственно. Понятно, что изготовление таких больших линз сопряжено с определёнными трудностями. Кроме того, темп роста стоимости линз существенно обгоняет темп уменьшения величины Δ LW, так как стоимость растёт пропорционально NA 3 (объёму линзы), а Δ LW уменьшается пропорционально 1/ NA.
Согласно формуле 5.2 другая возможность для увеличения NA связана с ростом показателя преломления среды, находящейся между последней линзой и полупроводниковой структурой. Это направление развития называется иммерсионной литографией и будет рассмотрено в следующем разделе.
Кроме разрешающей способности, другим важным параметром фотолитографии является глубина фокуса DF, т.е. вертикальный размер области вблизи фокальной плоскости выходной проекционной линзы, в которой уменьшенное изображение топологического рисунка фотошаблона еще имеет достаточную четкость для реализации процесса литографии. Глубина фокуса определяется из выражения
DF = k 2 λ / 2 NA 2, (5.6)
где k 2 – экспериментально определяемый коэффициент пропорциональности, примерно равный 0,5. В настоящее время глубина фокуса имеет величину меньше одного микрона, что сравнимо с толщиной плёнки резиста. В связи с этим фокальное изображение шаблона проецируется не на поверхность, а внутрь плёнки резиста на расстояние равное половине толщины плёнки (рис.5.6).
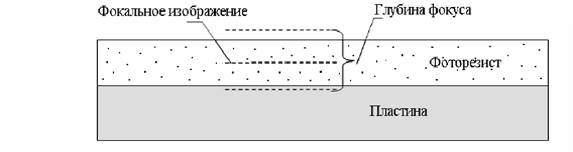
Рис.5.6 - Фокальное изображение рисунка фотошаблона в слое резиста
Анализ связи между глубиной фокуса и разрешением (формулы 5.1. и 5.6) показывает, что чем выше разрешение, тем меньше глубина фокуса и тем более жесткие требования предъявляются к точности системы экспонирования, а также к планарности и рельефу поверхности пластины. Поэтому с точки зрения получения приемлемой глубины фокуса, выгоднее уменьшать длину волны экспонирующего излучения, чем увеличивать числовую апертуру.
|
|
|
|
Дата добавления: 2014-01-15; Просмотров: 853; Нарушение авторских прав?; Мы поможем в написании вашей работы!