
КАТЕГОРИИ:
Архитектура-(3434)Астрономия-(809)Биология-(7483)Биотехнологии-(1457)Военное дело-(14632)Высокие технологии-(1363)География-(913)Геология-(1438)Государство-(451)Демография-(1065)Дом-(47672)Журналистика и СМИ-(912)Изобретательство-(14524)Иностранные языки-(4268)Информатика-(17799)Искусство-(1338)История-(13644)Компьютеры-(11121)Косметика-(55)Кулинария-(373)Культура-(8427)Лингвистика-(374)Литература-(1642)Маркетинг-(23702)Математика-(16968)Машиностроение-(1700)Медицина-(12668)Менеджмент-(24684)Механика-(15423)Науковедение-(506)Образование-(11852)Охрана труда-(3308)Педагогика-(5571)Полиграфия-(1312)Политика-(7869)Право-(5454)Приборостроение-(1369)Программирование-(2801)Производство-(97182)Промышленность-(8706)Психология-(18388)Религия-(3217)Связь-(10668)Сельское хозяйство-(299)Социология-(6455)Спорт-(42831)Строительство-(4793)Торговля-(5050)Транспорт-(2929)Туризм-(1568)Физика-(3942)Философия-(17015)Финансы-(26596)Химия-(22929)Экология-(12095)Экономика-(9961)Электроника-(8441)Электротехника-(4623)Энергетика-(12629)Юриспруденция-(1492)Ядерная техника-(1748)
Травление антиотражающих покрытий (АОП)
|
|
|
|
Особенности ТРАВЛЕНИЯ субмикронных МИКРОСТРУКТУР
Как упоминалось ранее, литография в суб – 0,25 мкм области требует использования пленок с очень низкой отражающей способностью, чтобы обеспечить получение требуемых размеров. Благодаря использованию антиотражающих покрытий (АОП), отражение может быть минимизировано благодаря поглощению большей части падающего светового потока или исключению интерференции. АОП могут быть или органические, или неорганические и могут быть нанесены как поверх, так и под фоторезистом. Структура, наиболее часто используемая в промышленности - абсорбционное, органическое, антиотражающее покрытие (нижнее антиотражающее покрытие НАОП) – будет темой нашего обсуждения. Органическое НАОП обычно травится с использованием стандартного плазменного оборудования. Газы, используемые для травления АОП, как правило, основаны на кислород или фтор – углерод содержащих смесях. Механизм травления обычно химический. Тяжелые газы, например, аргон, добавляются для обеспечения распылительной компоненты процесса. Также могут быть использованы такие газы, как СО, СО2, N2 или Cl2. Обычно используется комбинация двух или более газов. Дополнительные требования для сухих процессов травления АОП (помимо низкой привносимой дефектности, высокой производительности и т.д.) включают:
· Минимальный уход критических размеров (обычно, менее чем 10% от заданного на фотошаблоне).
· Минимальное травление фоторезиста.
· Минимальная деградация фоторезиста в процессе травления АОП.
· Минимальный подтрав подложки и, как следствие этого, возможность реставрации фотолитографии (это специфическое требование и порой более критичное, по сравнению с другими).
Первые три позиции взаимосвязаны и основная трудность при травлении органических АОП возникает из-за того, что фоторезист также является органической пленкой и, следовательно, любые газовые смеси, используемые для травления АОП, будут также травить и фоторезист. Хотя боковая составляющая скорости травления (и, следовательно, изменение критических размеров) может контролироваться настройкой параметров процесса сухого травления, скорости анизотропного травления фоторезиста и АОП оказываются почти одинаковыми. Для DUV материалов, природа фоторезиста определяет их более быстрое травление, по сравнению с материалами, основанными на новолаке (MUV or I-line). Следовательно, при травлении АОП могут иметь место большие потери фоторезиста. На рисунке 2.1 представлены относительные скорости травления нескольких коммерчески доступных материалов АОП и фоторезистов. Данные получены для травления при малой мощности в среде, основанной на CF4 в реакторе РИТ с емкостной связью.

Рис.2.1
Конечно, эти характеристики травления значительно зависят от параметров процесса и могут изменяться в зависимости от применения. Скорости травления АОП должны быть значительно выше, чем скорости травления фоторезиста. Хотя более новые DUV материалы АОП имеют тенденцию травиться более быстро, чем BARL, имеет место тенденция к изменению характеристик травления DUV резистивных материалов. Благодаря тому, что для получения данных, представленных на рис.2.1 использовались условия малой мощности травления, наибольшая разница в скоростях травления (на 11% большая скорость травления) наблюдается для “Resist - 5” по сравнению с BARL. Только один из DUV резистов имеет желаемую более низкую скорость травления по отношению к BARL, хотя характеры травления новых АОП и резистов сравнимы. Д-АОП (диэлектрические АОП или АОП, полученные методом CVD) выделяются отдельно на рис. 2.1. Они имеют желаемую высокую скорость травления по сравнению с BARL и всеми другими, использованными в данном случае, резистивными материалами. Характеристики травления диэлектрических АОП близки к характеристикам травления любых других диэлектрических материалов, и могут настраиваться для обеспечения лучшей селективности травления по отношению к органическим фоторезистам. Важно отметить, что композиция диэлектрических АОП является критичной для достижения преимуществ в селективности травления. Ранние эксперименты показали, что изменение их состава для оптимизации оптических характеристик (например, увеличение коэффициента затухания для усиления поглощения света) вызывает значительные изменения в скорости травления. Материалы для антиотражающих покрытий все еще продолжают разрабатываться, и стремление улучшить антиотражающие свойства также заставляет добиваться и увеличения их скоростей травления. Из перспектив сухого травления вытекают основные требования к АОП – минимизация ухода критических размеров (КР) и минимальные потери толщины фоторезиста и подложки.
2.2. Анализ особенностей ТРАВЛЕНИя ДИЭЛЕКТРИческих слоев субмикронных микроструктур .
Обработка диэлектриков, особенно окисла кремния и нитрида кремния - неотъемлемая часть производства современных полупроводниковых устройств. Благодаря большой энергии связи при травлении диэлектриков требуются системы, основанные на фторсодержащих газовых смесях и сильной ионной бомбардировке. Вертикальные профили травления достигаются благодаря пассивации боковых стенок за счет введения в плазму углеродсодержащих компонентов. Сильная ионная бомбардировка необходима для удаления полимера с горизонтальных поверхностей, а также для внедрения активных частиц внутрь поверхности окисла для последующего образования летучего SiFx. При травлении диэлектриков полагаются на соотношение скоростей процессов полимеризации и РИТ, чтобы обеспечить как вертикальный профиль, так и остановку процесса травления на нижележащем слое. В то время как размер окон твердой маски приближается к 0,18 мкм, аспектное соотношение возрастает до 6:1 и более.
Поток радикалов и ионов на нижнюю поверхность этих структур уменьшается из-за столкновений с боковыми стенками структуры и другими частицами. Продукты травления (SixFyOz и CxFy) не могут свободно диффундировать из таких структур, что приводит к интенсивной полимеризации в области дна структуры, что создает конический профиль травления и плохую передачу размеров маски. Другим аспектом этой проблемы является задержка РИТ, которая, как описано выше, вызывается зависимостью глубины травления от размеров структуры. Ионы теряются из-за заряда на диэлектрических стенках, в то время как диффузия нейтралов внутрь и из структуры затруднены из-за столкновений с другими частицами. Простое увеличение мощности разряда для повышения потока ионов и радикалов в традиционных системах приводит к деструкции фоторезиста и внесению дефектов в обрабатываемый слой. Четыре основных механизма повышения анизотропии и задержки РИТ были определены Бьюи:
Ионное затенение.
Рассеивание и зарядовый обмен в ОПЗ делает поступающие ионы изотропными. Снижение рабочего давления снижает вероятность столкновений, позволяя большему количеству входящих ионов достигать нижней поверхности структуры. В то же время, работа в режиме высокоплотной плазмы, который понижает толщину ОПЗ, снижает вероятность столкновений ион-нейтрал или столкновений с обменом заряда.
Затенение нейтралами
Столкновения, как с другими частицами, так и с боковыми стенками структуры, замедляет поток химически активных нейтралов (например, F) внутрь структуры. Доступ нейтральных частиц к нижней части структуры, необходимый для удаления полимера и формирования летучих продуктов травления, затрудняется. Уменьшение давления снижает эффект.
Накопление заряда
Электроны, из-за их высокого коэффициента диффузии и более протяженной средней длины свободного пробега, имеют тенденцию, преимущественно заряжать верхние части травимой структуры и области фоторезиста. Как результат, ионы отклоняются к боковым стенкам, что может приводить к их травлению. Это иллюстрируется микрофотографией профиля структуры на рисунке 2.2. Для устранения данного эффекта необходимо более тщательно подбирать плазменные химические системы и правильно организовывать ионный поток.

Рис.2.2.
Транспортировка нейтральных продуктов
Обратный поток продуктов травления со дна структуры может сталкиваться с входящими частицами или переосаждаться на дне структуры, значительно увеличивая высадку полимера. Уменьшение рабочего давления снижает этот эффект за счет возрастания летучести продуктов реакции и увеличения длины их свободного пробега.
Анизотропное травление диэлектрика проводится в двух случаях:
Во-первых, когда диэлектрик используется в качестве маскирующего слоя для травления нижележащего материала. Ключевое требование заключается в том, чтобы размеры литографической маски были перенесены в диэлектрический слой без изменений. Селективность к нижележащему слою не требуется и может быть даже нежелательной, поскольку диэлектрик при последующих этапах травления используется в качестве маски. Соответственно, целостность передаваемого изображения является первостепенной.
Во-вторых, диэлектрический материал должен быть протравлен без передачи изображения в нижележащий слой. Например, окно в окисле кремния часто должно открываться на поверхность нитрида кремния, который действует как стоп – слой изолирующий нижележащие проводники. Здесь селективность играет первостепенную роль и процесс травления (газовые смеси и тип реактора) выбираются так, чтобы обеспечить достаточную полимеризацию для защиты нижележащих слоев.
Второй случай селективного травления диэлектрика может в дальнейшем быть разделен на два класса, основанных на топографии нижележащих слоев. Первый – типичный случай травления контактного окна, которое, например, может находиться на плоской поверхности нитридного стоп – слоя. Этот стоп – слой может использоваться для обеспечения необходимого времени перетрава для коррекции неоднородности толщины травимого диэлектрического слоя и/или для защиты нижележащих пленок, которые могут быть повреждены при взаимодействии с химической системой плазмы. Например, на рис.2.3 травление нитридного спейсера было выполнено селективно по отношению к тонкому нижележащему окислу. Если этот тонкий окисел будет сильно задет во время травления нитрида, то легированные области могут быть также повреждены как во время травления, так и распылением при последующем проведении операции ионного легирования.
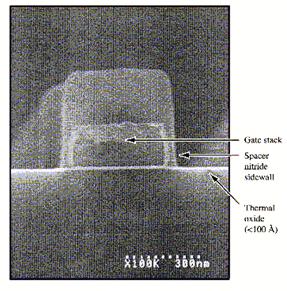
Рис.2.3.
Другой класс селективного травления диэлектрика находится вне характеристик топологии, например, самосовмещенный контакт (ССК) травится поверх структуры затвора. В этом «безкраевом» травлении нижележащая шапка нитрида и подкладка используются для защиты проводника затвора от закорачивания с контактом разводки. Здесь требуется селективность к нижней части структуры, на боковых стенках, углах и верхней части затвора. Достижение селективности в этом случае является более важным, поскольку защитные полимерные пленки и молекулы нижележащей подложки имеют тенденцию более легко, по сравнению с плоскими поверхностями, распыляться на углах структуры.
|
|
|
|
Дата добавления: 2014-01-15; Просмотров: 1181; Нарушение авторских прав?; Мы поможем в написании вашей работы!