
КАТЕГОРИИ:
Архитектура-(3434)Астрономия-(809)Биология-(7483)Биотехнологии-(1457)Военное дело-(14632)Высокие технологии-(1363)География-(913)Геология-(1438)Государство-(451)Демография-(1065)Дом-(47672)Журналистика и СМИ-(912)Изобретательство-(14524)Иностранные языки-(4268)Информатика-(17799)Искусство-(1338)История-(13644)Компьютеры-(11121)Косметика-(55)Кулинария-(373)Культура-(8427)Лингвистика-(374)Литература-(1642)Маркетинг-(23702)Математика-(16968)Машиностроение-(1700)Медицина-(12668)Менеджмент-(24684)Механика-(15423)Науковедение-(506)Образование-(11852)Охрана труда-(3308)Педагогика-(5571)Полиграфия-(1312)Политика-(7869)Право-(5454)Приборостроение-(1369)Программирование-(2801)Производство-(97182)Промышленность-(8706)Психология-(18388)Религия-(3217)Связь-(10668)Сельское хозяйство-(299)Социология-(6455)Спорт-(42831)Строительство-(4793)Торговля-(5050)Транспорт-(2929)Туризм-(1568)Физика-(3942)Философия-(17015)Финансы-(26596)Химия-(22929)Экология-(12095)Экономика-(9961)Электроника-(8441)Электротехника-(4623)Энергетика-(12629)Юриспруденция-(1492)Ядерная техника-(1748)
Литография с экстремальным ультрафиолетом
|
|
|
|
______________________________________________________________________
EUVL является обычной оптической литографией, но с использованием излучения с длиной волны 11 - 14 нм и отражательными оптикой и фотошаблонами. Источниками излучения в EUVL на первом этапе развития подобных систем служило синхротронное излучение. Однако позже был разработан малогабаритный источник предельного ультрафиолета, принцип работы которого основан на использовании излучения из лазерной плазмы. Излучение стандартного Nd:YAG лазера (1063 нм длина волны, 40 Вт мощность, 100 Гц частота, 5 нс длительность) фокусируется на импульсной газовой струе Xe кластеров. Образующаяся лазерная плазма содержит широкую спектральную полосу предельного ультрафиолета с  ~10-25нм. Оптическая система содержит набор зеркал между источником света и маской. Набор зеркал между маской и подложкой с резистивным обеспечивает уменьшение размера изображения в 4 раза. Схема установки приведена на рис. 22. Все отражательные оптические системы должны быть асферическими с размером неоднородностей ~10 Å. Эти зеркала представляют собой сложные пленочные покрытия: от 40 до 80 двухслойных пленок с толщиной каждого слоя ~
~10-25нм. Оптическая система содержит набор зеркал между источником света и маской. Набор зеркал между маской и подложкой с резистивным обеспечивает уменьшение размера изображения в 4 раза. Схема установки приведена на рис. 22. Все отражательные оптические системы должны быть асферическими с размером неоднородностей ~10 Å. Эти зеркала представляют собой сложные пленочные покрытия: от 40 до 80 двухслойных пленок с толщиной каждого слоя ~  /4. Такое же сложное строение имеет маска для EUV литографии, которая схематично представлена на рис. 22.
/4. Такое же сложное строение имеет маска для EUV литографии, которая схематично представлена на рис. 22.

Рис. 22. Схема EUV литографии.
Подобный литографический процесс позволяет рисовать линии с разрешением до 50 нм. Однако большой проблемой подобных систем является малое поле зрения оптической схемы, что не позволяем экспонировать всю поверхность кремниевой подложки. Подобные системы, как впрочем, и все другие с малой величиной  , требует применения системы сканирования изображения маски по поверхности подложки.
, требует применения системы сканирования изображения маски по поверхности подложки.
Если принять во внимание двадцатикратное снижение длины волны (от 248 до 20 нм), что позволит снизить значение численной апертуры и увеличить тем самым глубину фокуса и поле зрения оптических схем, то переход к EUV литографии позволил перейти 100 нм рубеж, оставаясь в рамках традиционной фотолитографии. Однако сложная зеркальная оптика и дорогостоящая технология изготовления фотошаблонов делает такой подход исключительно дорогостоящим и оставляет место для разработки литографических процессов основанных на иных физических принципах.
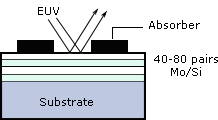
Рис. 23. Схема маски для EUV литографии.
______________________________________________________________________
|
|
|
|
Дата добавления: 2014-01-20; Просмотров: 1822; Нарушение авторских прав?; Мы поможем в написании вашей работы!