
КАТЕГОРИИ:
Архитектура-(3434)Астрономия-(809)Биология-(7483)Биотехнологии-(1457)Военное дело-(14632)Высокие технологии-(1363)География-(913)Геология-(1438)Государство-(451)Демография-(1065)Дом-(47672)Журналистика и СМИ-(912)Изобретательство-(14524)Иностранные языки-(4268)Информатика-(17799)Искусство-(1338)История-(13644)Компьютеры-(11121)Косметика-(55)Кулинария-(373)Культура-(8427)Лингвистика-(374)Литература-(1642)Маркетинг-(23702)Математика-(16968)Машиностроение-(1700)Медицина-(12668)Менеджмент-(24684)Механика-(15423)Науковедение-(506)Образование-(11852)Охрана труда-(3308)Педагогика-(5571)Полиграфия-(1312)Политика-(7869)Право-(5454)Приборостроение-(1369)Программирование-(2801)Производство-(97182)Промышленность-(8706)Психология-(18388)Религия-(3217)Связь-(10668)Сельское хозяйство-(299)Социология-(6455)Спорт-(42831)Строительство-(4793)Торговля-(5050)Транспорт-(2929)Туризм-(1568)Физика-(3942)Философия-(17015)Финансы-(26596)Химия-(22929)Экология-(12095)Экономика-(9961)Электроника-(8441)Электротехника-(4623)Энергетика-(12629)Юриспруденция-(1492)Ядерная техника-(1748)
Конструкции биполярных транзисторов
|
|
|
|
Тема 2: Проектирование полупроводниковых ИС на биполярных транзисторах
Основным схемным элементом биполярных ИС является биполярный n-p-n транзистор. Он обладает лучшими характеристиками, чем p-n-p транзистор, а технологически его изготавливать проще, поэтому все остальные элементы биполярных ИС выбирают и конструируют исходя из технологии и конструкции n-p-n транзистора. Практически все элементы изготавливают на основе переходов n-p-n транзистора. В современных ИС широкое распространение получил n+-p-n транзистор со скрытым подколлекторным n+ слоем, выполненный по планарно-эпитаксиальной технологии. Вид такого транзистора в разрезе изображен на рисунке.

Необходимость скрытого n+ слоя объясняется следующими причинами: тело коллектора имеет высокое удельное сопротивление (т.к. коллектор слабо легирован), а вывод коллектора располагается на поверхности. В результате получается большой путь для тока коллектора и потери в коллекторе. Увеличить легирование области коллектора и снизить удельное сопротивление не представляется возможным, т.к. в этом случае резко снижается пробивное напряжение коллекторного перехода. Выходом является формирование скрытого подколлекторного n+слоя. Он играет роль шунтирующей проводящей перемычки с малым сопротивлением, через которую протекает весь придонный ток транзистора. Конструктивно этот слой располагается непосредственно под всей базовой областью и простирается до области коллекторного контакта. Толщина этого слоя 2,5-10 мкм, удельное поверхностное сопротивление rs=10-30 Ом/ٱ. Рабочая зона транзистора начинается непосредственно под эмиттерным контактом и для обеспечения требуемого коллекторного тока при минимальном падении напряжения стараются коллекторный контакт расположить как можно ближе к эмиттерному. Минимальные горизонтальные размеры транзистора определяются двумя основными технологическими факторами:
1. Минимально достижимыми при фотолитографии размерами окон в окисле кремния и зазорами между ними.
2. Размер боковой диффузии под окисел.
Поэтому при проектировании транзисторов следует учитывать, что расстояние между базовой областью и коллекторным контактом должно быть значительно больше суммарных размеров боковой диффузии двух областей. Расстояние между изоляцией p-области и элементами транзистора также определяются размерами боковой диффузии. Эти расстояния примерно равны толщине эпитаксиального слоя и составляют 3,5-12 мкм.
Существует две основных конструкции биполярного транзистора. Они изображены на рисунках.


не симметричная конструкция симметричная конструкция
В несимметричной конструкции ток от коллектора к эмиттеру протекает только с одной стороны, а в симметричной – с трех сторон. В результате этого сопротивление коллектора получается в три раза меньше, что означает улучшение частотных характеристик и переключательных свойств, а также облегчает разводку соединений между транзисторами.
Рассмотренные конструкции транзисторов хорошо работают только при малых токах (IK<1мА), т.к. в области средних и больших токов существенную роль начинает играть эффект вытеснения тока эмиттера (резко падает коэффициент передачи тока b), поэтому в мощных транзисторах для увеличения b стараются обеспечить максимальное отношение периметра эмиттера к его площади. С этой целью целесообразно использовать узкий эмиттер с большим периметром. Этого удается достичь за счет «гребенчатой» конструкции эмиттера, причем чем мощнее транзистор, тем больше «гребенок».

Одной из характеристик транзистора являются значения пробивных напряжений двух его p-n-переходов. Обычно концентрация примесей на обеих сторонах p-n-перехода <1018 атомов/см3. Тогда пробой определяется началом лавинного умножения. Пробивное напряжение Uэб0 в 5-7 раз меньше, чем пробивное напряжение Uкб0, т.к. переход база-коллектор сформирован менее легированными слоями. Напряжение пробоя Uкэ0 меньше Uкб0 и оценивается по следующей формуле:  , где m=3 или 4. Пробой может также наступить в результате прокола базы. Такой прокол характерен для транзисторов с особо тонкой базой. Например, при ширине базы w=0,7 мкм пробой наступает при напряжении Uкэ0=3,5 В.
, где m=3 или 4. Пробой может также наступить в результате прокола базы. Такой прокол характерен для транзисторов с особо тонкой базой. Например, при ширине базы w=0,7 мкм пробой наступает при напряжении Uкэ0=3,5 В.
Характеристики транзистора зависят также от частоты сигнала. Эта зависимость объясняется физической структурой транзистора и наличием в нем паразитных элементов. Частота fТ, на которой коэффициент передачи по току в схеме с общим эмиттером падает до 1, называется предельной частотой коэффициента усиления тока. Другой частотной характеристикой является максимальная частота генерации fmax, при которой усиление по мощности падает до 1. Эти две характеристики связаны следующим соотношением:  , где
, где  – постоянная времени базы транзистора, S – ширина эмиттера.
– постоянная времени базы транзистора, S – ширина эмиттера.
Для обычного интегрального n-p-n транзистора fТ=400 МГц, fmax=500 МГц. Т.к. подвижность электронов значительно выше, чем подвижность дырок, то частотные свойства n-p-n транзисторов на порядок выше, чем у p-n-p. Несмотря на низкое пробивное напряжение, во входных каскадах аналоговых ИС широко применяются n-p-n транзисторы с тонкой базой. Такие транзисторы имеют b=2000-5000 при ширине базы w=0,2-0,3 мкм, коллекторном токе IK<20мкА и напряжении коллектор-эмиттер Uкэ=0,5 В. Пробивное напряжение таких транзисторов Uкэ0=1,5-2 В.
Многоэмиттерный транзистор
Этот тип транзистора широко используется в цифровых ИС. Число эмиттеров обычно колеблется от 2 до 8. Многоэмиттерный транзистор можно рассматривать как совокупность транзисторов с общими базами и коллекторами. При разработке конструкции многоэмиттерного транзистора приходится учитывать несколько обстоятельств. Для подавления действий паразитных n+-p-n+ транзисторов расстояние между краями соседних эмиттеров должно превышать диффузионную длину носителей заряда в базовом слое. Если структура легирована золотом, то диффузионная длина составляет 2-3 мкм, и указанные расстояния делают примерно равными 10-15 мкм. Для уменьшения паразитных токов через эмиттеры при инверсном включении необходимо искусственно увеличивать сопротивление пассивной области базы, удаляя базовый вывод от активной области транзистора. Кроме этого базовый контакт соединяется с активной областью узким перешейком с сопротивлением 200-300 Ом.


Многоколлекторный транзистор
Такой транзистор является основой логики И2Л. Многоколлекторный транзистор это практически многоэмиттерный транзистор в инверсном включении. В этом случае общим эмиттером является эпитаксиальный слой n, а коллектором – n+ малых размеров. Главной проблемой при конструировании такого транзистора является обеспечении достаточно высокого коэффициента усиления в расчете на один коллектор. Для этого скрытый n+ слой располагают как можно ближе к базовому слою, а n+-коллекторы располагаются как можно ближе друг к другу.
Транзисторы типа p-n-p
Интегральный транзистор типа p-n-p существенно уступает n-p-n транзистору по коэффициенту усиления и предельной частоте. Кроме этого, технологический процесс настроен на изготовление n-p-n транзистора и поэтому p-n-p транзистор приходится производить по этой технологии. В ИС применяются следующие конструкции p-n-p транзистора:
1. Горизонтальный транзистор. В настоящее время эти транзисторы наиболее часто используются в ИС. Это обусловлено совместимостью технологий n-p-n транзистора и горизонтального p-n-p транзистора. Эмиттерный и коллекторный слои получаются на этапе базовой диффузии, причем коллекторный слой охватывает эмиттерный со всех сторон. Базовая область формируется на основе эпитаксиального слоя с подлегированием контактной области во время эмиттерной диффузии. Перенос носителей заряда происходит в горизонтальном направлении.


Перенос носителей заряда наиболее эффективен в приповерхностной области, т.к. здесь расстояние w минимально и кроме этого здесь наиболее высокая концентрация носителей заряда. Ширину базы w удается выполнить с минимальными размерами 3-4 мкм, ограниченными величиной боковой диффузии под окисел. В результате получается b≈50, fТ ≈20-40 МГц. При обычной технологии без труда удается получить w=6-12 мкм. При этом b≈1,5-20, fТ ≈2-5 МГц. Для подавления действия паразитных p-n-p транзисторов стремятся уменьшить площадь данной части эмиттера. Для этого его делают возможно более узким и используют скрытый n+ слой. На основе горизонтального транзистора легко сформировать многоколлекторный транзистор типа p-n-p. Для этого достаточно разрезать кольцо коллектора на несколько частей. Основным недостатком горизонтального p-n-p транзистора является сравнительно большая ширина базы и неоднородность распределения примесей в ней.
2. Дрейфовый транзистор.


Два электрода в противоположных концах базы создают в базовом слое электрическое поле, которое уменьшает время переноса инжектированных дырок и создает в эмиттере напряжение смещения, снижающее инжекцию из донной части транзистора. За счет этого коэффициент передачи тока b повышается до 10, а предельная частота fТ – до 10-30 МГц.
3. Вертикальный транзистор.

Для получения такой структуры приходится изменять технологию: проводится более глубокая диффузия для формирования p-слоя и вводится дополнительная операция диффузии для создания p++области, причем для получения p++ требуется акцепторная примесь, у которой предельная растворимость больше, чем у донорной примеси n+. Фактически перед проведением диффузии акцепторной примеси приходится стравливать наиболее легированную поверхностную часть n+ слоя, а это еще одна дополнительная технологическая операция.
Составные транзисторы

Составные транзисторы могут быть реализованы на основе двух транзисторов одного или различных типов, расположенных в одной изолированной области. В зависимости от подключения выводов можно получить различные конфигурации составных транзисторов:


Составной транзистор имеет коэффициент усиления bсост≈ b1·b2. Однако его быстродействие определяется наименьшим быстродействием входящих в него транзисторов.
Торцевые транзисторы
Торцевые транзисторы используются в быстродействующих маломощных ИС. Высокое быстродействие этих транзисторов объясняется малой емкостью p-n-переходов. Существует два варианта реализации этих транзисторов:

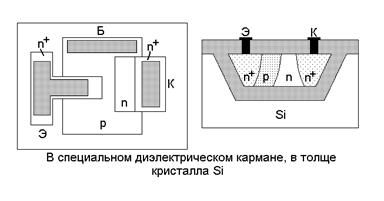
Малая емкость p-n-перехода получается за счет его малой площади. Удается добиться площади торцевой части эмиттера 6 мкм2, а торцевой части коллектора 30 мкм2. В результате получается емкость примерно 0,001 пФ. Это на 1-2 порядка меньше, чем в других типах транзисторов. Однако такой транзистор имеет небольшой коэффициент усиления по току (b≈2). Это объясняется тем, что в полупроводнике у границы раздела полупроводник-диэлектрик существует большая плотность дислокаций, возникающих из-за различия кристаллических решеток диэлектрика и кремния. Полупроводник с высокой плотностью дислокаций имеет малое время жизни неосновных носителей, а транзистор на его основе имеет малый коэффициент переноса носителей в области базы.
Из двух конструкций лучшими электрическими параметрами обладает торцевой транзистор, сформированный в толще кристалла и изолированный с помощью диэлектрика, т.к. диэлектрик здесь образован окислением кремния и имеет кристаллическую решетку почти такую же, как и у легированного кремния (b=20-30, но иногда достигает 100).
Транзисторы с повышенным пробивным напряжением

В целях повышения пробивного напряжения стараются уменьшить кривизну характеристик коллекторного p-n-перехода методом охранного кольца. В этом случае по периферии коллекторного перехода создается дополнительная диффузионная p-область с большей глубиной, чем расчетная глубина коллекторного перехода. Эта углубленная область имеет больший радиус кривизны и называется охранным кольцом. Ширина кольца выбирается минимальной с точки зрения технологии (5-10 мкм), чтобы не увеличивать емкость p-n-перехода. Применение охранного кольца позволяет увеличить пробивное напряжение с 50-70 В до 100-200 В.

В целях повышения пробивного напряжения может также применяться расширенный базовый контакт. В этой структуре высокоомная часть коллектора у поверхности p-n-перехода под действием обратного напряжения обедняется. Отрицательное напряжение на базовом контакте компенсируется действием положительного заряда в приповерхностной области коллекторного перехода. В результате создается расширенная область объемного заряда.

В транзисторе типа p-n-p для повышения пробивного напряжения может использоваться метод противоканальных колец. Этот метод позволяет избежать появления инверсных каналов у поверхности коллектора транзистора. В n-p-n транзисторах инверсные каналы на поверхности возникают редко, а для p-n-p транзисторов это типично. Для исключения этого явления высокоомная область коллектора p-типа рассекается p+-областью, в которой инверсия не возникает. Противоканальные кольца формируются одновременно с p+-эмиттером.
Транзисторы для быстродействующих и сверхбыстродействующих цифровых ИС
Имеется несколько путей повышения быстродействия транзисторов:
1. Транзистор с диодами Шоттки. Скорость переключения транзисторов, работающих в режиме насыщения, сильно ограничена временем рассасывания избыточного объемного заряда, который накапливается в области базы и коллектора. Это проблема легко решается при сочетании интегрального транзистора с диодом Шоттки, который шунтирует коллекторный переход транзистора.

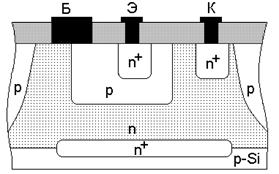
В этих конструкциях алюминиевая металлизация, обеспечивающая контакт с p-слоем базы, продлена в сторону коллекторного n-слоя. Алюминиевый пленочный проводник образует с p-слоем базы невыпрямляющий омический контакт, а с n-слоем коллектора – контакт Шоттки. На рисунке а) показан транзистор с диодом Шоттки, в котором контакт продлен до охранного кольца. На рисунке б) изображен транзистор с обычным расширенным электродом базы. Диоды Шоттки могут использоваться и в многоэмиттерных транзисторах. При этом диоды с p-n-переходами заменяются диодами Шоттки. Применение диодов Шоттки позволяет увеличить степень интеграции МС при одновременном увеличении быстродействия в 1,5-2 раза.
2. Уменьшение размеров элементов. Пропорциональное уменьшение геометрических размеров всех областей МС является традиционным направлением увеличения ее быстродействия. Это связано с уменьшением паразитных емкостей p-n-переходов. Минимальные размеры топологии определяются возможностями литографии. Наименьшие размеры (<1 мкм) позволяет получить электронолитография и рентгенолитография. Кроме этого размеры транзистора сильно зависят от глубины залегания p-n-перехода, поэтому одним из путей уменьшения размеров транзистора является создание конструкции транзистора с небольшой глубиной залегания p-n-переходов.
Существенное уменьшение глубины залегания p-n-переходов связано с освоением технологии ионного легирования. Недостатками этой технологии является очень высокий уровень дефектности областей кремния, подвергнутых ионной бомбардировке. Этот недостаток удается устранить нанесением на подложку поликристаллического кремния, который и подвергается локальной ионной бомбардировке. Затем производится диффузионный отжиг, в процессе которого примеси диффундируют из поликремния в подложку на небольшую глубину. В результате получается следующая транзисторная структура:
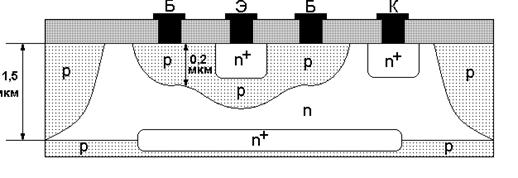
Такой транзистор имеет Uкб=8-12 В, Uэб=3,5-6 В, Uкэ=5-12 В, β=40-100.
Существует также конструкции с выступающими поликремниевыми электродами. Такие конструкции существенно уменьшают размеры транзистора и увеличивают предельную частоту fТ до 7ГГц.

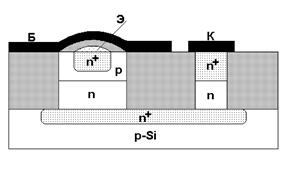
Применение техники самосовмещения вместе с ионным легированием позволяет получить еще меньшие размеры тразисторов.
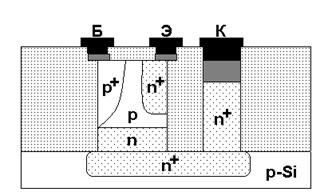
Такой транзистор имеет сверхмалые размеры. Однако в нем существует дополнительное сопротивление базы за счет легирования бором поликристаллического кремния. Поэтому без принятия специальных мер эта конструкция непригодна для сверхбыстродействующих ИС. Для устранения этого явления в конструкции применяется особый поликремний, сплавленный с платиной.
Недостатком конструкций с малыми размерами областей является низкое пробивное напряжение переходов и как следствие, пониженное напряжение питания и пониженная помехоустойчивость.
3. Транзистор с эмиттером на гетеропереходах. Гетеропереход – это переход между двумя материалами с различной шириной запрещенной зоны. В обычных транзисторах используется гомопереход с шириной запрещенной зоны по обе стороны эмиттера 1,1 эВ. Большая ширина запрещенной зоны в сторону эмиттера обеспечивает более высокий коэффициент инжекции. Это означает, что в полном токе эмиттерного перехода отношение тока электронов к току дырок будет значительно выше. От коэффициента инжекции непосредственно зависит коэффициент усиления транзистора. В обычном транзисторе повышения этого параметра можно добиться только за счет увеличения концентрации примесей в эмиттере и уменьшения – в базе. В транзисторе на гетеропереходах этого можно добиться и при сильно легированной базе. Меньшее сопротивление пассивной области базы дает возможность значительно повысить быстродействие транзистора без уменьшения или даже с увеличением коэффициента усиления тока β.
Транзистор на гетеропереходах изготавливается с использованием легированного фосфором низкоомного полуизолированного поликристаллического кремния в качестве материала эмиттера. Этот материал является смесью поликристаллического кремния и двуокиси кремния и имеет ширину запрещенной зоны 1,3-1,4 эВ. Пленка полуизолированного поликремния толщиной примерно 0,2 мкм контактирует непосредственно с базовой областью. Поверх нее наносится обычная пленка легированного поликристаллического кремния толщиной 0,3-0,5 мкм, на которую наносится металлическая разводка. Технологически это не связано с введением новых или изменением существующих технологических операций. Такая конструкция позволяет без уменьшения геометрических размеров транзистора добиться быстродействия в 1,5-2 ГГц.

|
|
|
|
|
Дата добавления: 2014-01-11; Просмотров: 11282; Нарушение авторских прав?; Мы поможем в написании вашей работы!