
КАТЕГОРИИ:
Архитектура-(3434)Астрономия-(809)Биология-(7483)Биотехнологии-(1457)Военное дело-(14632)Высокие технологии-(1363)География-(913)Геология-(1438)Государство-(451)Демография-(1065)Дом-(47672)Журналистика и СМИ-(912)Изобретательство-(14524)Иностранные языки-(4268)Информатика-(17799)Искусство-(1338)История-(13644)Компьютеры-(11121)Косметика-(55)Кулинария-(373)Культура-(8427)Лингвистика-(374)Литература-(1642)Маркетинг-(23702)Математика-(16968)Машиностроение-(1700)Медицина-(12668)Менеджмент-(24684)Механика-(15423)Науковедение-(506)Образование-(11852)Охрана труда-(3308)Педагогика-(5571)Полиграфия-(1312)Политика-(7869)Право-(5454)Приборостроение-(1369)Программирование-(2801)Производство-(97182)Промышленность-(8706)Психология-(18388)Религия-(3217)Связь-(10668)Сельское хозяйство-(299)Социология-(6455)Спорт-(42831)Строительство-(4793)Торговля-(5050)Транспорт-(2929)Туризм-(1568)Физика-(3942)Философия-(17015)Финансы-(26596)Химия-(22929)Экология-(12095)Экономика-(9961)Электроника-(8441)Электротехника-(4623)Энергетика-(12629)Юриспруденция-(1492)Ядерная техника-(1748)
Дифузанти
|
|
|
|
Дифузанти бувають газоподібні, рідкі, тверді. Акцепторні домішки: бор, галлій, індій (B, Ga, In) - p-типу. Донорні домішки: фосфор, миш`як, сурма (P, As, Sb) - n-типу.
Найбільш розповсюдженим джерелом P з твердого дифузанту є P2O5 (пентаоксид фосфору). Між Si і P2O5 відбувається хімічна реакція:
P2O5+Si=SiO2+P, що утворить склоподібне покриття пластина, з якої відбувається дифузія. "Загонка домішки" - 1-й етап (=30 - 40 хвил) 2 - 3 мкм, 2-й етап - "розгін" - перерозподіл домішки (t=800 - 10000 С, супроводжується вирощуванням SiO2). Приблизно 1.5 години. Рідке джерело P є POCl3 (оксихлорид фосфору) - Механізм дифузії аналогічний,тобто рідкі джерела реагують з О2, відтворюючи P2O5 (POCl3+O2=P2O5+Cl2). Газоподібним джерелом Р є фосфін PH3. PH3+O2=P2O5+H2O P2O5 - на поверхні Si при "загонці". Джерела Бора (В): твердий - В2О3 - борний ангідрид, рідкий - ВВr3 - трьохбромистий бор, BBr3+O2=B2O3+Br3 B2O3+Si=SiO2+B. Газоподібний - BCl3. Або: діборан B2H6: B2H6+O2=B2O3+H2O. Глибина дифузії - 4 мкм.. 100 мкм. Недоліки: висока температура процесу призводить до перерозподіл домішки в областях,що сформувалися раніше і зміщенню p-n-переходів, що ускладнює відтворювання окремих елементів.
12.5 Елементи напівпровідникових ІМС.
Дифузійні транзистори ІМС діляться на планарні, планарно-епитаксиальні і мезатранзистори. Планарний транзистор (plane - площина) - відрізняється тим, що всі шари, що відповідають емітеру, базі і колектору, виходять на одну поверхню.
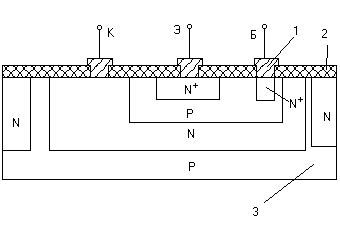
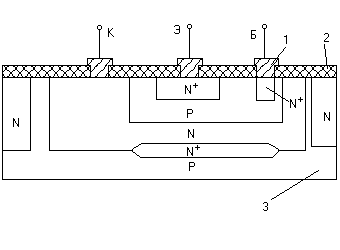
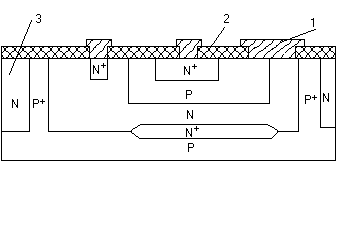
Послідовність виготовлення планарного NPN транзистора.
Оксидування поверхні заготівлі (Si p-типу).
Фотолітографія (розкриття вікон в оксиді).
Дифузія домішок n-типу і повторне оксидування.
Фотолітографія.
Дифузія домішок p-типу і повторне оксидування.
Фотолітографія.
Дифузія домішок n-типу і повторне оксидування.
Фотолітографія і формування виводів - напиленням плівки алюмінію (Al має добру адгезію з Si і SiO2). Після металізації (0.1 - 1 мкм) видаляється зайвий метал (травленням) і одержується необхідна форма контактних площадок. (Застосовується і напилення через маску).
Недолік - Iк переборює довгу дільницю дна колекторної області (під дном бази), що має малі поперечні розміри. В дифузійному колекторі концентрація домішок розподілена нерівномірно: вона max на поверхні і min на дні колектора. Тому шар колектора під базою має високий опір, що збільшує напругу насичення і час переключення транзистора.
12.6 Епітаксія.
Епітаксія - це процес осадження атомарного Si на монокристалічну Si пластину, при якому одержують плівку, що є продовженням структури пластини. Практичне значення має випадок, коли легована епітаксіальна плівка вирощується на легованій пластині. При застосуванні в пластині і в плівці що вирощується на межі їхнього розділу утвориться p-n-перехід. На відзнаку від дифузії, при якій p-n-перехід утвориться в результаті перекомпенсації впливу вхідної домішки і утворення області з більш високою концентрацією домішки, епітаксія дасть можливість одержувати шари в широкому діапазоні питомих опорів, не що залежать від опору вхідної пластини.
Відомі три групи процесів епітаксії:
1. Автоепітаксія - це процес орієнтованого наростання кристалічної речовини, однотипної по структурі з підложкою, що відрізняється від неї тільки вмістом легованих домішок (Si на Si).
2. Гетероепітаксія - це процес що орієнтованого наростання речовини, що відрізняється по складу від речовини підложки, що відбувається при їхній кристалохімічній взаємодії (наприклад, на сапфірі).
3. Хемоепітаксія - це процес орієнтованого наростання речовини, в результаті якого утворення нової фази відбувається при хімічній взаємодії речовини підложки з речовиною, що надходить з зовнішньої середи. Отриманий хемоепітаскіальний шар відрізняється по складу як від речовини підложки, так і від речовини, що надходить на її поверхню.
Існує три основні технологічні способи епітаксії:
1. Молекулярно-променева епітаксія з молекулярних пучків в вакуумі.
2. Газофазна епітаксія за допомогою хімічної взаємодії речовини в газовій або парогазовій суміші, що називається газовою або хімічною епітаксією.
3. Рідкофазна епітаксія в рідкій фазі шляхом рекристалізації з розплаву або розчину-розплаву.
1. Епітаксія з молекулярних пучків в вакуумі є процесом прямого переносу речовини. Речовина-джерело в високому вакуумі під впливом електронного пучка або за допомогою розігріву випаровується, створюючи потік молекулярних часток, що досягають підложки без проміжних взаємодій.
2. При кристалізації з газової фази за допомогою хімічної взаємодії атоми напівпровідника переносяться в склад хімічного сполучення, що дисоціює на підложці, визволяючи атоми напівпровідника або його молекули.
3. Рідкофазна епітаксія полягає в нарощуванні монокристалічного шару напівпровідника з розплаву або розчину-розплаву, насиченого напівпровідниковим матеріалом. Напівпровідник епітаксіально кристалізується на поверхні підложки, що вантажиться в розплав, при його охолодженні. Як розчинник використовують будь-який метал, що володіє необмеженою розчинністю з напівпровідником в рідкому стані, наприклад, Ga, GaAs, GaP.
Серед найбільш розповсюджених засобів нарощування епітаксіальних шарів Ge і Si основними є відновлення і піролітичний розклад.
При відновленні застосовують тетрахлорид Si (SiCl) або тетрабромід Si (SiBr4).
SiCl4+H2=Si (осадок)+HCl при t=1200 C
SiBr4 + H2 = Si(осадок) + HBr при t = 1050 C
Для піролітичного розкладу застосовують силан SiH4:
SiH4 = Si(осадок) + H2 при t = 1000 C
Процес епітаксіального нарощування при хлоридному засобі складається з наступних операцій:
1. Завантаження пластин в реактор.
2. Продувка реактора інертним газом (N2 видаляє повітря).
3. Нагрівання пластини до 1200 С і подача Н2 і НСl з метою очищення пластин (Н2 видаляє оксидні плівки, HCl - травлення верхнього шару).
4. Подача SiCl4 для осадження і легирування епітаксіальних шарів.
5. Припинення подачі SiCl4, продувка воднем.
6. Виключення нагрівання, продувка воднем і інертним газом.
7. Розвантаження реактора.
Найбільше розповсюдження отримав хлоридний спосіб епітаксії. Достоїнства - простота і доступність вхідних матеріалів.
SiCl4 + 2H2 = Si + 4HCl при t = 1200 С
Іноді використовують трихлорсилан:
SiHCl3 + H2 = Si + 3HCl
Товщина епітаксіальної плівки - 1 - 25 мкм.
Інший варіант - епітаксіально-планарна структура з прихованим шаром. Тут епітаксіальний колектор легують помірно, а малий опір колектора забезпечують паралельно включеним шаром (n+), що має високу концентрацію домішки.
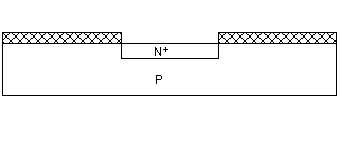

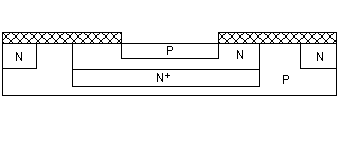
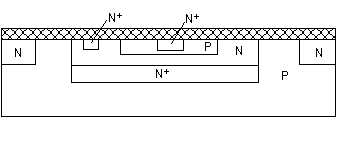

а) Вхідна пластина.
- Розкриття вікон під дифузію прихованого шару.
- Дифузія n+-домішки.
- Травлення оксиду.
- Епітаксіальне нарощування n-шару.
б) Оксидування пластини
- Фотолітографія.
- Розділова дифузія р-домішки на всю глибину епітаксіального шару і повторне оксидування.
в) Фотолітографія.
- Дифузія домішок p-типу і повторне оксидування.
г) Фотолітографія.
- Дифузія домішок n+-типу і повторне оксидування.
д) Фотолітографія і формування виводів - напиленням плівки алюмінію (Al має добру адгезію з Si і SiO2).
- Після металізації (0.1 - 1 мкм) видаляється зайвий метал (травленням) і одержується необхідна форма контактних площадок. (Застосовується і напилення через маску).
|
|
|
|
|
Дата добавления: 2014-12-10; Просмотров: 520; Нарушение авторских прав?; Мы поможем в написании вашей работы!