
КАТЕГОРИИ:
Архитектура-(3434)Астрономия-(809)Биология-(7483)Биотехнологии-(1457)Военное дело-(14632)Высокие технологии-(1363)География-(913)Геология-(1438)Государство-(451)Демография-(1065)Дом-(47672)Журналистика и СМИ-(912)Изобретательство-(14524)Иностранные языки-(4268)Информатика-(17799)Искусство-(1338)История-(13644)Компьютеры-(11121)Косметика-(55)Кулинария-(373)Культура-(8427)Лингвистика-(374)Литература-(1642)Маркетинг-(23702)Математика-(16968)Машиностроение-(1700)Медицина-(12668)Менеджмент-(24684)Механика-(15423)Науковедение-(506)Образование-(11852)Охрана труда-(3308)Педагогика-(5571)Полиграфия-(1312)Политика-(7869)Право-(5454)Приборостроение-(1369)Программирование-(2801)Производство-(97182)Промышленность-(8706)Психология-(18388)Религия-(3217)Связь-(10668)Сельское хозяйство-(299)Социология-(6455)Спорт-(42831)Строительство-(4793)Торговля-(5050)Транспорт-(2929)Туризм-(1568)Физика-(3942)Философия-(17015)Финансы-(26596)Химия-(22929)Экология-(12095)Экономика-(9961)Электроника-(8441)Электротехника-(4623)Энергетика-(12629)Юриспруденция-(1492)Ядерная техника-(1748)
Фотопроводимость полупроводников
|
|
|
|
Уровень Ферми для полупроводников
Одним и основных параметров полупроводника является уровень Ферми, вероятность заполнения которого при температуре, отличной от абсолютного нуля, равна 0,5. Энергетический уровень Ферми представляет собой среднюю термодинамическую энергию тела на один электрон. Уровень Ферми одинаков во всех частях равновесной системы, какой бы разнородной она ни была.
Для собственных полупроводников уровень Ферми проходит по середине запрещенной зоны. В электронном полупроводнике в сравнении с собственным имеется большое число электронов в зоне проводимости, т.е. средняя энергия электронов (и всего полупроводника) здесь будет выше. Следовательно, в электронном полупроводнике уровень Ферми должен находиться выше середины запрещенной зоны, причем, чем больше концентрация доноров, тем выше будет располагаться уровень Ферми. Аналогично можно заключить, что в дырочном полупроводнике уровень Ферми должен быть ниже середины запрещенной зоны, причем тем ниже, чем больше концентрация акцепторов.
Положение уровня Ферми зависит от температуры и легирования. В объёме пространственного однородного П. оно определяется условием сохранения полного числа электронов или, иными словами, условием электронейтральности:
n + Na- = р + N+d, (2)
где Nd — концентрация ионизованных доноров, Na- — акцепторов, захвативших электрон.
В сильно легированных П. концентрация носителей остаётся постоянной и равной (Nd — Na) при всех температурах вплоть до области собственной проводимости.
Для полупроводников характерно явление фотопроводимости — увеличение электропроводности под действием электромагнитного излучения. Фотопроводимость, как правило, обусловлена появлением дополнительных неравновесных носителей в результате поглощения электронами квантов света с энергией, превышающей энергию их связи. Различают собственную и примесную фотопроводимости. В первом случае фотон поглощается валентным электроном, который переходит в зону проводимости, что приводит к рождению пары электрон — дырка (рисунок 4.1,а). Очевидно, такой процесс может происходить под действием света с частотой, соответствующей области собственного поглощения полупроводника: hν ≥ ΔЕ. Во втором случае, если полупроводник содержит примеси, то фотопроводимость может возникнуть и при hν < ΔЕ. Если электроны забрасываются с донорных уровней в зону проводимости в случае полупроводника n-типа, то возрастает число электронов (электронная примесная фотопроводимость), и фотон должен обладать энергией hν ≥ ΔЕD (рисунок 4.1б). Если электроны из валентной зоны забрасываются на свободные акцепторные уровни в случае полупроводника р-типа, то возрастает число дырок (дырочная примесная фотопроводимость), и фотон должен обладать энергией hν ≥ ΔЕА (рисунок 4.1,в). ΔЕ, ΔЕD, ΔЕА – энергии активации соответствующей проводимости.
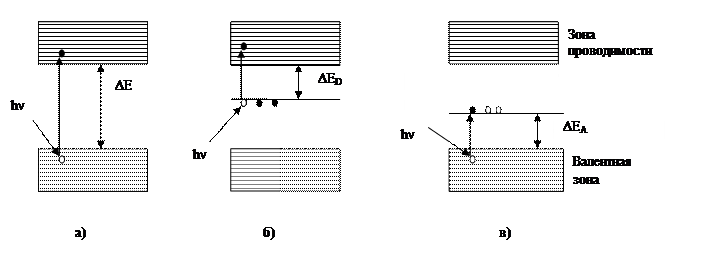
Рисунок 4.1 – Виды фотопроводимости
Зависимость фотопроводимости от частоты излучения определяется спектром поглощения полупроводника. По мере увеличения коэффициента поглощения фотопроводимость сначала достигает максимума, а затем падает. Спад фотопроводимости объясняется тем, что при большом коэффициенте поглощения весь свет поглощается в поверхностном слое проводника, где очень велика скорость рекомбинации носителей (поверхностная рекомбинация). Требование к энергии фотона hν ≥ ΔЕ, где ΔЕ - энергия активации соответствующей проводимости, означает, что существует красная граница внутреннего фотоэффекта, которая определяется из условия: hν = ΔЕ. Переходя от частоты к длине волны, получим
 (3)
(3)
Некоторое количество носителей тока присутствует в полупроводнике и при отсутствии света. Часть электронов переводится из заполненной зоны (и с донорных уровней) в зону проводимости (и на акцепторные уровни) в результате теплового движения. Количество таких носителей - и вместе с ним электропроводность кристалла – определяется температурой кристалла и быстро увеличивается при нагревании. В этом случае говорят о равновесных носителях тока и о темновой электропроводности кристалла. Количество носителей заряда равно равновесному не только в полной темноте, но и в тех случаях, когда энергия фотонов недостаточно велика для того, чтобы вызвать электронные переходы в кристалле.
В отличие от тепловой световая энергия запасается в основном электронами полупроводника и практически не изменяет температуру кристаллической решетки. Поэтому в присутствии света тепловое равновесие между электронами и решеткой нарушается. Носители заряда, возникающие в результате оптической ионизации, называются неравновесными.
После того как освещение кристалла прекращается равновесие между электронами и решеткой восстанавливается. В обычных условиях энергия, запасенная неравновесными носителями, очень мала по сравнению с тепловой энергией кристаллической решетки. Процесс установления теплового равновесия между решеткой и электронами сводится к тому, что неравновесные электроны и дырки рекомбинируют друг с другом, а температура кристалла практически не меняется. Следовательно, не изменится концентрация равновесных носителей.
Явление фотопроводимости позволяет за короткое время (~ мксек или ~ нсек) изменять электропроводность полупроводника в очень широких пределах, а также даёт возможность создавать высокие концентрации носителей тока в полупроводниках, в которых из-за относительно большой ΔE и отсутствия подходящих примесей не удаётся получить заметных равновесных концентраций носителей. Использование фотопроводимости с разными ΔE и глубиной примесных уровней (Si, Te, InSb, PbS, CdS, РЬТе, Ge, легированный Zn или Au и т.д.) позволяет создавать высокочувствительные приёмники света для различных областей спектра от далёкой инфракрасной до видимой.
14.5 P-n переход и его вольт-амперная характеристика
Электронно-дырочный переход (p — n-переход) - область полупроводника, в которой существует пространственное изменение типа проводимости (от электронной n к дырочной p). Электроны из области n перемещаются в область р, а дырки, наоборот, - из области р в область n. Встречаясь на границе р и n областей, дырки и электроны рекомбинируют. Следовательно, в этой пограничной области значительно уменьшается концентрация носителей заряда и обнажаются некомпенсированные заряды неподвижных ионов. Со стороны n-области обнажаются положительные заряды доноров, а со стороны области р - отрицательные заряды акцепторов. Область нескомпенсированных неподвижных зарядов и есть область р-п перехода. Здесь образуется двойной слой пространственного заряда — отрицательные заряды в р-области и положительные заряды в n -области (рис. 5.1).

Рис. 5.1. Схема p-n-перехода
Возникающее при этом контактное электрическое поле по величине и направлению таково, что оно противодействует диффузии свободных носителей тока через переход; в условиях теплового равновесия при отсутствии внешнего электрического поля полный ток через переход равен нулю. Эту область называют запорным слоем электронно-дырочного перехода. Электрическое поле электронно-дырочного перехода, препятствует прохождению электронов из области р-типа в область п-типа и дырок в обратном направлении.. Существует динамическое равновесие, при котором небольшой ток, создаваемый неосновными носителями (электронами в р-области и дырками в n-области), течёт к p — n-переходу и проходит через него под действием контактного поля, а равный по величине ток, создаваемый диффузией основных носителей (электронами в n-области и дырками в р-области), протекает в обратном направлении. При этом основным носителям приходится преодолевать контактное поле (потенциальный барьер). Разность потенциалов ∆φ0, возникающая между p- и n-областями из-за наличия контактного поля (контактная разность потенциалов, высота потенциального барьера), для большинства р-п переходов обычно составляет: для германия 0,35 В, а для кремния - 0,7 В.
Внешнее электрическое поле изменяет высоту потенциального барьера и нарушает равновесие потоков носителей тока через него. Если внешнее поле направлено против контактного, то потенциальный барьер понижается (прямое смещение). В этом случае с ростом приложенного напряжения экспоненциально возрастает число основных носителей, способных преодолеть потенциальный барьер. Появляется отличный от нуля ток через p — n-переход -прямой ток. При повышении приложенного напряжения этот ток экспоненциально возрастает. Приложение обратного внешнего электрического поля (обратное смещение) приводит к повышению потенциального барьера. При этом диффузия основных носителей через переход становится пренебрежимо малой (обратный ток).
В то же время потоки неосновных носителей не изменяются, поскольку для них барьера не существует. Потоки неосновных носителей определяются скоростью тепловой генерации электронно-дырочных пар. Эти пары диффундируют к барьеру и разделяются его полем, в результате чего через p — n-переход течёт ток Is (ток насыщения), который обычно мал и почти не зависит от приложенного напряжения. Т. о., зависимость тока I через p — n-переход от приложенного напряжения U (вольтамперная характеристика) обладает резко выраженной нелинейностью (рис. 5.2). При изменении знака напряжения ток через p — n-переход может меняться в 105—106 раз. Благодаря этому p — n-переход является вентильным устройством, пригодным для выпрямления переменных токов. Зависимость сопротивления перехода от U позволяет использовать p — n-переход в качестве регулируемого сопротивления (варистора).
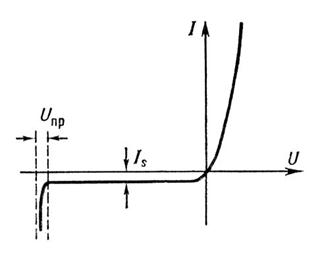
Рис. 5.2 - Вольтамперная характеристика р — n-перехода: U — приложенное напряжение; I - ток через переход; Is — ток насыщения; Unp — напряжение пробоя
При подаче на p — n-переход достаточно высокого обратного напряжения U = Uпр возникает электрический пробой, при котором протекает большой обратный ток (рис. 5.2). Различают лавинный пробой, когда на длине свободного пробега в области объёмного заряда носитель приобретает энергию, достаточную для ионизации кристаллической решётки, туннельный пробой, возникающий при туннелировании носителей сквозь барьер, и тепловой пробой, связанный с недостаточностью теплоотвода от p — n-перехода, работающего в режиме больших токов.
p—n-переход может быть создан различными путями: 1) в объёме одного и того же полупроводникового материала, легированного в одной части донорной примесью (р-область), а в другой — акцепторной (n-область); 2) на границе двух различных полупроводников с разными типами проводимости; 3) вблизи контакта полупроводника с металлом, если ширина запрещенной зоны полупроводника меньше разности работ выхода полупроводника и металла; 4) приложением к поверхности полупроводника с электронной (дырочной) проводимостью достаточно большого отрицательного (положительного) потенциала, под действием которого у поверхности образуется область с дырочной (электронной) проводимостью (инверсный слой).
От приложенного напряжения зависит ёмкость p — n-перехода. Повышение потенциального барьера при обратном смещении означает увеличение разности потенциалов между n- и р-областями полупроводника и, отсюда, увеличение их объёмных зарядов. Поскольку объёмные заряды являются неподвижными и связанными с кристаллической решёткой ионами доноров и акцепторов, увеличение объёмного заряда может быть обусловлено только расширением его области и, следовательно, уменьшением ёмкости. При прямом смещении к ёмкости слоя объёмного заряда (называется также зарядной ёмкостью) добавляется т. н. диффузионная ёмкость, обусловленная тем, что увеличение напряжения на Э.-д. п. приводит к увеличению концентрации неосновных носителей, т. е. к изменению заряда. Зависимость ёмкости от приложенного напряжения позволяет использовать p — n-переход в качестве варактора — прибора, ёмкостью которого можно управлять, меняя напряжение смещения.
p—n-переход находит многообразные применения, основанные на зависимости контактной разности потенциалов и тока насыщения от концентрации неосновных носителей. Их концентрация существенно изменяется при различных внешних воздействиях — тепловых, механических, оптических и др. На этом основаны различного рода датчики: температуры, давления, ионизирующих излучений. p — n-переходы являются основой разного рода полупроводниковых диодов, а также входят в качестве составных элементов в более сложные полупроводниковые приборы — транзисторы, тиристоры и т. д.
|
|
|
|
Дата добавления: 2014-01-04; Просмотров: 3985; Нарушение авторских прав?; Мы поможем в написании вашей работы!