
КАТЕГОРИИ:
Архитектура-(3434)Астрономия-(809)Биология-(7483)Биотехнологии-(1457)Военное дело-(14632)Высокие технологии-(1363)География-(913)Геология-(1438)Государство-(451)Демография-(1065)Дом-(47672)Журналистика и СМИ-(912)Изобретательство-(14524)Иностранные языки-(4268)Информатика-(17799)Искусство-(1338)История-(13644)Компьютеры-(11121)Косметика-(55)Кулинария-(373)Культура-(8427)Лингвистика-(374)Литература-(1642)Маркетинг-(23702)Математика-(16968)Машиностроение-(1700)Медицина-(12668)Менеджмент-(24684)Механика-(15423)Науковедение-(506)Образование-(11852)Охрана труда-(3308)Педагогика-(5571)Полиграфия-(1312)Политика-(7869)Право-(5454)Приборостроение-(1369)Программирование-(2801)Производство-(97182)Промышленность-(8706)Психология-(18388)Религия-(3217)Связь-(10668)Сельское хозяйство-(299)Социология-(6455)Спорт-(42831)Строительство-(4793)Торговля-(5050)Транспорт-(2929)Туризм-(1568)Физика-(3942)Философия-(17015)Финансы-(26596)Химия-(22929)Экология-(12095)Экономика-(9961)Электроника-(8441)Электротехника-(4623)Энергетика-(12629)Юриспруденция-(1492)Ядерная техника-(1748)
Электронно-дырочный переход и его свойства
|
|
|
|
Виды токов в полупроводниках
Если полупроводник помещен в электрическое поле, то в нем возникают два вида токов: дрейфовый и диффузионный.
Дрейфовый ток обусловлен перемещением носителей зарядов (электронов или дырок) под действием электрического поля. Плотность дрейфового тока определяется концентрацией электронов n (или дырок p), зарядом электрона q и средней скоростью V перемещения заряда в направлении, перпендикулярном сечению полупроводника:
jE = nqV
Диффузионный ток. В полупроводниках электрический ток вызывается не только электрическим полем, но и неравномерным распределением подвижных носителей заряда (электронов и дырок) по объему кристалла.
Если в некотором объеме полупроводника имеется область с большей концентрация электронов, то число электронов, движущихся из области с большой концентрацией в область с меньшей концентрацией, будет превышать число частиц, движущихся в противоположном направлении. В результате появится некоторое упорядоченное диффузионное перемещение электронов проводимости в направлении уменьшения их концентрации, т.е. возникнет диффузионный электрический ток, направление которого противоположно направлению диффузии электронов. Плотность диффузионного тока j прямо пропорциональна концентрации электронов проводимости. Аналогичный процесс происходит и при неравномерной концентрации дырок, создающей диффузионный электрический ток, совпадающий по направлению с направлением диффузии дырок.
Диффузия электронов и дырок создает на переходе напряженность электрического поля
Е = dU/dx,
поэтому кроме диффузионного тока через переход будет также проходить дрейфовый ток (ток проводимости).
Электронно-дырочным переходом называют тонкий слой между двумя частями полупроводникового кристалла, в котором одна часть имеет электронную, а другая - дырочную электропроводность.
На этой стадии важно понять, что полупроводниковый переход представляет собой изменение материала с p-типа на n-тип в пределах одной и той же непрерывной кристаллической решетки. При простом соединении образцов материала p-типа и материала n-типа не возникает p-n переход.
Технологический процесс создания электронно-дырочного перехода может быть различным:
1. сплавление (сплавные диоды);
2. диффузия одного вещества в другое (диффузионные диоды);
3. эпитаксия — ориентированный рост одного кристалла на поверхности другого (эпитаксиальные диоды) и др.
По конструкции электронно-дырочные переходы могут быть симметричными и несимметричными, резкими и плавными, плоскостными и точечными и др. Однако для всех типов переходов основным свойством является несимметричная электропроводность, при которой в одном направлении кристалл пропускает ток, а в другом — не пропускает.
Устройство электронно-дырочного перехода показано на рис. 5.4.
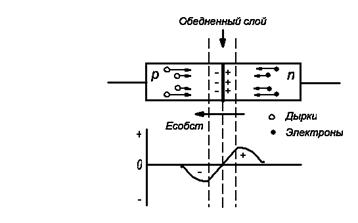
Рис. 5.4. p-n переход и распределение объемного заряда в нем
Одна часть этого перехода легирована донорной примесью и имеет электронную проводимость (n-область). Другая часть, легированная акцепторной примесью, имеет дырочную проводимость (p-область). Концентрация электронов в одной части и концентрация дырок в другой существенно различаются. Кроме того, в обеих частях имеется небольшая концентрация неосновных носителей. Электроны в n-области стремятся проникнуть в p-область, где концентрация электронов значительно ниже. Аналогично, дырки из p-области перемещаются в n-область. В результате встречного движения противоположных зарядов возникает диффузионный ток. Электроны и дырки, перейдя через границу раздела, оставляют после себя противоположные заряды, которые препятствуют дальнейшему прохождению диффузионного тока. В результате на границе устанавливается динамическое равновесие и при замыкании n и p областей ток в цепи не протекает.
Распределение плотности объемного заряда в переходе приведено на рис. 5.4. При этом внутри кристалла на границе раздела возникает собственное электрическое поле Eсоб направление которого показано на рис. 5.4. Напряженность этого поля максимальна на границе раздела, где происходит скачкообразное изменение знака объемного заряда. На некотором удалении от границы раздела объемный заряд отсутствует и полупроводник является нейтральным.
Высота потенциального барьера на p-n переходе определяется контактной разностью потенциалов n и p областей. Контактная разность потенциалов, в свою очередь, зависит от концентрации примесей в этих областях:
ψ = φTlnNnPp/ni2
где φT = kT/q - тепловой потенциал, Nn, и Pp- концентрации электронов и дырок в N и P областях, ni - концентрация носителей зарядов в нелегированном полупроводнике. Контактная разность потенциалов для германия имеет значение
0,6... 0,7В, а для кремния 0,9... 1,2В. Высоту потенциального барьера можно изменять приложением внешнего напряжения к р-n переходу. Если внешнее напряжение создает в p-n переходе поле, которое совпадает с внутренним, то высота потенциального барьера увеличивается, при обратной полярности приложенного напряжения высота потенциального барьера уменьшается. Если приложенное напряжение равно контактной разности потенциалов, то потенциальный барьер исчезает полностью.
Если приложенное напряжение снижает потенциальный барьер, то оно называется прямым, а если повышает его - обратным. Приложение прямого и обратного напряжения к p-n переходу показано на рис. 5.5. Если к p-n переходу подключен внешний источник постоянного напряжения, то потенциальный барьер обедненного слоя увеличивается или уменьшается в зависимости от полярности поданного напряжения или смещения. На рис. 5.5 показаны оба случая: (а) обратное смещение, когда потенциальный барьер увеличивается, а обедненный слой расширяется, и (б) прямое смещение, когда барьер уменьшается, а обедненный слой сужается. В случае обратного смещения через переход течет очень маленький ток, связанный с тепловым разрушением ковалентных связей в обеих областях. Неосновные носители имеют такую полярность, которая способствует их прохождению через переход. Однако при комнатной температуре этот обратный ток у кремниевого перехода настолько мал (порядка 1 нА), что на практике им часто пренебрегают. Когда же переход смещен в прямом направлении, потенциальный барьер понижается, нарушается равновесие и часть электронов из n-области и дырок из p-области теперь способны пересечь переход. Чем больше напряжение прямого смещения, тем ниже потенциальный барьер, тем большее число электронов и дырок проходит сквозь обедненный слой и, следовательно, возникает ток, текущий через переход.
Следует отметить, что при увеличении э.д.с. прямого смещения, эффективное сопротивление перехода уменьшается из-за понижения потенциального барьера. В результате небольшое увеличение напряжения, приложенного в прямом направлении, вызывает значительное увеличение тока. Обычно у маломощных кремниевых диодов напряжение прямого смещения 0,6 В вызывает ток около 1 мА, а при напряжении 0,8 В ток возрастает до 100 мА.
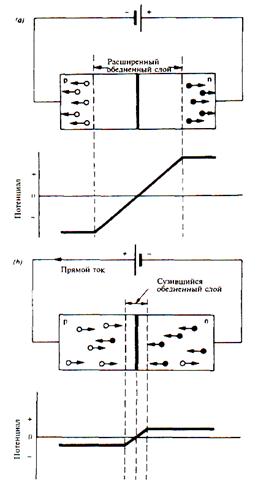
Рис.5.5. Приложение обратного (а) и прямого (б) напряжений к p-n переходу
Обратный ток в p-n переходе вызывается неосновными носителями одной из областей, которые, дрейфуя в электрическом поле области объемного заряда, попадают в область, где они уже являются основными носителями. Обратный ток зависит только от количества неосновных носителей, появляющихся на границах области объемного заряда. Внешнее приложенное напряжение не влияет на число носителей, проходящих через переход в единицу времени т.е на величину обратного тока. Следовательно, обратный ток через переход не зависит от высоты потенциального барьера, т. е. он остается постоянным при изменении обратного напряжения на переходе. Этот ток называется током насыщения и обозначается
Iобр = Is.
При прямом смещении p-n перехода появляется (диффузионный) ток, вызванный диффузией основных носителей, преодолевающих потенциальный барьер. Пройдя p-n переход, эти носители попадают в область полупроводника, для которой они являются неосновными носителями. Концентрация неосновных носителей при этом может существенно возрасти по сравнению с равновесной концентрацией. Такое явление носит название инжекцией носителей. Таким образом, при протекании прямого тока через переход из электронной области в дырочную будет происходить инжекция электронов, а из дырочной области будет происходить инжекция дырок. Диффузионный ток зависит от высоты потенциального барьера и по мере его снижения увеличивается экспоненциально:
Iдиф = IseU/φT,
где U - напряжение на p-n переходе.
Кроме диффузионного тока прямой ток содержит ток проводимости, протекающий в противоположном направлении, поэтому полный ток при прямом смещении p-n перехода будет равен разности диффузионного тока и тока проводимости:
Iпр = Iдиф – Is = Is(eU/φT – 1)
Уравнение называется уравнением Эберса - Молла, а соответствующая ему вольт - амперная характеристика p-n перехода приведена на рис. 5.6. Вольт - амперная характеристика p-n перехода представляет собой зависимость тока через переход при изменении на нем значения и полярности приложенного напряжения. Из графика видно, что кремниевый переход практически не проводит ток, пока э.д.с. прямого смещения не превышает 0,5 В. У германиевых переходов эта величина меньше и составляет 0,2 В.

Рис. 5.6. Вольт - амперная характеристика p-n перехода
Поскольку при T = 300К тепловой потенциал φT = 25мВ, то уже при U = 0,1 В можно считать, что
I = Iдиф = Is eU/φT
Дифференциальное сопротивление p-n перехода можно определить, воспользовавшись формулой:
1/rдиф = dI/dU = 1/φT (I + Is),
откуда получаем
rдиф = (I + Is)/φT.
Так, например, при токе I = 1 А и φT = 25 мВ дифференциальное сопротивление перехода равно 25 мОм.
Предельное значение напряжения на p-n переходе при прямом смещении не превышает контактной разности потенциалов ψк. Обратное напряжение ограничивается пробоем p-n перехода. Пробой p-n перехода возникает за счет лавинного размножения неосновных носителей и называется лавинным пробоем. При лавинном пробое p-n перехода ток через переход ограничивается лишь сопротивлением питающей p-n переход электрической цепи.
Полупроводниковый p-n переход имеет емкость, которая в общем случае определяется как отношение приращения заряда на переходе к приращению падения напряжения на нем, т. е.
С = dq/du.
Емкость перехода зависит от значения и полярности внешнего приложенного напряжения. При обратном напряжении на переходе эта емкость называется барьерной и определяется по формуле
Cбар = Сбар(0)/√(1 – U/ψk),
где ψк - контактная разность потенциалов, U - обратное напряжение на переходе, Сбар (0) — значение барьерной емкости при U = 0, которое зависит от площади p-n перехода и свойств полупроводникового кристалла. Зависимость барьерной емкости от приложенного напряжения приведена на рис. 5.7.

Рис.5.6. Зависимость барьерной емкости от напряжения на p-n переходе
Теоретически барьерная емкость существует и при прямом напряжении на p-n переходе, однако она шунтируется низким дифференциальным сопротивлением rдиф. При прямом смещении p-n перехода значительно большее влияние оказывает диффузионная емкость, которая зависит от значения прямого тока I и времени жизни неосновных носителей τp. Эта емкость не связана с током смещения, но дает такой же сдвиг фазы между напряжением и током, что и обычная емкость. Значение диффузионной емкости можно определить по формуле
Cдиф = Iτp/φT.
Полная емкость перехода при прямом смещении определяется суммой барьерной и диффузионной емкостей
C = Cдиф +Cбар.
При обратном смещении перехода диффузионная емкость отсутствует и полная емкость состоит только из барьерной емкости.
|
|
|
|
|
Дата добавления: 2014-01-05; Просмотров: 1554; Нарушение авторских прав?; Мы поможем в написании вашей работы!