
КАТЕГОРИИ:
Архитектура-(3434)Астрономия-(809)Биология-(7483)Биотехнологии-(1457)Военное дело-(14632)Высокие технологии-(1363)География-(913)Геология-(1438)Государство-(451)Демография-(1065)Дом-(47672)Журналистика и СМИ-(912)Изобретательство-(14524)Иностранные языки-(4268)Информатика-(17799)Искусство-(1338)История-(13644)Компьютеры-(11121)Косметика-(55)Кулинария-(373)Культура-(8427)Лингвистика-(374)Литература-(1642)Маркетинг-(23702)Математика-(16968)Машиностроение-(1700)Медицина-(12668)Менеджмент-(24684)Механика-(15423)Науковедение-(506)Образование-(11852)Охрана труда-(3308)Педагогика-(5571)Полиграфия-(1312)Политика-(7869)Право-(5454)Приборостроение-(1369)Программирование-(2801)Производство-(97182)Промышленность-(8706)Психология-(18388)Религия-(3217)Связь-(10668)Сельское хозяйство-(299)Социология-(6455)Спорт-(42831)Строительство-(4793)Торговля-(5050)Транспорт-(2929)Туризм-(1568)Физика-(3942)Философия-(17015)Финансы-(26596)Химия-(22929)Экология-(12095)Экономика-(9961)Электроника-(8441)Электротехника-(4623)Энергетика-(12629)Юриспруденция-(1492)Ядерная техника-(1748)
Полевые СВЧ транзисторы на основе арсенида галлия
|
|
|
|
Транзисторы с управляющим переходом металл-полупроводник.
Структура такого транзистора показана на рис. 4.16.
Большая ширина запрещенной зоны GaAs 1,43 эВ обуславливает большое удельное сопротивление подложки 107 108 Ом·см. Арсенид-галлиевая подложка практически представляет собой диэлектрик.
108 Ом·см. Арсенид-галлиевая подложка практически представляет собой диэлектрик.
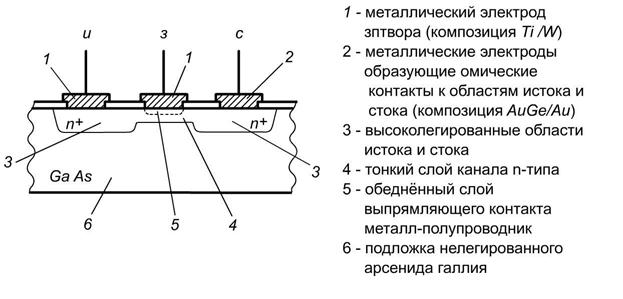
Рис. 4.16
На поверхности подложки методами ионного легирования создаются высоколегированные области n+ истока и стока, а также тонкий слой канала толщиной 0,1 0,2 мкм, концентрация примеси в котором составляет 1017 см-3. Затем на поверхность канала наносится металлический электрод из композиции Ti/w, который образует выпрямляющий контакт с полупроводником канала. К областям истока и стока создаются металлические электроды из композиции AuGe/Au, образующие невыпрямляющие омические контакты.
0,2 мкм, концентрация примеси в котором составляет 1017 см-3. Затем на поверхность канала наносится металлический электрод из композиции Ti/w, который образует выпрямляющий контакт с полупроводником канала. К областям истока и стока создаются металлические электроды из композиции AuGe/Au, образующие невыпрямляющие омические контакты.
Проводящий канал формируется между обедненным слоем выпрямляющего контакта затвор-канал и подложкой. При изменении напряжения на затворе меняется толщина обедненного слоя, а следовательно и толщина проводящей части канала, которая определяет проводимость канала и ток стока.
Транзистор работает при обратных и небольших прямых напряжениях не более 0,5 на переходе затвор-канал. Обратно включенный переход металл-полупроводник обеспечивает малый ток в цепи затвора и высокое входное сопротивление транзистора.
Максимально допустимое напряжение на стоке ограничивается напряжением пробоя контакта затвор-канал.
Емкость затвор-канал представляет собой барьерную емкость контакта металл-полупроводник. Для снижения емкости необходимо уменьшить длину канала.
В данном транзисторе практически отсутствуют емкости перекрытия затвор-исток и затвор-сток и малы емкости сток-подложка и исток-подложка. Вследствие этого предельная частота крутизны fs=1/(2πtnp), будет определяться временем пролета носителей через канал tnpk ≈L/Vнас. Тогда
fs=Vнас/(2πL).
Для L=1 мкм получаем fs≈30 ГГЦ.
Граничная частота усиления, на которой модуль коэффициента усиления по напряжению равен единице при условии отсутствия внешней емкости может достигать величины fтр=μуfs, где μу= S·R – статический коэффициент усиления (S – крутизна, R – внутреннее сопротивление).При μу>10 граничная частота будет превышать 300 ГГц.
Таким образом, полевой транзистор с диодом Шоттки на основе арсенида галлия является СВЧ-транзистором, работающим на более высокой частоте, чем биполярные транзисторы.
В импульсном режиме время переключения составляет 10-100 пс (пикосекунд). Это позволяет использовать такие транзисторы в сверх быстродействующих интегральных микросхемах.
Арсенид-галлиевые полевые транзисторы с диодом Шоттки на основе эпитаксиальных структур.
Основой для изготовления таких транзисторов является многослойная эпитаксиальная пластина. Рассмотрим основные этапы изготовления таких транзисторов рис. 4.17.
1. Многослойная эпитаксиальная пластина арсенида галлия металлизируется сплавом Au-Ge-Ni.
Эпитаксиальная пластина изготавливается следующим образом. Первоначально на пластинах GaAs выращивается высокоомный буферный слой толщиной ~ 5 мкм. После буферного слоя выращивается активный слой толщиной ~ 0,7 мкм, а затем высоколегированный контактный слой.
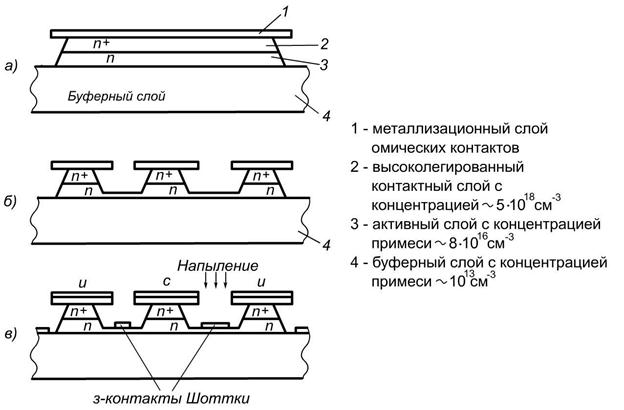
Рис. 4.17
2. Методом глубокого химического травления формируется мезаструктура.
3. Производится утолщение канала под затвор. При этом получается значительное подтравливание, что позволяет применять самосовмещение.
4. Осаждением Ti, W, Au формируется затвор.
5. На площадки истоков осаждается толстый слой золота, позволяющий осуществлять обратный монтаж.
Такие транзисторы могут работать на частотах 15-20 ГГц.
|
|
|
|
|
Дата добавления: 2014-01-07; Просмотров: 3149; Нарушение авторских прав?; Мы поможем в написании вашей работы!