
КАТЕГОРИИ:
Архитектура-(3434)Астрономия-(809)Биология-(7483)Биотехнологии-(1457)Военное дело-(14632)Высокие технологии-(1363)География-(913)Геология-(1438)Государство-(451)Демография-(1065)Дом-(47672)Журналистика и СМИ-(912)Изобретательство-(14524)Иностранные языки-(4268)Информатика-(17799)Искусство-(1338)История-(13644)Компьютеры-(11121)Косметика-(55)Кулинария-(373)Культура-(8427)Лингвистика-(374)Литература-(1642)Маркетинг-(23702)Математика-(16968)Машиностроение-(1700)Медицина-(12668)Менеджмент-(24684)Механика-(15423)Науковедение-(506)Образование-(11852)Охрана труда-(3308)Педагогика-(5571)Полиграфия-(1312)Политика-(7869)Право-(5454)Приборостроение-(1369)Программирование-(2801)Производство-(97182)Промышленность-(8706)Психология-(18388)Религия-(3217)Связь-(10668)Сельское хозяйство-(299)Социология-(6455)Спорт-(42831)Строительство-(4793)Торговля-(5050)Транспорт-(2929)Туризм-(1568)Физика-(3942)Философия-(17015)Финансы-(26596)Химия-(22929)Экология-(12095)Экономика-(9961)Электроника-(8441)Электротехника-(4623)Энергетика-(12629)Юриспруденция-(1492)Ядерная техника-(1748)
Жидкофазная эпитаксия
|
|
|
|
Жидкофазная эпитаксия (ЖФЭ) – это частный случай кристаллизации из раствора-расплава.
К металлу-растворителю предъявляются следующие требования:
· низкая температура плавления;
· низкая упругость пара;
· хорошая растворимость в нем полупроводникового материала в жидкой фазе;
· минимальная растворимость его в кристаллическом полупроводниковом материале;
· минимальное влияние его на электрофизические свойства полупроводникового материала;
· техническая возможность обеспечения ему высокой степени чистоты;
· инертность к материалу контейнера.
При получении эпитаксиальных слоёв полупроводниковых соединений обычно в качестве растворителя используют один из компонентов вещества, например, для соединений типа АIIIBV – это обычно составляющий соединение элемент третьей группы периодической системы.
Методы ЖФЭ в зависимости от способа создания пересыщения подразделяются на:
· изотермические
· неизотермические.
Последние наиболее часто примененяются.
Процессы ЖФЭ протекают в условиях приближенных к равновесным, поэтому при их реализации широко используются диаграммы состояния, благодаря чему, процессы поддаются математической обработке, что способствует точному определению состава исходной жидкой фазы, что особенно важно при получении многокомпонентных полупроводниковых материалов.
Неизотермический вариант ЖФЭ (способ равновесного охлаждения)
Процесс выращивания эпитаксиального слоя в варианте равновесного охлаждения показан на рис. 67.

Рис. 67. Неизотермический вариант выращивания слоев соединения АВ методом ЖФЭ. а – диаграмма состояния при постоянном давлении; б – температурно-временной график процесса: I – момент приведения в контакт подложки и раствора-расплава, II – момент прерывания контакта подложки и раствора-расплава.
Этот вариант используется главным образом для автоэпитаксии.
Рассмотрим в качестве примера наращивание одного эпитаксиального слоя для создания двухслойной структуры.
После загрузки в контейнер подложек и шихты состава С0 в установке выращивания создается необходимая защитная или восстановительная атмосфера, потом контейнер нагревается до температуры гомогенизации раствора-расплава Тв., составляющей обычно 0,7¸0,8 от температуры плавления соединения АВ, и при этом подложки и расплав не находятся в контакте. Система регулирования температуры обеспечивает ее поддержание в зоне контейнера с точностью не хуже 0,2¸0,50С при градиенте температуры не более 0,2¸0,50С на всей длине контейнера. В интервале времени t1¸t2 расплав гомогенизируется. При выращивании полупроводниковых соединений типа AIIIBV и твердых растворов на их основе время гомогенизации составляет не менее 1 часа.
После проведения гомогенизации раствора-расплава температуру снижают до температуры ликвидус Тл. состава С0, приводят расплав в контакт с подложкой и выдерживают в интервале времени t3¸t4 для установления термодинамического равновесия между расплавом и подложкой.
Во время наращивания слоя в интервале времени t4¸t5 производят управляемое снижение температуры со скоростью от единиц до нескольких десятков градусов в час и после этого расплав с подложек удаляют. Состав жидкой фазы на фронте кристаллизации меняется при этом от С0 до СК..
Как видно из рис. 67 при кристаллизации из раствора-расплава состав твердой фазы отвечает выращиваемому полупроводниковому соединению АВ, в то время как состав жидкой фазы на фронте кристаллизации по составу гораздо ближе к растворителю А, особенно в области низких температур. Это приводит к тому, что слой жидкой фазы, прилегающий к фронту кристаллизации переобогащается компонентом А за счет кристаллизации соединения АВ. Для компенсации этого переобогащения необходим подвод кристаллизуемого вещества из более далеких от фронта кристаллизации слоев расплава. Этот подвод вещества может быть осуществлен только за счет диффузии.
Допустим, что выращивание происходит на горизонтально расположенную подложку, причем поперечное сечение расплава и подложки совпадает (см. рис. 68).

Рис. 68. Схема роста эпитаксиального слоя (2) из раствора-расплава (1) на подложку (3) в процессе ЖФЭ.
Рассмотрим варианты изменения состава жидкой фазы по толщине во время проведения процесса наращивания эпитаксиального слоя (рис. 69).

Рис. 69. Распределение концентраций компонентов по толщине жидкой фаз (h) по мере наращивания эпитаксиального слоя с конечной скоростью охлаждения.
1. Процесс проводится с бесконечно малой скоростью, и кристаллизация проходит строго по равновесной диаграмме состояния.
В расплаве успевает проходить выравнивающая диффузия. Распределение состава жидкой фазы по толщине в различные моменты времени определяется прямыми линиями 0®1*®2*®3* (рис. 69.), причем толщина расплава в рамках допущения на характер распределения не влияет.
В этом случае толщина выращенного слоя определяется «по правилу рычага» и будет максимально возможной.
При совпадении площадей контактирующих расплава и подложки и считая, что ликвидус в интервале выращивания описывается линейной зависимостью с постоянным наклоном m=DT/DCж. (рис. 67), получим:
d0=h·(C0 – Cк.)/Cтв.=h·R·t/(Cтв.·m), (74)
где t – время выращивания, а R =DT/t – скорость снижения температуры.
Приведенный выше вариант эпитаксиального наращивания слоя является идеальным, поскольку процессы всегда проходят с конечной скоростью кристаллизации. Толщина слоя из-за не достижения термодинамического равновесия в системе жидкость – твердая фаза всегда будет меньше, рассчитанной по уравнению (74).
Рассмотрим кинетические приближения, позволяющие определить реальную толщину эпитаксиального слоя в зависимости от условий проведения выращивания эпитаксиальных слоев с конечными скоростями кристаллизации.
Распределение концентрации i -того компонента в жидкой фазе описывается II законом диффузии и в одномерной задаче при совмещении начала координат с границей раздела фаз и с учетом перемещения этой границы в процессе эпитаксиального роста, получим:
 , (75)
, (75)
где f – скорость перемещения границы раздела, равная скорости роста эпитаксиального слоя.
Скорость f определяется из закона сохранения массы вещества на границе раздела фаз в предположении, что эта граница является связывающей, то есть все диффундирующее вещество (АВ), достигшее этой границы, осаждается из расплава на поверхность кристаллизации. Математически это может быть записано в следующем виде:
 , (76)
, (76)
где Сiтв.(0, t) и Сiж (0, t ) — концентрации растворенного i -того компонента в твердой и жидкой фазах на фронте кристаллизации в произвольный момент времени t, соответственно.
Диффузионные процессы в растворе-расплаве являются наиболее медленными из процессов, протекающих при эпитаксиальном наращивании из жидкой фазы. Поэтому они определяют кинетику эпитаксиального роста в целом и, следовательно, решение диффузионных уравнений с учетом (76) и граничных условий для концентраций и температур позволяет, в принципе, рассчитать скорость роста и толщину эпитаксиальных слоев для различных условий процесса ЖФЭ.
Однако при решении конкретных задач пользуются рядом упрощающих допущений.
Во-первых, хотя диффузия в твердой фазе и может оказывать заметное влияние на некоторые характеристики эпитаксиальных слоев (например, на особенности распределения основных и примесных компонентов), ее воздействие на кинетику роста пренебрежимо мало. Поэтому без заметного ущерба для точности вычислений вторым членом в числителе уравнения (76) можно пренебречь.
Во-вторых, из-за высокой теплопроводности жидкой фазы за исключением случаев, когда температурный градиент в расплаве создается преднамеренно, условия в расплаве могут считаться изотермическими.
И, в-третьих, из-за малой скорости перемещения фронта кристаллизации вторым членом уравнения (75) обычно пренебрегают и пользуются уравнением II закона диффузии в неподвижных координатах с учетом граничных условий, отвечающих конкретным условиям роста.
Таким образом, при расчете толщины наращиваемых слоев обычно используют следующие допущения:
· исходный раствор-расплав однороден по составу;
· температурные градиенты в жидкой и твердой фазах отсутствуют;
· состав жидкой фазы у фронта кристаллизации изменяется в процессе эпитаксиального наращивания в соответствии с равновесной диаграммой состояния;
· коэффициенты диффузии растворенного компонента и наклон линии (поверхности) ликвидуса системы в рассматриваемом температурном интервале сохраняются постоянными.
Эти допущения означают отсутствие кинетических ограничений на поверхности роста и конвекции в жидкой фазе и предполагают малый температурный интервал охлаждения.
Для решения уравнения (75) в форме, связывающей толщину эпитаксиальных споев d со временем роста t необходимо записать граничное условие материального баланса растворенного вещества границе раздела жидкой и твердой фаз:
 при x=0. (77)
при x=0. (77)
Начальное условие в соответствии с принятым допущением об однородности состава исходного раствора может быть записано в следующем виде:
 . (78)
. (78)
Кроме того, границу раздела жидкая фаза – паровая предполагаем отражающей (массообмен на границе отсутствует), то есть:
 . (79)
. (79)
Рассмотрим решения для основных разновидностей ЖФЭ.
2. Кристаллизация происходит с конечной скоростью из тонкого слоя расплава толщиной h2. Как видно из рис. 69 в слое расплава не успевает проходить выравнивающая диффузия и распределение состава по толщине в различные моменты времени описывается кривыми 0®1®2®3. Однако, в формировании эпитаксиального слоя участвует растворенное вещество всего объема раствора-расплава. Этот случай называют кристаллизацией из жидкой фазы конечной толщины. Решением диффузионной задачи с учетом граничных условий является:
 . (80)
. (80)
Анализ выражения (80) показывает, что уже при  экспоненциальным членом можно пренебречь и выражение (80) превращается в выражение (74).
экспоненциальным членом можно пренебречь и выражение (80) превращается в выражение (74).
Это означает, что при малой толщине слоя раствора-расплава диффузионные ограничения для переноса растворенного вещества к поверхности кристаллизации уменьшаются, и толщина слоев приближается к пределу, определяемому термодинамически равновесными факторами.
3. Кристаллизация происходит с конечной скоростью из толстого слоя расплава толщиной h1 (рис. 70.). Как видно из рис. 69 в слое расплава, как и в предыдущем случае, не успевает проходить выравнивающая диффузия и распределение состава по толщине в различные моменты времени описывается кривыми 0®1®2®3. Однако, в формировании эпитаксиального слоя участвует лишь часть растворенного вещества из объема раствора-расплава. Этот случай называют кристаллизацией из жидкой фазы полубесконечной толщины.
В случае полубесконечной жидкой фазы концентрация растворенного вещества на границе раздела жидкая фаза – паровая сохраняется постоянной и равной С0. Тогда граничное условие на ней принимает вид:
 . (81)
. (81)
В этом случае решением диффузионной задачи является:
 (82)
(82)
где 
Критерием применимости того или иного приближения является характеристическое время диффузии, определяемое как  . При характеристическом времени много больше времени процесса – используют приближение полубесконечной жидкой фазы, а много меньше – конечной.
. При характеристическом времени много больше времени процесса – используют приближение полубесконечной жидкой фазы, а много меньше – конечной.
На практике считают, что при  – приближение полубесконечной жидкой фазы, а при
– приближение полубесконечной жидкой фазы, а при  – конечной, где t – время процесса выращивания. В интервале
– конечной, где t – время процесса выращивания. В интервале  ни то ни другое приближения некорректны.
ни то ни другое приближения некорректны.
Эффективность процесса оценивают по величине  При равновесном охлаждении она обычно достаточно высока.
При равновесном охлаждении она обычно достаточно высока.
Следствием проведения процессов эпитаксиального наращивания с конечными скоростями кристаллизации неизбежно приводит к образованию области концентрационного переохлаждения (рис. 59), поскольку градиент температур в расплаве практически равен нулю. А это означает, что область концентрационного переохлаждения будет простираться по всему объему раствора-расплава. Тогда по уравнению (72) для сохранения планарности фронта кристаллизации при этих условиях требуется нулевая скорость выращивания. Для многокомпонентного раствора-расплава условие (72) приобретает вид:
 , (83)
, (83)
где индекс 1 относится к металлу-растворителю, а остальные – к растворенным веществам; k* – коэффициент распределения компонента на границе раздела фаз; mi – парциальная величина наклона поверхности ликвидус.
Поэтому для жидкофазной эпитаксии определяющим фактором сохранения планарности фронта кристаллизации является сама величина переохлаждения в растворе-расплаве DT, которая не должна превышать DTкр. для гомогенного зародышеобразования.
Основными недостатками неизотермического варианта эпитаксиального выращивания являются:
· при кристаллизации многокомпонентных полупроводниковых соединений не удается обеспечивать постоянство состава эпитаксиального слоя;
· при гетероэпитаксии происходит сильное подрастворение подложки, влияющее на свойства выращенного эпитаксиального слоя.
Изотермический вариант ЖФЭ
1. Метод ступенчатого охлаждения широко применяется для выращивания эпитаксиальных слоев. Этот метод основан на том, что в отсутствии контакта с подложкой из-за существенной разницы в структуре ближнего порядка полупроводниковых материалов в жидкой и твердой фазах, раствор-расплав способен выдерживать значительные переохлаждения, составляющие до 15÷200С.
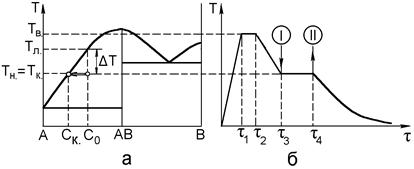
Рис. 70. Изотермический вариант выращивания слоев соединения АВ методом ЖФЭ. а – диаграмма состояния при постоянном давлении; б – температурно-временной график процесса: I – момент приведения в контакт подложки и раствора-расплава, II – момент прерывания контакта подложки и раствора-расплава.
При выращивании эпитаксиальных слоев методом ступенчатого охлаждения (рис. 70.) после гомогенизации расплава в интервале времени t1¸t2 снижают температуру до Тн., создавая при этом в растворе-расплаве переохлаждение DТ, приводят расплав в контакт с подложкой, выдерживают в интервале времени t3¸t4 (в этот период происходит эпитаксиальный рост слоя), после чего расплав удаляют. Скорости кристаллизации в этом методе выращивания обычно выше, чем при равновесном охлаждении и практически не поддаются контролю. Косвенно регулировать скорость кристаллизации возможно лишь величиной переохлаждения DТ.
Расчет толщины эпитаксиального слоя проводят, как и в предыдущем случае, в рамках приближений. При ступенчатом охлаждении выражения принимают вид:
· для конечной жидкой фазы:
 , (84)
, (84)
где  ;
;
· для полубесконечной жидкой фазы:
 . (85)
. (85)
Метод ступенчатого охлаждения применяют обычно при выращивании гетероструктур, так как подрастворение подложки в этом случае минимально, однако толщина выращенных слоев лимитируется допустимой величиной переохлаждения. Увеличивать объем расплава нецелесообразно. Поэтому применяют комбинированный метод, заключающийся в том, что сначала приводят подложку в контакт с переохлажденным расплавом (ступенчатое охлаждение), а затем проводят программируемое снижение температуры (равновесное охлаждение). Толщину слоев определяют по результатам расчета обоих последовательных процессов.
При изотермических процессах пересыщение раствора-расплава можно реализовать за счет изменения его состава в процессе выращивания, то есть в результате подпитки. Подпитка раствора-расплава может быть из жидкой, газовой и твёрдой фазы.
2. Подпитка из жидкой фазы – это вариант изотермического смешивания двух насыщенных растворов.
Реализация этого способа понятна из рис. 71. в качестве исходных расплавов выбираются два с одинаковой температурой ликвидус. После гомогенизации расплавов по аналогии с рис 70. снижают температуру до температуры ликвидус для составов С0 и С1, стабилизируют ее, приводят расплав состава С0 в контакт с подложкой и дозировано подают в него расплав состава С1. Из полученного нового пересыщенного для температуры выращивания расплава состава С2 и происходит кристаллизация эпитаксиального слоя.

Рис. 71. Схема реализации варианта изотермического смешивания: а – в двухкомпонентной системе; б – в трехкомпонентной ситеме.
3. Подпитка из газовой фазы.
· положительная подпитка: введение в раствор-расплав летучего с помощью создания избыточного давления его паров в реакторе;
· отрицательная подпитка: изменение состава раствора-расплава в результате испарения летучего растворенного компонента.
Расчеты производятся по выражениям, аналогичным приведенным в разделе «Легирование летучей примесью из расплава».
Техническая реализация основана на проведении процессов в закрытом реакторе, снабженным контейнером с летучим компонентом, помещенным в специальную температурную зону.

4. Подпитка из твёрдой фазы (сэндвич метод в градиенте температур) аналог зонной плавки в температурном градиенте.
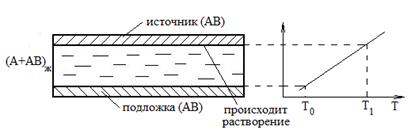
Рассмотренные варианты широкого применения не нашли в виду их малой гибкости и нетехнологичности.
Аппаратурное оформление
Реализация по способу осуществления контакта с подложкой:

1. Контакт погружения (метод Нельсона)

Рис. 9.7. Схема установки для выращивания эпитаксиальных пленок Ge методом жидкостной эпитаксии: 1 — герметичная камера; 2 — нагреватель; 3 — тигель; 4 — расплав; 5 — растворяемое вещество; 6 — держатель; 7 — подложка.
2. Механическое нанесение (устройство слайдерного типа)

3. Гидравлическая подача
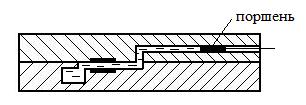
|
|
|
|
Дата добавления: 2014-01-07; Просмотров: 4585; Нарушение авторских прав?; Мы поможем в написании вашей работы!