
КАТЕГОРИИ:
Архитектура-(3434)Астрономия-(809)Биология-(7483)Биотехнологии-(1457)Военное дело-(14632)Высокие технологии-(1363)География-(913)Геология-(1438)Государство-(451)Демография-(1065)Дом-(47672)Журналистика и СМИ-(912)Изобретательство-(14524)Иностранные языки-(4268)Информатика-(17799)Искусство-(1338)История-(13644)Компьютеры-(11121)Косметика-(55)Кулинария-(373)Культура-(8427)Лингвистика-(374)Литература-(1642)Маркетинг-(23702)Математика-(16968)Машиностроение-(1700)Медицина-(12668)Менеджмент-(24684)Механика-(15423)Науковедение-(506)Образование-(11852)Охрана труда-(3308)Педагогика-(5571)Полиграфия-(1312)Политика-(7869)Право-(5454)Приборостроение-(1369)Программирование-(2801)Производство-(97182)Промышленность-(8706)Психология-(18388)Религия-(3217)Связь-(10668)Сельское хозяйство-(299)Социология-(6455)Спорт-(42831)Строительство-(4793)Торговля-(5050)Транспорт-(2929)Туризм-(1568)Физика-(3942)Философия-(17015)Финансы-(26596)Химия-(22929)Экология-(12095)Экономика-(9961)Электроника-(8441)Электротехника-(4623)Энергетика-(12629)Юриспруденция-(1492)Ядерная техника-(1748)
Генерация и рекомбинация в полупроводниках
|
|
|
|
В состоянии термодинамического равновесия процессы генерации и рекомбинации носителей заряда взаимно уравновешены. Но при этом генерация является ведущим в этом единстве и связана с воздействием энергетических факторов: теплового хаотического движения атомов кристаллической решетки (тепловая генерация), поглощенных полупроводником квантов света (световая генерация) и других. Так как полупроводник всегда находится под действием всех этих факторов или хотя бы одного ( ), генерация носителей происходит непрерывно. Рекомбинация представляет собой внутреннюю реакцию системы на появление и возрастание числа носителей. Именно рекомбинация, противодействуя накоплению носителей, обусловливает равновесные концентрации электронов
), генерация носителей происходит непрерывно. Рекомбинация представляет собой внутреннюю реакцию системы на появление и возрастание числа носителей. Именно рекомбинация, противодействуя накоплению носителей, обусловливает равновесные концентрации электронов  и дырок
и дырок .
.
При воздействии на полупроводник дополнительного внешнего энергетического фактора (света, сильного электрического ноля и др.) из-за генерации новых носителей заряда их концентрация n и p (неравновесная концентрация) будет превышать равновесную концентрацию на величину  (или
(или  ), которую называют избыточной концентрацией. Таким образом,
), которую называют избыточной концентрацией. Таким образом,

 .
.
Избыточная концентрация носителей заряда может возникать в отдельных областях полупроводниковой структуры прибора не только в результате внешних энергетических воздействий, но и за счет различных процессов (инжекции, экстракции, аккумуляции и т. д.), которые могут происходить в полупроводниковых приборах.
В зависимости от источника дополнительной энергии различают:
1. Тепловая генерация – происходит при воздействии теплового хаотического движения атомов кристаллической решетки.  . Идет и в собственном и в примесном полупроводниках. С ростом температуры концентрация возрастает экспоненциально.
. Идет и в собственном и в примесном полупроводниках. С ростом температуры концентрация возрастает экспоненциально.
|
|
|
2. Фотогенерация (световая) – происходит при воздействии поглощенных полупроводником квантов света (это может быть рентгеновское или  -излучение). Должны выполняться условия
-излучение). Должны выполняться условия  в собственном полупроводнике или
в собственном полупроводнике или  в примесных полупроводниках.
в примесных полупроводниках.
3. Ударная ионизация – лавинное размножение носителей. В сильных полях  (
( для кремния) на длине свободного пробега электрон проводимости е - (или дырка проводимости е +) набирают дополнительную энергию, достаточную для ионизации атомов примеси или собственных атомов полупроводника.
для кремния) на длине свободного пробега электрон проводимости е - (или дырка проводимости е +) набирают дополнительную энергию, достаточную для ионизации атомов примеси или собственных атомов полупроводника.
4. Полевая генерация – электрическое поле срывает е - с внешних оболочек атомов. Возникает при  в/см.
в/см.
Если в ограниченный участок объема полупроводника ввести избыточные концентрации электронов и дырок, тогда в полупроводнике возникнет электрическое поле Е, под влиянием которого избыточные, заряды будут покидать тот объем, в который они были введены. Изменение их концентрации определяется из уравнения непрерывности, которое для данного случая имеет вид
 ;
;  ,
,
где  — изменение напряженности электрического поля Е по геометрической координате х;
— изменение напряженности электрического поля Е по геометрической координате х;  и
и  — подвижность электронов и дырок.
— подвижность электронов и дырок.
Решение уравнений позволяет определить разность избыточных концентраций  и
и  в любой момент времени:
в любой момент времени:
 ,
,
где  — время диэлектрической релаксации;
— время диэлектрической релаксации;  - относительная диэлектрическая проницаемость полупроводника;
- относительная диэлектрическая проницаемость полупроводника;  - диэлектрическая постоянная воздуха.
- диэлектрическая постоянная воздуха.
Как видно из уравнения, переходный процесс имеет апериодический характер и заканчивается в течение времени (3  5)
5) .
.
Таким образом, если в полупроводник введено разное количество электронов и дырок, то разность концентраций носителей заряда противоположного знака стремится к нулю, уменьшаясь по экспоненциальному закону. Время диэлектрической релаксации не более  с. Поэтому процесс уравновешивания зарядов одного знака зарядами другого происходит за очень короткий промежуток времени. Это дает возможность сделать важный теоретический вывод: в однородном полупроводнике независимо от характера и скорости образования носителей заряда в условиях как равновесной, так и неравновесной концентрации не могут иметь место существенные объемные заряды в течение времени, большего(3
с. Поэтому процесс уравновешивания зарядов одного знака зарядами другого происходит за очень короткий промежуток времени. Это дает возможность сделать важный теоретический вывод: в однородном полупроводнике независимо от характера и скорости образования носителей заряда в условиях как равновесной, так и неравновесной концентрации не могут иметь место существенные объемные заряды в течение времени, большего(3  5)
5) , за исключением участков малой протяженности.
, за исключением участков малой протяженности.
|
|
|
Этот вывод называют условием электронейтральности или квазиэлектронейтральности полупроводника. Ограничение относительно участков малой протяженности касается участков p-n переходов и поверхностных слоев, которые при рассмотрении полупроводника в целом также можно считать электронейтральным.
Условие электронейтральности для полупроводника, в котором имеются электроны и дырки с концентрациями п и р и ионы акцепторной и донорной с концентрациями  ,
,  , математически записывают в виде
, математически записывают в виде
 .
.
Различают два механизма обеспечения условия электронейтральности:
1. если в полупроводник с электропроводностью определенного типа, например р, ввести некоторое количество дырок (основных носителей), концентрация которых равна  , то они уходят из начального объема, изменяя свою концентрацию в соответствии с выражением
, то они уходят из начального объема, изменяя свою концентрацию в соответствии с выражением  ;
;
2. если в полупроводник n-типа ввести дополнительные дырки (неосновные носители), концентрация которых  , то электроны из объема полупроводника под действием электрического поля приходят в область объема, куда были введены дырки, компенсируя заряд неосновных носителей – дырок. В итоге в этом объеме через время
, то электроны из объема полупроводника под действием электрического поля приходят в область объема, куда были введены дырки, компенсируя заряд неосновных носителей – дырок. В итоге в этом объеме через время  окажется дополнительный заряд электронов
окажется дополнительный заряд электронов  , равный заряду введенных дырок
, равный заряду введенных дырок  :
:  .
.
Таким образом, если возмущение было вызвано основными носителями заряда, то рассасывание их произойдет за малый промежуток времени. Если возмущение вызвано неосновными для данного полупроводника носителями заряда, то в течение короткого времени в полупроводнике появится дополнительный заряд основных носителей, компенсирующий заряд неосновных носителей.
Если возмущение, в результате которого появилась дополнительная концентрация носителей заряда в полупроводнике, закончилось, то эти заряды в результате рекомбинации рассасываются, причем их концентрация убывает по экспоненциальному закону:
|
|
|
 ,
,
где  — концентрация носителей заряда в момент прекращения возмущения и окончания процесса нейтрализации;
— концентрация носителей заряда в момент прекращения возмущения и окончания процесса нейтрализации;  — время жизни носителей заряда.
— время жизни носителей заряда.
Время жизни носителей заряда  , поэтому рассасывание заряда происходит значительно дольше, чем его нейтрализация.
, поэтому рассасывание заряда происходит значительно дольше, чем его нейтрализация.
Рассмотрим случай линейной рекомбинации, когда в полупроводник с явно выраженной примесной электропроводностью введены неосновные носители заряда в небольшом количестве. Тогда появление неравновесных неосновных носителей заряда не вызывает существенного изменения концентрации основных, с которыми происходит рекомбинация. Время жизни при этом оказывается постоянным, а количество носителей заряда, рекомбинировавших в единицу времени в единице объема, пропорционально первой степени избыточной концентрации  .
.
Пусть в момент времени  в полупроводнике p-типа создана избыточная концентрация
в полупроводнике p-типа создана избыточная концентрация  , которая после окончания действия источника избыточных носителей заряда, должна стремиться к нулю при
, которая после окончания действия источника избыточных носителей заряда, должна стремиться к нулю при  . Решение уравнений при этих условиях имеет вид
. Решение уравнений при этих условиях имеет вид

т. е. при линейной рекомбинации избыточная концентрация неосновных носителей за время жизни уменьшается в е раз (рис.1).
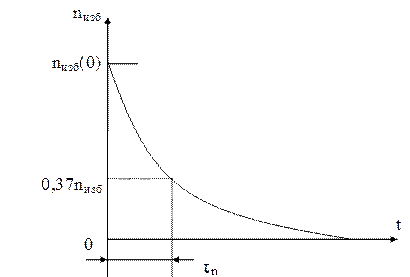
Рис. 1. Изменение избыточной концентрации во времени
Вывод: Изменение избыточной концентрации неосновных носителей происходит с постоянной времени, близкой к равновесному времени жизни неосновного носителя.
Механизмы рекомбинации могут быть различны (рис. 2).
Межзонная, или непосредственная, рекомбинация происходит при переходе свободного электрона из зоны проводимости в валентную зону на один из свободных энергетических уровней, что соответствует исчезновению пары носителей заряда — свободного электрона и дырки. Однако такой процесс межзонной рекомбинации маловероятен, так как свободный электрон и дырка должны оказаться одновременно в одном и том же месте кристалла. Кроме того, должен выполняться закон сохранения импульса, т. е. рекомбинация электрона и дырки возможна только при одинаковых, но противоположно направленных импульсах электрона и дырки. Поэтому, например, в германии на 10 тыс. рекомбинаций лишь одна происходит в результате межзонной рекомбинации.
|
|
|
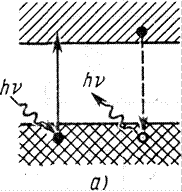

Рис. 2. Различные механизмы генерации и рекомбинации носителей заряда:
а) межзонная генерация и рекомбинация; б) генерация и рекомбинация с участием пустых рекомбинационных ловушек; в) генерация и рекомбинация с участием заполненных электронами рекомбинационных ловушек; --------- условное обозначение генерации; — — — — условное обозначение рекомбинации. Цифры означают этапы процессов генерации и рекомбинации
В большинстве полупроводников, используемых в настоящее время, рекомбинация происходит через рекомбинационные центры, которые называют рекомбинационными ловушками. Рекомбинационные ловушки – это атомы примесей, различные включения в кристалле, незаполненные узлы кристаллической решетки, трещины и другие дефекты кристаллической структуры (объема или поверхности), энергетические уровни, которые находятся в глубине запрещенной зоны (достаточно далеко как от В3, так и от 3П).
Двухэтапный процесс рекомбинации более вероятен, так как он не требует одновременного присутствия в данном месте кристалла свободного электрона и дырки. Рекомбинационная ловушка воспринимает количество движения, необходимое для соблюдения закона сохранения импульса, и может забрать часть энергии, освобождаемой в процессе рекомбинации.
Рекомбинация на ловушках (рис. 2) носит ступенчатый характер. Для полупроводника р-типа уровень Ферми  вблизи валентной зоны значительно ниже ловушек, почти все ловушки свободны. Первая стадия в переходе е - из зоны проводимости на уровень ловушки, т.е. захват е - (неосновного носителя) ловушкой. Это относительно медленный процесс, т.к. он определяется столкновением е - с ловушками, а концентрация е - в полупроводнике р-типа мала. На втором этапе е - переходит с уровня ловушки в валентную зону. Это относительно быстрый процесс, т.к. он определяется столкновением е + с ловушками (захватом дырки), а концентрация е + в полупроводнике р-типа велика. Скорость рекомбинации и время жизни
вблизи валентной зоны значительно ниже ловушек, почти все ловушки свободны. Первая стадия в переходе е - из зоны проводимости на уровень ловушки, т.е. захват е - (неосновного носителя) ловушкой. Это относительно медленный процесс, т.к. он определяется столкновением е - с ловушками, а концентрация е - в полупроводнике р-типа мала. На втором этапе е - переходит с уровня ловушки в валентную зону. Это относительно быстрый процесс, т.к. он определяется столкновением е + с ловушками (захватом дырки), а концентрация е + в полупроводнике р-типа велика. Скорость рекомбинации и время жизни  определяются 1-й стадией, причем
определяются 1-й стадией, причем  обратно пропорционально концентрации свободных ловушек. В полупроводнике n-типа уровень Ферми
обратно пропорционально концентрации свободных ловушек. В полупроводнике n-типа уровень Ферми  лежи значительно выше уровня ловушек и почти все ловушки заняты е -. Основной стадией рекомбинации, определяющей время жизни, является захват е + ловушкой, т.е. переход е - с уровня ловушки в валентную зону. 2-й стадией является переход е - из зоны проводимости на уровень ловушки. Т.о. в полупроводнике любого типа проводимости 1-ой и основной стадией рекомбинации, от которой зависит время жизни носителя, является захват неосновного носителя ловушкой. 2-я, более быстрая стадия, – захват основного носителя.
лежи значительно выше уровня ловушек и почти все ловушки заняты е -. Основной стадией рекомбинации, определяющей время жизни, является захват е + ловушкой, т.е. переход е - с уровня ловушки в валентную зону. 2-й стадией является переход е - из зоны проводимости на уровень ловушки. Т.о. в полупроводнике любого типа проводимости 1-ой и основной стадией рекомбинации, от которой зависит время жизни носителя, является захват неосновного носителя ловушкой. 2-я, более быстрая стадия, – захват основного носителя.
В связи с тем, что на поверхности кристалла перечисленных дефектов значительно больше, чем в объеме, процесс рекомбинации на поверхности должен идти значительно интенсивнее. Его рассматривают и оценивают обычно отдельно, считая поверхностную рекомбинацию разновидностью рекомбинации с участием рекомбинационных ловушек.
В зависимости от того, как расходуется энергия, освобождающаяся при рекомбинации электрона и дырки, рекомбинацию можно подразделить на два вида: излучательную и безызлучательную.
Излучательной рекомбинацией (рис. 2) называют рекомбинацию, при которой энергия, освобождающаяся при переходе электрона на более низкий энергетический уровень, излучается в виде кванта света (фотона).
При безызлучательной (фононной) рекомбинации избыточная энергия электрона передается кристаллической решетке полупроводника, т. е. избыточная энергия, идет на образование фононов — квантов тепловой энергии.
Строго говоря, характер излучения зависит от строения зон полупроводника. Если экстремумы у зон совпадают (рис. 3, а) (в реальном полупроводнике ширина запрещенной зоны меняется в зависимости от геометрической координаты) и при переходе электрона значение его импульса  остается постоянным, то энергия
остается постоянным, то энергия  выделяется в виде фотона. При несовпадении экстремумов (рис. 3, 6) обычно имеет место безызлучательная рекомбинация с выделением фонона.
выделяется в виде фотона. При несовпадении экстремумов (рис. 3, 6) обычно имеет место безызлучательная рекомбинация с выделением фонона.


Рис. 3. Процесс рекомбинации носителей заряда:
а — межзонная рекомбинация при совпадении экстремумов; б —межзонная рекомбинация при несовпадении экстремумов
Время жизни неравновесных носителей заряда зависит от температуры полупроводника. Рассмотрим температурную зависимость времени жизни на примере полупроводника с электропроводностью n-типа с рекомбинационными ловушками в верхней половине запрещенной зоны (рис. 2). При очень низкой температуре рекомбинационные ловушки заполнены электронами, так как вероятность их заполнения, судя по положению уровня Ферми, намного больше 50%. При этом первый этап рекомбинации (захват дырки рекомбинационной ловушкой) происходит быстро и время жизни оказывается небольшим. С повышением температуры уровень Ферми смещается вниз и находится вблизи энергетических уровней рекомбинационных ловушек. Это означает, что теперь не все ловушки заполнены электронами, т. е. не все ловушки могут захватить блуждающие по полупроводнику дырки. Поэтому с повышением температуры время жизни растет.

Рис. 4. Пояснение температурной зависимости времени жизни:
а — зависимость положения уровня Ферми от температуры и заполнение уровней рекомбинационных ловушек электронами; б — зависимость времени жизни от температуры
Кроме того, с ростом температуры увеличивается тепловая скорость неосновных носителей, а значит, уменьшается вероятность их захвата рекомбинационными ловушками.
Необходимо отметить, что рассмотренная температурная зависимость времени жизни справедлива только для полупроводника с рекомбинационными ловушками одного сорта или типа. Если же в полупроводнике будут рекомбинационные ловушки разных типов, создающие в запрещенной зоне несколько различных энергетических уровней, то температурная зависимость времени жизни может быть сложнее представленной на рис. 4.
Время жизни носителей заряда в значительной степени зависит от концентрации в полупроводнике рекомбинационных ловушек, так как рекомбинация чаще всего происходит с их помощью. Но кроме рекомбинационных ловушек в запрещенной зоне полупроводника обычно существуют энергетические уровни, которые могут захватывать носители только какого-либо одного типа. Такие уровни называют уровнями ловушек захвата, а дефекты кристаллической решетки, создающие уровни ловушек захвата, – ловушками захвата.
Энергетические уровни ловушек захвата электронов расположены в запрещенной зоне вблизи зоны проводимости, ловушек захвата дырок – вблизи валентной зоны (рис. 5).

Рис. 5. Расположение энергетических уровней ловушек захвата и схематическое изображение процесса захвата электронов и дырок
Через некоторое время после захвата носителей заряда ловушкой захвата может произойти ионизация этой ловушки, т. е. освобождение носителя заряда. Если время нахождения носителя в ловушке захвата велико или велика концентрация ловушек захвата, то эффективное время жизни носителя заряда может оказаться значительно больше действительного времени жизни, так как находящийся в ловушке захвата носитель не может в это время рекомбинировать. Рекомбинация возможна только после ионизации ловушки захвата или после освобождения носителя заряда.
Таким образом, в запрещенной зоне энергетической диаграммы полупроводника может существовать много различных локальных энергетических уровней, связанных с наличием разных примесей. Часть из них может быть уровнями ловушек захвата, часть — уровнями рекомбинационных ловушек. При различной степени отклонения от термодинамического равновесия роль, выполняемая отдельными ловушками, может изменяться, т. е. ловушки захвата могут стать рекомбинационными ловушками и наоборот. Чтобы установить количественный критерий отличия этих энергетических уровней, введены понятия демаркационных уровней, для которых вероятность ионизации с образованием носителя одного знака равна вероятности захвата носителя заряда противоположного знака.
В неравновесном состоянии распределение свободных электронов и дырок уже не соответствует распределению этих носителей заряда при термодинамическом равновесии. Поэтому в неравновесном состоянии распределение свободных электронов по энергетическим уровням характеризуется своим квазиуровнем Ферми для электронов, распределение дырок — своим квазиуровнем Ферми для дырок, которые имеют тот же смысл для полупроводника в неравновесном состоянии, что и уровень Ферми в условиях термодинамического равновесия. Чем больше неравновесные концентрации свободных электронов и дырок отклоняются от своих равновесных значений, тем больше отличается положение квазиуровней Ферми для электронов и для дырок от положения уровня Ферми в условиях термодинамического равновесия.
При качественном рассмотрении различных зависимостей параметров полупроводниковых приборов можно в первом приближении считать демаркационные уровни совпадающими с соответствующими квазиуровнями Ферми
(рис. 6). Уровни, лежащие выше электронного демаркационного уровня или выше квазиуровня Ферми для электронов, являются уровнями захвата электронов. Вероятность их заполнения электронами меньше 50%, что соответствует большой вероятности (более 50%) переброса электронов с этих уровней в зону проводимости в результате тепловой генерации. Аналогично, уровни, лежащие ниже дырочного демаркационного уровня или квазиуровня Ферми для дырок, являются уровнями захвата дырок.

Рис. 6. Вероятность заполнения энергетических уровней в состоянии термодинамического равновесия (кривая 1) и в неравновесном состоянии (кривая 2) и расположение квазиуровней Ферми или демаркационных уровней для электронов и дырок
Для уровней; расположенных между электронными и дырочными демаркационными уровнями или между квазиуровнями Ферми, характерна большая вероятность заполнения, с одной стороны, электронами, а с другой стороны, дырками. В действительности сумма вероятностей заполнения какого-либо уровня электроном и дыркой должна быть равна единице. Поэтому следует считать, что заполнение электронами и дырками всех уровней, расположенных между демаркационными уровнями Wдем n „ и Wдем p одинаково. В связи с этим уровни, расположенные между электронным и дырочным демаркационными уровнями, следует считать уровнями рекомбинационных ловушек.
|
|
|
|
Дата добавления: 2014-01-20; Просмотров: 7087; Нарушение авторских прав?; Мы поможем в написании вашей работы!