
КАТЕГОРИИ:
Архитектура-(3434)Астрономия-(809)Биология-(7483)Биотехнологии-(1457)Военное дело-(14632)Высокие технологии-(1363)География-(913)Геология-(1438)Государство-(451)Демография-(1065)Дом-(47672)Журналистика и СМИ-(912)Изобретательство-(14524)Иностранные языки-(4268)Информатика-(17799)Искусство-(1338)История-(13644)Компьютеры-(11121)Косметика-(55)Кулинария-(373)Культура-(8427)Лингвистика-(374)Литература-(1642)Маркетинг-(23702)Математика-(16968)Машиностроение-(1700)Медицина-(12668)Менеджмент-(24684)Механика-(15423)Науковедение-(506)Образование-(11852)Охрана труда-(3308)Педагогика-(5571)Полиграфия-(1312)Политика-(7869)Право-(5454)Приборостроение-(1369)Программирование-(2801)Производство-(97182)Промышленность-(8706)Психология-(18388)Религия-(3217)Связь-(10668)Сельское хозяйство-(299)Социология-(6455)Спорт-(42831)Строительство-(4793)Торговля-(5050)Транспорт-(2929)Туризм-(1568)Физика-(3942)Философия-(17015)Финансы-(26596)Химия-(22929)Экология-(12095)Экономика-(9961)Электроника-(8441)Электротехника-(4623)Энергетика-(12629)Юриспруденция-(1492)Ядерная техника-(1748)
Лабораторная работа № 1. Исследование статических вольт-амперных характеристик полупроводниковых диодов
|
|
|
|
Физические основы электроники
Полевые транзисторы
Биполярные диоды и транзисторы
Лабораторные работы
Методическое пособие по курсу
Часть I
Твердотельная электроника
для студентов, обучающихся по направлению
«Электроника и наноэлектроника»
Москва Издательский дом МЭИ 2013
УДК 621.383
М
Утверждено учебным управлением МЭИ
Подготовлено на кафедре полупроводниковой электроники
Рецензенты: доктор технических наук, профессор А.М. Гуляев.
М Физические основы электроники (твердотельная электроника). Лабораторные работы: методическое пособие И.Н. Мирошникова, О.Б. Сарач, Б.Н. Мирошников. - М.: Издательство МЭИ, 2013. - 96 с.
Представлены теоретические сведения и методика выполнения цикла лабораторных работ по исследованию электрических явлений в полупроводниковых приборах, методах исследования их характеристик, так и свойств оптоэлектронных приборов (фоторезисторов, фототранзисторов, светодиодов).
Методические указания предназначены для обеспечения учебного процесса при многоуровневой подготовке специалистов по укрупненной группы специальностей и направлений подготовки 210100 «Электроника и наноэлектроника», а также для образовательных программам технической и педагогической направленности.
© Национальный исследовательский университет МЭИ, 2013
Мирошникова Ирина Николаевна
Сарач Ольга Борисовна
Мирошников Борис Николаевич
Методическое пособие по курсу
«Физические основы электроники», часть I
«Твердотельная электроника»
для студентов, обучающихся по направлению
«Электроника и наноэлектроника»
Редактор издательства
____________________________________________________________
Темплан издания МЭИ 2012, метод. Подписано в печать
Печать офсетная
Формат 60×84/16 Физ. печ. л. 3 Тираж 200 экз. Изд. № Заказ ____________________________________________________________
Цель работы: изучение принципа работы полупроводниковых диодов и светодиодов.
Контролируемое введение примеси – легирование позволяет управлять концентрацией свободных носителей заряда в полупроводнике. Если атомы примеси отдают электроны, примесь называется донорной. Уровень донорной примеси Ed находится в запрещенной зоне вблизи дна зоны проводимости Ec (рисунок 1.1). Для ионизации атомов примеси требуется энергия Ec–Ed. Для Si и Ge донорной примесью могут быть элементы пятой группы. Если атомы примеси принимают электроны, примесь называется акцепторной. Уровень акцепторной примеси Ea находится в запрещенной зоне вблизи потолка валентной зоны Ev. Для ионизации атомов примеси требуется энергия Ea-Ev. Для Si и Ge акцепторной примесью могут быть элементы третьей группы.
 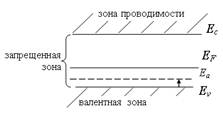 а) б)
а) б)
|
| Рис. 1.1. Зонная структура полупроводника: а) полупроводник n-типа (электронный); б) полупроводник p-типа (дырочный) |
При температурах, близких к комнатной концентрации основных носителей заряда совпадает с концентрацией легирующей примеси:  ,
,  .
.
Произведение концентраций свободных электронов и дырок в полупроводнике равно квадрату собственной концентрации носителей заряда  . Из этого соотношения находят концентрацию неосновных носителей заряда, т.е. дырок в полупроводнике n-типа (
. Из этого соотношения находят концентрацию неосновных носителей заряда, т.е. дырок в полупроводнике n-типа ( ) и электронов в полупроводнике p-типа (
) и электронов в полупроводнике p-типа ( ).
).
Удельная электропроводность полупроводника σ ( , где
, где  – удельное сопротивление) прямо пропорциональна концентрации свободных носителей заряда и их подвижности μ:
– удельное сопротивление) прямо пропорциональна концентрации свободных носителей заряда и их подвижности μ:
 ,.................................... (1.1)
,.................................... (1.1)
где q – элементарный заряд (q = 1,6 ∙ 10–19 Кл).
Для расчета подвижности в германии может быть использована эмпирическая формула:
 , (1.2)
, (1.2)
где  ‒ суммарная концентрация ионов доноров и акцепторов, остальные величины являются эмпирическими постоянными.
‒ суммарная концентрация ионов доноров и акцепторов, остальные величины являются эмпирическими постоянными.
Германий (Ge)
| Носители заряда | μ1 | μ2 | N0, см –3 | a | b |
| см2/(В∙с) | |||||
| электроны | 8,1∙1016 | 0, 48 | 0,269∙ln(N) - 10,9 | ||
| дырки | 1,4∙1017 | 0,42 | 0,33∙ln(N) - 14,5 |
Для расчета подвижности в кремнии (Si) и арсениде галлия (GaAs) следует использовать следующую также эмпирическую формулу:
 , (1.3)
, (1.3)
где
 (1.4)
(1.4)
| Тип п/п материала | Тип носителей заряда |  , см2/(В·с) , см2/(В·с)
|  , см2/(В·с) , см2/(В·с)
|  ,
см-3 ,
см-3
| 
| 
| 
|
| Si | Электроны Дырки | 1414,0 470,5 | 68,5 44,9 | 9,2∙1016 2,2∙1017 | 2,42 2,20 | 0,26 0,36 | 0,71 0,72 |
| GaAs | Электроны Дырки | 9400,0 450,0 | 750,0 30,0 | 7∙1016 5∙1017 | 2,3 2,3 | 0,50 0,45 | 0,5 0,5 |
Полупроводниковым диодом называют прибор с одним p-n-переходом и двумя выводами. Структура диода на основе p-n-перехода и его потенциальная диаграмма показаны на рисунке 1.2, а, условное обозначение – на рисунке 1.2, б.
 Рис. 1.2. Диод на основе p-n перехода (здесь Na > Nd)
Рис. 1.2. Диод на основе p-n перехода (здесь Na > Nd)
|
На границе областей n- и p-типа проводимости существует область, обедненная подвижными носителями заряда, – область пространственного заряда (ОПЗ). Нескомпенсированные ионы акцепторов у границы раздела создают отрицательный объемный заряд Q – = qNa –, нескомпенсированные ионы донорной примеси создают положительный объемный заряд Q + = qNd +. В результате в ОПЗ образуется внутреннее электрическое поле E опз, препятствующее перемещению электронов из n-области в p-область и дырок из p‑области в n-область.
Разность потенциалов между границами ОПЗ φk называется контактной разностью потенциалов. Для резкого (ступенчатого) p-n-перехода
 , (1.5)
, (1.5)
Здесь φT = kT/q – тепловой потенциал равный 0,026 В при комнатной температуре, T – абсолютная температура (в Кельвинах), k – постоянная Больцмана (k=8,617 ∙ 10–5 эВ/К);  и
и  – концентрации неосновных носителей заряда в соответствующих областях в состоянии термодинамического равновесия.
– концентрации неосновных носителей заряда в соответствующих областях в состоянии термодинамического равновесия.
При приложении к p-n-переходу внешнего напряжения практически все оно падает на ОПЗ, так как ОПЗ имеет наиболее высокое сопротивление. Если «+» источника напряжения соединяется с n-областью, а «-» – с p‑областью, внешнее электрическое поле совпадает по направлению с внутренним, высота потенциального барьера увеличивается и становится равной φk+U. Это обратное включение.
Если «+» источника напряжения соединяется с p-областью, а «-» – с n‑областью, внешнее электрическое поле направлено против внутреннего, высота потенциального барьера уменьшается и становится равной φk -U. Это прямое включение. Если внешнее напряжение будет близко к φk, носители смогут переходить через барьер, и через диод будет течь значительный ток.
 Вольт-амперная характеристика (ВАХ) диода на основе p-n-перехода показана на рисунке 1.3. При приложении напряжения состояние ТДР нарушается. При обратном смещении ОПЗ расширяется, потенциальный барьер повышается, концентрация неосновных носителей заряда (np и pn) будет меньше равновесной (np0 и pn0).
Вольт-амперная характеристика (ВАХ) диода на основе p-n-перехода показана на рисунке 1.3. При приложении напряжения состояние ТДР нарушается. При обратном смещении ОПЗ расширяется, потенциальный барьер повышается, концентрация неосновных носителей заряда (np и pn) будет меньше равновесной (np0 и pn0).
| Рис. 1.3. Вольт-амперная характеристика диода |
При приложении прямого смещения носители будут преодолевать понизившийся потенциальный барьер. Электроны за счет диффузии (т.е. из-за разницы концентраций) будут проникать из n-области в p-область, а дырки – из p-области в n-область, концентрация неосновных носителей заряда вблизи ОПЗ будет выше равновесной. Этот процесс называется инжекцией. Распределение концентраций носителей при прямом смещении показано на рисунке 1.4.
Концентрация носителей на границе ОПЗ:
 , (1.6)
, (1.6)
 , (1.7)
, (1.7)
Зависимость распределения концентрации носителей от координаты определяется длиной области. В случае длинной области, превышающей диффузионную длину  неосновных носителей тока
неосновных носителей тока
 . (1.8)
. (1.8)

| Рис. 1.4. Распределение концентрации носителей при прямом смещении |
В случае короткой области
 (1.9)
(1.9)
Для расчета концентрации электронов формулы аналогичные.
Если количество инжектированных неосновных носителей заряда много меньше количества основных носителей заряда – это низкий уровень инжекции (НУИ).
Плотность диффузионного тока дырок на границе ОПЗ (x = xn):
j p диф =  , (1.10)
, (1.10)
плотность диффузионного тока электронов на границе ОПЗ (x = -xp):
jn диф =  , (1.11)
, (1.11)
где Dn и Dp – коэффициенты диффузии электронов и дырок, см2/(В·с);
 ; (1.12)
; (1.12)
Ln – диффузионная длина электронов в p-области, Lp – диффузионная длина дырок в n-области;
 , (1.13)
, (1.13)
τn – время жизни электронов в p-области, τp – время жизни дырок в n-области.
При условии НУИ и отсутствии генерации и рекомбинации носителей заряда в ОПЗ полная плотность тока через диод:
j = js  , (1.14)
, (1.14)
где js – плотность тока насыщения:
 (1.15)
(1.15)
Умножив плотность тока на площадь p-n-перехода S получим ток через диод:
I = Is  . (1.16)
. (1.16)
При U > 0 ток экспоненциально растет с ростом напряжения, при U < 0  <<1, следовательно, ток через p-n-переход равен току насыщения.
<<1, следовательно, ток через p-n-переход равен току насыщения.
Формула (1.16) описывает ВАХ идеализированного p-n-перехода. В реальных диодах напряжение падает не только на ОПЗ, но и на слаболегированной области диода – базе:
 . (1.17)
. (1.17)
Сопротивление базы 
При обратном смещении ток через диод увеличивается из-за генерации электронно-дырочных пар в ОПЗ, при прямом смещении рекомбинация носителей в ОПЗ увеличивает общий ток. Плотность тока рекомбинации-генерации носителей заряда в ОПЗ:
 (1.18)
(1.18)
где  – ширина ОПЗ, а
– ширина ОПЗ, а  – эффективное время жизни носителей заряда:
– эффективное время жизни носителей заряда:
 (1.19)
(1.19)
Для многих практических случает можно использовать следующие формулы:
– прямое смещение pn-перехода:
 , (1.20)
, (1.20)
– обратное смещение pn-перехода:
 . (1.21)
. (1.21)
Ширина ОПЗ согласно зависит от смещения. Для ступенчатого p-n-перехода ширина ОПЗ:
 . (1.22)
. (1.22)
где ε0 – электрическая постоянная (ε0 = 8,854 ∙ 10 –14 Ф/см), ε – относительная диэлектрическая проницаемость материала.
Влияние эффектов высокого уровня инжекции тоже искажает ВАХ. Прямая ветвь ВАХ диода показана на рисунках 1.5, 1.6.

| 
|
| Рис. 1.5. ВАХ с учетом сопротивления базы в линейном масштабе | Рис. 1.6. Прямая ветвь ВАХ полупроводникового диода в полулогарифмическом масштабе |
Кроме того, вследствие саморазогрева прибора (выделение мощности I ∙ U) растет температура, и меняются параметры p-n-перехода (см. Лабораторную работу №2). При приложении большого обратного напряжения происходит пробой из-за лавинного увеличения количества носителей заряда в ОПЗ или из-за туннелирования электронов через ОПЗ. Он может перейти в тепловой пробой, ведущий к необратимому изменению характеристик.
Согласно идеализированной теории p-n перехода I ~  . При изменении тока в 10 раз (на декаду) напряжение получает приращение ΔU = 2,3
. При изменении тока в 10 раз (на декаду) напряжение получает приращение ΔU = 2,3  . Путем экстраполяции прямой ветви ВАХ идеализированного p‑n-перехода, построенной в полулогарифмическом масштабе (рисунок 1.6), к напряжению U = 0 можно найти значение тока насыщения Is. В области малых напряжений наклон ВАХ кремниевых диодов может быть меньше и определяться показателем экспоненты U/(m
. Путем экстраполяции прямой ветви ВАХ идеализированного p‑n-перехода, построенной в полулогарифмическом масштабе (рисунок 1.6), к напряжению U = 0 можно найти значение тока насыщения Is. В области малых напряжений наклон ВАХ кремниевых диодов может быть меньше и определяться показателем экспоненты U/(m  ). Если наклон соответствует коэффициенту m = 2, то преобладающим механизмом, определяющим протекание тока в диоде, считаются процессы генерации и рекомбинации носителей заряда в ОПЗ, что позволяет экстраполяцией участка с наклоном U/(2
). Если наклон соответствует коэффициенту m = 2, то преобладающим механизмом, определяющим протекание тока в диоде, считаются процессы генерации и рекомбинации носителей заряда в ОПЗ, что позволяет экстраполяцией участка с наклоном U/(2  ) найти значение тока
) найти значение тока  .
.
При домашней подготовке необходимо ознакомиться с типами р-n-переходов, изучить принцип работы полупроводникового диода, рассмотреть особенности ВАХ реальных диодов.
Предварительное расчетное задание
1. Провести расчет φk, Is и rб диодов.
2. Рассчитать и построить ВАХ идеального диода и ВАХ реального диода при температуре 300 K в одной системе координат.
|
|
|
|
|
Дата добавления: 2014-11-29; Просмотров: 1875; Нарушение авторских прав?; Мы поможем в написании вашей работы!