
КАТЕГОРИИ:
Архитектура-(3434)Астрономия-(809)Биология-(7483)Биотехнологии-(1457)Военное дело-(14632)Высокие технологии-(1363)География-(913)Геология-(1438)Государство-(451)Демография-(1065)Дом-(47672)Журналистика и СМИ-(912)Изобретательство-(14524)Иностранные языки-(4268)Информатика-(17799)Искусство-(1338)История-(13644)Компьютеры-(11121)Косметика-(55)Кулинария-(373)Культура-(8427)Лингвистика-(374)Литература-(1642)Маркетинг-(23702)Математика-(16968)Машиностроение-(1700)Медицина-(12668)Менеджмент-(24684)Механика-(15423)Науковедение-(506)Образование-(11852)Охрана труда-(3308)Педагогика-(5571)Полиграфия-(1312)Политика-(7869)Право-(5454)Приборостроение-(1369)Программирование-(2801)Производство-(97182)Промышленность-(8706)Психология-(18388)Религия-(3217)Связь-(10668)Сельское хозяйство-(299)Социология-(6455)Спорт-(42831)Строительство-(4793)Торговля-(5050)Транспорт-(2929)Туризм-(1568)Физика-(3942)Философия-(17015)Финансы-(26596)Химия-(22929)Экология-(12095)Экономика-(9961)Электроника-(8441)Электротехника-(4623)Энергетика-(12629)Юриспруденция-(1492)Ядерная техника-(1748)
Эпитаксия
|
|
|
|
Травление
1. Химическое травление – химическая реакция жидкого травителя с кремниевой пластиной с последующим образованием растворимого соединения. Процесс состоит из следующих стадий:
1) диффузия реагента к поверхности;
2) адсорбция реагента;
3) поверхностная химическая реакция;
4) десорбция продуктов реакции;
5) диффузия продуктов реакции от поверхности;
Пример реакции для изотропного травления кремния:
Si + 4HNO3 ® SiO2 +4NO3 +2H2O
SiO2 + 4HF ® SiF4 + 2H2O
Для большей равномерности травления ванну с раствором и пластиной кремния вращают в наклонном положении (динамическое травление) или вводят в ванну ультразвуковой вибратор.
Для травления кремния используют анизотропное и изотропное травление. Изотропное травление происходит во всех направления с приблизительно одинаковой скоростью. Для травление используются фосфорная, азотная и уксусная кислоты.
Анизотропное травление основано на том, что скорость химической реакции зависит от кристаллографического направления: минимальная скорость травления в направлении [111], а максимальная – в [100] (скорость травления в направлении [100] в 600 раз больше чем в направлении [111]). В качестве анизотропного травителя используются калиевая кислота и вода.
При использовании анизотропного травления скорость зависит от кристаллографического направления и боковые стенки лунок приобретают рельеф или огранку, углы под которыми вытравливаются боковые стенки лунок строго определены. плоскость [111] является как бы непроницаемой для травителя, что дает возможность при использовании маски избежать подтравливания.
Эпитаксия – это ориентированный рост полупроводниковых слоёв на полупроводниковой подложке, при котором кристаллографическая ориентация повторяет ориентацию подложки.
Если подложка и плёнка – одно и тоже вещество то процесс автоэпитаксиальный, иначе гетероэпитаксиальный.
Методы этого наращивания делят на прямые и косвенные.
1. Прямые – частицы полупроводника переносятся без промежуточных химических реакций (испарение, сублимация, реактивное распыление).
2. Косвенные – полупроводниковые плёнки получают путём разложения паров полупроводниковых соединений (методы восстановления в H2 хлоридов, бромидов кремния, а также метод разложения органических соединений кремния).
Недостаток прямого метода – сложность точного дозирования примеси в плёнке. Поэтому чаще используют косвенный метод - восстановление из хлоридов кремния SiCl4
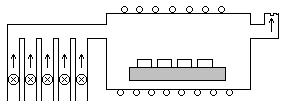
Рис. 12. Схема установки используемой для восстановления из хлоридов кремния
1. Загружаются пластины Si в реакционную камеру (пластины обработаны)
2. Продувка H2
3. Заполнение HCl для стравливания SiО2
4. Нагрев камеры до 12000 и подача SiCl4 + H2, происходит реакция восстановления SiCl4 + H2= SiCl2+2HCl
Скорость роста порядка 0,5-5 микрон в минуту. Толщина плёнки 10-20 микрон. В процессе выращивания возможно легирование В2Н6 или РН3, создающего дырочную (р) или электронную (n) проводимость.

Скорость роста пленки зависит от температуры в камере, кристаллографической ориентации кристалла в подложке (быстрее в [110], медленнее в [100]), от скорости потока газа-носителя, концентрации SiCl4 в H2, равномерности потока газа из поверхности кремния.
При невысоких температурах и больших содержаниях SiCl4 в H2 образуются рыхлые аморфные слои кремния, при повышении температуры структура кремния ухудшается и появляется поликремний.
Для всех процессов требуется высокая степень чистоты исходных элементов. Поддержание определенного технологического режима позволяет получить постоянство параметров пленки кремния в пределах 5¸10%.
В процессе выращивания слоя кремния возможно легирование соединений бора B206 (диборан) – получается р-тип кремния или фосфора PH3 (фосфин) – получается n-тип кремния, задающих дырочную или электронную проводимость.
|
|
|
|
|
Дата добавления: 2014-12-07; Просмотров: 938; Нарушение авторских прав?; Мы поможем в написании вашей работы!