
КАТЕГОРИИ:
Архитектура-(3434)Астрономия-(809)Биология-(7483)Биотехнологии-(1457)Военное дело-(14632)Высокие технологии-(1363)География-(913)Геология-(1438)Государство-(451)Демография-(1065)Дом-(47672)Журналистика и СМИ-(912)Изобретательство-(14524)Иностранные языки-(4268)Информатика-(17799)Искусство-(1338)История-(13644)Компьютеры-(11121)Косметика-(55)Кулинария-(373)Культура-(8427)Лингвистика-(374)Литература-(1642)Маркетинг-(23702)Математика-(16968)Машиностроение-(1700)Медицина-(12668)Менеджмент-(24684)Механика-(15423)Науковедение-(506)Образование-(11852)Охрана труда-(3308)Педагогика-(5571)Полиграфия-(1312)Политика-(7869)Право-(5454)Приборостроение-(1369)Программирование-(2801)Производство-(97182)Промышленность-(8706)Психология-(18388)Религия-(3217)Связь-(10668)Сельское хозяйство-(299)Социология-(6455)Спорт-(42831)Строительство-(4793)Торговля-(5050)Транспорт-(2929)Туризм-(1568)Физика-(3942)Философия-(17015)Финансы-(26596)Химия-(22929)Экология-(12095)Экономика-(9961)Электроника-(8441)Электротехника-(4623)Энергетика-(12629)Юриспруденция-(1492)Ядерная техника-(1748)
Вторично-ионная масс-спектроскопия (ВИМС)
|
|
|
|
Каналирование. Физические принципы и методы измерения
Особенности рассеяния медленных ионов









метод исследования в-ва путём определения масс атомов и молекул, входящих в его состав, и их кол-в. Совокупность значений масс и их относит. содержаний наз. м а с с - с п е к т р о м (рис.). В М.-с. используется разделение в вакууме ионов с разными отношениями массы m к заряду е под воздействием электрич. и магн. полей (см. МАСС-СПЕКТРОМЕТР). Поэтому исследуемое в-во прежде всего подвергается ионизации (если оно не ионизовано, напр. в электрич. разряде или в ионосферах планет). В случае жидких и тв. в-в их либо предварительно испаряют, а затем ионизуют, либо же применяют поверхностную ионизацию. Чаще исследуют положит. ионы.
При бомбардировке поверхности ионами высокой энергии происходит выбивание из поверхности составляющих ее атомов или кластеров, в том числе и в заряженном состоянии. Исследуя распределение вылетающих ионов по массе, можно изучать состав поверхности. Этот метод получил название вторичной ионной масс-спектроскопии (ВИМС). В качестве первичных обычно используются ионы Cs+, Ar+, O2+ с энергией от 1 до 30 кэВ 3. Во вторичном пучке атомы с низким потенциалом ионизации чаще присутствуют в виде положительных ионов, а атомы с большим сродством к электрону – в виде отрицательных ионов.
Различают две разновидности метода – статический и динамический. В статическом методе плотность тока первичных ионов составляет 10-10 − 10-9 А/см2. В таком режиме изучается непосредственно состав поверхности. В динамическом методе ВИМС плотность тока первичного пучка ионов существенно выше: 10-5 − 10-4 А/см2. При таких токах скорость распыления поверхности достаточно велика и изучается распределение атомов различного сорта по глубине.
27. Самое важное значение в вопросе о возможностях ВИМС как метода анализа поверхностей имеет взаимосвязь между параметрами пучка первичных ионов, скоростью распыления поверхности и порогом чувствительности для элементов. Из-за отсутствия информации о такой взаимосвязи часто возникают неправильные представления о возможностях метода. Соотношения между током первичных ионов, диаметром и плотностью пучка, скоростью распыления поверхности и порогом чувствительности при типичных условиях иллюстрируются графиком, представленным на фиг.5. Скорость удаления (число монослоев в секунду) атомов мишени при заданной энергии ионов пропорциональна плотности их тока DP, а порог чувствительности при регистрации методом ВИМС (минимальное количество элемента, которое можно обнаружить в отсутствие перекрывания пиков масс-спектра) обратно пропорционален полному току ионов IP. Коэффициент пропорциональности между порогом чувствительности ВИМС и IP определяется исходя из результатов измерений для ряда элементов в различных матрицах путем приближенной оценки, основанной на экспериментальных значениях для типичных пар элемент - матрица. При построении графика на фиг.5 предполагалось, что площадь захвата анализатора, из которой вторичные ионы отбираются в анализатор, не меньше сечения пучка первичных ионов. Данное условие обычно выполняется в масс-спектрометрии, если диаметр области, из которой поступают ионы, не превышает 1 мм.

Оборудование ВИМС.
Установка ВИМС состоит из четырех основных блоков: источника первичных ионов и системы формирования пучка, держателя образца и вытягивающей вторичные ионы линзы, масс-спектрометра для анализа вторичных частиц по отношению массы к заряду (m/е) и высокочувствительной системы регистрации ионов. Для получения первичных ионов в большинстве установок используются газоразрядные или плазменные источники. Совместно с соответствующей системой формирования и транспортировки пучка эти источники обеспечивают широкие пределы скорости распыления поверхности - от 10-5 до 103 А/с. Разделение вторичных частиц по m/е производится либо магнитными, либо квадрупольными анализаторами. Наиболее широко распространенным анализатором в установках ВИМС, очень удобным при анализе состава образцов и обнаружении малых количеств (следов) элементов в них, является магнитный спектрометр с двойной фокусировкой (в котором осуществляется анализ по энергии и по импульсу), что связано с его высокой чувствительностью к относительному содержанию. Для таких многоступенчатых магнитных спектрометров фоновый сигнал, возникающий из-за хвостов основных пиков материала матрицы (рассеяние стенками, на атомах газа и т.д.), может быть сведен к уровню менее 10-9 для общего фона и всего 10-6 для масс, близких к основному пику. Все же в отдельных конкретных случаях более практичным может оказаться менее дорогой квадрупольный анализатор.
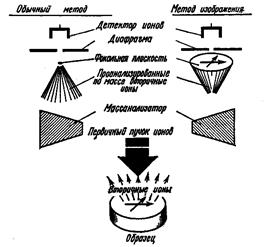
При исследовании распределения того или иного элемента по слоям, параллельным поверхности образца, для обнажения глубоколежащих слоев твердого тела in situ в большинстве методов анализа поверхности (не только ВИМС) применяют распыление ионами. При этом разрешение по глубине, обеспечиваемое выбранным методом анализа поверхности, оказывается не очень существенным, поскольку разрешение будет определяться в основном перемешиванием в приповерхностных слоях и другими процессами, сопровождающими травление поверхности.
Разрешение по глубине, обеспечиваемое при данном методе определения профилей концентрации, можно характеризовать тем уширением профиля тонкого поверхностного слоя или резкой границы раздела между двумя различными материалами, которое обусловлено самим процессом измерения.
Измерение профилей методом ВИМС сводится к регистрации сигнала вторичных ионов интересующего нас элемента как функции времени распыления. В случае однородной матрицы это время, выполнив соответствующие градуировочные измерения (распыление пленки известной толщины, измерения глубины кратера, коэффициентов распыления и т.д.), можно пересчитать в глубину залегания элемента. Изменение интенсивности вторичных ионов не всегда отражает относительное изменение концентрации элемента; поэтому нужна осторожность при интерпретации глубинных профилей, особенно вблизи самой поверхности, т. е. когда глубина меньше RP+2DRP, а также пленок, состоящих из различающихся по составу слоев, или матриц с неоднородным распределением следов элементов, которые способны даже при малой концентрации сильно повлиять на вторично-эмиссионные свойства образца.
Пригодность метода ВИМС для определения глубинного профиля наряду с его высокой чувствительностью к большинству элементов делает его весьма привлекательным как метод изучения тонких пленок, ионной имплантации и диффузии. Факторы, существенные при проведении глубинного анализа методом ВИМС, могут быть разделены на две группы: приборные и обусловленные особенностями сочетания ион – матрица.
|
|
|
|
|
Дата добавления: 2015-04-24; Просмотров: 1383; Нарушение авторских прав?; Мы поможем в написании вашей работы!