
КАТЕГОРИИ:
Архитектура-(3434)Астрономия-(809)Биология-(7483)Биотехнологии-(1457)Военное дело-(14632)Высокие технологии-(1363)География-(913)Геология-(1438)Государство-(451)Демография-(1065)Дом-(47672)Журналистика и СМИ-(912)Изобретательство-(14524)Иностранные языки-(4268)Информатика-(17799)Искусство-(1338)История-(13644)Компьютеры-(11121)Косметика-(55)Кулинария-(373)Культура-(8427)Лингвистика-(374)Литература-(1642)Маркетинг-(23702)Математика-(16968)Машиностроение-(1700)Медицина-(12668)Менеджмент-(24684)Механика-(15423)Науковедение-(506)Образование-(11852)Охрана труда-(3308)Педагогика-(5571)Полиграфия-(1312)Политика-(7869)Право-(5454)Приборостроение-(1369)Программирование-(2801)Производство-(97182)Промышленность-(8706)Психология-(18388)Религия-(3217)Связь-(10668)Сельское хозяйство-(299)Социология-(6455)Спорт-(42831)Строительство-(4793)Торговля-(5050)Транспорт-(2929)Туризм-(1568)Физика-(3942)Философия-(17015)Финансы-(26596)Химия-(22929)Экология-(12095)Экономика-(9961)Электроника-(8441)Электротехника-(4623)Энергетика-(12629)Юриспруденция-(1492)Ядерная техника-(1748)
Выращивание монокристаллов кремния по методу Чохральского
|
|
|
|
Производство полупроводниковых материалов
Влияние света на проводимость полупроводников
Влияние деформации на проводимость полупроводников
От деформации (растяжения, сжатия) изменяются межатомные расстояния (увеличиваются, уменьшаются) в кристаллической решетке ПП, а, следовательно, меняется подвижность носителей заряда. Согласно формуле (3.1) произойдет изменение удельного электрического сопротивления.
Отношение относительного изменения удельного электрического сопротивления к относительной деформации (удлинению, сжатию) в данном направлении называется тензочувствительностью ПП:
dP = (Δρ / ρ) / (Δℓ / ℓ) (3.6)
Сильная зависимость удельного сопротивления от механических деформаций в кремнии, германии используется для изготовления из этих материалов тензодатчиков.
Под действием света в ПП может осуществляться переход электрона, в свободное состояние или образовываться дырка. Освобожденные светом электроны находятся в зоне проводимости очень короткое время (10-7 ÷ 10-3 с). При отсутствии внешнего электрического поля они хаотически перемещаются в междуатомных промежутках (междоузлиях) кристаллической решетки. Когда к кристаллу ПП приложена разность потенциалов, они участвуют в электропроводности. Таким образом, поглощение света приводит к появлению в ПП дополнительных неравновесных носителей заряда, и электропроводимость его возрастает:
σ = σТЕМН + σС (3.7)
где σТЕМН - проводимость ПП б темноте; δС - фотопроводимость, появляющаяся при освещении ПП.
Максимальную длину волны падающего света, поглощаемую ПП, называют красной границей внутреннего фотоэффекта.
Энергия частиц света фотонов равна
EФ = hv = h(c/λ) (3.8)
где h - постоянная Планка; h = 4.14x10-15 эВ∙с; с=3∙108 м/с - скорость света; ν и λ - частота и длина волны падающего света.
Подставив значения h и с, получим
ЕФ = 1,23/λ.
Если вместо ЕФ ваять значение ширины запрещенной зоны, например, для Si ΔЕ = 1,12 эВ,.то получим λ =1,1 мкм.
Таким образом, Si будет поглощать свет только с длиной волны, меньше 1,1 мкм.
Зависимость проводимости ПП от освещения используют для создания различных фоточувствительных приборов, работающих в инфракрасной, видимой и ультрафиолетовой частях спектра (фотодиоды, фототранзисторы, солнечные батареи, и др.).
В ПП соединениях может наблюдаться эмиссия электронов из ПП в вакуум под действием квантов света (внешний фотоэффект), Это лежит в основе действия ПП фотокатодов в фотоэлектронных умножителях.
Около 75% всего производства монокристаллического Si ведется по методу Чохральского, который обеспечивает должный уровень качества, необходимый при изготовлении БИС (интегральных микросхем большой степени интеграции).
Метод Чохральского основан на направленной кристаллизации на затравку из большого объема расплава.
Современная установка для выращивания по Чохральскому (рисунок 3.1) представляет большой агрегат высотой более 5 м, включающий рабочую камеру, электронагреватель, прецизионную кинематическую систему, систему вакуумирования и газораспределения, устройства контроля и управления через ЭВМ.
Последовательность операций при выращивании монокристаллов следующая.
3.5.1.1 Подготовка и загрузка исходных материалов. В тигель помещают поликристаллический Si, полученный хлоридным методом, легирующую примесь, отходы монокристаллов, вакуумируют рабочую камеру, расплавляют материалы в тигле и выдерживают при Т > Тплавл
чтобы испарились летучие примеси.
3.5.1.2 Прогрев затравки. Затравка - это монокристаллический
стержень из Si малого диаметра, служащий центром кристаллизации.
Поперечное сечение затравки определяет ориентацию монокристалла: Δ - (III), □ - (100), ▬ - (110).
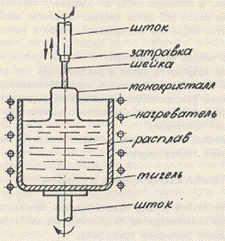
Рисунок 3.10 – Схема установки для выращивания слитков Si по методу Чохральского.
Прогревают затравку при высоких температурах, чтобы предотвратить термоудар, появление структурных несовершенств при опускании ее в расплав.
3.5.1.3 Выращивание шейки. Затравку опускают в расплав и с высокой скоростью поднимают, при этом из расплава "вытягивается"
тонкий кристалл малого диаметра - шейка.
3.5.1.4 Разращивание и "выход на диаметр". За счет снижения
скорости "подъема до (1,5-3) мм/мин осуществляется увеличение
диаметра до заданного номинала.
3.5.1.5 Выращивание цилиндрической части в автоматическом режиме. ЭВМ обеспечивает управление системами поддержания температуры, скорости вытягивания, подъема и опускания штока с затравкой,
вращения тигля.
3.5.1.6 Оттяжка на конус и отрыв кристалла от остатков расплава.
3.5.1.7 Медленное охлаждение кристалла, чтобы свести до минимума дефекты его структуры. Диаметр монокристаллических слитков
(75-100) мм, длина 1,5 м. Возможно выращивание слитков диаметром 150 мм и более. В заданную марку по удельному сопротивлению попадает обычно не более 50% длины слитка, остальная часть распределяется на другие марки или направляется снова в тигель для расплавления.
Недостатки метода Чохральского:
- растворение кварцевого тигля в расплаве Si со скоростью 10-6 г/(cм2. с), что обусловливает высокое содержание кислорода в слитке и малое удельное электрическое сопротивление, не более 104 Ом∙м;
- неравномерное распределение примесей, дефектов по длине слитка и по площади кристалла.
Для выращивания высокочистых монокристаллов Si г применяют метод бестигельной зонной плавки.
|
|
|
|
|
Дата добавления: 2015-05-26; Просмотров: 1042; Нарушение авторских прав?; Мы поможем в написании вашей работы!