
КАТЕГОРИИ:
Архитектура-(3434)Астрономия-(809)Биология-(7483)Биотехнологии-(1457)Военное дело-(14632)Высокие технологии-(1363)География-(913)Геология-(1438)Государство-(451)Демография-(1065)Дом-(47672)Журналистика и СМИ-(912)Изобретательство-(14524)Иностранные языки-(4268)Информатика-(17799)Искусство-(1338)История-(13644)Компьютеры-(11121)Косметика-(55)Кулинария-(373)Культура-(8427)Лингвистика-(374)Литература-(1642)Маркетинг-(23702)Математика-(16968)Машиностроение-(1700)Медицина-(12668)Менеджмент-(24684)Механика-(15423)Науковедение-(506)Образование-(11852)Охрана труда-(3308)Педагогика-(5571)Полиграфия-(1312)Политика-(7869)Право-(5454)Приборостроение-(1369)Программирование-(2801)Производство-(97182)Промышленность-(8706)Психология-(18388)Религия-(3217)Связь-(10668)Сельское хозяйство-(299)Социология-(6455)Спорт-(42831)Строительство-(4793)Торговля-(5050)Транспорт-(2929)Туризм-(1568)Физика-(3942)Философия-(17015)Финансы-(26596)Химия-(22929)Экология-(12095)Экономика-(9961)Электроника-(8441)Электротехника-(4623)Энергетика-(12629)Юриспруденция-(1492)Ядерная техника-(1748)
Вторично-ионная эмиссия
|
|
|
|
Основные физические и приборные параметры, характеризующие метод ВИМС, охватываются формулами (4.1) - (4.3). Коэффициент вторичной ионной эмиссии SА±, т. е. число (положительных или отрицательных) ионов на один падающий ион, для элемента А в матрице образца дается выражением
SА±=gА±САS, (4.1)
где gА± - отношение числа вторичных ионов (положительных или отрицательных) элемента А к полному числу нейтральных и заряженных распыленных частиц данного элемента, а СА -атомная концентрация данного элемента в образце. Множитель S - полный коэффициент распыления материала (число атомов на один первичный ион). В него входят все частицы, покидающие поверхность, как нейтральные, так и ионы. Величины gА± и S сильно зависят от состава матрицы образца, поскольку отношение gА± связано с электронными свойствами поверхности, а S в большой степени определяется элементарными энергиями связи или теплотой атомизации твердого тела. Любой теоретический способ пересчета измеренного выхода вторичных ионов в атомные концентрации должен, давать абсолютное значение отношения gА± или набор его приведенных значений для любой матрицы
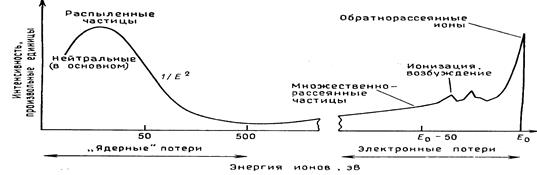
Рис.4.4. Энергетический спектр электронов, рассеянных при соударении с твердотельной мишенью [2].
Вторичный ионный ток iА± (число ионов в секунду), измеряемый в приборе ВИМС, дается выражением
iА± =hASA±IP, (4.2)
где iА± - ионный ток для моноизотопного элемента (для данного компонента многоизотопного элемента ионный ток равен faiА±, где fa, - содержание изотопа, а в элементе А). Величина hA -эффективность регистрации ионов данного изотопа в используемом приборе ВИМС. Она равна произведению эффективности переноса ионов через масс-анализатор на чувствительность ионного детектора. Множитель hA обычно можно рассматривать как константу, не зависящую от вида элемента или массы изотопа, если энергетические распределения вторичных ионов примерно одинаковы и имеют максимум при нескольких электрон-вольтах, так что зависящее от массы изменение чувствительности детектора частиц мало. Наконец, IP полный ток первичных ионов (число ионов в секунду), падающих на образец.
Конечно, величина IP связана с плотностью тока первичных ионов DP (число ионов за секунду на 1 см2) и диаметром пучка d (см). Если для простоты принять, что сечение пучка круглое, а плотность DP тока постоянна в пределах сечения, то
IP=( 0,25 p)DPd2. (4.3)
При существующих источниках первичных ионов, используемых в приборах ВИМС, плотность тока на образец, как правило, не превышает 100 мА/см2 (в случае однозарядных ионов ток 1 mА соответствует потоку 6.2 1015 ион/с). В табл. 1 приводятся типичные значения параметров, входящих в формулы (4.1) - (4.3).
Таблица 1.
Типичные значения параметров
в формулах (4.1)- (4.3) [1].
| gА± | 10-5¸10-1 |
| S | 1¸10 |
| hA | 10-5¸10-2 |
| DP | 10-6¸10-2 mA/cm2 |
| d | 10-4¸10-1 cm |
Самое важное значение в вопросе о возможностях ВИМС как метода анализа поверхностей имеет взаимосвязь между параметрами пучка первичных ионов, скоростью распыления поверхности и порогом чувствительности для элементов. Из-за отсутствия информации о такой взаимосвязи часто возникают неправильные представления о возможностях метода. Соотношения между током первичных ионов, диаметром и плотностью пучка, скоростью распыления
 поверхности и порогом чувствительности при типичных условиях иллюстрируются графиком, представленным на рис.4.5. Скорость удаления (число монослоев в секунду) атомов мишени при заданной энергии ионов пропорциональна плотности их тока DP, а порог чувствительности при регистрации методом ВИМС (минимальное количество элемента, которое можно обнаружить в отсутствие перекрывания пиков масс-спектра) обратно пропорционален полному току ионов IP. Коэффициент пропорциональности между порогом чувствительности ВИМС и IP определяется исходя из результатов измерений для ряда элементов в различных матрицах путем приближенной оценки, основанной на экспериментальных значениях для типичных пар элемент - матрица. При построении графика на рис.4.5 предполагалось, что площадь захвата анализатора, из которой вторичные ионы отбираются в анализатор, не меньше сечения пучка первичных ионов. Данное условие обычно выполняется в масс-спектрометрии, если диаметр области, из которой поступают ионы, не превышает 1 мм.
поверхности и порогом чувствительности при типичных условиях иллюстрируются графиком, представленным на рис.4.5. Скорость удаления (число монослоев в секунду) атомов мишени при заданной энергии ионов пропорциональна плотности их тока DP, а порог чувствительности при регистрации методом ВИМС (минимальное количество элемента, которое можно обнаружить в отсутствие перекрывания пиков масс-спектра) обратно пропорционален полному току ионов IP. Коэффициент пропорциональности между порогом чувствительности ВИМС и IP определяется исходя из результатов измерений для ряда элементов в различных матрицах путем приближенной оценки, основанной на экспериментальных значениях для типичных пар элемент - матрица. При построении графика на рис.4.5 предполагалось, что площадь захвата анализатора, из которой вторичные ионы отбираются в анализатор, не меньше сечения пучка первичных ионов. Данное условие обычно выполняется в масс-спектрометрии, если диаметр области, из которой поступают ионы, не превышает 1 мм.
Распыление ионным пучком - разрушающий процесс. Но если требуется, чтобы поверхность оставалась практически без изменения, то анализ методом ВИМС можно проводить при очень малых скоростях распыления образца (менее 10-4 монослоя в секунду). Чтобы при этом обеспечить достаточную чувствительность метода (»10-4 монослоя), как видно из рис.4.5, необходим первичный ионный пучок с током 10-10 А диаметром 1 мм. При столь низкой плотности тока первичных ионов (10-5 мА/см2) скорость поступления на поверхность образца атомов или молекул остаточных газов может превысить скорость их распыления первичным пучком. Поэтому измерения методом ВИМС в таких условиях следует проводить в сверхвысоком или чистом (криогенном) вакууме.
Указанные приборные условия приемлемы не во всех случаях анализа. Например, определение профиля концентрации примесей, присутствующих в малых количествах в поверхностной пленке толщиной свыше 500 А, удобно проводить при диаметре пучка, равном 100 мкм, и при скорости распыления, превышающей 10-1 атомных слоев в секунду. Еще более высокие плотности ионного тока требуются, чтобы обеспечить статистически значимые количества вторичных ионов с единицы площади поверхности, необходимые при исследовании распределения по поверхности следов элементов при помощи ионного микрозонда или масс-спектрального микроскопа. На основании сказанного и данных рис.4.5 мы заключаем, что невозможно обеспечить поверхностное разрешение в несколько микрометров для примеси, содержание которой равно»10-4%, при скорости распыления менее 10-3 атомных слоев в секунду. Это взаимно исключающие условия.
Методом ВИМС анализ поверхности можно проводить в двух разных режимах: при малой и большой плотности тока, распыляющего образец. В режиме малой плотности распыляющего тока изменяется состояние лишь малой части поверхности, благодаря чему почти выполняется основное требование, предъявляемое к методам анализа самой поверхности. В режиме же высоких плотностей токов и соответствующих больших скоростей распыления проводится измерение профилей распределения элементов по глубине, микроанализ и определение следовых количеств элементов (<10-4%). В соответствии со всеми этими вариантами создан ряд приборов ВИМС, в которых применяются разные способы создания и фокусировки первичных ионных пучков и разные анализаторы вторичных ионов.
|
|
|
|
|
Дата добавления: 2015-05-29; Просмотров: 1114; Нарушение авторских прав?; Мы поможем в написании вашей работы!