
КАТЕГОРИИ:
Архитектура-(3434)Астрономия-(809)Биология-(7483)Биотехнологии-(1457)Военное дело-(14632)Высокие технологии-(1363)География-(913)Геология-(1438)Государство-(451)Демография-(1065)Дом-(47672)Журналистика и СМИ-(912)Изобретательство-(14524)Иностранные языки-(4268)Информатика-(17799)Искусство-(1338)История-(13644)Компьютеры-(11121)Косметика-(55)Кулинария-(373)Культура-(8427)Лингвистика-(374)Литература-(1642)Маркетинг-(23702)Математика-(16968)Машиностроение-(1700)Медицина-(12668)Менеджмент-(24684)Механика-(15423)Науковедение-(506)Образование-(11852)Охрана труда-(3308)Педагогика-(5571)Полиграфия-(1312)Политика-(7869)Право-(5454)Приборостроение-(1369)Программирование-(2801)Производство-(97182)Промышленность-(8706)Психология-(18388)Религия-(3217)Связь-(10668)Сельское хозяйство-(299)Социология-(6455)Спорт-(42831)Строительство-(4793)Торговля-(5050)Транспорт-(2929)Туризм-(1568)Физика-(3942)Философия-(17015)Финансы-(26596)Химия-(22929)Экология-(12095)Экономика-(9961)Электроника-(8441)Электротехника-(4623)Энергетика-(12629)Юриспруденция-(1492)Ядерная техника-(1748)
План лекции. Субмикронные транзисторы и нанотранзисторы
|
|
|
|
Лекция 7
Субмикронные транзисторы
и нанотранзисторы
Тема 2.1. Субмикронные
полупроводниковые транзисторы
(окончание)
2.1.5. Субмикронные МДП–транзисторы и нанотранзисторы
2.1.6. Трехмерные транзисторные структуры
2.1.7. Перспективы совершенствования нанотранзисторов
2.1.8. Нанотранзисторы Intel и AMD для микропроцессоров
Вопросы к лекции
2.1.5. Субмикронные МДП–транзисторы и нанотранзисторы
2.1.5.1. Масштабирование субмикронных МДП–транзисторов [18]
Масштабное уменьшение размеров транзистора в плоскости кристалла требует уменьшения размеров элементов транзистора и по глубине кристалла, в частности толщины подзатворного диэлектрика и глубины залегания
р – п –переходов (табл. 2.1.2). Известно, что значения тока, подпороговые и другие характеристики МДП–транзисторов с традиционной структурой и длиной канала более 30 нм допускают их применение в разнообразных электронных системах.
Таблица 2.1.2
| Параметр | 2001 г. | 2006 г. | 2012 г. |
| Длина канала, мкм | 0,18 – 0, 12 | 0,1 | 0,05 |
| Толщина окисла, нм | 4 – 5 | 3 – 4 | |
| Глубина переходов rj, мкм | 0,07 – 0,13 | 0,05 | < 0,05 |
Уменьшение длины затвора и толщины затворного окисла транзистора является одним из условий повышения быстродействия интегральных схем вообще и микропроцессоров в частности. В современных транзисторных структурах толщина подзатворного оксида может быть менее 1 нм, что оценивается толщиной в три атомных слоя. При этом наблюдается рост тока утечки, вызванный процессами туннелирования через тонкий слой окисла. Поэтому на практике, даже при закрытом канале, через затвор протекает ток утечки. До последнего времени при разработке микросхем током утечки пренебрегали, поскольку его значение было невелико по сравнению с током, проходящим через открытый канал. Но с уменьшением размеров транзисторов ток утечки стал сопоставим с током, проходящим через транзистор во включенном состоянии, а риск ложного переключения транзистора возрос.
Теоретические и экспериментальные исследования показывают, что при дальнейшем укорочении канала приемлемые характеристики могут быть получены в случае использования вертикальных МДП–транзисторных структур. Вплоть до длины канала 6 нм такой транзистор сохраняет высокую крутизну подпороговых кривых с отношением токов (открыт/закрыт) порядка 108, хотя при этом становится проблематичным получение требуемого для выполнения логических функций перепада напряжения порядка 0,5 В. Таким образом, теория предсказывает сохранение баллистическим МДП–нанотранзистором необходимых для реализации логических функций свойств вплоть до значений длин канала 8-10 нм. Вместе с тем, предполагаемым сроком освоения 32 нм технологии считается 2009 г., а 22 нм – 2011 г.
2.1.5.2. Технология «кремний–на–изоляторе» [15,19]
Транзисторы со сверхтонкой пленкой-основанием выполняются на основе пленки кремния толщиной 30–40 нм, нанесенной поверх оксидного слоя (технология «кремний–на–изоляторе» – КНИ или SOI). При этом это кремний может быть частично или полностью обеднено носителями (технология «обедненный кремний–на–изоляторе» – FDSOI).
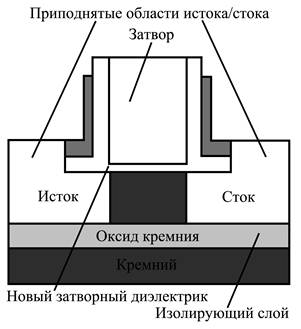 Рис. 2.1.23. Структура МОП транзистора Terahertz
Рис. 2.1.23. Структура МОП транзистора Terahertz
|
Если тонкая пленка полностью обеднена подвижными носителями при всех значениях напряжения смещения, то в области канала заряда нет. В этом случае электрическое поле в инверсном слое прибора меньше, чем в обычных приборах с сильнолегированной областью канала, выполненных по традиционной технологии. Такие транзисторы обладают большой крутизной и, соответственно, высоким быстродействием.
Данный подход использован при создании МОП–транзисторов Terahertz корпорацией Intel (рис. 2.1.23).
Транзистор изготавливается на слое из кремния толщиной 30 нм, использование оксида кремния вместо традиционного диоксида кремния позволяет снизить ток утечки через затворный диэлектрик на четыре порядка.
Предполагается, что потенциально подобная технология позволяет создавать транзисторы, пригодные к масштабированию и способные работать на частотах переключения, приближающихся к 1 терагерцу.
Terahertz–транзисторы превосходят стандартные КМОП–структуры по быстродействию на 25% и по потребляемой мощности на 30%. При напряжении 1,3 В рабочий ток транзистора, приведенный к ширине структуры, равен 650 мкА/мкм, а ток утечки составляет всего 9 нА/мкм.
Как предполагается, такие транзисторы могут стать базовыми элементами при разработке микропроцессоров фирмы Intel с минимальными топологическими нормами 20 нм, быстродействием 20 ГГц и рабочим напряжением 1 В. Технология TeraHertz, представленная специалистами Intel в декабре 2001 г. послужила основой для последующих разработок, таких, как транзисторы Tri-Gate. Аналогичные технологии используются и фирмой AMD.
2.1.5.3. Технология напряженного кремния [19,20]
Особенность этой технологии заключается в создании слоя напряженного кремния путем формирования его на подложке соединения SiGe. Из рис. 2.1.24, а видно, что постоянная кристаллической решетки монокристаллического кремния и твердого раствора SiGe различны.

| 
|
| а | б |
Рис. 2.1.24. Технология напряженного кремния: а – слои с исходными постоянными кристаллической решетки; б – напряженный слой кремния на SiGe-подложке [19]
При эпитаксиальном выращивании кремния на подложке SiGe атомы кремния стремятся подстроиться под структуру подложки, и поэтому происходит растягивание решетки кремния. Слой кремния становится напряженным. Оказывается, что подвижность электронов μ e в таком материале на 70% выше, чем в обычном кремнии. Это позволяет, не масштабируя геометрические параметры транзистора, увеличить его быстродействие на 35%.
2.1.5.4. МОП-транзистор FinFET («плавникоподобный») [18,19]
Предложенная рядом фирм, в том числе, IBM конструкция транзистора FinFET (точнее – Double Gate FinFET) представляет собой кремниевое тело (столбик, вставка, «плавник» – fin), которое как–бы обернуто затвором. Конструкция прибора такова, что формируются два самосовмещенных канала с двух сторон кремниевого тела (рис. 2.1.25). Выступающая передняя область тела представляет собой исток транзистора, а задняя область – сток.

| 
|
Рис. 2.1.25. Структура FinFET–транзистора
Ток течет в плоскости, параллельной плоскости тела. Активная ширина прибора W равна высоте тела-столбика и может быть увеличена за счет включения нескольких столбиков.
Структура FinFET аналогична традиционной МОП–структуре, хотя и является квазипланарной конструкцией, в которой активный слой полупроводника «стоит на ребре». Отличительной особенностью является активная область, которая в данном случае формируется вставкой. Высота тела вставки составляет 180 нм, толщина затворного диэлектрика – 2,2 нм, поликремниевого затвора – 75 нм.
Фирмой IBM разработаны симметричные и асимметричные n- и
р- канальные МОП-транзисторы этого типа с длиной канала ~ 30 нм, характеристики которых оптимизированы для получения высокого быстродействия и низкого порогового напряжения соответственно. Процесс изготовления полностью обедненного симметричного FinFET предусматривает формирование рисунка тела-вставки толщиной 20 нм методами фотолитографии. Структура затвора состоит из термически выращенной пленки оксинитрида толщиной 1,6 нм и поликристаллического кремния. Выступающие области истока/стока изготовлены путем проведения ионной имплантации с четырех сторон пластины. Типичный ток в n –канальном транзисторе составляет 1300 мкА/мкм, в р- канальном – 850 мкА/мкм.
Специалистами Калифорнийского университета в Беркли (США), корпорации Intel и Национальной лаборатории Лоуренса созданы FinFET-транзисторы с длиной канала 20 нм.
FinFET–транзистор корпорации AMD стал результатом ее сотрудничества с учеными Калифорнийского университета и консорциумом Semiconductor Research. Это устройство имело длину затвора всего 10 нм.
|
|
|
|
Дата добавления: 2014-01-05; Просмотров: 1067; Нарушение авторских прав?; Мы поможем в написании вашей работы!