
КАТЕГОРИИ:
Архитектура-(3434)Астрономия-(809)Биология-(7483)Биотехнологии-(1457)Военное дело-(14632)Высокие технологии-(1363)География-(913)Геология-(1438)Государство-(451)Демография-(1065)Дом-(47672)Журналистика и СМИ-(912)Изобретательство-(14524)Иностранные языки-(4268)Информатика-(17799)Искусство-(1338)История-(13644)Компьютеры-(11121)Косметика-(55)Кулинария-(373)Культура-(8427)Лингвистика-(374)Литература-(1642)Маркетинг-(23702)Математика-(16968)Машиностроение-(1700)Медицина-(12668)Менеджмент-(24684)Механика-(15423)Науковедение-(506)Образование-(11852)Охрана труда-(3308)Педагогика-(5571)Полиграфия-(1312)Политика-(7869)Право-(5454)Приборостроение-(1369)Программирование-(2801)Производство-(97182)Промышленность-(8706)Психология-(18388)Религия-(3217)Связь-(10668)Сельское хозяйство-(299)Социология-(6455)Спорт-(42831)Строительство-(4793)Торговля-(5050)Транспорт-(2929)Туризм-(1568)Физика-(3942)Философия-(17015)Финансы-(26596)Химия-(22929)Экология-(12095)Экономика-(9961)Электроника-(8441)Электротехника-(4623)Энергетика-(12629)Юриспруденция-(1492)Ядерная техника-(1748)
P_ n переход в равновесном состоянии
|
|
|
|
Фотодиоды
Работа фотодиода основана на контактных явлениях, т.е. явлениях, возникающих в области контакта материалов с различными электрофизическими свойствами. Наиболее распространенным контактом такого рода является контакт донорного и акцепторного полупроводников, приводящий к появлению p-n перехода. В фотодиодах используют такие материалы как германий, кремний, соединения галлия и др,
 P -n переход можно получить высокотемпературной диффузией из газовой фазы вначале доноров, а затем акцепторов (или наоборот), а также сплавлением, эпитаксиальным наращиванием, ионной бомбардировкой. Как следствие, в монокристалле появляются области с электронной и дырочной проводимостями, а между ними - некая переходная область, называемая p-n переходом. Контакт между р - и n -областями полупроводников изображен на рис. 11 для случая неравной концентрации примеси (концентрация доноров больше). Пунктирной линией показана условная – так называемая металлургическая – граница между областями монокристалла с разным типом проводимости. Таким образом, кристалл фотодиода имеет неоднородную структуру. Если p-n переход создается в полупроводнике одного вида, т.е. p - и n области получены на основе материала, с одинаковой шириной запрещенной зоны, то такие контакты называют гомопереходами, а если приконтактные области созданы на основе материалов с разными запрещенными зонами – то гетеропереходами.
P -n переход можно получить высокотемпературной диффузией из газовой фазы вначале доноров, а затем акцепторов (или наоборот), а также сплавлением, эпитаксиальным наращиванием, ионной бомбардировкой. Как следствие, в монокристалле появляются области с электронной и дырочной проводимостями, а между ними - некая переходная область, называемая p-n переходом. Контакт между р - и n -областями полупроводников изображен на рис. 11 для случая неравной концентрации примеси (концентрация доноров больше). Пунктирной линией показана условная – так называемая металлургическая – граница между областями монокристалла с разным типом проводимости. Таким образом, кристалл фотодиода имеет неоднородную структуру. Если p-n переход создается в полупроводнике одного вида, т.е. p - и n области получены на основе материала, с одинаковой шириной запрещенной зоны, то такие контакты называют гомопереходами, а если приконтактные области созданы на основе материалов с разными запрещенными зонами – то гетеропереходами.
Возникновение такого контакта, если предполагать, что он осуществился мгновенно, приводит к неравновесному состоянию. Это связано с тем, что в n -области концентрация электронов на порядки больше, чем в p -области, а в p -области концентрация дырок на порядки больше, чем в n -области. Как следствие, начинается процесс диффузии основных носителей в соседние области. В результате приграничные области кристалла теряют свою электрическую нейтральность, поскольку заряды неподвижных ионов не компенсируются зарядами противоположного знака, которые имеют подвижные носители – дырки и электроны. Действительно, когда валентный электрон покидает вой атом-донор и диффундирует в р -область, то в узле решетки вместо нейтрального атома остается его положительно заряженный ион. Аналогично, при уходе дырки от акцептора в узле решетки возникает ион заряженный отрицательно. В итоге, в приграничной р -области образуется объемный отрицательный некомпенсированный заряд ионов акцепторов, а в приграничной n -области – объемный положительный заряд ионов доноров (ионы обозначены кружками на рис.11). Следовательно, в области контакта появляется разность потенциалов, называемая контактной разностью Uк и возникает внутреннее электрическое поле ٤ к . Контактная разность потенциалов увеличивается с каждым актом диффузии, приводящей к росту числа ионов примеси.
Рис.11.P-n гомопереход в
равновесном состоянии
Как следует из анализа рис.11, внутреннее поле препятствует процессу диффузии основных носителей, являясь для них потенциальным барьером. По мере роста потенциального барьера ток диффузии уменьшается, а значит, уменьшается и концентрация основных носителей в приграничных областях объемного заряда. Неосновные же носители, расположенные по обе стороны металлургической границы и находящиеся в области действия сил внутреннего электрического поля, перебрасываются им в соседние области, где они меняют свой статус, становясь основными носителями.
Таким образом, ток неосновных носителей является током дрейфа, ибо причиной его возникновения является электрическое поле p-n перехода. При встрече в области перехода, при условии достаточного сближения, основные и неосновные носители могут рекомбинировать, а следовательно, восстанавливать ионы примеси до нейтральных атомов, что вызовет снижение потенциального барьера. Указанное обстоятельство, в свою очередь, приведет к росту тока диффузии, следствием которого вновь произойдет повышение потенциального барьера. Таким образом, неизбежно наступит состояние равновесия, при котором токи дрейфа и диффузии уравновесят друг друга. Следовательно, результирующий ток через переход будет равен нулю.
Поскольку в равновесном состоянии уровень Ферми должен быть единым для всего монокристалла (обозначен горизонтальной пунктирной линией на рис.11), то происходит искривление энергетических зон так, как показано на рис.11 внизу (сопоставьте с рис.7 Приложения).
В результате рекомбинационных процессов, области объемных некомпенсированных зарядов – ионов примеси имеют чрезвычайно низкую проводимость из-за низкой концентрации в них носителей тока. По этой причине их называют обедненными или высокоомными областями.
Если обозначить ширину p - и n - областей как l p и l n соответственно, то общая ширина обедненной области составит l= l p +l n . Поскольку проводимость ее чрезвычайно мала, подвижные носители в пределах обедненной области на рис.11 не показаны. Обозначены лишь (кружками) ионы примеси. Участки кристалла, расположенные за пределами обедненной области, имеют высокую проводимость и в целом электрически нейтральны, поэтому на рисунке заряды в этих областях никак не обозначены.
Обедненный слой шириной l в целом также электрически нейтрален: отрицательный заряд в p -области Q - = eNаlрS равен положительному заряду в n-области Q + = eNдlnS (Nа,.Nд – концентрации ионов акцепторов и доноров соответственно, S – площадь перехода). Из условия непрерывности на границе раздела (Q - = Q+) следует l n/l p=Nа/Nд . Если концентрация примеси в n - и p - областях одинакова, то Nа = Nд и lp = ln . Такой переход называют симметричным. Однако, на практике чаще всего используют несимметричные переходы. У несимметричных переходов концентрации примеси в p - и n -областях отличаются на несколько порядков. Если, к примеру, Nд ›› Nа, то lp ›› Ln и lp ≈ l, как это имеет место на рис.11, т.е. обедненный слой в основном сосредоточен в области с меньшей концентрацией примеси. Эту область называют базой, а область с большей концентрацией примеси – эмиттером.
На рис.11 схематически изображен кристалл примесного полупроводника с созданным в нем несимметричным переходом, причем, роль эмиттера играет n -область. Показан (сверху вниз) график изменения концентрации носителей и напряженности ٤ к внутреннего электрического поля в переходе как функции x – n(x), p(x) и ٤ к (x), а также потенциальные диаграммы для зоны проводимости и валентной зоны. Переход находится в равновесном состоянии, в обедненной области действует внутреннее поле, обусловленное контактной разностью потенциалов, а результирующий ток через переход равен нулю, т.к. ток диффузии равен току дрейфа, и оба тока имеют противоположное направление.
Если на n -область кристалла направить поток излучения с энергией квантов не меньшей энергии ионизации доноров, то поглощение фотона приведет к появлению неравновесной электронно-дырочной пары носителей. Возникший градиент концентрации заставит неравновесные (избыточные) носители диффундировать в область с меньшей их концентрацией, в том числе и в направлении к p-n переходу. При этом часть носителей может рекомбинировать, что, конечно же, нежелательно. Попадая в поле перехода, неравновесные фотоносители начнут дрейфовать в соответствии с направлением поля: дырки по полю, электроны против поля, т.е. произойдет процесс их разделения. В результате, в n -области будут накапливаться электроны, а в p - области – дырки.
Поскольку их заряды по знаку противоположны зарядам некомпенсированных ионов примеси в приграничной области (рис.11), то контактная разность потенциалов Uк уменьшится на величину, называемую фотоЭДС – Eф,и на выводах фотодиода появится напряжение, которое можно назвать напряжением холостого хода Uхх = Eф, поскольку диод работает без нагрузки. Как следствие, произойдет уменьшение потенциального барьера перехода до величины e (Uк-Uхх) (рис.112а).
 Величина фотоЭДС не может быть больше контактной разности потенциалов, поскольку при этом эффект разделения неравновесных носителей в переходе исчезает. Её полярность – «плюс» на аноде (дырки накапливаются в p -области, с которой соединён вывод анода), «минус» на катоде (электроны накапливаются в n -области, с которой соединён вывод катода). Следовательно, потенциальная диаграмма на рис.11 изменится так, как если бы на фотодиод было бы подано прямое напряжение величиной Eф = Uхх (рис.112а). На самом же деле диод находится в режиме холостого хода, т.е. к его выводам ничего не подключено, и результирующий ток перехода I равен нулю, хотя составляющие этого тока отличны от нуля.
Величина фотоЭДС не может быть больше контактной разности потенциалов, поскольку при этом эффект разделения неравновесных носителей в переходе исчезает. Её полярность – «плюс» на аноде (дырки накапливаются в p -области, с которой соединён вывод анода), «минус» на катоде (электроны накапливаются в n -области, с которой соединён вывод катода). Следовательно, потенциальная диаграмма на рис.11 изменится так, как если бы на фотодиод было бы подано прямое напряжение величиной Eф = Uхх (рис.112а). На самом же деле диод находится в режиме холостого хода, т.е. к его выводам ничего не подключено, и результирующий ток перехода I равен нулю, хотя составляющие этого тока отличны от нуля.
ис.112. Режимы работы фотодиода
В частности, понижение потенциального барьера приводит к появлению неравновесной составляющей тока диффузии (тока основных носителей) Iдиф, теплового тока (тока неосновных носителей) I0 и, наконец, фототока Iф, который, учитывая его дрейфовый характер, совпадает по направлению с направлением теплового тока. С учетом направления этих составляющих, результирующая величина тока перехода составит:
 (27)
(27)
В идеализированном переходе [2,3] ток диффузии и тепловой токи связаны следующей зависимостью:
 (28)
(28)
где  – напряжение холостого хода, оно же – фотоЭДС Eф,
– напряжение холостого хода, оно же – фотоЭДС Eф,  - температурный потенциал. Учитывая (27),найдем величину составляющей полного тока перехода, обусловленную процессом поглощения фотонов, в режиме холостого хода:
- температурный потенциал. Учитывая (27),найдем величину составляющей полного тока перехода, обусловленную процессом поглощения фотонов, в режиме холостого хода:
 (29)
(29)
Преобразуя (29) и логарифмируя, найдём выражение для напряжения холостого хода:

 (30)
(30)
Надо полагать, что максимальное значение фототока – Iкз будет иметь место в режиме «короткого замыкания» выводов фотодиода. В этом случае все неравновесные носители будут выводится из кристалла и «циркулировать» по контуру - кристалл, выводы, короткозамкнутая перемычка, кристалл. Понятно, что никакого накопления неравновесных носителей в p и n областях не будет, следовательно, потенциальный барьер перехода будет иметь максимальную высоту – eUк - такую же, как и в состоянии термодинамического равновесия при отсутствии излучения (рис.11, рис.112б). Поскольку в данном режиме напряжение на выводах равно нулю, то контактная разность потенциалов – Uк будет уравновешиваться падением напряжения на сопротивлении p и n областей.
Величина фототока короткого замыкания составит:
 , (31)
, (31)
где L (l на рис.11) – ширина p - n перехода, S – его площадь, Ln, Lp – диффузионные длины электронов и дырок соответственно (расстояние, которое носители проходят в процессе диффузии за время жизни, [2,3] + Приложение), е – заряд электрона, q – скорость генерации неравновесных носителей в соответствии с (18).
Вполне понятно, что рабочим режимом фотодиода является режим работы с нагрузкой. При подключении к диоду нагрузки (Rн) по ней начнет протекать ток нагрузки – Iн. Следовательно, при том же темпе генерации неравновесных носителей (18), их концентрация в p и n областях кристалла уменьшится, что приведет к росту потенциального барьера перехода и уменьшению – относительно  напряжения на выводах диода, в данном случае – напряжения нагрузки Uн (рис.112в, рис.12). Таким образом, ток нагрузки всегда меньше фототока короткого замыкания, т.е. Iн < Iф =Iкз. Для данного режима работы выражение (27) преобразуется к виду:
напряжения на выводах диода, в данном случае – напряжения нагрузки Uн (рис.112в, рис.12). Таким образом, ток нагрузки всегда меньше фототока короткого замыкания, т.е. Iн < Iф =Iкз. Для данного режима работы выражение (27) преобразуется к виду:
 . (32)
. (32)
Поскольку при подключении нагрузки потенциальный барьер снижается на величину еUн (рис.112в), то величина тока диффузии:
 . (33)
. (33)
Подставляя (33) в (32), преобразуя и логарифмируя обе части полученного выражения, имеем:
 . (34)
. (34)
Полученное выражение является вольтамперной характеристикой (ВАХ) освещенного идеализированного перехода и фотодиода на его основе. Графики ВАХ освещенного и неосвещенного фотодиодов приведены на рис.12. Рассмотренные режимы – холостого хода и нагрузки – имеют место в IV-й четверти системы координат - участок графика 1, линия нагрузки Rн. Анализ графика показывает, что, если ставится задача усиления сигнала фотодиода, то необходимо, чтобы он работал в режиме холостого хода, т.е. усилитель должен иметь максимально высокое входное сопротивление, поскольку оно является нагрузкой фотодиода.
Режим работы, соответствующий участку 1 IV-й четверти называют гальваническим или генераторным, а также фотовольтаическим. Достоинством этого режима является отсутствие темнового тока и необходимости в источнике питания, недостатком – невысокая чувствительность и быстродействие, хотя и существенно большее, чем у фоторезистора. Данный режим положен в основу работы так называемых солнечных батарей, представляющих собой групповое соединение большого количества фотодиодов, работающих в гальваническом режиме работы.

Для увеличения быстродействия на фотодиод подают обратное напряжение (не превышающее, естественно, максимально допустимой величины). Поскольку внешнее поле совпадает с внутренним полем, результирующая напряженность внутреннего поля при этом возрастает, что вызывает рост энергии разделяемых носителей. При некотором ее значении взаимодействие (столкновение) носителей с атомами полупроводника может вызвать их ионизацию, следовательно, количество избыточных носителей возрастёт. В результате при том же потоке излучения получают большее значение фототока, и, следовательно, большее значение чувствительности фотодиода. Платой за более высокую чувствительность в данном режиме является появление темнового тока, являющегося, по сути, обратным током p-n перехода I0, протекающем в отсутствие излучения при наличии обратного напряжения. Данный режим работы называют фотодиодным, ему соответствует участок 2 III-й четверти рис.12.
Вполне понятно, что наибольшее значение фототока будет иметь место при поглощении квантов непосредственно в p-n переходе (отсутствует диффузия в приконтактных областях), поскольку скорость дрейфа на порядки больше скорости диффузии, но вероятность такого исхода у обычных диодов с p-n структурой кристалла невелика, поскольку переход имеет небольшую ширину. По этой же причине не так велико и быстродействие (хотя оно также много больше, чем у фоторезисторов), т.к. поле перехода ускоряет неравновесные носители короткое время.
Более высокие быстродействие и чувствительность имеют фотодиоды с p-i-n структурой кристалла, у которых между базой и эмиттером выполнена своего рода «вставка» из собственного полупроводника. Как следствие, во-первых, повышается вероятность поглощения фотонов в поле перехода, во-вторых, увеличивается расстояние, на котором носители получают ускорение, а значит, они за меньшее время достигают омических контактов фотодиода.
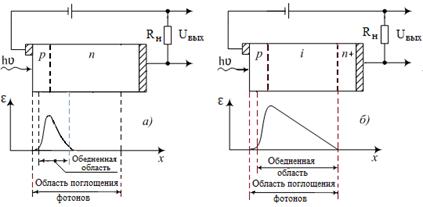 Рис. 13. Структура кристалла и внутреннего поля
Рис. 13. Структура кристалла и внутреннего поля
p-n и p-i-n фотодиодов
На рис.13. приведены структуры кристаллов p-n и p-i-n фотодиодов и графики распределения напряженности поля переходов Ԑ по координате х. Косой штриховкой указаны омические контакты диодов. Как следует из рисунка, неравновесные носители при прохождении p-i-n структуры испытывают действие поля на значительно большем по длине участке кристалла, нежели это имеет место у структуры p-n типа. Быстродействие таких диодов, оцениваемое граничной частотой, составляет единицы – десятки гигагерц, поэтому такие диоды широко применяют в системах передачи информации.
Стремление получить высокую чувствительность привело к созданию фотодиодов, у которых создается электрический пробой перехода лавинного типа. При этом диод работает на участке 3 рис.12. За счет актов лавинного размножения оптически генерированных носителей при их взаимодействии с атомами полупроводника, его фототок на несколько порядков превышает ток всех вышерассмотренных приборов. Лавинные фотодиоды (ЛФД) имеют высокое быстродействие, обусловленное высокой скоростью пролета неравновесных носителей через переход. ЛФД, в основном, применяют для регистрации излучения ближнего и дальнего инфракрасных диапазонах. Для того, чтобы лавинный пробой не перешел в тепловой, необходима стабилизация напряжения источника питания и охлаждение кристалла до температуры порядка десятков Кельвин.
Ранее отмечалось, что, возникшие в в результате поглощения фотона ОГН, в процессе диффузии могут рекомбинировать, не достигнув p-n перехода, что приведёт к уменьшению квантового выхода, а значит, и фототока. Для уменьшения вероятности подобного исхода толщина p или n слоёв, в которых происходит поглощение квантов, должна быть меньше диффузионной длины LD, т.е. достаточно тонкой. Но с уменьшением толщины слоя растёт его сопротивление, что также вызывает уменьшение фототока.
Выходом из положения является использование p-n гетеропереходов. Гетеропереходы (от греч. heteros – другой) в отличие от гомопереходов образуются при контакте полупроводников с различной шириной запрещённой зоны, например, таких соединений как AlGaAs – GaAs, GaAsP – GaAs и других. Если излучение падает на широкозонную область кристалла, у которой ширина запрещённой зоны больше энергии фотонов, то фотоны «проскакивают» эту область, что повышает вероятность их поглощения в области p-n перехода.
|
|
|
|
|
Дата добавления: 2014-11-18; Просмотров: 1188; Нарушение авторских прав?; Мы поможем в написании вашей работы!