
КАТЕГОРИИ:
Архитектура-(3434)Астрономия-(809)Биология-(7483)Биотехнологии-(1457)Военное дело-(14632)Высокие технологии-(1363)География-(913)Геология-(1438)Государство-(451)Демография-(1065)Дом-(47672)Журналистика и СМИ-(912)Изобретательство-(14524)Иностранные языки-(4268)Информатика-(17799)Искусство-(1338)История-(13644)Компьютеры-(11121)Косметика-(55)Кулинария-(373)Культура-(8427)Лингвистика-(374)Литература-(1642)Маркетинг-(23702)Математика-(16968)Машиностроение-(1700)Медицина-(12668)Менеджмент-(24684)Механика-(15423)Науковедение-(506)Образование-(11852)Охрана труда-(3308)Педагогика-(5571)Полиграфия-(1312)Политика-(7869)Право-(5454)Приборостроение-(1369)Программирование-(2801)Производство-(97182)Промышленность-(8706)Психология-(18388)Религия-(3217)Связь-(10668)Сельское хозяйство-(299)Социология-(6455)Спорт-(42831)Строительство-(4793)Торговля-(5050)Транспорт-(2929)Туризм-(1568)Физика-(3942)Философия-(17015)Финансы-(26596)Химия-(22929)Экология-(12095)Экономика-(9961)Электроника-(8441)Электротехника-(4623)Энергетика-(12629)Юриспруденция-(1492)Ядерная техника-(1748)
Мкость р-n-перехода
|
|
|
|
Инжекция неосновных носителей заряда в случае приложения к р-n-переходу прямого напряжения и экстракция неосновных носителей заряда в случае приложения к переходу обратного напряжения приводят к изменению по сравнению с равновесными концентраций носителей заряда вблизи перехода. Изменение величины приложенного внешнего напряжения вызывает изменение распределения избыточных носителей вблизи перехода, а следовательно, величины суммарного объёмного заряда. Это явление напоминает процессы в обычном конденсаторе, в котором изменение напряжения, приложенного к обкладкам, вызывает изменение накопленного заряда по закону ∆q=С∆U. Поэтому принято считать, что р-n-переход обладает емкостными свойствами или просто ёмкостью. Ёмкость р-n-перехода оказывает чрезвычайно важное влияние на его импульсные свойства.
Емкостные свойства р-n-перехода различны при прямом и обратном смещениях. Так, при прямом смещении они обусловлены главным образом накоплением избыточных концентраций неосновных носителей заряда в р- и n-областях и характеризуются так называемой диффузионной емкостью, которая определяется выражением
 , (2.1)
, (2.1)
где S – площадь р-n-перехода; pn, np – равновесные концентрации дырок в n-области и электронов в р-области; Lp, Le – диффузионные длины дырок в n-области и электронов в р-области; U – внешнее напряжение, приложенное к р-n переходу; Т – температура полупроводника; k – постоянная Больцмана; е – заряд электрона.
Из уравнения (2.1) видно, что с увеличением прямого напряжения (U>0) диффузионная ёмкость р-n-перехода быстро возрастает. При обратном смещении (U<0) диффузионная ёмкость уменьшается, и при достаточно большой величине обратного напряжения ее можно считать равной нулю.
При обратном смещении емкостные свойства р-n-перехода обусловлены образованием областей объемных зарядов ионизированных примесных атомов и характеризуются так называемой барьерной ёмкостью, которая для резкого р-n-перехода определяется выражением
 , (2.2)
, (2.2)
где Na, Nд – концентрации атомов акцепторной примеси в р-области и донорной примеси в n-области, соответственно; UK – контактная разность потенциалов р-n перехода; e - относительная диэлектрическая проницаемость полупроводника; e0 – электрическая постоянная.
Из выражения (2.2) следует, что барьерная ёмкость тем больше, чем выше концентрации примесей в полупроводнике и чем меньше напряжение, приложенное к переходу. Учитывать барьерную ёмкость особенно важно при достаточно больших обратных смещениях р-n перехода, так как диффузионная емкость при этом практически равна нулю. При прямом смещении барьерная емкость значительно меньше диффузионной.
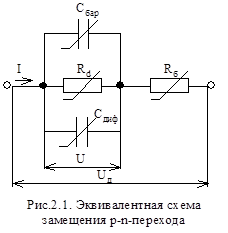
| 
|
Для анализа динамических процессов в р-n-переходе пользуются его эквивалентной схемой замещения, представленной на рис.2.1. Схема содержит два конденсатора Сбар и Сдиф, отражающих барьерную и диффузионную ёмкости р-n-перехода, а также два резистора Rd и Rб. Первый из них отражает электропроводность области объёмных зарядов р-n перехода, а второй – электропроводность р- и n- областей полупроводника, носящих название базы. Характерно, что все элементы в схеме на рис.2.1 являются нелинейными, их параметры зависят от величины и знака приложенного напряжения Uд.
Зависимости Сбар и Сдиф от напряжения рассмотрены выше. Сопротивление Rd при большом обратном напряжении велико, т.к. в области объёмных зарядов практически отсутствуют подвижные носители. При подаче на р-n-переход прямого напряжения область объёмных зарядов, во первых, сужается, а во вторых, обогащается подвижными носителями, что приводит к резкому снижению величины Rd.
Сопротивление Rб зависит от приложенного напряжения слабее, чем Rd. Тем не менее при обратном смещении оно больше из-за экстракции неосновных носителей, а при прямом смещении оно меньше из-за инжекции неосновных носителей в р- и n-области полупроводника.
|
|
|
|
|
Дата добавления: 2015-06-04; Просмотров: 414; Нарушение авторских прав?; Мы поможем в написании вашей работы!